Туннельная инжекция в р — /г-переходе
 25 февраля, 2014
25 февраля, 2014  admin
admin Прямая ветвь вольт-амперной характеристики для некоторых материалов хорошо описывается выражением
/ = /5ехр(а10, (2.13)
второе отличается от выражения (2.11) тем, что показатель a в Данном случае не зависит от температуры. В качестве примера
|
Рис. 2.5. Температурная зависимость для прямой ветви вольт-амперной характеристики красного диода из GaP, изготовленного методом жидкостной эпитаксии [6]. Вндио, что низкотемпературная составляющая тока (туннельный ток) имеет наклон, который не зависит от температуры. У высокотемпературной составляющей тока коэффициент п в соотношении lp ~ exp (eVlnkgТ) зависит от температуры; значения п близки к 2. |
такой зависимости на рис. 2.5 приведены характеристики светодиода из фосфида галлия [6]. Обычно независимость ос от Г служит признаком того, что преобладает туннельный механизм прохождения тока. В туннельном диоде (диоде Эсаки) [7] концентрации примеси в п - и p-областях велики; они выше, чем концентрации состояний в интервале энергий kBT у краев зоны проводимости и валентной зоны. В этих условиях распределение носителей описывается статистикой Ферми — Дирака, а уровень Ферми находится в зоне проводимости (в n-области) и в валентной зоне (в p-области). Такой полупроводник называется вырожденным. Для кремния при 300 К концентрация мелких доноров, при которой уровень Ферми проходит по краю зоны проводимости (невозмущенной), составляет 6-Ю19 см-3. При этом примесные уровни расширяются в примесные зоны, которые сливаются с размытыми краями разрешенных зон кристалла (рис. 2.6). Обычно распределение плотности состояний вблизи края зоны при вырождении зон описывается выражением [8]
dN (Е) — const • [exp (£’/£’0)] dE. (2.14)
|
|
|
Р(Е) 5 |
|
Рис. 2.6. Энергетнчеекое распределение плотности состояний р(Е) в нелегированном кристалле полупроводника (а), распределение р(Е) при низкой концентрации примеси, когда доноры и акцепторы образуют дискретные уровни (б), и распределение р(І') при высокой концентрации донорной примеси (е) [12]. Примесные уровни сливаются с разрешенными зонами, образуя «хвосты» распределения плотности состояний. Прн «хвост» валентной зоны Ед имеет четкую верхнюю границу, а «хвост» зоны проводимости четкой ннжней границы не имеет. - |
|
|
|
/>(£) а |
|
/>(£) в |
Эта зависимость согласуется с экспериментальными данными, полученными для края поглощения в сильнолегированном арсе - ниде галлия (рис. 2.7) и сдвига полосы люминесценции в зависимости от интенсивности возбуждения (разд. 3.3.3). Точное зна - чение Ео зависит от концентрации и энергии ионизации примесей. В арсениде галлия при низком уровне поглощения и малом смещении величина Е0 обычно порядка 10—15 мэВ [8, 9а, 96], Имеются данные о том, что в области перед истинной зоной проводимости энергия Ео резко увеличивается до ^50 мэВ [10], Выло показано также [П] , что плотность заполненных состояний «хвоста» зоны проводимости арсенида галлия гораздо меньше концентрации электронов, так что уровень Ферми проходит выше «хвоста», в почти невозмущенной части зоны проводимости.
Туннелирование — явление, обусловленное просачиванием основных носителей через потенциальный барьер вследствие того, что волновая функция электронов вблизи слоя пространственного заряда имеет конечное значение и в и в р-области. (аналогично для дырок). Это явление становится существенным только при малых значениях (^;Ю нм) ширины барьера, При
3 Зак. 1242
|
Рис. 2.7. Край поглощения в арсениде галлия, легированном теллуром, без компенсирующей примеси (кривая 1, п я* 8-Ю17 см-3; кривая 5, р « 6-Ю17 см-3) н компенсированном цинком (кривые 2—4) [13]. Температура 77 К* Кривая 2 соответствует материалу с некомпенсированной концентрацией электронов ~10 6 см"3, кривые 3 и 4—материалам, перекомпенсированным до концентрации дырок 3,4 • 1017 и 7,5 * Ю17 см"~3 соответственно при 300 К. Видно, что компенсация повышает коэффициент поглощения, сдвигает край поглощения в область меньших энергий и расширяет его. На оси абсцисс отмечено положение максимума люминес*з j ценции £Макс Для материалов, легированных до п»р«8*1017 см“ . | 1 |
этом требуется, чтобы на одном и том же энергетическом уровне Ї с одной стороны имелась большая концентрация заполненных состояний, а с другой — незаполненных. Оба эти условия выполняются в сильнолегированных р — «-переходах при малых пря* мых смещениях (рис. 2.8). При прямых туннельных переходах Величина избыточного (туннельного) тока при прямом смещении описывается выражением
I = A exp (— Btn'hEg2/eF), (2.15)
где А — множитель, выражение для которого довольно сложное и который включает распределение Ферми —Дирака для зоны проводимости и валентной зоны, Eg — энергия электрона, отсчитываемая от ближайшего края зоны, F — поле в переходе и В — постоянная, не зависящая от температуры. Туннельный ток, хотя и слабо, но зависит от температуры (из-за температурной зависимости Eg). Эта зависимость имеет вид / ~ exp (const - Т),
г
|
|
|
ТуннелироВанил "7 примесный уровень |
|
J' Рис.'2.8. Зонная диаграмма вырожденного с обеих сторон р — «-перехода [1]. Прямое туннелирование из зоны проводимости в валентную зону возможно лншь при небольших прямых смещениях; оно отсутствует при прямом напряжении выше Vi. В этой области напряжений наблюдается довольно значительный избыточный ток (-------------------------- — на вольт- амперной характеристике) за счет туннелирования на примесные уровни с возможностью последующей излучательной рекомбинации. |
|
£ |
а не / ~ exp (eV/kBT), как для диффузионного тока [выражение
(2.11) ]. Выражение для тока, обусловленного туннелированием с участием фононов (относительно маловероятный процесс, имеющий существенное значение только для полупроводников с непрямыми межзонными переходами, таких, как кремний и фосфид галлия), имеет такой же вид, только пг* заменяется приведенной массой для направления туннелирования, a Eg— величиной Eg — ftco, где ftco — энергия фонона. Туннельный диод представляет большой интерес благодаря наличию на характеристике участка отрицательного сопротивления (рис. 2.8) при напряжениях, превышающих напряжение, соответствующее максимуму туннельного тока. Такая характеристика позволяет использовать туннельный диод для усиления СВЧ-сигналов и в качестве быстродействующих переключателей.
В идеальной модели избыточный туннельный ток падает до нуля при увеличении прямого смещения до значения, при котором исчезает перекрытие валентной зоны и зоны проводимости. Конечно, туннельный ток имеет место и при напряжениях, больших, чем требуется для устранения перекрытия в модели с не - возмущенной зонной структурой, что объясняется наличием уже упоминавшихся «хвостов» плотности состояний на краях зон,
Прямое напряжение, В
Рнс. 2.9. Температурная зависимость для прямой ветви вольт-амперной характеристики красного диода из фосфида галлия, изготовленного методом жидкостной эпитаксии [14].
Наличие участка отрицательного сопротивления при температурах выше ~103 К можно объяснить влиянием глубоких ловушек электронов, образуемых донорной примесью
кислорода [14].
Как показано в работе [17], благодаря этому у кремниевых диодов наблюдается заметный туннельный ток вплоть до прямых смещений ^ 200 мэВ; эти напряжения примерно вдвое больше, чем для идеальной модели (~ 90 мэВ). Кроме того, даже при больших напряжениях может происходить горизонтальное туннелирование на глубокие примесные уровни и излучательная рекомбинация на этих состояниях (рис. 2.8). В этом случае может наблюдаться второй максимум туннельного тока (рис. 2.8) при напряжении, которое определяется положением примесных состояний в запрещенной зоне.
В диодах из GaAs и GaP наблюдалось отрицательное сопротивление другой природы (рис. 2.9). В работе [14] обнаружено, что относительная интенсивность красного и инфракрасного электролюминесцентного излучения из p-области диода (разд. 3.2.8) заметно возрастает, когда диод входит в режим с отрицательным сопротивлением. Для объяснения этого эффекта была использована модель Эшли и Милнса [15], согласно которой отрицательное сопротивление в р — і — n-диодах обусловлено двойной инжекцией, и было предположено, что при малых смещениях этому механизму препятствуют глубокие донорные уровни кислорода в г-области, которые захватывают преимущественно электроны (разд. 3.2.2).
В более поздней работе [16] температурная зависимость на участке характеристики с отрицательным сопротивлением объясняется образованием при низких температурах «-области с высоким удельным сопротивлением. При увеличении прямого смещения режим с отрицательным сопротивлением устанавли
вается после того, как быстро нарастающая концентрация инжектированных дырок становится сравнимой с концентрацией электронов. Время установления режима с отрицательным сопротивлением велико: ~ 1 мс при типичных значениях тока. Это время значительно больше времени жизни дырок при малых токах и связано скорее с разогревом образца, чем с насыщением центров рекомбинации. Разогрев происходит вследствие резкого повышения мощности, рассеиваемой в высокоомном п-слое.
Диодные структуры, обладающие S-образной (рис. 2.9), а не N-образной (рис. 2.8) вольт-амперной характеристикой, могут быть получены и другими способами. В работах [18—21] сообщается о создании зеленых светодиодов из GaP: N на основе четырехслойных р — п — р — n-диодных структур, изготовленных методом жидкостной эпитаксии. Японские исследователи [18] считают, что п — р-структура (обнаруженная при исследовании профиля распределения примеси методом поверхностнобарьерной емкости) образуется в этих светодиодах на подложках п-типа вследствие того, что при малых концентрациях серы (легирующая примесь) из-за загрязнения углеродом из графитовой лодочки и ползуна в печи в начале процесса растет слой p-типа. Верхняя область p-типа формируется диффузией цинка. В работе [19] подчеркивается роль загрязнения кремнием, поскольку детали установки для выращивания были изготовлены только из плавленого кварца. Предполагается, что возникновение слоев с высоким сопротивлением или слоев p-типа в процессе эпитаксиального выращивания из жидкой фазы вызвано введением глубокого акцепторного уровня, чему способствует увеличение концентрации вакансий фосфора Vp при выращивании в условиях пониженного перенасыщения. Природа этого акцептора неизвестна. При исследованиях методом фотоемкости обнаружен уровень с энергией 0,4 эВ над валентной зоной.
Структуры с S-образной характеристикой были получены на ■ Gai_JU*As [21а, 246] методом жидкостной эпитаксии. В этом случае р — /г-переход содержал высокоомную область, появление которой связывают с глубокими уровнями типа акцепторных, вносимыми кремнием (разд. 3.3.8).
Очевидно, в процессе роста одного слоя фосфида галлия высокоомная область может возникать несколько раз, что вызывает образование множества внутренних переходов. В отличие от японских исследователей авторы работы [19] считают, что между излучающим свет переходом, полученным диффузией Цинка, и высокоомной p-областью, содержащей кремний, существует оптическая связь. Участок с отрицательным наклоном на вольт-амперной характеристике в зеленых светодиодах из Gap :N обусловлен совместным влиянием сверхлинейной зависимости фототека^ высокоомной области (определяющей переключение) от освещения и нелинейной зависимости излучения от тока (В ~Р при малых токах). Поскольку для возникновения режима отрицательного сопротивления необходимо, чтобы Произведение квантового выхода светодиода и квантового вьь хода фотоионизации в высокоомном слое превышало 1, последняя величина должна быть ^,1000. Это очень большое значение для полупроводника с непрямыми переходами. На приборе, работающем в режиме переключения, был достигнут внешний квантовый выход излучения 0,08% на длине волны 565 нм при плотности тока 11 А/см2 [19]. В спектрах низкотемпературной фотолюминесценции слоев p-типа, самопроизвольно возникающих в приборах фирмы «Ферранти» [19], преобладают линии, обусловленные рекомбинацией на мелких донорно-акцепторных парах S — С, что согласуется с сообщением японских исследователей. Однако на основании этих данных нельзя категорически утверждать, что остаточным акцептором, определяющим электрические свойства слоя, является углерод, а не кремний. Отсутствие в спектрах линий, связанных с донорным уровнем кремния, и тот факт, что обычно кремний в фосфиде галлия дает больше донорных состояний [22], — недостаточные основания для окончательного вывода. Трудности связаны с относительно низкой силой осциллятора оптических переходов, вызванных донором SiGa и акцептором Sip, по сравнению с силой осциллятора оптических переходов, вызванных донором Sp в GaP (разд. 3.1.1). Кроме ТОГО, ВОЗМОЖНО, ЧТО ЭТИ центры (SiGa, Sip) имеют относительно малое сечение захвата носителей [22а]. Исследования, проведенные в фирме «Белл» и Лабораториях английских вооруженных сил (SERL) [23, 50], подтверждают предположение, что в нелегированном фосфиде галлия, выращенном
В СТаНДарТНЫХ УСЛОВИЯХ, ДОМИНИРУЮЩИМ ДОНОрОМ ЯВЛЯеТСЯ SiGa-
На этом основании можно ожидать, что SiP является доминирующим акцептором, поскольку в нелегированном фосфиде галлия, полученном из раствора, концентрация серы обычно больше, чем углерода.
S-образные вольт-амперные характеристики р — п — р — п - структур, полученных в работе японских исследователей [18], чрезвычайно разнообразны: пороговое напряжение переключения изменяется от ~3 до ~160 В, а поддерживающее напряжение составляет 2—3 В. В их приборах зеленое излучение с квантовым выходом ~10-4 испускается верхним (Zn — S) р — n-переходом. Время переключения в большинстве случаев находится в диапазоне 0,1 —1,0 мкс и обратно пропорционально избыточному напряжению. Устройства такого типа были бы чрезвычайно полезны для создания самопереключающихся многоразрядных буквенно-цифровых индикаторов (при условии что их характеристики станут более управляемы). В работе [20] исследовались четырехслойные структуры на основе фосфида галлия, работающие либо как высокотемпературные (0 < Т < <500°С) переключатели (динисторы), либо как управляемые вентили (тиристоры). Эти приборы были изготовлены путем эпитаксиального выращивания из жидкой фазы, в результате которого на подложке п-типа (такой же, как для светодиодов) создавался эпитаксиальный р—п-переход с последующей диффузией цинка, формирующей p-область в верхнем эпитаксиальном слое «-типа. Эпитаксиальное выращивание производилось в графитовой скользящей лодочке. Так же как в работе [18], в процессе роста слой p-типа самопроизвольно сменялся слоем n-типа, Цричем, согласно фотолюминесцентным исследованиям, доминирующими мелкими акцептором и донором являются соответственно углерод и сера. При определенной геометрии слоев (которая относительно хорошо контролировалась) были получены напряжения переключения в прямом и обратном направлении соответственно 280 и 80 В. Тиристор мог быть переключен в проводящее состояние управляющим током плотностью менее 5 А/см2, при этом плотность поддерживающего тока составляла 15 А/см2 при прямом смещении 2,2 В.
Для динисторов при прямом включении напряжение переключения составляло 380 В при 300 К и 310 В при 715 К - Подробно действие этих четырехслойных классических диодов Шокли было исследовано с помощью электронного растрового микроскопа. Структуры р — п — р — п, содержащие легированные азотом эпитаксиальные слои, обнаруживали зеленую полосу электролюминесценции, характерную для GaP: N (рис. 3.17), яркость которой при 300 К и плотности тока 20 А/см2 составляла 1700—3400 кд/м2. Время включения электролюминесценции составляло примерно 100 не и определялось временем излуча - тельной рекомбинации на комплексе, содержащем азот.
В работе [24] наблюдались переключение и осцилляции тока и яркости в р — і—n-диодах на основе GaP: N, полученного Жидкостной эпитаксией. Авторы работы [24] считают, что отрицательное сопротивление в их приборах обусловлено присутствием двух типов неидентифицированных глубоких ловушек в t'-области и объясняется в основном тем же механизмом двойной инжекции, который был рассмотрен выше (рис. 2.9).
Фирма «Шарп» (Sharp Corporation) сообщила об излучающих р — п — р — «-структурах на GaAs и GaAlAs (красные светодиоды). В случае арсенида галлия визуализация излучения Для применения в индикаторах может быть достигнута путем нанесения на поверхность структуры люминофора, излучающего в зеленой области (гл. 4). Схемотехнические аспекты создания Матричных (размером 5X7 элементов) индикаторов с памятью На основе таких структур из арсенида галлия с отрицательным сопротивлением рассмотрены в работе [24aJ. В настоящее время при эпитаксиальном выращивании из жидкой фазы применяется метод со скользящей лодочкой; кроме того, вместо цинка и теллура используется амфотерная примесь — кремний [246]. В работе [24в] описан сдвиговый регистр, аналогичный соответ-< ствующему устройству на основе кремниевых приборов с заря довой связью (ПЗС), но с оптической связью вместо зарядовой Электрическая изоляция в двумерных матрицах обеспечивается протравливанием трех верхних слоев с образованием мезаструк-і тур. Как и в ПЗС, трехтактное электрическое управление обе* спечивает однонаправленную передачу заряда между соседними, оптически связанными элементами. Оптическая связь между бо, лее отдаленными элементами слишком слаба, чтобы изменит их электрическое состояние. Целый ряд интересных логически схем, а также твердотельные линейные сканирующие устройств могут быть созданы на основе структур с отрицательным сопротивлением из арсенида галлия. Состояние таких структур может изменяться также под действием внешнего оптического сигнала, например светового пера.




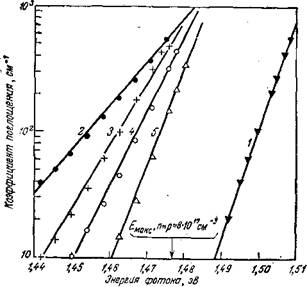
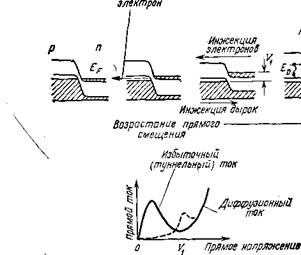
 Опубликовано в
Опубликовано в