Особенности оценки литографических параметров
 27 января, 2014
27 января, 2014  admin
admin |
|
Применение электроно - и рентгенорезистов, как и фоторезистов, требует оценки их чувствительности G, разрешающей способности и контрастности у. Здесь наблюдаются особенности, обусловленные природой актиничного излучения.
Для оценки чувствительности электроно - резиста используют два способа: либо выражают чувствительность радиационнохимическим выходом структурирования G(X) или деструкции G(S) (их определение см. в разделе VII.2), либо получают кривую чувствительности и находят ряд ее параметров. Для экспериментального
Рис. VII. 15. Зависимость от дозы излучения О:
1 — нитрат целлюлозы; 2 — ПММА; 3 — поли-а-гидроксиизо - масляная кислота. Df МГо
определения G(S) и G(X) исходят из теоретически выведенных уравнений (VII. 24) и (VII. 27). В том случае, если полимер при облучении только деструктирует, исходят из уравнения (VII. 43) изменения среднечисленной степени полимеризации после облучения:
1 /Мп (£>) = 1/Мп (0) + Q (S) £>/(9,6 • 10») (VII. 43)
где М„(0) и Mn(D)—средиечисленная ММ полимера до и после облучения дозой D.
Мп можно определить экспериментально: классическим осмо - метрическим методом или методом ГПХ, в некоторых случаях совместно с МРС. Из тангенса угла наклона прямолинейной зависимости /Мп от дозы излучения D (рис. VII. 15) можно вычислить G(S). По чувствительности к потоку электронов нитрат пеллю - лозы, следовательно, сравним с ПММА, а поли-а-гидроксиизомас - ляная кислота — хуже ПММА,
Сложнее определение G(S) и G(X), когда в полимере при облучении протекают одновременно структурирование и деструкция. В этом случае из уравнений для среднечисленной и среднемассовой степени полимеризации получают два уравнения, выведенные в предположении наиболее вероятного ММР:
l/Mn (D) = 1 /Мп (0) + 9,6 • 10» [О (S) - О (X)] D (VII. 44)
1/М» (D) = 1/М. (0) + 9,6 • 10» [О (S) - 4G (X)] D (VII. 46)
где Ма,(0) и Mn(D)—среднемассовая ММ полимера до и после облучения дозой D.
Измеряют значения Мп и Mw при помощи рассеяния света, ГПХ и ГПХ—МРС, а из тангенса угла наклона [74] прямых вычисляют
|
|
значения G(S) и G(X). В случае преобладания структурирования значения G(S) и G(X) можно найти также из золь-гель - анализа образцов, экспонированных до точки гелеобразования. На рис. VII. 16 приведены экспериментально определенные массовые доли геля wr в зависимости от нормализованной дозы излучения D/Dr для сополимера бутадиена с 2,3-эпоксипропилмет-
Рис. VII. 16. Зависимость массовой доли геля wr от норма* лнзованной дозы излучения DjDr для сополимера бута* диена с 2,3-эпокснпропнлметакрнлатом.
акрилатом. Кривая, построенная путем минимализации, дает значения G(S) « 0 и 0(Х)= 2,7 [75]. Это простая экспериментальная методика требует, однако, расчетов на ЭВМ.
Обычно кривые чувствительности хорошо воспроизводятся. Как будет показано ниже, в некоторых случаях (прежде всего у позитивных резистов) они не дают полного совпадения с приводимыми в литературе значениями литографической чувствительности, которые выражаются, как правило, в единицах дозы излучения на единицу площади. Параметры чувствительности в этом случае лучше рассматривать совместно с критериями контрастности. Чувствительность и контрастность зависят от свойств и структуры компонентов полимерных резистов: химического состава, ММ,
ММР, Гс, плотности, средней атомной массы (только для рент - генорезистов); а также от параметров технологического процесса; состава проявителя, условий проявления, предварительного и заключительного отверждения.
Определение чувствительности негативных электронорезистов хорошо иллюстрирует рис. VII. 17, а. Полимерный резист, нанесенный на подложку, на заранее определенной площади экспонируется рядом подходящих доз излучения. После проявления в стандартных условиях для данных доз определяют толщину резиста de и нормализуют эти значения, т, е. относят их к максимально
достигнутой толщине слоя d“aKC (как правило меньшей, чем первоначальная толщина резиста d). Получают график в координатах h — lgZ) (где h — нормализованная толщина слоя, h — =de/deaKC} и величиной Д.', как правило, характеризуют чувствительность негативного резиста. Эта величина отвечает дозе ионизирующего излучения до точки гелеобразования DT, но может не совпадать с ней по абсолютному значению. Так же как и DT, Dр зависит от ММ полимера резиста Mw{0) до облучения, что
|
|
|
|
|
|
|
|
Рис. VII. 17. Кривые чувствительности негативных (а) н позитивных (0) электронорезистов! 1 — резист; 2 — подложка.
является причиной различия в значениях, приводимых разными авторами для одного типа резиста. При необходимости сравнения чувствительности разных негативных резистов нельзя обойтись без Mw, так как только произведение D‘mw(0) Дает реальную основу для их сравнения. Однако и в этом случае причиной различных значений может быть ММР. Доза D* на рис. VII. 17, а отвечает достижению h ж 0,5. Коэффициент контрастности у находят из соотношения:
V = l/(lg D°r - lg д') = (lg £>?/£>')_1 (VII. 46)
где — доза излучения, необходимая для 100 %-ного сшивания резиста, т. е. для достижения d“aKC.
Коэффициент контрастности у является мерой скорости структурирования, зависит прежде всего то ММР (с уменьшением ширины ММР у возрастает) и, как будет показано ниже, прямо пропорционален разрешающей способности резиста,
Определение чувствительности позитивных резистов проводят двумя несколько различающимися способами. Первый способ [76], принцип которого подобен применяемому для негативных резистов, иллюстрируется рис. VII. 17, б. Полимерный резист экспонируют разными дозами и при условии одинакового режима проявления находят величины йе и dTPl получают зависимость нормализованной толщины h = de/de°p от lg D (Dnop отвечает чувствительности позитивного резиста). Коэффициент контрастности у для позитивных резистов по аналогии с негативными резистами определяют по уравнению:
Y = l/(lg Dp - lg Dnop) = (lg Dp/Dnop)-1 (VII. 47)
где Dnop — экспозиционная доза, отвечающая началу изменения растворимости резиста (Dn0p соответствует DlT для негативных резистов); Dp — минимальная экспозиционная доза, отвечающая полному растворению резиста.
Чувствительность, следовательно, определяется как доза излучения, вызывающая полное растворение резиста при данных условиях проявления. Как правило, эта доза не равна наиболее низкому значению, при котором можно растворить весь облученный полимер. В случае использования термодинамически лучшего растворителя [77] облучение может быть проведено меньшей дозой, но при этом возрастает также растворимость необлученного полимера, что часто является причиной технологического брака. Пельц - бауер и Вагнер предложили [78] с целью исключения различий в чувствительности резистов, обусловленных разной толщиной и разной длительностью проявления, использовать стандартные толщину слоя 1 мкм и время проявления 1 мин.
Условию стандартизации определения чувствительности позитивных электронорезистов в наибольшей степени отвечает методика, разработанная в лабораториях фирмы IBM (США) [79]. Сначала экспериментально подбирают такие условия проявления, чтобы время полного проявления неэкспонированного слоя данного резиста толщиной 1 мкм составляло 1240 с (стандартный режим проявления). Затем регистрируют толщину слоя в процессе проявления резиста, экспонированного разными дозами (рис. VII. 18,а). Из этой зависимости для каждой дозы облучения и времени, соответствующего d = 0, находят толщину неэкспонированного слоя резиста dPac4, зависимость которой от дозы представлена на рис. VII. 18, б. Оптимальная чувствительность D0пт определяется из полученной таким образом зависимости графической экстраполяцией к исходной толщине резиста.
При определении величин Dlr, Dnoр, -DonT непосредственно не учитывается ММ резиста, в последнее время рекомендовано выражать чувствительность произведением DBopMw или DlMw где Mw— среднемассовая ММ исходного резиста [25]. Однако и при таком способе выражения чувствительности в нем не находит отражение влияния ММР,
С точки зрения практического использования электронорезис - тов в данном технологическом цикле так же, как и в случае фоторезистов, наибольшее значение имеет так называемая литографическая чувствительность, т. е. доза, при которой достигаются минимальные отклонения экспонированных и неэкспонированных линий одинаковой ширины от размеров, заданных программой. Для негативных резистов эта доза примерно соответствует D0i5.
|
Рис. VII. 18. Экспериментальное определение чувствительности позитивных электронорези - стов на основе измерения скорости проявления: а — кинетические кривые растворения слоя резиста прн разных экспозиционных дозах; б — зависимость ^расч от Д03Ы излучения, прн которой достигается полное проявление соответствующего экспонированного слоя. |
Новая техника определения радиационно-химического выхода сшивания G(X) или деструкции G(S) полимера приводится в разработке фирмы Bell [80].
Изменение растворимости при облучении позитивных электро - норезистов, в значительной мере определяющей возможности их применения, изучалось применительно к литографии не только экспериментально, но и теоретически [81]. Для некоторых типов позитивных резистов изменение растворимости может изменить их чувствительность на порядок.
Разрешение, достигаемое на данной стадии литографического процесса, определяется параметрами экспонирующего устройства, свойствами резистов и факторами, влияющими на скорость обработки слоя резиста и образование нужного рельефа. Когда указывается разрешающая способность резиста, необходимо всегда приводить условия, в которых был образован рельеф, прежде всего ускоряющее напряжение, толщину слоя резиста, условия обработки резиста, а в некоторых случаях и последующих слоев [82], и способы измерения ширины линий. Без этих основных данных невозможно сравнивать отдельные материалы и сопоставлять результаты литографических процессов. Ниже перечислены факторы, оказывающие влияние на разрешающую способность электронной (I), рентгеновской (II) и ионной (III) литографии.
Экспонирующее устройство: ускоряющее напряжение источника (I), размер пучка измерения и его форма (I), геометрия рельефа (I), длина волны излучения (II), рисунок маски (II), коэффициент контрастности маски (II), масса и заряд ионов (III).
Материал для литографии (I—III): состав резиста, толщина слоя резнста, Тс полимерного резиста, коэффициент контрастности резиста, атомный номер элемента, входящего в состав материала подложки (I), толщина подложки (I), чувствительность резиста.
Технологические факторы (I—III): температура предварительной термообработки, состав проявителя, режим плазменного удаления вуали, способ травления.
Формирование микроструктур с минимальными размерами менее 100 нм сопровождается дополнительными трудностями. На качество такого изображения влияют энергия и экспозиционная доза; ширина линий зависит от степени экспонирования отраженными и рассеянными электронами. Необходимо учитывать слой - ность системы, материал подложки, условия проявления, характер последующих операций [83].







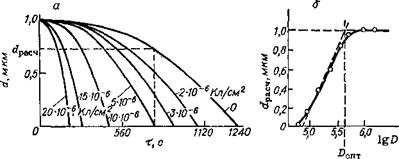
 Опубликовано в
Опубликовано в