ФОТОРЕЗИСТЫ-ДИФФУЗАНТЫ
 7 января, 2014
7 января, 2014  admin
admin Фоторезисты-диффузанты — новые светочувствительные материалы, на основе которых могут быть осуществлены обе основные операции планарной технологии изготовления полупроводниковых приборов: фотолитография и диффузия. Диффузионный процесс определяет' уровень глубины электронно-дырочного перехода в кремнии и концентрацию легирующей примеси. Создание однородных диффузионных переходов относится к числу сложных задач планарной технологии, решение которых обусловлено в большой степени выбором диффузанта.
В патентах и научных публикациях последних лет прослеживается тенденция к использованию полимерных источников диффузии наряду с мономерными газообразными и жидкими [46—49]. Так, в пат. США 3084079 описано создание сплошной органической пленки из водного раствора метилтриметоксисилана и триметокси- бороксана; при 200°С в пленке протекает гидролиз компонентов, а затем и поликонденсация. Из образовавшегося полимера при 600 °С формируется легирующий оксид, используемый для последующей высокотемпературной диффузии. Сообщается об источни
ках легирования, которые включены в полимерную пленку (например, на основе цианоэтилцеллюлозы): нитрид бора, порошок алюминия [пат. США 3630793].
Значительно более перспективным представляется использование в диффузионных источниках растворимых в органических растворителях полимерных элементорганических соединений, благодаря прежде всего возможности их равномерного нанесения на поверхность полупроводниковых пластин. Предложен состав, включающий полимерный карборан (0,2 г), полиметилсилоксан (8 г), бутилацетат (40 г), который позволяет получать поверхностные
|
а в |
|
J-S1 |
|
|
|
С |
|
pm— |
|
ВИЩ22йЗ-§Юя „ Г ;-Si 211 |
|
мп шт.. |
|
-Si / |
|
III |
|
hv |
|
IV |
|
YJ |
№3-s.
рис. VI. 1. Основные этапы планаррой технологии изготовления полупроводниковрго прибора по традиционному методу (я) и при проведении диффузии из слой фотореанстй-диффу&аи^ та (б):
/ — подготовка поверхности; Я —окисление; /// —экспонирование; /V — проявление; Ve - травление; VI — диффузия.
(J — шаблон; 2 — фоторезист; S — фоторевист-диффузант.
концентрации бора 0,5-1020 - f - 3,0-1020 атом/см3 [48]; подобные составы рекомендованы для диффузии фосфора и мышьяка. Использованием полимерных пленочных источников достигнут малый разброс значений поверхностного сопротивления на пластинах кремния: 1,71 % для бора и 1,65% для фосфора и мышьяка [48]. При определенном подборе полимерных элементорганических соединений появляется возможность создания диффузионных слоев с нужными электрофизическими характеристиками.
В процессе длительного использования органических фоторезистов в основном решены вопросы создания однородных слоев с минимальным разбросом толщин. Это и определило идею разработки фоторезистов-диффузантов, обладающих точностью дозировки примесей, а также технологичностью нанесения, присущих фоторезистам. Схема селективного легирования из фоторезиста-диффузанта приведена на рисунке VI. 1.
В качестве диффузантов невозможно использовать светочувствительные составы, содержащие атомы серы или другие елек-
тронодонорные атомы, а также не участвующие в легировании полупроводника атомы металлов; совершенно недопустимо присутствие даже примесных количеств (К)-5—10-®%) атомов тяжелых металлов (Pb, Cr, Си, Fe, Ni, Zn, Аи, Ag, и т. д.). Все эти включения искажают электрофизические параметры полупроводникового прибора, поэтому используемый фоторезист-диффузант не должен их содержать.
Таким образом, исходя из условий формирования электронодырочных переходов в полупроводниковых структурах, композиции фоторезистов-диффузантов могут быть основаны на соединениях, состоящих исключительно из атомов кислорода, азота, углерода и водорода, в которые должны быть включены нужные легирующие атомы, например, II, III, V, VIII групп, редкоземельных элементов и т. д. Первоначально заданное количество атомов легирующего элемента в композиции легко может быть сохранено в рисунке полимерного фоторельефа. Последний после защиты оксидом используется как источник диффузии для создания определенной поверхностной концентрации примеси нужной глубины залегания. Технология изготовления полупроводниковой структуры упрощается: сокращается число используемых материалов и операций, в частности, исключается наиболее критичная операция — травление [50].
В принципе любой тип светочувствительных составов может быть использован при создании на его основе фоторезистов-диффузантов. Однако при этом необходимо, учитывая указанные выше ограничения по составу, обеспечивать эффективность протекания фотохимического процесса; во время высокотемпературной диффузии не должно выделяться гари, сажи, ядовитых паров. Однако фотополимерные составы радикальной или ионной фотополимеризации почти не используются в качестве основы фоторезистов-диффузантов, так как возможности фотополимеризации элементоргани - ческих полимеров пока мало изучены, а для ониевых солей трудно варьировать содержание в слое легирующего атома. Не используются и системы на основе поливинилциннаматов. Нарушение геометрических размеров халконовой цепи при введении легирующих атомов отрицательно влияет на эффективность фотолиза, поскольку фотоциклодимеризация халконовых групп —СН = СН — СО— очень чувствительна к пространственному расположению связей —СН=СН—.
К тому же атомы тяжелых элементов повышают относительную скорость внутренней конверсии возбужденных состояний ал - кена, что, в свою очередь, затрудняет фотоциклодимеризацию. Кроме того, для введения атомов каждого конкретного легирующего элемента в циклодимеризующиеся системы необходим свой путь синтеза. Едва ли можно рекомендовать в качестве основы фоторезистов-диффузантов и составы, включающие феноло-альде - гидные смолы, вследствие их деструкции при высокотемпературной диффузии и выделения при этом летучих продуктов и сажи, что может привести к неравномерности легирования.
Имеется взаимосвязь содержания источника легирования в композиции слоя диффузанта с создаваемой в результате диффузии его поверхностной концентрацией и глубиной перехода в полупроводнике. По грубой оценке, например, для малой глубины перехода в кремний (3—5 мкм) слой диффузанта должен содержать 5-1016 атом/см3 фосфора для достижения поверхностной концентрации 1016 атом/см3. Для воспроизведения концентраций 1021 атом/см3 при глубоких переходах (порядка 40 мкм) необходимо увеличить содержание фосфора в материале источника в 105 раз. Введением в композицию фоторезиста—диффузанта мономерных соединений с легирующими атомами достигаются низкие поверхностные концентрации легирующих примесей, а для создания высоких концентраций приходится обращаться к элементоргани - ческим полимерам в качестве пленкообразующей основы слоя.
Поскольку разброс поверхностных концентраций примеси на пластинах любой площади должен быть минимален во всем диапазоне концентраций от 1016 до 1021 атом/см3, то для достижения таких параметров существенна низкая летучесть первичного диффузанта, а затем и продуктов его термораспада: она должна быть минимально возможной при повышенных температурах. Желательно, чтобы полимерный слой превращался при термоокислении в плотную пленку с выделением при этом минимального количества дыма и сажи.
Как видно из материала гл. IV, практически любые замещенные ароматические азиды эффективно распадаются под действием света, а образовавшиеся нитрены структурируют самые разнообразные полимеры. Введение элементов II, III, V, VIII групп как в мономерную молекулу, содержащую фрагмент ароматического азида, так и в полимер мало влияет на эффективность образования нитрена и его реакционную способность по отношению к полимеру [47]. Поэтому группа негативных азидсодержащих фоторезистов оказалась удобной для создания фоторезистных композиций, пригодных для использования и в качестве диффузантов.
Для унифицирования применения использовались соединения, фотолиз и область поглощения которых мало зависят от природы элемента. К ним относятся трис(ж-азидоарил)фосфиноксиды, синтезируемые по обычной схеме (а. с. СССР 523905)
|
|
где R = H(I), 3-CI(II), 2-СН3(1П)
а также арилазидопроизводные сурьмы и мышьяка [51]. Новые азиды устойчивы в обычных условиях работы с фоторезистами, не изменяются при длительном хранении в растворах и на воздухе. Эти соединения легко фотолизуются, например квантовый выход фотолиза соединения I составляет 0,54±0,05 (7,=254нм, этанол), хорошо сшивают полимеры типа циклополиизопрена, ряд других полимеров [52]. Все они растворимы в органических растворителях, легко совмещаются с полимерами. Требования полупроводниковой технологии по высокой чистоте (особенно по содержанию Си, Fe, Ni Pb, Mn Cr, Mg не более 10~5—10-6 % ) могут быть легко выполнены при очистке этих веществ или промежуточных продуктов обычными химическими приемами. Малая зависимость параметров интегральной светочувствительности композиции от содержания триазидов в слое позволяет варьировать концентрацию светочувствительного легирующего компонента без изменения режимов экспонирования, что упрощает технологию их применения [52].
Предлагается композиция из 0,2—0,5 г трис(ж-азидофенил)фос - финоксида (Х„акс = 255 нм) и Юг эпоксидированного циклокаучука (3,8 % эпоксигрупп). Компоненты растворяют в 100 мл о-ксилола п полученный светочувствительный состав наносят на подложку центрифугированием, сушат при 60 °С, облучают через диапозитив лампой ДРШ-250, засвечивают и проявляют ксилолом или уайт - спиритом. Диффузию проводят при 1300 °С в течение 4 ч на воздухе в пластины p-Si с удельным объемным электрическим сопротивлением р = 50 Ом см. Полученный р—л-переход имеет вольт-ампер - ную характеристику, близкую к теоретической, и время жизни 10 мкс. Поверхностная концентрация 1015—1018 атом/см3 зависит от концентрации ароматического азида и режима диффузии [а. с. СССР 520559]. Подобные же азидсодержащие элементорганиче - ские композиции описаны для селективного легирования полупроводниковых пластин мышьяком [а. с. СССР 622035]. Диффузию из
фоторезиста в этом случае проводят на воздухе при 1250°С, полу
ченные р—п переходы также имеют время жизни неосновных носителей порядка 8—10 мкс.
Для селективного легирования подложки бором предлагают [а. с, СССР 544932] вводить в слой негативного азидсодержащего фоторезиста полиэфиркарборанадипинат при следующем соотношении компонентов, % (масс):
Полиэфиркарборанадипинат 0,4—10,5
Эпоксидированнын циклокаучук 3,5—6,4
2,6-Бис (4-азидобензилиден)-4-метилциклогексанои 0,64—0,7
Растворитель До 100
Из таких составов получают пленки, имеющие следующие характеристики интегральной светочувствительности при облучении лампой ДРШ-250 на расстоянии 25 см:
Пороговая светочувствительность, 23
см2/(Вт-с)
Коэффициент контрастности 1,09
Фоторезист наносят на центрифуге на пластины n-Si с р = = 50 Ом •см, экспонируют и проводят диффузию на воздухе при 1300°С. В результате диффузии был получен р—л-переход, имеющий вольт-амперную характеристику, близкую к теоретической, и большое время жизни при поверхностной концентрации от 1018 до 1020 атом/см3. Имеется возможность плавного регулирования поверхностной концентрации путем изменения концентрации диф - фузанта (полиэфиркарборанадипината) в фоторезисте. На основе фоторезистов-диффузантов удалось получить новые типы модуляторных тиристоров и диодов с достаточно высокими характеристиками [53].
В 1980 г. появилось сообщение о литографии и диффузии из фоторезистов, содержащих металлорганические соединения Си, Ва, Ti, Sm, Ей или смеси этих соединений [54].
Разрешение структур не только на поверхности, но и в объеме полупроводниковых пластин достаточно велико. Так, для прецизионной электронолитографии с субмикронными размерами элементов рельефа были разработаны типы электронорезистов, включающих элементорганические соединения с легирующими атомами (яп. заявка 49-34018, 49-34019). Вакуумный электронорезист для полностью сухой литографии [а. с. СССР 1056123] разработан на основе силсесквиоксанов (SiRJg-xSbxO^ (где R = СН = СН2; jc = 0,5—1), его разрешающая способность 104 линий/мм, электронная чувствительность 5 • 10—6 Кл/см2, при отжиге в диффузионной печи (30 мин, 400 °С) глубина диффузии атомов сурьмы составляет 1 мкм.

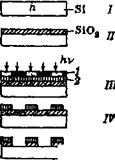

 Опубликовано в
Опубликовано в