Свойства фосфида галлия, выращенного методом Чохральского
 11 марта, 2014
11 марта, 2014  admin
admin Избыточная концентрация дислокаций в фосфиде галлия, полученном вытягиванием из расплава по методу Чохральского под флюсом, по сравнению с материалом, изготовленным методом жидкостной эпитаксии, долго была одной из важных проблем [165]. В работе [166] проведены микроскопические исследования поверхностных фигур травления на кристаллах, выращенных методом Чохральского при различных температурах в диапазоне между 1100°С (нормальные условия при выращивании из раствора) и ~ 1450°С (вытягивание по методу Чохральского из стехиометрического расплава). Результаты подтвердили ранее полученные данные: число дискообразных ямок травления (S-типа) уменьшается при более низких температурах выращивания, особенно в материале n-типа (рис. 3.29). Квантовый выход излучения находится в обратной зависимости от плотности этих необычных ямок травления [167]. Они связаны с декорированными дислокациями и г-слоями на границе раздела р- и n-областей и, следовательно, как считают, содержат выделившуюся примесь [168]. При переходе от GaP : Zn, О, выращенного из раствора, к материалу, полученному вытягиванием из расплава по методу Чохральского, квантовый выход фотолюминесценции уменьшается примерно в 100 раз [169]. Это объясняется значительно более сильным конкурирующим механизмом безызлучательной рекомбинации инжектированных электронов, чем в типичном высококачественном фосфиде галлия, изготовленном методом жидкостной эпитаксии [164]. Наличие тригональных ямок травления с острыми углами (D-типа), характерных для выявленных травлением недекорированных дис-
|
Рис. 3.29. Распределение ямок травления D - и S-типа в фосфиде галлия ft-типа, полученном разными методами [166]. |
Хорошо заметно различие по форме между глубокими трипирамидальными (тригоиаль - ными) дислокационными и мелкими (с плоским дном) дискообразными ямками травле - ни я. В типичном материале п-типа, вытянутом по методу Чохральского при 1470 °С, плотность ямок травления D-типа составляет ДО4—ДО5 см —2Э а плотность ямок S-типа
больше или равна 107 см-2%
|
Рис. 3.30. Изображение в проходящих рентгеновских лучах бездислокаштои - иой пластины фосфида галлия из начальной (у затравки) части слитка, выращенного при 1400°С из расплава, содержащего 31 ат.% фосфора [171]. Кроме низкой плотности S-дефектов (рис. 3-29) и эффективной фотолюминесценции, в этих кристаллах обнаруживаются большие области, свободные от включений галлия, двойников и границ роста, с относительно низкой плотностью дислокаций. Это дает возможность оценивать состояние поверхности раздела с расплавом, полезный диаметр кристалла, чистоту исходных материалов н т. д. Все эти свойства ухудшаются, если используется расплав с меньшим содержанием фосфора; в то же время большая концентрация фосфора приводит к увеличению плотности нежелательных S-дефектов, хотя тенденция к увеличению включений галлия уменьшается. В данном кристалле, выраженном из нестехиометрнческого расплава, плотность дислокаций быстро возрастает к концу слнтка. Дифракционная контрастная граница, отделяющая сердцевину кристалла от периферии, обозначена СВ. Гдетлые фигуры неправильной формы приписываются иару-> шенням, возникшим при обработке, в частности при полировке. |
локаций, прямого влияния на квантовый выход излучения почти не оказывает [166]. Эти данные согласуются с результатами, полученными па GaAsi-^P^ [142] и GaAs, где осаждение примеси в подложке и неоднородности распределения примеси (типа полос) менее вредны, чем недекорированные дислокации, по крайней мере при плотностях менее 105 см-2 [170].
Условия выращивания из нестехиометрического расплава при низких температурах высококачественного фосфида галлия, свободного от включений галлия, двойников и границ зерен, были частично определены с помощью исследований материала в рентгеновских лучах [171] (рис. 3.30). В работе [172] исследована серия кристаллов, выращенных вытягиванием из нестехиометрического расплава по Чохральскому под флюсом и легированных цинком и кислородом. Отмечается, что квантовый выход фотолюминесценции и время жизни неосновных носителей
|
Ува/V/a Рис. 3.31. Зависимость величины, обратной времени жизии неосновных носителей для безызлучательной рекомбинации 1/тп в фосфиде галлия р-тнпа, от относительной концентрации вакансий галлия и0а/[172]. |
Приводятся данные для GaP, выращенного нз раствора (SO), из стехиометрического
*
(LEG/S) и нестехиометрнческого (LEC/NS) расплава по методу Чохральского. Vq3 — кон*
дентрация вакансий галлия при выращивании нз стехиометрического расплава при температуре ~ 1460 °С.
А затравка LEC (легированный (ZnPO )2); ф конец слитка LEC ^легированный Zn(POj)2); ■ SG (легированный 2п(РО0г); ♦ SG (легированный Zn(GajOs); О SG (легированный
Zn(P03)2, отожженный).
плавно увеличиваются с уменьшением температуры выращивания; это наводит на мысль о связи с концентрацией вакансий галлия [VGa] (рис. 3.31). Считается, что изолированные Vоа не несут ответственности за возникновение фигур травления S-типа. Указанное предположение подкрепляется работами по непосредственному измерению концентрации Vgb методом электрометрического титрования.
В этих работах определялась общая концентрация ионов галлия во взвешенных с большой точностью образцах фосфида галлия, выращенных при разных температурах: принимались меры для сведения к минимуму эффектов увлечения галлия [172а]. Достигнутая точность определения концентрации VGa составила ±10 частиц на тысячу для материала, выращен - •цого различными методами н при различной температуре,
|
Относительное содержание tpoctpopa Рис. 3.32. Фазовая диаграмма с линией солидуса для фосфида галлия [172а]. По оси ординат отложена температура выращивания или отжига кристаллов фосфида галлня; по оси абсцисс вверху — концентрация галлия, найденная методом электрометрического титрования. LEC — кристаллы, выращенные методом Чохральского под флюсом. Для средней температуры выращивания кристаллов из раствора (SG) принято значение 1100 °С. ------- расчетная кривая; Д затравка LEC (нелегированный порошок); V затравка LEC (нелегированный кристалл); ▼ затравка LEC (легированный кристалл); С) конец слитка LEC (иелегированный); # конец слнтка LEC (легированный); ■ LEC (отожженный); Q SG. |
Результаты хорошо согласуются с формой кривой солидуса, вычисленной для фосфида галлия в работе [172а] (рис. 3.32). Линия солидуса вблизи максимальной температуры плавления относительно плоская, и на нижнем конце слитка всегда наблюдаются большие отклонения от стехиометрии, чем в начальной части у затравки. Максимальное отклонение от стехиометрии соответствует температуре ~ 1400°С и гораздо сильнее выражено на ветви, обогащенной галлием; это справедливо и для арсенида галлия. Соответствие теоретической кривой некоторой части экспериментальных данных позволяет определить неизвестные энтальпию и энтропию для включений атомов галлия и фосфора, а затем провести полный количественный термодинамический анализ. Кроме того, можно определить абсолютные концентрации вакансий Vgа и Vp в зависимости от температуры и на рис. 3.31 по оси абсцисс отложить концентрацию Vgs в диапазоне 1016—— 1019 см-3 [1726]. На ветви, соответствующей обогащению галлием, концентрация вакансий фосфора при 1100 °С (материал, полученный методом жидкостной эпитаксии) примерно в 2 раза ниже концентрации при 1465°С, в то время как концентрация вакансий галлия в первом случае меньше примерно на три порядка.
Результаты, приведенные на рис. 3.31, свидетельствуют о том, что центры безызлучательной рекомбинации связаны скорее с вакансиями галлия, а не фосфора. Предположив, что эти же связанные с вакансиями галлия центры определяют время жизни неосновных носителей в эпитаксиальном (из жидкой фазы) фосфиде галлия р-типа, т. е. ответственны за конкурирующий механизм на рис. 3.28, Джордан и др. [1726] для сечения захвата электрона этим центром получили вполне правдоподобную величину ~5-10~17 см-2.
В работе [1726] обсуждается также способ определения соответствующей концентрации вакансий в кристаллах, выращенных в условиях равновесия не между твердой фазой и жидкой, а между твердой и газообразной, что имеет место при выращивании из газовой фазы или в процессе диффузии и отжига. Данные по отожженным кристаллам, выращенным методом жидкостной эпитаксии, представленные на рис. 3.31, свидетельствуют в пользу высказанного предположения, но, конечно, не доказывают его. Более существенно то, что в эпитаксиальном фосфиде галлия, выращенном из жидкой фазы при температуре гораздо ниже обычной (вплоть до ~850°С), наблюдаются чрезвычайно большие времена жизни (тп ~ 150 не) [172в]. Однако даже это время жизни примерно в 6 раз меньше, чем ожидается для рекомбинации через KGa-центры. Заметим, что существует много причин, по которым следует ожидать, что слои фосфида галлия, выращенные при минимальной из возможных температур, будут обладать лучшими характеристиками. В работе [172в] отмечается дополнительное улучшение характеристик материала в результате понижения содержания кислорода. Возможная роль комплексов, состоящих из вакансии галлия и донора, в ограничении квантового выхода в фосфиде галлия, полученном методом жидкостной эпитаксии, обсуждается в разд.
3.4.4. Согласно работе [172г], предположение об определяющем влиянии нейтральных комплексов Vaa^ahVaa> включающих вакансии галлия и атом фосфора в узле галлия, которые обладают лучшими термохимическими параметрами, также не противоречит эксперименту.
Возможно, что мы скоро поймем недостатки материала, выращенного методом Чохральского. Что касается фосфида галлия, полученного по методу Чохральского из нестехиометрического расплава, то наиболее обещающим для непосредственного изготовления приборов является материал n-типа с низкой плотностью S-дефектов, вытянутый из расплава, содержащего 30— 35% фосфора. В этом случае трудностей, связанных с включениями свободного галлия, не возникает [166]. Красные светодиоды из GaP : Zn,0, изготовленные методом жидкостной эпитаксии слоя p-типа на подложках из такого материала, обладали хорошо контролируемым квантовым выходом в диапазоне 1—2% при плотности тока ~7 А/см2. Из нестехиометрического расплава по методу Чохральского можно получить слитки достаточно большого диаметра (по крайней мере 15 мм); однако рост кристалла определяется диффузией и, следовательно, является медленным процессом, а соответствующая стоимость 1 г материала более высока, чем в случае вытягивания из стехиометрического расплава. Пока не выяснено, можно ли существенно улучшить характеристики материала, вытянутого из стехиометрического расплава по Чохральскому, путем отжига при достаточно высоком давлении паров галлия. Вместе с тем, как мы видели, особый режим диффузии цинка может быть полезным [82а].
Мы уже отмечали другой главный недостаток материала, выращенного методом Чохральского, — большинство атомов вводимого специально кислорода занимает место в междоузлиях [99, 107]. С точки зрения диагностики было бы полезно, если бы явно безызлучательный центр удалось каким-либо методом превратить в излучательный, даже если при этом материал становится непригодным для изготовления приборов. Возможным методом является диффузия лития или меди. Хорошо известно, что диффузия лития в кремний, легированный кислородом, превращает нейтральный «кварцеподобный» центр, ответственный за полосу поглощения на длине волны 9 мкм, в электрически активный центр — донор (Li — 0)т [173]. При этом представляет интерес тот факт, что в фосфиде галлия, выращенном по Чохральскому при 1450 °С и легированном кадмием или цинком, после диффузии лития в обоих случаях наблюдается особая линия излучения связанного экситона, причем смещение бесфонон - ных линий примерно соответствует (Ед)Cd —(EA)zп (рис. 3.33) [174а]. Такое излучение никогда не наблюдалось в фосфиде галлия, полученном методом жидкостной эпитаксии. До настоящего времени не удалось получить дополнительной информации о соответствующем центре, например показать, включает он кислород или нет. Правдоподобная модель, предложенная в работе [107], включает рекомбинацию экситона на нейтральном
|
2)6 2)8 2,20 2, гг z,2i 228 228 2,278 2,282 2,288 2,290 2Щ 2,298 2,302 2,306 2?Ю Энергия сротона, зВ |
Рис. 3.33. Спектры фотолюминесценции фосфида галлия, выращенного методом Чохральского и легированного цинком или кадмием, после диффузии лития (температура 1,8 К, регистрация фотографическая) [174].
В различных спектрах наблюдается ряд похожих линий, например линии C—G, Н, од - нако основное внимание привлекает отчетливый, относительно узкий дублет А, В, наблюдавшийся на спаде широких, почти бесструктурных полос со стороны высоких энергий. Как и все отмеченные линии, эти полосы наблюдаются только в случае диффузии лнтия в GaP, выращенный по Чохральскому и легированный цинком или кадмием. В материале, полученном методом жидкостной эпитаксии, они не наблюдаются, а в GaP, выращенном по Чохральскому из нестехиометрического расплава, становятся менее отчетливыми с уменьшением температуры выращивания (рис. 3.31). Линии Л н В в материале, легированном цинком, находятся при энергии на v 28 мэВ больше, чем в материале с кадмием. Интересно, что эта величина близка, ио не равиа разности энергий ионизации - (^Л)2п (та^л 3.1). Этот факт свидетельствует в пользу предполо
жения о причастности указанных акцепторов к появлению линий А и В, причем соответствующий механизм специфичен для материала, выращенного по Чохральскому под
флюсом,
центре, состоящем из пары атомов Lii — ZnGa (или Lii — CdGa), связанной с кислородом внедрения, который сам по себе также является нейтральным. Некоторые из множества возможных комплексов, включающих атомы лития и собственные дефекты в арсениде галлия, были выявлены в работе [173в]. Авторы воспользовались другой (более обычной) возможностью, связанной с литием. Благодаря малой массе литий проявляет дефекты, с которыми образует комплексы, вызывая поглощение, определяемое локальными модами колебаний. Прямых доказательств наличия азота внедрения N; в фосфиде галлия нет, за исключением данных о влиянии облучения на возникновение дефектов в кристаллах, полученных методом жидкостной эпитаксии и сильно легированных азотом [173а]. Очевидно, атомы NP смещаются в междоузлия в основном при взаимодействии с атомами Р/, которые при 300 К очень подвижны. Аналогичный эффект наблюдается и на других примесях замещения небольшого размера (типа бора и углерода). Однако в фосфиде галлия, выращенном по методу Чохральского, в процессе температурной обработки при Т > 800 °С наблюдались необычные изменения концентрации Np. Возможно, что часто наблюдавшийся, рост концентрации Np связан с тем же механизмом, который обусловливает отжиг дефектов N/ в облученных кристаллах.
Новый метод выращивания кристаллов фосфида галлия, называемый диффузионным синтезом, обладает рядом значительных преимуществ для получения высококачественного материала, пригодного для изготовления светодиодов [174]. Выращивание кристаллов производится с небольшой скоростью в растворе галлия, помещенном в область с постоянным градиентом температуры ~ 1200 °С; фосфор проникает в раствор из источника с температурой 420 °С под давлением 1 атм. Скорость роста равна нескольким миллиметрам в сутки. Были получены поликристаллы длиной 7,6—10,2 см и диаметром почти 5 см, содержащие монокристаллические области объемом до 1 см3. Исследования методом травления показали очень низкую плотность дислокаций, и в частности низкую плотность ямок травления S-типа (рис. 3.29). В процессе роста можно добавить серу или теллур (в качестве доноров), в противном случае основной остаточной примесью является кремний. Квантовый выход диодов с эпоксидным покрытием, изготовленных методом жидкостной эпитаксии слоя фосфида галлия, легированного цинком и кислородом, на подложках p-типа, достигал 10%. Это значение намного превосходит все известные до настоящего времени результаты для однослойной эпитаксии.




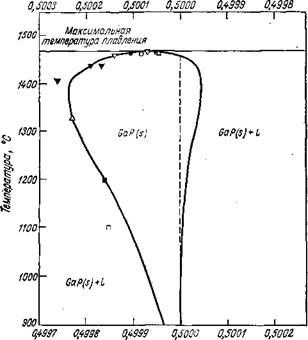

 Опубликовано в
Опубликовано в