Излучательные переходы в GaAs с участием многих частиц
 16 марта, 2014
16 марта, 2014  admin
admin В работе [235] проведены обширные исследования эволюции спектров люминесценции GaAs при 77 К вблизи края запрещенной зоны с ростом интенсивности возбуждения. Цель этих исследований •— установить механизмы переходов в лазерах. Для упрощения интерпретации экспериментальных данных использовалось оптическое возбуждение тонких, однородно легированных образцов. Результаты этой работы, касающиеся изменения энергетического положения максимума излучения в условиях генерации (или порога генерации) с изменением концентрации примесей, качественно совпадают с теми, что изображены на рис. 3.37. Важное различие состоит в том, что при концентрациях ниже ~ 1017 см-3 наблюдаются переходы только с одной энергией, не зависящей от концентрации примесей. Эта энергия равна 1,497 эВ [235], что на ~16 мэВ меньше ширины запрещенной зоны в чистом GaAs. Существенные дополнительные сдвиги в область более низких энергий происходят при увеличении уровня оптической накачки выше порога генерации. Сдвиги в область больших энергий, обычно приписываемые заполнению зон [200], не были обнаружены в относительно слабо легированном (с<1018 см-3) некомпенсированном материале. Эти сдвиги, как считают, слишком велики, чтобы их можно было связать с экситонным взаимодействием [235]. Во всяком случае, мелкие экситоны, характерные для GaAs (рис. 3.37), не должны оставаться связанными [выражение (3.28)] при высоких концентрациях оптически возбуждаемых носителей на пороге генерации (~1017 см-3; эта величина практически не зависит от концентрации примесей в интервале 1014— 1019 см-3). Сдвиги слишком ВЄЛИКИ для переходов с участием доноров (во всяком случа§ мелкие доноры, характерные для GaAs, также не должны связывать электрон благодаря эффекту экранирования [214]), и они происходят слишком быстро, чтобы быть следствием уменьшения запрещенной зоны из-за нагрева кристалла за время импульса.
Однако указанные в пользу экранирования аргументы могут не быть столь существенны; об этом говорят результаты экспериментальной работы, заключающиеся в том, что в актах рекомбинации, рождающих краевую люминесценцию, могут преобладать экситонные механизмы, действие которых протекает в значительно более жестких условиях, чем разрешено соотношением (3.28), например в GaP : N и сильнолегированном GaP : Zn,0 р-тлпа при 300 К (разд. 3.2.9).
Сдвиги не обусловлены переходами из свободного состояния в связанное с участием акцепторов, которые происходят при меньших энергиях и существенны только при (Na — Nd) > > 1016 см-3. Высказывалось предположение [235], что эти сдвиги обусловлены взаимодействием электрон — дырка — решетка, которое может уменьшить Eg на 16 мэВ при концентрации оптически возбуждаемых носителей 1017 см-31). В работе [235] представлено также доказательство, свидетельствующее о том, что наблюдаемые сдвиги могут быть полностью объяснены эффектом коррелированного взаимодействия носителей в плазме, который был описан Вольфом [237]:
АЕ = (2,4/г,) (т*/е2) • 13,6 эВ, (3.30)
где fs — отношение расстояния между частицами к боровскому радиусу для примесей; rs « 1 для концентрации электронов в GaAs, равной ~ 1017 см-3.
В работе [139] опровергнут факт существования сдвига ширины запрещенной зоны. Оптическое усиление при слабом уровне сигнала имеет острый максимум, соответствующий энергии, на ~10 мэВ меньшей, чем ширина запрещенной зоны очищенного GaAs при 2 К, причем максимум не сдвигается при изменении мощности накачки (при этом отсутствует какое-либо усиление при энергиях, равных или больших ширины запрещенной зоны). Напротив, максимум люминесценции сдвигается в область еще более низких энергий при увеличении длины области возбуждения лучом лазера при постоянной плотности падающей мощности. Спектр спонтанной люминесценции соответствует уширенному спектру, показанному на рис. 3.39 (полученному при высоких уровнях оптической накачки). При этом пики вынужденного излучения появляются со стороны меньших энергий в области слабого спонтанного излучения.
^ Об аналогичных эффектах сообщалось для ІпР в работе [236],
Таким обрааом, сдвиг в область меньших энергий может быть обусловлен возможностью превышения порога в области хвоста спектра усиления, а не реальным уменьшением ширины запрещенной зоны. Это смещение связывают с насыщением процесса усиления. Состояния связанного экситона не полностью экранированы свободными носителями, возбужденными светом. Процесс рекомбинации, приводящий к усилению стимулированного излучения, должен становиться собственным, когда насыщается процесс, который происходит при участии связанных экситонов и характеризуется большим усилением; тогда, вероятно, идет излучательная оже-рекомбинация при участии взаимодействующих свободных экситонов (т. е. это двухэлектронный переход с участием свободного экситона, который был впервые предложен для CdS [238]). Однако такое экситон-экситонное взаимодействие давало бы сдвиг максимума стимулированного излучения в область меньших энергий при увеличении напряженности магнитного поля. Этот вывод противоречит результатам, полученным на очень чистом GaAs и на CdSnP2 п-типа: в них наблюдался сдвиг в область больших энергий, пропорциональный^ + »с)1/2> где ®р июс — плазменная и циклотронная частоты
[209]. При таких полях, когда сор « о)с, или Н « 4л(4лпт*)'12, где п — концентрация возбужденных носителей, ожидается и происходит тушение стимулированного излучения. Для типичных условий в GaAs это происходит при Н ~ 45 кГс.
Большой интерес вызвала интерпретация энергетического спектра усиления стимулированного излучения, полученного из спектров фотолюминесценции с помощью целого ряда хитроумных способов [197]. Однако тут еще много проблем; например, в настоящее время нельзя с помощью какого-либо механизма интерпретировать спектры сильно возбужденного GaP : N, полученные в работе [198].
В работе [238а] еще раз подробно изучены усиление и спектры люминесценции GaAs р-типа высокой чистоты. Было также использовано мощное импульсное возбуждение азотного лазера. При этом особое внимание было обращено на то, что люминесценцию следует собирать в плоскости поверхности кристалла под углом 90° к направлению распространения возбуждающего света для того, чтобы снизить до минимума искажение спектров, связанное с прохождением испускаемых фотонов через область, где происходит усиление. Измерения зависимости оптического усиления от энергии кванта и мощности возбуждения были выполнены методом, при котором изменяется длина области возбуждения [139]. Помимо некоторых особенностей, наблюдаемых при малом уровне спонтанной люминесценции (рис. 3.43, вставка), спектры при высоких уровнях возбуждения
|
|
|
I__ | г 1 < »---- 1__ »---- ---- 1-- |
|
М5 $80 $85 (450 $95 //00 (,505 (510 (5/5 /,520 $2S ‘ Энергия (ротона, зВ |
|
Рис. 3.43. Спектры фотолюминесценции очищенного GaAs p-типа, возбужденного сфокусированной узкой (длиной 1700 мкм) полоской свега, полученной от ^-лазера f238a]. Регистрируемая фотолюминесценция выходит под углом 90е (к нвправлеиию возбуждающего света). Уровни возбуждения обозначены на кривых, причем /0 4,5 кВт/см2. Нижние шкалы по осн ординат соответствуют спектрам, снятым при 6,6 /0, 26 h и 66 /0. Для ясности спектры несколько разнесены по вертикали в области больших интенсивностей. Спектр, изображенный на вставке, записан при значительно меньшем уровне возбуждения, и его можно прямо сравнивать со спектром, приведенным на рис. 3.39. Дублет (4А) на рис. 3.39 здесь обозначен (А0, А) на основных спектрах. |
содержат два пика (А и В), отсутствующие при слабом возбуждении.
Спектры, изображенные на рис. 3.43, были записаны при очень большой длине области возбуждения; при меньших длинах пик В быстро сдвигается в область больших энергий, проходя через пик А, и заканчивает свое перемещение около связанного с ним пика в спектре усиления, лежащего при очень малых длинах области возбуждения и при энергии кванта, равной 1,5115 эВ. Пик люминесценции А наблюдается довольно стабильно при энергии 1,5108 эВ; это положение максимума соот-
|
8280 8250 8240 8220 8206, 8180 8160 Длина Волны, А Рис. 3.44. Температурная зависимость спектров фотолюминесценции очищенного монокристалла GaAs p-типа, снятых при уровне возбуждения 222/о (/о « 4,5 кВт/см2) [238а]. Шкала по оси ординат — линейная. Компонента В, соответствующая переходам зона — зона, опять сдвинута в область меньшнх энергий при большой длине области возбуждения; при Г > 10 К оиа. очевидно, преобладает над более узкой полосой А, определяемой процессом экситон-электроиного рассеяния. |
ветствующей полосы в спектре усиления. Значения энергии указаны для уровней возбуждения / — 6,6 /о, что соответствует ~30 кВт/см2. Таким образом, в отличие от полосы А эффект усиления, связанный с В, быстро насыщается с ростом длины области возбуждения. Этот процесс доминирует при более высоких температурах (рис. 3.44), и ему соответствует максимальное усиление — 1500 см-1 при температуре в криостате, равной 2 К, как и ожидалось для процесса прямой электронно-дырочной межзонной рекомбинации [247]. Из анализа формы линии следует, что в горячей плазме нет сохранения квазиимпульса при оптическом переходе (разд. 3.3.7); эффективная температура, найденная из хвоста линии в области больших энергий, получается высокой — вплоть. до 70 К. Сохранение квазиимпульса
достигается путем многократного возбуждения электронов и дырок в плазме [237а]. Быстрый сдвиг пика люминесценции В в область меньших энергий с ростом / можно объяснить только уменьшением ширины запрещенной зоны в плотной электроннодырочной плазме по сравнению с шириной запрещенной зоны в одноэлектронном приближении. Это уменьшение сохраняется вплоть до 300 К- Максимальный коэффициент усиления для «уширенного» процесса при переходе зона — зона при 77 К равен — 300 см-1. Считают, что пик люминесценции А, который характеризуется максимальным коэффициентом усиления, приблизительно в 10 раз меньшим при / = 222 /о, обусловлен экси - тон-электронным рассеянием — процессом, который обсуждался также для CdS [238]. Этот процесс ослабляется при увеличении температуры за счет термической диссоциации свободного экситона. /'
По форме хвоста асимметричной полосы люминесценции в длинноволновой области получаются разумные значения эффективной температуры экситон-электронной системы (~5—10 К)- Порог в коротковолновой области для спонтанного излучения лежит вблизи Eg — Ех, а не Eg — 2Ех, как ожидается для экси - тон-экситонного рассеяния, хотя последний может давать вклад в стимулированное излучение. Напротив, в работе [238в] для объяснения главной полосы излучения при средних уровнях возбуждения отдается предпочтение процессу экситон-экситонного рассеяния, поскольку имеется необходимое соответствие между этим механизмом и видом хвоста полосы в длинноволновой области. В работе [238а], однако, утверждается, что с равным успехом эта форма совпадает и с той, которая должна быть в случае экситон-электронного процесса. В работе [238в] отмечается, что целый ряд эффектов затрудняет подгонку формы кривой вблизи порога в коротковолновой области при Eg — 2Ех — в области, на которую обращают особое внимание авторы работы [238а] при анализе спонтанного излучения. Изменения в спектре при приложении электрического поля согласуются с этим предположением, но являются и доказательством того, что при этом происходит увеличение вклада экситон-электронного процесса.
В работе [238а] показано, что форма спектра спонтанного излучения может быть получена только в том случае, если при нимать в рассмотрение оба процесса, причем экситон-электрон - ный процесс должен становиться преобладающим при переходе к большим уровням возбуждения. Эти противоположные точки зрения только подчеркивают то, что сейчас еще довольно рано вносить определенные суждения относительно этих сложных явлений, которые в настоящее время являются объектами спектроскопических исследований целого ряда лабораторий.
|
Таблица 3.3 Механизмы лазерных переходов в прямозонных материалах [238]
|
Природа лазерных переходов в прямозонных полупроводниках рассмотрена также в работе [238г], из которой взяты данные, приведенные в табл. 3.3. В настоящее время широко при-
знано, что излучательные переходы при низких температурах образца идут в соответствии с распределениями разогретых электронно-дырочных пар и экситонов как при средних, так и при высоких уровнях возбуждения. Специальные меры могут быть предусмотрены для того, чтобы свести к минимуму эффекты разогрева, как это сделано в работе [2386], посвященной бозе - конденсации экситонов в CdSe при возбуждении ультракороткими импульсами лазера с модулированной добротностью.
Эти наблюдения согласуются с многочастичным подходом к рекомбинации взаимодействующих электронов и дырок, впервые предложенным Басовым, Богданкевичем, Гончаровым, Лав - рушкиным и Судзиловским [239]. Джонсон [209] выдвинул теорию электронного газа, в которой изменение ширины запрещенной зоны объясняется электронно-плазменным взаимодействием, изменяющим среднюю собственную энергию, вычисленную в приближении случайных фаз в интервале параметра плотности 1 < rs < 5 (такие значения, очевидно, он принимает для полупроводниковых лазеров). Сдвиг максимума в длинноволновую область с ростом уровня возбуждения связывается с увеличением нулевой энергии электронно-дырочной плазмы.
Джонсон также подвергает сомнению энергетический спектр оптического усиления малого сигнала, полученный в работе [139], на том основании, что нельзя получить однородную оп - * тическую накачку прямозонных полупроводников внутри больших областей, в которых бы не проявлялись дифракционные эффекты, усложняющие картину. Он полагает, что некоторые особенности, наблюдаемые иногда в этих спектрах усиления, могут возникать из-за усиления узких линий люминесценции, исходящих из периферических, слабо возбужденных областей полупроводника, связанных с широкополосным процессом в непосредственно освещенной области, где коэффициент усиления достиг одинакового уровня насыщения. Если это так, то возможно, что спектр усиления имеет одинаковую форму для всех прямозонных полупроводников, как этого требует механизм многоэлектронного взаимодействия.
Эти экспериментальные проблемы рассмотрены в работе [238а], в которой действительно найдено, что описанный выше межзонный процесс В идет преимущественно вблизи возбужденной светом поверхности, где концентрация свободных носителей максимальна. Процесс А, как предполагается, преобладает на большей глубине, тогда как процесс, в котором участвует связанный с нейтральным акцептором экситон (Л, X), все еще достаточно сильно проявляется при высоких уровнях возбуждения (рис. 3.43) и, по-видимому, идет в основном вблизи края пространственного распределения возбужденных светом носителей, г^е их плотность мала и где возможно образование экситонов
[выражение (3.28)]. Экситонные процессы будут также преоб ладать в рекомбинации в самом начале и в самом конце образо вания и спада плотности носителей, генерированных коротким импульсами света. Такие эффекты можно проанализировав с помощью стробоскопической спектроскопии с достаточно высо ким разрешением по времени [2386].
При очень высоких уровнях возбуждения полагают, что пер выми насыщаются прямые рекомбинационные процессы, и спект коэффициента усиления объясняется с помощью оже-рекомби нации в плазмонах [240]. Такие процессы, по-видимому, невоз можны для пороговых условий появления стимулированного из лучения в GaP : N [198, 241] и GaP : Zn,0 [241]. Очевидно, в этих случаях уровень возбуждения недостаточен для экранирования взаимодействия носителей с глубокими ловушками. Крессел и др. [242] при исследовании спонтанных и лазерных спектров двойных гетеропереходов р+ — п — п+ лазерных диодов также пришли к выводу, что спектр спонтанной люминесценции •не смещается при увеличении уровня инжекции, но расширяется в длинноволновой области. Они предположили, что, согласно модели взаимодействия, предложенной Басовым и др. [239], для объяснения сужения запрещенной зоны следует ввести новый хвост плотности состояний разрешенной зоны, который связан с локальными флуктуациями кулоновского поля, возникающими 'вследствие вероятностной природы взаимодействия между носителями.
Подобный эффект рассмотрен Доу и Редфилдом [244] для легированного материала. В работе [240] сделано предположение, что, кроме увеличения межзонного коэффициента усиления, эти эффекты взаимодействия создают возможность процессов усиления при меньших энергиях, которые при низких температурах представляют собой боковую полосу, связанную с плазмонами, а при высоких — самоиндуцированный хвост полосы, удовлетворяющий правилу Урбаха. Последний процесс преобладает при температурах, близких к комнатной, и дает в случае GaAs коэффициенты усиления, лежащие в диапазоне 10— 100 см-1; эти значения соответствуют процессу В, рассмотренному выше. Теория флуктуации плазмонов объясняет, почему порог при комнатной температуре не чувствителен к легированию вплоть до концентраций, равных 1018 см-3, и почему пик лазерного излучения отстоит на 20—30 мэВ от максимума спектра спонтанной люминесценции даже при 300 К [242, 242а]. Данные, взятые из рис. 1 работы [242а], должны быть изменены в соответствии с новым значением ширины запрещенной зоны GaAs при 300 К [222д]. Тогда энергия перехода в лазере остается в грубом приближении одинаково сдвинутой в область меньших энергий по сравнению с шириной запрещенной зоны,
Состояние электронно-дырочной плазмы в GaAs очень похоже на состояние плазмы в Si и Ge. Существенное различие состоит в том, что в GaAs средняя энергия частиц ненамного меньше энергии связи свободного экситона, поэтому конденсация в электронно-дырочные капли невозможна [244а] в противоположность хорошо теперь известным эффектам в Si и Ge [2446]. В спектрах, снятых при выводе излучения с торца прямоугольных светодиодов, изготовленных из прямозонных материалов, иногда появляются духи, расположенные при малых энергиях. Это явление впервые обсудили Капп и Биард [245]; на них обратили также особое внимание Крессел и др. [242].
Кроме изложенного выше, Холоньяк и др. [246] сообщили, что вклады в переходы зона — зона и зона — акцептор (свободные — связанные) можно различить по спектрам спонтанного излучения GaAs р-типа вплоть до Na— Nd «2-Ю18 см-3. Это подтверждает ту точку зрения (рис. 3.37), что все переходы кончаются на уширенных акцепторных состояниях в материале р-типа. Генерация происходит главным образом на переходах зона — зона при Na — Nd 2-1017 см-3 и на переходах зона — акцептор при Na — Nd 1,5-Ю18 см-3, т. е. последние преобладают в эффективных светодиодах с обычным уровнем легирования (рис. 3.35).

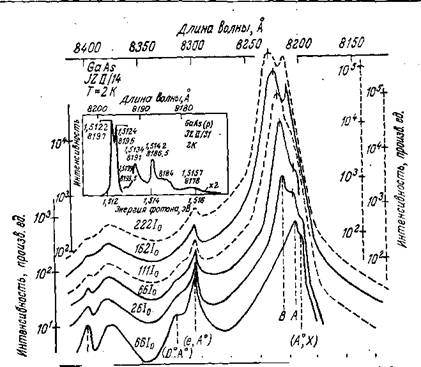
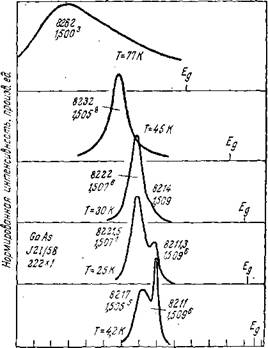
 Опубликовано в
Опубликовано в