Газовая эпитаксия GaAsi_xP*
 12 апреля, 2014
12 апреля, 2014  admin
admin Существует много способов эпитаксиального нанесения полупроводниковых соединений A'"BV из газовой фазы. Эпитаксия осуществляется как в запаянной трубке [96], так и в проточных системах [97] с участием одного транспортирующего агента. Этим агентом могут быть пары воды [98] и галогеноводороды
[99] . Хотя эти методы и пригодны для получения бинарных соединений, они не позволяют точно и независимо регулировать парциальное давление двух летучих компонентов (мышьяк и фосфор для получения GaAsi-xP*). Поэтому были разработаны Открытые системы для транспортного синтеза [100, 101]. Они
|
Рис. 5.14. Схема установки для синтеза и транспорта с использованием соединений водорода и химического осаждения из газовой фазы т. |
основаны на следующей системе химических реакций (аналогичная система реакций описывает образование GaP): синтез и транспорт
2AsH3.(r.) ^ Vs As, + ЗН2 (г.), (5.16)
2НС1 (г.) + 2Ga (ж.) ^ 2GaCl (г.) + Н2 (г.); (5.17)
эпитаксия
2GaCI (г.) + y2As4 (г.) + Н2 (г.) 2GaAs (тв.) + 2НС! (г.). (5.18)
Схема установки, применяемой для проведения этих реакций в лабораторных условиях, показана на рис. 5,14. Арсин AsH3
и фосфин РН3 вводятся в балластный сосуд вместе с легирую
щей добавкой я-типа H2Se. Смесь трех газов вводится в поток транспортирующего газа — водорода — после источника Ga. Газообразный НС1 над жидким галлием дает летучий монохлорид галлия — один из реагентов, необходимых для образования тройного соединения AmBv. Легирование, необходимое для получения проводимости p-типа, осуществляется введением паров Zn в реакционную зону. Возможности данного метода проявились в том, что с его помощью было приготовлено очень большое число соединений AIHBV, включая различные многослойные структуры [102]. В реакторе этого типа были получены следующие материалы, представляющие интерес с точки зрения изготовления светодиодов: GaAs, GaP, GaN, InAs, InP, AIAs, A1P, GaAsi-лгР*, Gai_*InxAs, Gai_*In*P и Gai-*Al*As.
В другой системе транспортного синтеза вместо соответствующих соединений водорода используются галогениды AsCl3 и РС1з [ЮЗ]. Схема этой системы осаждения показана на рис. 5.15,
|
|
|
лигатуры |
|
і Регулируемый 1 натекатель г Отфильтрованный |
|
Зона |
Зона |
Зона |
Держатель подложки |
|
галлия |
реакции |
эпитаксии |
|
|
(77S°C) |
S00X) |
(ЯО°С) |
|
Рис. 5.15. Схема установки для синтеза и транспорта с использованием гало - генидов и химического осаждения из газовой фазы [10]. |
Важное отличие ее состоит в том, что галогенид AsCl3 (или РСЦ) вводится до источника Ga, поскольку это соединение является источником Asi (или Р4) и НС1. Химические реакции в этой системе при получении GaAs могут быть записаны следующим образом: синтез и транспорт
2AsC!3 (г.) + ЗНа (г.) ^ 2НС1 (г.) + 2Ga (ж). :
эпитаксия
2GaCl (г.) + VaAs* (г.) + Н2 (г.;
VaAs, (г.) + 6НС1 (г.), (5.19)
2GaCl (г.) + На (г.); (5.20)
=Ь 2GaAs (тв.) + 2НС1 (г.). (5.21)
Отметим, что уравнения (5.20) и (5.21) идентичны уравнениям (5.17) и (5.18) для системы с AsH3.
После того как были найдены оптимальные критические параметры роста, а именно: ориентация подложки, температура осаждения, мольная доля AsCl3, вводимая в поток газа, с помощью этой системы был получен очень высококачественный GaAs [104].
Следует отметить, что в обеих системах состав газа в зонах реакции и эпитаксии идентичен (рис. 5.14 и 5.15) и рост кристаллов достигается снижением температуры подложки по отношению к температуре в зоне реакции. Желательно, однако, протравить поверхность подложки in situ до проведения эпитаксии. Это можно сделать, либо повышая температуру в зоне осаждения, либо смещая равновесие реакции осаждения. Избыток НС1 в потоке газа сдвигает реакцию, описанную уравнениями (5.18) и (5.21), влево, что приводит к газовому травлению [105]. Тот же эффект можно получить в системе с АэС1з заменой водорода на инертный газ (например, гелий). В этом случае вместо реакции
2GaCl (г.) + V2As4 (г.) + Н2 (г.) ^ 2GaAs (тв.) + 2НС1 (г.) (5.21)
идет реакция
2GaC! (г.) + VaAs4 (г.) 2GaAs (тв.) + С12 (г.). (5.22)
Свободная энергия во второй реакции при обычных давлениях паров и температурах осаждения положительна; из-за этого реакция сдвигается влево, что ведет к удалению вещества с подложки [106]. Простота перехода от травления к эпитаксии является одним из преимуществ метода химического осаждения из газовой фазы, который еще не используется в полной мере.
Другое преимущество метода химического осаждения из газовой фазы состоит в том, что этот метод можно легко применить в промышленном производстве, т. е. в реакционных камерах большой емкости. Сообщалось о нескольких вертикальных системах большой емкости, в которых одновременно можно осуществлять рост слоев методом химического осаждения из газовой фазы на многих GaAs-подложках (8—16) большой площади.
Схема реактора для эпитаксии на большом числе подложек [107] показана на рис. 5.16. GaAs-подложки, ориентированные вдоль направления (100), размещаются на держателе в форме пирамиды, который находится во время осаждения при температуре 800—825°С. В сосуде с жидким галлием поддерживается температура 775—800°С, а летучий GaCl образуется при введении смеси НС1 и Н2. Температура в зоне реакции составляет 900—925 °С. В этой зоне AsH3, РН3 и лигатура вводятся в транспортирующий газ — водород. На рис. 5.17 [108] показан разрез, на котором виден профиль осажденной структуры. Эпитаксия начинается с тонкого GaAs-слоя на GaAs-подложке со скоростью роста ~ 1 мкм/мин. По мере постепенного увеличения давления РН3 состав нанесенной пленки обогащается фосфором, а скорость роста постепенно уменьшается. При содержании фосфора, соответствующем мольной доле х = 0,4, скорость роста
|
-......................... ДУ, +К$Н3 +Н2+лигатура 1<—/7е</6 |
|
Уплотнение реактора П—[j ■ ■ г<—Выводное отберстие |
|
Зона еаллця —> |
|
Зона реакции |
|
|
|
—Вращающийся держатель подложек |
|
вращающийся держатель |
|
|
|
Зона Опитакс迥* |
|
4$ — шайб |
|
шайб |
Рис. 5.16. Схема реактора на большое число подложек для химического осаждения слоев GaAsi-*P* из газовой фазы на подложки из GaAs [13],
равна --'0,4 мкм/мин. Эффективность транспортировки, т. е. отношение числа молей GaAsi_*P*, осажденного на подложку, к числу молей Ga, перенесенного из источника, может превышать 25% [108, 109].
Постепенное изменение состава эпитаксиального слоя должно быть осуществлено по двум причинам. Во-первых, чтобы получить прозрачную область для света, возбужденного р— п-переходом (гл. 7), и, во-вторых, чтобы уменьшить механические напряжения ■ и количество дефектов решетки, появляющихся в результате нанесения и охлаждения эпитаксиального слоя на подложке с другой постоянной решетки и коэффициентом теплового расширения [88, 110—112].
Дислокации прорастают сквозь всю толщину выращенного слоя [108, 109], распространяясь в основном вдоль направлений (1 0 0) и (2 1 1). Хотя и высказано предположение, что дислокации сами по себе не приводят к уменьшению квантового выхода люминесценции [113], однако было показано, что высокая плотность дислокаций уменьшает квантовый выход диффузионных GaAsi_xP. v-ripH6opoB [114]. Слои, состав которых приведен на рис. 5.17, обычно имеют плотность дислокаций в верхнем слое 104 — 105 см-2, тогда как плотности дислокаций в слое с переменным составом часто превышают 106 см-2 [108].
Постоянные решетки GaAs и GaP при высоких температурах неизвестны. Исходя из значений, полученных при температурах, близких к комнатной [115, 116], рассогласование решетки при температуре роста составляет ~4%. Кроме того, при охлаждении до комнатной температуры от типичной температуры роста [116] GaAs сжимается, по оценкам, на 15%
|
~ 100 мкм ~25мкм ~300мкм |
|
GaAs/.xPx'.Te GdASf_ j~ Pj.. Те GaAs или GaP |
|
Эпитаксиальный слой постоянного состава 6aAs,-xPx Эпитаксиальный слой 'переменного состава |
|
Монокристаллическая подложка |
Рис. 5.17. Типичный профиль ОаАві-^Р^-структурн, выращеииой газовой эпитаксией.
больше, чем GaP. Следовательно, слой GaP, нанесенный на GaAs, сгибает его так, что он становится вогнутым, если на структуру смотреть со стороны GaAs. Механическое напряжение, связанное с рассогласованием решетки, можно ослабить, если на границе между слоями образуются так называемые дислокации несоответствия [117]. Для переходной зоны с линейным изменением состава плотность дислокации определяется [118] соотношением
р = (*'вГ1 [(aGaP)-‘ - (aGaAs)-‘], (5.23)
где k' — константа, связанная с вектором Бюргерса, б — толщина переходной ЗОНЫ, а ЯоаР и CGaAs— постоянные решетки бинарных соединений.
Из этого соотношения следует, что постоянное изменение концентрации не снижает числа дислокаций несоответствия, а просто распределяет их по всей толщине переходной зоны. Искривляющие механические напряжения в выращенных слоях также сильно зависят от толщины переходной зоны б и толщины выращенного слоя. Максимальные механические напряжения в слое GaP, выращенном на подложке с плавным изменением состава в переходной зоне, приведены на рис. 5.18. Значения по ординате представляют собой величину механического напряжения в конце переходной зоны, возникающего при плавном изменении состава, характеризуемого мольной долей фосфора от х = 0 до х = 1 на расстоянии от 0 до 0,4 мм, отложенном по оси абсцисс. Достаточно низкие механические напряжения могут быть получены при плавном изменении состава на толщине 20—40 мкм, если затем идет однородный по составу слой толщиной 40—80 мкм. Следует отметить, что для данной толщины подложки и толщины переходной зоны имеется опти-
|
Толщина слоя БаР, мм Рис. 5.18. Максимальное механическое напряжение в слое GaP в зависимости от его толщины для случая линейного распределения состава при переходе от GaAs к GaP [25]. Штриховая лнння соответствует отсутствию переходной области. Толщина слоя GaAs составляет 300 мкм. |
мальная толщина однородного по составу слоя, для которого изгибающее напряжение достигает минимального значения.
Возможность получения переходов тройных полупроводников с плавным изменением состава — одно из основных преимуществ метода химического осаждения из газовой фазы. Поскольку плотность дислокаций в любой точке кристалла является функцией локального напряжения, обусловленного различием постоянных решеток da/dx, следует избегать локальных флуктуаций изменения концентрации. Это было с успехом достигнуто для GaAsi_*P*, тогда как для Ini_*Ga*P встретились существенные трудности. Две системы материалов отличаются друг от друга.
1. Рассогласование решеток бинарных соединений почти в 2 раза выше для In,_^GaxP, чем для GaAsi-^Px, что требует более широкого переходного слоя.
|
ВаР
Рис. 5.20. Зависимость состава твердого раствора In^^Ga^P от мольиой доли всего потока НС1 для источника Ga [26]. 0 0,1 0,2 0,3 0,4 0,5 0,6 0,7 0,8 0,9 1,0 Мольная доля потока Ш над бег |
|
|
|
НС1*Иг |
|
Подложка N, ВыВод |
|
нсі*нг |
|
Рис. 5.19. Схема ростовой системы, используемой для осаждения Ini-*Ga*P из газовой фазы [26]. |
|
ЩсточнишстчникХ Зона /f1 1 'реакци |
|
Зона Зона реакции 1зпитаксиА |
2. Если в случае GaAsi-xP* два смешиваемых газа (AsH3, РН3) получаются до их введения в систему химического осаждения из газовой фазы, то летучие галогениды индия и галлия должны быть оба синтезированы и смешаны в самой си - ■ хтеме (рис. 5.19) [119].
3. Из-за большей стабильности InCl по сравнению с GaCl состав твердого раствора очень чувствителен к отношению концентраций двух галогенидов. Малое изменение (рис. 5.20) соотношения долей НС1, прошедших над двумя металлами In и Ga, приводит к быстрому изменению состава твердого раствора в обогащенной индием части твердого раствора. Точно такую зависимость (хотя и не так резко выраженную) можно ожидать и для GaAsi_*P* (рис. 5.21), если исходить из имеющихся данных о константе равновесия при 850 °С [120].
Поэтому квантовый выход приборов из Ini_*Ga*P был на несколько порядков величины ниже, чем предсказывалось тео - _ рией [121]. Хотя усовершенствование технологии роста, а именно особая тщательность в управлении потоками газов и смеше-
|
Рис. 5.21. Зависимость состава твердого раствора GaAsj-*P* от отношения давлений паров фосфора к давлению паров мышьяка в газовой фазе [27]. Состав определен для химического осаждения из газовой фазы при 850 "С. |
нием газов, могло бы улучшить эту характеристику [122], трудно предположить, что данный твердый раствор перспективен для светодиодов.

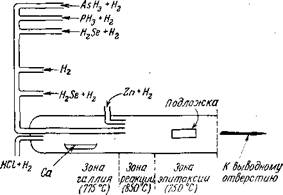
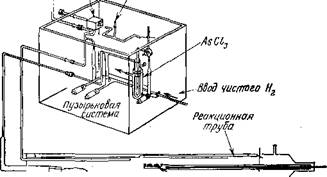

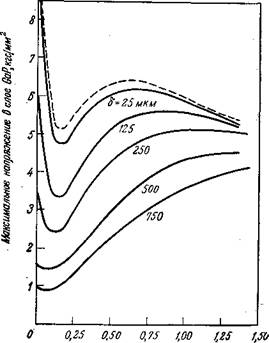



 Опубликовано в
Опубликовано в