Самопоглощение люминесценции
 18 марта, 2014
18 марта, 2014  admin
admin Сильное зависящее от энергии поглощение вблизи края запрещенной зоны прямозонного полупроводника (рис. 2.7) приводит к существенному самопоглощению люминесценции и
“О
|
Т - 297 К - р-]013ш~3 |
|
10 |
|
1,30 1,40 Энергия hv, зЗ а |
|
|
I
В
і
|
I S 1 1 |
|
f, S0 |
|
1,20 |
|
_ |
||
|
г |
Г-297К |
|
|
- |
п-10,!см'3 ' |
/vV |
|
і |
\ |
|
|
_ |
і Імкм |
|
|
: |
10 мкм |
|
|
- |
і. і. |
а„чоо мкм і " і і |
|
/0г |
|
10 |
|
1,30 1,40 Энергия hv, эВ S |
|
10' |
Рис. 3.46. Влияние самопоглощеиия излучения на спектр электролюминесценции планарного светодиода при Т « 300К [II].
а — излучение регистрируется со стороны р-области диода, изображенного на вставке; б — излучение регистрируется со стороны л-области.
К искажению формы полосы люминесценции. Самопоглощение более существенно в материале р-типа или в сильнокомпенсиро - ванном «-материале (рис. .3.46), поскольку край поглощения в них сдвинут в область меньших энергий (рис. 2.7). Если удается избежать отражений от задней грани кристалла, то в экспериментах по фотолюминесценции (рис. 3.46) можно получить неискаженный спектр, так как в этом случае излучение возникает в слое кристалла толщиной порядка I мкм, лежащем у поверхности. Излучение большинства GaAs-диодов выходит из p-области перехода. Это является следствием большой величины отношения масс m*hJm*e»7, определяющего условия инжекции
|
[выражения (2.12), (2.29)] г), сравнительно высоко расположен - , ного квазиуровня Ферми для электронов вследствие эффекта за - | .полнения зоны в га-области, а также образования примесной j
|
трудно применять соотношение (3.33) для введения поправок в форму спектра диодов с р — n-переходом, поскольку вслед ствие многократного полного внутреннего отражения излучени неточно определено значение d (угол полного внутреннего ОТр£ жения для границы GaAs — воздух равен всего 1,6°). Более пс дробно поправка на самопоглощение рассматривается в гл. ( Влияние самопоглощения может быть сведено к минимум несколькими способами. В одном из них излучение лучше сс бирать со стороны n-области р — n-перехода или через очен тонкое окно р-области [203]. Тем не менее Арчер и Керпс [248 нашли, что внешний квантовый выход равен всего ~10/с если даже собирать свет со стороны д-области, когда внутрег ний квантовый выход г]/ « 50%. В раббте [249] показано, чт в сильнокомпенсированном GaAs максимум люминесценции мс жет быть существенно меньше Eg, где а составляет ~ 1 см~ а не несколько тысяч, как обычно. Такое преимущество компен сированного материала удобно реализовать в светодиодах, легі; рованных Si, поскольку Si — амфотерная примесь [250]. Люмн несценция таких диодов nponcxoflnf при а << 100 см-1 (рис. 3.47 Для однородной плотности фотонов в диоде с малым средний коэффициентом поглощения а можно, записать следующее соот - 1 ношение между ці и т]я при спонтанной люминесценции [251а, 1
2516]
|
(3.34) |
• гіЕ = ті//(1+аіда,
|
,2
|
(3.35)
щ, п% — показатели преломления полупроводника и окружающей ‘ среды, V — объем кристалла, А — площадь поверхности кристалла. Это соотношение было проверено для т)красн в GaP [252].
|
Энергия hv, зВ. Рис. 3.47. Край поглощения и спектр люминесценции сильнокомпенсирован - ного светодиода из GaAs, легированного Si, при Т « 300 К [11]. |
Влияние самопоглощения на спектры в слаболегированном GaAs обсуждалось в разд. 3.3.5.
Весьма интересны амфотерные свойства Si в GaAs, в особенности с точки зрения создания светодиодов с большим внешним квантовым выходом (гл. 4). Спитцер и Паниш [253] исследовали характерные инфракрасные линии поглощения локальных фононов, связанных с SiGa и SiAs - Они пришли к выводу, что хорошо известный переход от проводимости гс-типа к проводимости р-типа, наблюдаемый вблизи 850 °С при уменьшении температуры роста кристалла, выращиваемого из расплава GaAs : Si, не сопровождается достаточно большим изменением спектра локальных линий, таким, чтобы в диапазоне более низких температур МОГЛО бЫТЬ ВЫПОЛНеНО СООТНОШеНИе [SiAs] > > [Siaa]; следовательно, этот переход должен возникать ПО другой, не установленной пока причине. Это предположение было радикальным, поскольку соответствующие концентрации носителей высоки (вплоть до 1018 см-3), и кажется невероятным, что в процессе производства столь плохо контролировалось содержание примесей, что проводимость определяется каким-то другим, неконтролируемым акцептором. Ньюмен [254], однако, проанализировал эти эффекты, связанные с локальными фононами, и, пришел к выводу, что отношение сил осцилляторов для коле-
|
Энергия, эВ Рис. 3.48. Спектр краевой люминесценции монокристаллического GaAs, полученного методом жидкостной эпитаксии [256а]. В спектре присутствуют относительно острые компоненты в области 1,49 эВ, обусловленные рекомбинацией на донорно-акцепторных парах (прн меньших энергиях) н переходами из свободного состояния в связанное на мелком Si-акцепторе с энергией ноннзацни ~35 мэВ (рис. 3.40). При 5*1,40 эВ в спектре имеются более широкие компоненты, обусловленные бесфононной рекомбинацией н рекомбинацией с участием продольного оптического фонона на неизвестном, но связанном с Si акцептором (0,1 эВ) (см. спектр иа рнс. 3.47). Акцепторный уровень проявляется четко, даже несмотря на то, что это-* кристалл слабо легирован: N • Ю13 см”"3 (в отличне от кристалла, спектр которого изображен на рис. 3.47). |
баний SiGa и SiAs равно ~2, а не ~1, как предполагалось в более ранних работах [253], так что объяснение этих эффектов ролью электрических свойств Si в GaAs может быть вполне приемлемым. Несмотря на это Кунг и Спитнер [254а] использовали величину соотношения ~ 1 при анализе влияния положения уровня Ферми на распределение Si по узлам решетки, на которое влияют одновременно введенные доноры Те или акцепторы Zn и Mg. Их результаты согласуются в той мере, в какой их можно сравнивать с простой термодинамической моделью Лонжини и Грина [2546]. Несомненно, упругие константы для колебаний SiGa и SiAs почти эквивалентны [254в].
В работе [255] найдено, что температура роста, при которой происходит переход от п - к р-типу проводимости, уменьшается по логарифмическому закону с ростом отношения атомных концентраций А1 и As в GaAlAs, опускаясь до ~ 700 °С при Xa/xas « 0,5. Чо и Хаяши [256] показали, что GaAs с заданным профилем легирования может быть получен методом молекулярной эпитаксии. Присутствие акцептора с уровнем ~0,1 эВ, с которым связаны процессы, проиллюстрированные на рис. 3.47, может быть заметно даже в слабо легированном кремнием GaAs, выращенном методом жидкостной эпитаксии (рис. 3.48). Этот важный с точки зрения технологии примесный центр в настоящее время пока неидентифицирован. Предположение, что он возникает из комплексов SiGa — Sas, кажется совершенно неправдоподобным [256а]. Этот комплекс является изоэлектрон - ной примесью замещения, а не акцептором и не должен давать связанного состояния, поскольку Еа-{- Е0 ~ 0,04 эВ значительно меньше е2/ег да 0,5 эВ [равенство (3.12)]. Некоторые свойства компенсации GaAs я-типа при загрязнении кремнием [220а] и поведение электропроводности GaAs: Si при отжиге [2566] также указывают на то, что поведение этой амфотерной примеси является сложным.



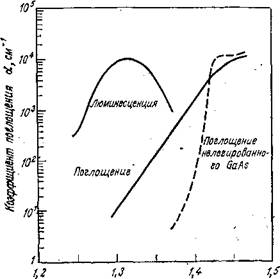

 Опубликовано в
Опубликовано в