Рентгеновская литография
 8 ноября, 2013
8 ноября, 2013  admin
admin Впервые возможности получения структур с большим числом элементов с помощью рентгеновского излучения продемонстрировали в 1972 г. Спирс и Смит [54], которые высказали предположе
ние, что этот метод может быть с высокой производительностью использован для получения полупроводниковых микросхем [55].
Рентгеновская литография — технология будущего. Для нее можно использовать квазиточечный источник мягкого (0,25—
|
|
3,0 кэВ) рентгеновского излучения. Наиболее важ - ные части экспозиционного устройства, работающего с рентгеновским излучением, приведены на рис. 1.21. Рентгеновское излучение возникает при бомбардировке плоскости источника ускоренными электронами в вакууме, после чего проходит через тонкое (25—30 мкм) бериллиевое окно. Для бомбардировки источника используются элек-
Рис. 1.21. Схема ренп еновского литографа:
1 — охлаждение анодов. 2 — палладиевый анод; 3 - электронная пушка; 4 — пучок электронов; 5 — бер- риллиевое окно; 6 — кремниевая подложка; 7 — стол; 8 — маска; 9—12 — механизмы, обеспечивающие движение стола по осям х, у, z и поворот s одной из плоскостей; 13 — система охлаждения корпуса; 14 — система вакуумировання
троны с энергией 10—30 кэВ. Однородный поток рентгеновского излучения затем формируется маской, образованной поглощающим слоем на мембране из прозрачного материала 5—10 мкм толщиной (рис. 1.22). Маска размещена параллельно подложке на расстоянии 10—100 мкм от экспонируемой поверхности, на которую на-
2
SHAPE * MERGEFORMAT

|
-4 |
Рис. 1. 22. Разрез маски для рентгеновской литографии:
|
-6 |
/ — полиимид (2,5 мкм); 2 — золото (0,1— 1,0 мкм); 3 — полиимид (2 мкм); 4 — нитрид бора (3—6 мкм); 5 — окно в кремниевой подложке (3—6 мкм); 6 — кольцо из пирекса.
несен слой рентгеновского резиста. Для уменьшения потерь излучения пространство между источником рентгеновского излучения и маской вакуумировано или заполнено гелием с низким давлением.
Для создания потока экспонирующего рентгеновского излучения были испытаны синхротроны, плазма и мощные лазеры [56], но их практическое использование ограничено высокой стоимостью или недостаточной изученностью. Типичный спектр источника из
палладия, бомбардируемого электронами с энергией 20 кэВ, имеет один острый пик при 2,84 кэВ и очень малое излучение с другой энергией. Светосила источника определяется параметрами электронной оптики, характеристикой анода (температурой плавления, давлением пара, модулем упругости) и эффективностью охлаждающей системы.
Поскольку в настоящее время не существует оптических систем для рентгеновского излучения, необходимо конструировать экспозиционные устройства для переноса изображения в масштабе 1:1, Можно одновременно экспонировать всю подложку или использовать пошаговое экспонирование; при этом не избежать необходимости решения некоторых проблем, например, повышения стабильности маски.
Наиболее узким местом всей системы рентгеновской литографии является маска [57]. Мембрана, имеющая рисунок микросхемы в виде слоя рентгеновского абсорбента, должна быть очень тонксй, сделанной из материала с низким атомным номером для сведения к минимуму абсорбции рентгеновского излучения, и одновременно должна обладать достаточной механической прочностью, чтобы сохранять все элементы рисунка. В большинстве случаев мембрана натянута на твердом ровном кольце, коэффициент термического расширения которого такой же, как и у кремния (см. рис. 1.22) Необходимо корректировать расстояние между маской и пластиной в зависимости от температуры, так как абсорбционный материал, образующий маску, и кремниевая пластина могут иметь разные коэффициенты термического расширения [58].
В то время как при оптической литографии пропускание для прозрачной и непрозрачной областей различается на несколько порядков, для масок рентгеновской литографии достаточно отношение пропусканий около 10. Для достижения хорошей контрастности абсорбционный материал — золото — наносится слоем толщиной 0,1—1,0 мкм.
При современной технологии производства интегральных схем с помощью рентгеновской литографии можно создавать элементы размером 0,5—-1,0 мкм. Резистами служат хлорсодержащие полимеры, которые, по всей видимости, являются пока наилучшими. Лучшего разрешения можно достичь при использовании более мягкого излучения (большей длины волны), чем у La палладия, поскольку в этом случае можно использовать более тонкий слой абсорбента на маске, при котором одновременно возрастает поток, экспонирующий резист. Рентгеновские маски фирм Hewlett-Packard и Bell Laboratories описаны в [59, 60].
При взаимодействии рентгеновского излучения с веществом наблюдается абсорбция в соответствии с уравнением (I. 16):
/ = 1^т°й (1.16)
где /о и / — интенсивности излучения; рт— коэффициент абсорбции; р — плотность; d — толщина поглощающего слоя.
Одновременно с этим возникает небольшое количество фотоэлектронов, которые в результате упругих и неупругих столкновений инициируют химические реакции в слое резиста. Пробег фотоэлектронов составляет 100—200 нм и не лимитирует разрешения. На разрешение сильно влияет полутень, изображенная на рис. I. 23. Поскольку источник имеет конечный размер ds и находится от
маски на расстоянии D, край маски образует не четкую тень, а
полутеневой переход о. Из данных рис. 1.23 и уравнения (I. 16)
эту полутень можно вычислить по уравнению (I. 17):
а = ddsID (1.17)
Одновременно с этим явлением при экспонировании наблю
|
|
дается небольшое увеличение размеров, которое определяется фактором А = dig®. Это увеличение может усложнить производство многослойных интегральных схем, однако в случае постоянного рисунка схемы при экспонировании каждого слоя оно постоянно, если при этом не наблюдается смещения меток совмещения слоев.
Преимущества рентгеновской технологии состоят в высоком качестве образования структур (отсутствуют дифракция и эффект близости [61]), однородном экспонировании, позволяющем ис-
Рнс. 1.23. Геометрия экспонирования рентгеновскими лучами:
— размер источника; D — расстояние меж - ду источником н маской; d — расстояние меж - 22- ДУ маской и поверхностью резнста; о — расстояние пучка рентгеновских лучей; Д — отклонение ширины лннин; 1 — маска; 2 — по[2] верхность резиста.
пользовать толстые слои резиста с высоким AR *, в возможности управления толщиной линий и нечувствительности к загрязнениям. Преимущества отдельных литографических систем можно рассматривать в соответствии с рядом критериев [62]: разрешение, которое может быть получено, производительность, капитальные и эксплуатационные расходы, занимаемая площадь. В ряду всех известных литографических систем, дающих субмик - ронное разрешение, рентгеновская литография наиболее предпочтительна. При этой оценке, однако, не рассматривается ряд проблем, возникающих при изготовлении масок для рентгеновской литографии.
1.3.4. Ионная литография
Ускоренные ионы, например Ga3+, Ве2+, In3+, Sn2+ и др. [63, 64], при прохождении через вещество могут вызвать химические реакции подобно ускоренным электронам. Однако, поскольку рассеяние ионов (с энергией 1—3 МэВ) существенно меньше рассеяния электронов, существует возможность при помощи ионной литографии достигать высоких степеней разрешения [65]. Фокусированный пучок ионов можно сканировать подобно потоку электронов, что может быть использовано для непосредственного образования структур с высокой плотностью элементов в разных полимерных материалах, например в ПММА [63]. Разрешение определяется рассеянием ионов и возникающих вторичных электронов.
|
а ЮОкВт |- 95 кВ 1 |
5 4 4 |
100 кВт р _ 95 кВ [ |
У |
|
|
У77/Л |
)Ъ777г |
X//Z& |
>////А 2 |
|
|
“Р777771 |
||||
|
j У//Л— |
z. xzzzz |
'///У |
||
|
7Л |
/У/ |
|
к// |
|
|
'/J |
S/ |
|
36 кВ |
Рнс. 1.24. Схема ионного источника в триодном (а) н тетродном (<Г) исполнении:
|
ов |
1 — нонный источик (жидкий металл); 2 — экстрактор; 3 — электростатические линзы; 4 — трй - одная область; 5 -» Ускорители.
Возможности ионной литографии интенсивно изучаются, однако к ее технологическому использованию ведет еще долгий путь. На рис. 1.24 изображены два возможных исполнения ионного источника: триодное (источник, экстрактор и первый ускоритель) с чеканными электростатическими линзами (рис. 1.24, а) и тетродное (рис. 1.24,6). Разработана система проекционной ионной микролитографии 1:60 [66]. В ней используются уменьшающие ионнооптические системы высокого разрешения в сочетании с прецизионным движением (шаг-и-повторение) подложки. Поскольку достигается многократное уменьшение, пучки ионов, проходящие через маску, на подложке концентрируются, что при использовании органического резиста дает возможность экспонировать весь кристалл (чип) за несколько миллисекунд. Кроме того, можно проводить прямое травление диэлектрика (Si02, Si3N4), полупроводника (Si, GaAs) и металлических слоев при времени экспонирования порядка секунды; при этом указанные слои могут быть использованы как неорганические резисты. Ионная проекционная микролитография, таким образом, дает возможность создания новых технологических приемов [67], включающих сканирующую литографию, безмасочные имплантацию и травление [63].

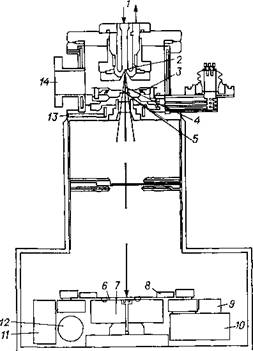

 Опубликовано в
Опубликовано в