Рекомбинация в области пространственного заряда
 27 февраля, 2014
27 февраля, 2014  admin
admin Второй (и более важной для светодиодов) причиной отклонения реальной характеристики от идеальной является невыполнение основного допущения теории о постоянстве электронного и дырочного токов в обедненном слое диода. Хотя в области малых плотностей токов характеристики германиевых диодов близки к идеальной [32], характеристики диодов из материалов с более широкой запрещенной зоной (таких, как кремний, арсенид галлия и фосфид галлия) существенно отличаются от идеальной [выражение 2.11)]. Эти отличия обусловлены поверхностными эффектами, и главным образом процессами генерации— рекомбинации в обедненном слое. Поверхностные эффекты в основном сводятся к влиянию ионного или молекулярного заряда в окисной пленке полупроводника. Этот заряд электростатически индуцирует заряд в объеме полупроводника, благодаря чему в приповерхностном слое полупроводника создается обедненный слой или даже каналы из-за формирования инверсных слоев1). Наличие этих слоев сильно сказывается на высо-
') Вопросы физики и химии поверхности полупроводников хорошо осве - рхены в работе [33].
кочастотных свойствах полупроводниковых диодов. Мы не будем более останавливаться на поверхностных явлениях в полупроводниках; заметим лишь, что рекомбинация электронно-дырочных пар на поверхности обычно идет значительно интенсивнее, чем в объеме1), а поверхностный ток утечки, который существенно зависит от геометрии и технологии изготовления диода, может оказаться больше других составляющих обратного тока Is, обусловленных генерацией в объеме и в обедненном слое. Последнее замечание особенно справедливо для полупроводников с широкой запрещенной зоной, в которых генерационные составляющие обратных токов малы из-за малости множителя exp (—Eg/kaT) в выражении для члена га2, входящего в соотношение (2.12). Однако планарная технология позволяет даже на фосфиде галлия получать р — га-переходы с пренебрежимо малыми поверхностными токами утечки.
При современном уровне развития технологии составляющая обратного тока Is, обусловленная генерацией — рекомбинацией в обедненном слое, в полупроводниках с широкой запрещенной зоной [Eg > (£g)si] имеет по крайней мере тот же порядок, что и составляющая, обусловленная диффузией из объема. В смещенном р — «-переходе изменения концентрации неосновных носителей с каждой стороны перехода могут быть описаны с помощью двух квазиуровней Ферми — Фр для дырок и Фге для электронов (рис. 2.1) — вместо одного уровня Ферми, описывающего концентрации носителей в равновесных условиях. При наличии смещения произведение рп в примыкающих к переходу областях уже не равно га?, а определяется выражением
|
(2.19) |
рп = п ехр [е (Фр - Фп)//гвГ].
|
dt dt (« + «i)V+(/7 + Pi)T«o ’ |
При обратном смещении Фр — Фп < 0 и рп < raj. В этих условиях доминирующую роль играет генерация пар в обедненном слое. При прямом смещении справедливы противоположные неравенства и в обедненном слое преобладает рекомбинация пар носителей на примесных центрах. При наличии одного рекомбинационного уровня скорость рекомбинации, как показано в работе [35], описывается выражением
(2.20)
где тр, и — минимальные времена жизни дырок и электронов соответственно для рекомбинации на данном уровне, п и
рі — концентрации электронов и дырок в случае, когда уровень Ферми проходит по рекомбинационному уровню Et. Таким образом,
щ = щ exp [(£f — E{)lkBT],
Pi = П| exp [(Я,-£,)/№ ( }
где Еі — уровень Ферми в материале с собственной проводимостью (он близок к середине запрещенной зоны). Скорость рекомбинации достигает максимума при Ei—Et, и, если ^Р, = хп„ она равна, согласно выражению (2.20), в предположении постоянства квазиуровней Ферми в обедненном слое
dn 1 nt [exp (eVlkBT) -1]
dt xm exp [e (t - Фп)/квТ] + exp [e (Фр - [2])/kBT] + 2 ’ v
где я|) = — Ei/e. Величина f> изменяется в пределах обедненно- слоя (рис. 2.1), и выражение (2.22) достигает максимально;; значения при 2i|) = Ф„ +ЧФР. Тогда для V > kBT/e
— - j т*я, exp (eV/2kBT). (2.23
Величину полного рекомбинационного тока в переходе полу чают умножением выражения (2.23) на объем обедненного слоя. Отметим, что этот ток пропорционален tit и ехр(е]//2kBT), тогда как диффузионный ток [выражение (2.12)] пропорционален п?. В общем случае прямой ток описывается зависимостью Ь
exp(eV/nkBT), где 1 < п < 2. Если преобладает диффузион* ная составляющая тока, то п= 1; если же доминирует составляющая, обусловленная рекомбинацией в слое объемного заряда, то п=2. Это иллюстрируется рис. 2.10, на котором представлены в увеличенном масштабе прямые ветви вольт-амперных характеристик диодов из фосфида галлия. На рис. 2.11 приведены вольт-амперные характеристики типичного кремниевого диода [36]. В полупроводниках с широкой запрещенной зоной и малым собственным временем жизни (такие, как арсенид галлия и фосфид галлия) токи рекомбинации в обедненном слое могут быть большими по сравнению с диффузионными токами даже при относительно близком расположении ловушек к краям зон. Из положения квазиуровней Ферми на рис. 2.1 следует, что мелкие донорные и акцепторные уровни заполнены соответственно электронами и дырками лишь вблизи нейтральных п - и р-областей, а в большей части обедненного слоя при малых смещениях они ионизированы. Однако глубокие уровни могут располагаться между Ф„ и Фр во всем обедненном слое. Следовательно, глубокие уровни являются центрами рекомбинации во Всем обедненном слое, тогда как мелкие уровни могут играть
|
Относительная интенсивность зеленом излучения Рис. 2.10. Зависимость интенсивности электролюминесценции от напряжения (нижняя кривая), рассчитанная для рекомбинации на глубоких уровнях по модели Шокли — Рида — Холла или для рекомбинации донорно-акцепторных пар [37]. Отмечены четыре участка (1 — 4) с различными значениями параметра п (фнг. 2.5), опреде - ляющего наклон кривой. Экспериментальные кривые для красных светодиодов GaP снимались в непрерывном (□) или импульсном режиме (О) н в зависимости только от смещения (ф). В экстраполированной области смещение перехода считается пропорциональным логарифму интенсивности зеленой электролюминесценции. Кривые A — D относятся к диффузионным диодам, изготовленным в различных условиях. |
роль таких центров лишь на краях обедненного слоя. Заряд глубоких центров может изменяться либо под действием оптического возбуждения, либо вследствие инжекции во время пере - ‘ ходного процесса смещения границы обедненного слоя при приложении соответствующего импульса напряжения. Емкость перехода чувствительна к таким изменениям заряда; это дает нам хороший аналитический метод исследования глубоких рекомбинационных центров, как излучательных, так и безызлучательных
|
eWl/kT Рис. 2.11. Идеальная н реальная (------------------ ) вольг-амперйые характеристики кремниевого диода [35]. а—участок с преобладанием генерационио-рекомбинациониого тока; б—участок с преобладанием диффузионного тока; в—участок с высоким уровнем инжекции, при котором происходит модуляция проводимости; г — участок, наклон которого определяется последовательным сопротивлением; д—-участок обратной ветви, иа котором ток обусловлен генерацией—рекомбинацией и поверхностной утечкой. |
(разд. 3.2.8 и 3.6.2). При малых смещениях ток, обусловленный рекомбинацией на мелких ловушках, определяется, выражением
ejhk£AW / { _eVt fL'Wxpf fMexpf—V
(Wp,)I‘(vd-'V) Ubt ykBTj
(2.24)
где W — ширина обедненного слоя, a Vk— напряжение «излома» характеристики [при V Vk преобладает ток, описываемый выражением (2.23)]. Напряжение излома Vk равно
Vk = | 2 {Et - Et)Je + {kBT/e) In (t*/0 I + (2kBT/e) In ('/2). (2.25)
Теперь ясно, что даже в области, где диффузионный ток пренебрежимо мал, коэффициент п может меняться от 1 до 2 в за - зисимости от того, какая рекомбинация преобладает: на мелких
или на глубоких ловушках. Изменения этого коэффициента видны на кривых интенсивности электролюминесдентного излучения светодиодов из GaP, легированных цинком при различных режимах диффузии, в зависимости от приложенного напряжения (рис. 2.10). Рассмотрим последний тип отклонений характеристики от идеальной. При больших прямых смещениях дифференциальное сопротивление перехода становится таким малым, что значительная часть приложенного напряжения падает на омическом сопротивлении нейтральных областей полупроводника. При этом в хорошо спроектированных диодах с малым сопротивлением растекания концентрация инжектированных неосновных носителей становится сравнимой с концентрацией основных носителей, т. е. наблюдается модуляция проводимости. Трудность исследования I—V - и L—У-характеристик состоит в том, что они имеют физический смысл, если V соответствует падению напряжения непосредственно на р — и-переходе. Зависимости интенсивности излучения от тока тоже могут дать неправильные представления о физике процессов в диоде, поскольку составляющая тока I, ответственная за излучение, может существенно отличаться от полного тока и иметь другое значение п. Гершензон и др. [37] обошли эту трудность, используя экстраполяцию зависимости интенсивности зеленого излучения от напряжения (L — У-характеристика) в область, где невозможно измерить непосредственно напряжение на переходе V. Они исходили из того, что для очень мелких уровней, дающих зеленую электролюминесценцию в фосфиде галлия (разд. 3.2), величина 2(Et — Еі) I близка к eVo, поэтому, согласно выражению (2.25), величина V никогда не превосходит Vk, а, следовательно, интенсивность излучения всегда должна быть пропорциональна exp(eV/kaT). Этот вывод подтверждают экспериментальные данные в той области, где напряжение V может быть измерено непосредственно. В современных светодиодах из GaP:N такая зависимость наблюдается при токах не более 1 мА (разд. 2.4).
Любые рекомбинационные уровни могут давать излучатель - ную рекомбинацию в какой-нибудь области светодиода, хотя глубокие уровни в обедненном слое в основном дают безызлу-' чательную рекомбинацию. Люминесценция, обусловленная рекомбинацией на существенно различных уровнях Et (иначе говоря, связанная с разными составляющими тока), может иметь разные значения п в соотношении L ~ ехр(eV/пквТ). Это часто имеет место в диодах из фосфида галлия, у которых в довольно широком диапазоне смещений п = 2 для красного излучения, тогда как для зеленого ti = 1.
Результаты подробных исследований [37а] световых и вольт - амперных характеристик современных зеленых и красных светодиодов из фосфида галлич, изготорленные методом двойной
жидкостной эпитаксии, свидетельствуют. о прекрасном согласии экспериментальных данных с теорией Са — Нойса — Шокли, учитывающей диффузионную и рекомбинационную (в области пространственного заряда) компоненты тока и омическое последовательное сопротивление. Совпадение экспериментальных и теоретических данных наблюдалось в диапазоне токов, составляющем более девяти порядков. Рекомбинационная компонента тока в области пространственного заряда обусловлена глубокими уровнями, расположенными вблизи середины запрещенной зоны. Методика исследования включала автоматическую регистрацию, обработку и анализ зависимостей тока диода, излучения и емкости (разд. 2.3) от напряжения в выбранном диапазоне прямого и обратного смещения. В результате анализа получали вольт - амперные характеристики, зависимости коэффициента инжекции и квантового выхода излучения от прямого тока через прибор, а также профиль распределения легирующей примеси в области пространственного заряда. Зеленые светодиоды из GaP : N обладали резким р — «-переходом, и ширина области пространственного заряда была пропорциональна V'12 [выражение (2.26)]. В красных светодиодах из GaP : Zn, О распределение примеси соответствовало плавному переходу с постоянным градиентом и ~ у/з. Однако вольт-амперные характеристики этих диодов давали лучшее согласие с моделью, предполагающей существование і-области толщиной ~ 0,1 мкм. В этой модели ширина перехода не зависит от напряжения, что согласуется с более ранними экспериментальными данными на диодах такого же типа [38]. Подобный анализ можно провести только в отсутствие значительных аномальных компонент тока, например обусловленных поверхностными утечками. Избавиться от поверхностных утечек обычно (но не всегда) удается с помощью соответствующего травления поверхности.

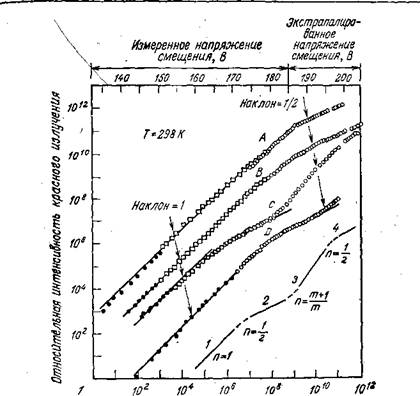
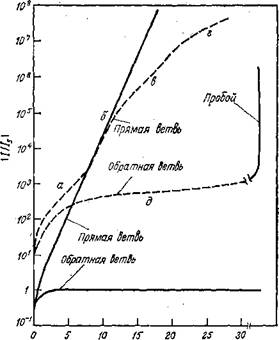
 Опубликовано в
Опубликовано в