ОЛЕОФИЛЬНЫЕ АРИЛАЗИДЫ В ФОТОРЕЗИСТАХ
 25 декабря, 2013
25 декабря, 2013  admin
admin Диазидобензилиденовые производные циклокетонов применяются в композициях с полимерными связующими, содержащими ненасыщенные связи в главной цепи. Так, разработана светочувствительная композиция [пат. Великобритании 1470059], содержащая диазид I (от 0,01 до 20 %), а в качестве полимерного связующего— сополимер метилметакрилата и этил-М-акрилоилглицина; композиция может включать триплетные сенсибилизаторы. В качестве растворителей применяются ксилол, циклогексанол, ДМФА,
дихлорэтан или их смсси. Иногда в проявитель вводят добавки красителя или пигмента, ПАВ, адгезивов. Используется водно-щелочное проявление (10 %-ный раствор Na3P04-12H20). Эта композиция может применяться на различных полимерных и металлических подложках, тканях, стекле.
Высокой светочувствительностью, стабильностью при хранении, разрешающей способностью и возможностью водного проявления характеризуется азидсодержащая композиция на основе сополимеров с большим содержанием непредельных связей [пат. США 4275142]. Сополимер включает компоненты А, В и С, где А — конъюгированный диолефин CH2=CR—СР'=СНР" (R = Н, Aik Ci—C4, Hal; R', R"=H, CH3, Cl), например, 1,3-бутадиен, хлоро - прен; В — ненасыщенная карбоновая кислота CHR=CR'—СООН (R, R' = H, СН^, С2Н5, С1), например, акриловая, метакриловая, малеиновая, фумаровая; С — ненасыщенный мономер CH2=CR— COOR' (R = Н, СН3; R' = Alk Ci—С]3). Слой, содержащий 2,6- бис (4-азидобензилиден)циклогексанон (диазид II) может быть получен толщиной 11 мкм, экспонирован ртутной лампой сверхвысокого давления (250 Вт, 10 с, расстояние 60 см); после проявления водой он выдерживает травление подложки раствором CuS04 в 10 %-ной водной НС1 на глубину 0,17 мм. Резист обеспечивает великолепную воспроизводимость элементов и точек. Эти слои могут быть использованы в производстве печатных форм, печатных плат, флексографических пластин.
Промышленность выпускает ряд составов на основе диазида I и полиметилизопропенилкетона. Их проявляют смесью циклогек - сана и 2-нитропропана. Они обеспечивают высокое разрешение и термическую стойкость рельефа, который выдерживает плазменное травление, например CF4—02 (96:4). Разрешение и светочувствительность таких составов (например, ONNR-20) аналогичны параметрам, получаемым для позитивных фоторезистов [15].
|
СО
/ СО |
|
СО
|
|
или |
|
R, R' R" = Н, Aik или Alkylen до С2о, n = 0s - 10, чаще 0, 1; Z = ОН, Hal. |
Другой тип пленкообразующего компонента для азндсодер - жащих фоторезистов создан на основе мономерных норборне - нов. Полимеризацию их ведут с раскрытием норборненового би - или тетрацикла (в этилхлориде при 25 °С в течение 4 ч) [пат. США 4106943]:
|
X, Y = Н, (CH2)„COOR, (CH2)„OCOR', (CH2)„CN, (CH2)„Z или X и Y вместе образуют следующий цикл: |
Эти полимеры термопластичны, их пленки обладают низким поверхностным натяжением, они хорошо растворимы в органических растворителях. Для придания водорастворимости слоям в полимер вводятся гидроксильные или карбоксильные группы. В качестве светочувствительных компонентов предлагается использовать, например, диазид I, 4,4'-диазидостильбен, гс-фенилендиазид, 4,4'-диазидостильбен-а-карбоновую кислоту, 2,7-диазидофлюорен и пр. Таким образом, на основе полимеров с терпеновым циклом можно создать композиции фоторезистов как водного, так и органического проявления.
Повышение механической прочности слоев и их адгезии к подложкам достигается введением в слои сополимеров метакрилатов, например:
|
О |
|
|
|
R |
|
CI |
|
С1 |
|
о |
|
он |
п = 1000 ^ 2500.
Композиции очувствляются диазидом I и 4,4'-диазидостильбен- 2,2'-дисульфокислотой (диазидом III) [пат. ЧССР 186630, 144618].
Для предварительно очувствленных печатных плат разработаны составы [пат. США 4139390], включающие карбонил - и сульфо - нилазиды: ArCON3; ArCH = CHArCON3; BCbH4S02N3
|
Ar = феннл, феннлен, а - или [5-нафтил с различными заместителями; Q=0, S, Se, Na (А = Н, AlkCj—С6, АгС6 —Сю, карбалкокснл илн карбамнл); R, R'=H, Aik, ArAlk, ArAlkoxyl, Hal; R", R'" = N3 или Aik; Z = СН или N; R"" = H, Aik, ArAlk, Ac; В = Ac C2 — C5. |
Они поглощают в области 280—360 нм.
Целесообразно визуализировать элементы изображения непосредственно после экспонирования. По цвету видимого изображения точнее выбирается экспозиция, облегчается проявление фоторельефа. Наибольшую сложность представляет введение красителей, не приводящее к уменьшению скорости фотосшивания. Поскольку этого трудно достичь, то технологичными считаются уже те фоторезистные композиции, в которых скорость структурирования слоя уменьшается не более, чем на порядок. Исходя из этих соображений, предлагается введение в слои лейкооснований три - фенилметановых красителей, а также производных ксантена, тио - ксантена или диметилантрацена. При экспонировании происходит фотоокисление лейкооснования красителя с окрашиванием осве
щенных участков слоя. В качестве полимерной основы этих слоев обычно используют полиэфиры, поликарбонаты или полисульфонаты, содержащие в главной цепи халконовую группировку —СН=СН—СО—. Например, предлагается для широкого применения полимер формулы:
|
где тип равны 1, 2 или 3, одинаковы либо различны. |
р
Триплетные сенсибилизаторы ускоряют сшивание азидсодержащих полимерных матриц; кроме того, в композицию вводятся стабилизаторы, например:
|
R где Х = 0, СН2; R, R' = Н, Aik; R" = О, NH; R'", R"" « ОН, NH2; |
|
|
Эти соединения препятствуют появлению окраски при хранении композиций, содержащих лейкооснований красителя.
Азидсодержащие фоторезисты могут быть использованы для создания контрастных фотошаблонов, защищающих от УФ-излу - чения при экспонировании светом 340—450 нм [яп. заявка
51— 40452; пат. Великобритании 1475579. При этом пленка имеет прозрачную подложку, и водо - или спирторастворимый светочувствительный слой, содержащий диазид I или II, диазидо - бензилиден - или диазидоциннамалиденацетон. Содержание арил - азида в композиции должно быть достаточно высоким, чтобы после экспонирования продукты его фотолиза в слое обеспечивали оптическую плотность не менее 1 в области 340—450 нм. Для достижения оптической однородности проэкспонированного слоя возможно использование комбинации арилазидов, области поглощения которых перекрываются. В качестве полимерного связующего используется азидсодержащий полимер или смесь полимеров, например: модифицированный производными дикарбоновой кислоты сополимер бутилметакрилата, 2-гидроксиэтилгексилакрилата и 2-гидроксиэтилметакрилата (60:10:30). Кроме того добавляется Жирорастворимый розовый, 4-гидроксибензальазин. Проявляют водой с добавлением в нее моноэтаноламина и красителя, например Турецкого красного. Иногда в проявитель могут быть добавлены
ПАВ, например лаурилсульфат. После проявления слой ополаскивают водой, покрывают защитным слоем (раствор ПВС) и измеряют оптическую плотность. Удается, например, получить шаблон со следующей спектральной характеристикой:
Длина волиы, им 300 320 340 360—450 460 500
Оптическая плотность ^2 ^2 1,9 ^-2 1,9 1,2
В 1981 г. предложено использовать в фотомаскирующем элементе два слоя [яп. заявка 56—44415]: светочувствительный слой состоит из диазидобензилиден- или диазидоциннамалиденкетонов с высокой оптической плотностью, а сверху его покрывают клейким твердым защитным слоем, прозрачным к УФ-свету. Защитный слой практически не пропускает кислород, что способствует усилению взаимодействия арилнитренов с полимерами.
В композиции, чувствительные к излучению с длинами волн до 600 нм, рекомендуется [яп. заявка 57—59954] вводить 1,5- или 1,8-бис (я-азидобензоилокси)антрахиноны; они содержат циклокаучук или стирол-бутадиеновый каучук, растворителем служит смесь толуола, хлорбензола, тетрагидрофурана (50:30:20). Такие фоторезисты можно использовать в проекционной фотолитографии.
Среди композиций азидсодержащих фоторезистов более 20 последних лет разрабатываются составы [пат. США 2940853], включающие диазидобензилиденовые производные кетонов, чаще других диазида I и диазида II. Использование этих слоев обусловлено их спектральной чувствительностью (Ямакс 350—360 нм) в области максимальной эмиссии ртутных ламп, высоким квантовым выходом фоторазложения, в том числе и в полимерных матрицах, легкой совместимостью с полимерными матрицами. Полиизопреновый циклокаучук был первым пленкообразующим веществом, предложенным для слоев; содержащих диазиды I и II. Широкое распространение этих составов вызвано универсальностью их применения: они используются в полупроводниковом приборостроении, производстве интегральных схем (ИС, БИС, СБИС), при создании печатных плат и офсетных печатных форм. Именно эти составы легли в основу ряда промышленных марок фоторезистов: ФН-11, ФН-Пк, KMER, KTER, 5CR-2, FSR, OMR-83 и т. д.
При прочих равных условиях эффективность сшивания полимера очень сильно зависит от небольших изменений в его целях. Так, с помощью методов золь-гель-фракционирования и равновесного набухания установлено, что при сшивании диазидом I эпокси - Дированного циклополиизопрена частота возникновения поперечных мостиковых связей в 2—3 раза больше, чем у аналогичных составов на основе циклополиизопрена [42].
В ряде патентных разработок последних лет по-прежнему основой азидсодержащих фоторезистов являются диазид I и цикло - каучук. В то же время предлагаются различные способы совершенствования качества фоторезистного слоя. Эксплуатационные характеристики рекомендуется улучшать, применяя строгие критерии отбора циклокаучуков (по содержанию двойных связей, степени циклизации и пр.), используя другие типы циклизованных полидиенов или вводя добавки, регулирующие свойства полимера в процессе циклизации. Другой путь улучшения фоторезиста — дополнительное включение в него соединений, способных повышать, например, контрастность слоя или нейтрализовать эффекты стоячих волн в фоторельефе. Наконец, для фоторезистов, содержащих тот же диазид I, предлагаются другие типы полимеров, позволяющие перейти либо к водно-щелочному проявлению, либо к высокой гидрофобности рельефа, либо даже к дифференциации свойств слоев после фотолиза диазида, т. е. к сухому переносу изображения. В большинстве предлагаемых композиций соотношение диазид : циклокаучук: растворитель лежит в пределах 3-н5:100: :700-4- 1000.
В 1972 г. проанализированы свойства фоторезистов с учетом соотношения в циклизованном цис- 1,4-полиизопрене со средними размерами молекул 400—550 нм циклизованных и нециклизован - ных звеньев, двойных связей, входящих в цикл и в открытую цепь, а также предложена зависимость этих соотношений в полимере от содержания диазида I в слое [пат. ФРГ 2153781], дающая оптимальный состав. При использовании найденного оптимального состава фоторезиста обеспечивается надежное получение высокораз - решенного фоторельефа на различных подложках. Фирмой Hunt (США) для азидсодержащих композиций разрабатываются циклокаучуки с узким ММР, полидисперсностью менее 1,865 и ненасы - щенностью 6,0—8,2 ммоль/г [европ. пат. 0063043].
Сочетание высокой разрешающей способности, адгезии к подложке, кислотостойкости (практически последние два свойства и определяют резистивность состава) отмечены в фоторезисте на основе эпоксидированного циклополиизопрена и диазида I [а. с. СССР 398916]. Кроме того, этот состав после фотолитографии обладает высокими диэлектрическими свойствами, что позволяет использовать фоторельеф в качестве межслойной изоляции многослойного печатного монтажа. Электрофизические параметры слоя и резистивность фоторезиста в значительной мере обусловлены высокой плотностью пространственной сетки, возникающей на фото - и термозадубленных участках слоя.
Использование в качестве полимерной основы фоторезистов циклизованных полимеров представляется чрезвычайно перспективным— в них эффективен фотолиз азидов и темновые реакции нитренов, структурирующих циклокаучуки, таким образом, интегральная светочувствительность фоторезистов достаточно высока. Циклокаучуки, обладая малой ММ, дают твердые и плотные пленки, они позволяют после экспонирования создать высокоразрешен - ные рельефы. В азидсодержащих фоторезистах для коротковолнового УФ-света (WR-резистов), полученных на основе циклокаучу - ков, разрешение достигает субмикронных размеров. Кроме того, именно фоторезисты на основе циклокаучуков и диазидов в настоящее время являются одними из наиболее плазмостойких (например, состав OMR-83, Япония), В циклокаучуки легко вводить раз
личные функциональные группы. Включение в молекулу цйклоизо - прена атомов хлора, карбоксильных групп и других реакционноспособных центров придает фоторезистному слою ряд дополнительных ценных эксплуатационных свойств: повышает его светочувствительность, термостойкость, адгезию к подложке и т. д. С целью повышения светочувствительности были специально синтезированы различные циклокаучуки. Так, цис- 1,4-циклополибутадиен, полученный циклизацией полибутадиена при 20 °С в присутствии системы дихлорид этилалюминия — трихлоруксусная кислота в разбавленном растворе (6-10-3 моль/'л), оказался весьма подходящим для создания фоторезистов; композиция включает диазид II. Эти слои обладают прекрасной адгезией к различным субстратам, их светочувствительность втрое превосходит светочувствительность слоев на основе циклоиолиизопрена; разрешение фоторельефа достигает 1,6 мкм.
Циклополибутадиеновые композиции более термостабильны, чем циклополиизопреновые: пленка фоторельефа выдерживает
термообработку при 250 °С. Термогравиметрическим анализом было показано, что циклизованный полибутадиен разлагается при температурах, на 80 °С превышающих температуру разложения циклополиизопрена [43].
Для повышения термостойкости слоев разработана композиция, состоящая из диазида I, циклокаучука и конъюгированного диена, содержащего карбонил (или потенциальный карбоксил) [заявка Японии 59—13237]. Композиции, включающие циклокаучуки, устойчивы продолжительное время только до 180 °С. Предлагается [заявка Великобритании 2049211; франц. пат. 2455304; пат. ФРГ 3014261; пат. США 4294908] в обычные композиции негативных азидсодержащих фоторезистов, содержащих, например, диазид I или II, 4,4'-диазидостильбен, 4,4'-диазидобензофенон, включать в качестве основы слоя модифицированные циклокаучуки, полученные циклизацией в присутствии фторсодержащих производных сульфокислот CFnH3_nS03X или CFnH3_nS02Y (где X = Н, Aik или CF„H3_nS02; Y = Hal, п — 1, 2, 3) полимеров с основной цепью следующей общей формулы:
|
|
R — R'"" = Aik С, — С4, Ar, Н.
Для циклизации могут быть использованы, например, полимеры и сополимеры цис - и транс-1,4-бутадиена, 1,2-пентадиена, цис - и трансА,4-изопрена, 2-фенил-1,4-бутадиена. Дополнительно в светочувствительные композиции вводят триплетные сенсибилизаторы. По сравнению с фоторезистами на основе циклополиизопренов
эти композиции выдерживают термообработку после экспонирования при 250°С, причем после травления заметно уменьшается число проколов в слое.
В 1981 г. была предложена арилазидная композиция [пат. США 4287294; пат. ФРГ 2919841] специально для получения термостойких рельефных структур на полупроводниковых материалах, при этом в качестве светочувствительного агента используется ази - досульфофенилмалеинимид, а термостойким пленкообразующим компонентом слоя являются полиамиды карбоновых кислот; растворителем служит смесь диметилацетамид — диоксан (1 : 1). Этот фоторезист образует на алюминиевой фольге сшивающийся слой толщиной 6 мкм, после проявления [проявитель — смесь у-бутирол - актон —толуол (1:1), 16 с] разрешение 10 мкм, структура полученного рельефа полностью сохраняет размеры изображения и абрис углов после термообработки при 340 °С в течение 1 ч. Слой обладает хорошими электроизоляционными свойствами и может быть использован в качестве межслойной изоляции.
Термостойкие фоторезисты с такими же электроизолирующими свойствами созданы при введении в композицию, приготовленную на основе соли алкенилированного амина полиамидокислоты европ. пат. 0065353], диазидобензилиденовых или диазидоциннама - лиденовых производных циклокетонов. После экспонирования слой проявляют смесью Ы-метил-2-пирролидон — этанол (5:1). Получены элементы с размером 2 мкм. Полимер имидизируют при дальнейшей термообработке.
Композиции, содержащие диазид I, помимо циклополиизопре - нов или циклополибутадиенов могут включать и полициклогекса - диен при обычном соотношении компонентов [а. с. СССР 651298], а также циклизованные производные гомо - и сополимеров конъюгированных диенов [европ. пат. 0068808].
Широко используемый путь улучшения качества азидсодержащих фоторезистивных композиций — введение в слои различных мономерных добавок.
Сохранение размеров изображения, задаваемого фотошаблоном, в большой степени зависит от того, насколько уменьшен эффект стоячих волн, возникающих в слое фоторезиста при отражении света от подложки. Считается, что для точного воспроизведения размеров изображения, заданного фотошаблоном, важно сохранить значения поглощения света композиций во все время экспонирования, несмотря на падение по мере облучения оптической плотности собственно диазидного компонента. С этой целью в фоторезисты вводят соединения, повышающие экстинкщда всей системы в целом. Предлагается [пат. США 4287289, 4268603; заявка Японии 53—151842] в обычные композиции резистов вводить моно - и бисазокрасители, обладающие высокими коэффициентами экстинкции в области 330—430 нм, следующих формул:
RR, C6H3N=NC6H4NR"R,,/: rR"R''/NC6HsR",'N==NC6H2RR'—]2(0)„
R, R' = Н, ОН, Aik, Alkoxyl; R", R'" = Aik, Azalk, Alkoxyl; n = 0, 1.
Так, в фоторезист OMR-83, содержащий циклокаучук и диазид I, вводят 1-этокси-4-(4-М,1М-диэтиламинофенилазо)бензол. Эта композиция, нанесенная на кремниевую подложку толщиной слоя 1 мкм, выдерживает 20-минутный нагрев перед экспонированием (60 или 80 °С) без заметного снижения поглощения слоя. После проявления слой обеспечивает разрешение 2,5 мкм и точцо воспроизводит рисунок элементов шаблона.
В качестве противоореольных добавок предлагается включать в слой из циклокаучука и диазида I флюоресцирующий компонент, например, Г^Ы-замещенные азометинов на основе фенилендиами - нов или гидразинов:
[RR'C=N—Ь(А)п или rr'C=NR"
А = фенилен; R = Аг или 2-арилэтилен) R' = Н, Aik, Ar; R" = Ar; n — 0 или 1.
Уменьшая светорассеяние в слое, эти добавки способствуют более полному структурированию экспонируемых участков [заявка Японии 55—34931]. Обычно при проявлении азидсодержащих фоторезистов уменьшение исходной толщины слоя может составлять до 50%. В результате введения добавок замещенных азометинов толщина слоя уменьшается не более, чем на 10%, что в свою очередь улучшает кислотостойкость рельефа при травлении.
Разрешение, достигаемое в позитивных фоторезистах на основе феноло-формальдегидных смол, выше, чем в составах на основе каучуков и циклокаучуков. Кроме того, при проявлении этих составов водными растворами снижается токсичность материалов и пожароопасность производства. НС в ряде случаев является основой азидсодержащих фоторезистов. Именно с НС были использованы в качестве светочувствительных компонентов азидопирены [44]. Фотолиз азидопирена в феноло-формальдегидной смоле наряду с резким снижением растворимости смолы дает сине-зеленое окрашивание. Увеличение гидрофобности засвеченного слоя и изменение окраски обусловлены появлением хиноидных структур при реакциях нитренов с фенольными группами смолы [45]. Хи - нонимины были идентифицированы в экспериментах на модельных мономерных фенолах.
Разработаны светочувствительные составы водно-щелочного проявления на основе поли-4-винилфенола и 3,3'-диазидодифенил - сульфона (MRS) [4, 22]. Азидофенольные смолы используются в фоторезистах (например, MRL), высокая чувствительность которых сравнима со светочувствительностью позитивных составов. Эти фоторезисты отличаются и значительной разрешающей способностью, более высокой, чем у составов на основе циклокаучука [22].
При разработке щелочерастворимых композиций [пат. США 4148655; пат. Великобритании 1594030; заявка Японии 56—23144] основное внимание уделяли совершенствованию состава смол. Пленкообразующим компонентом служат НС, получаемые кислотной конденсацией формальдегида с замещенными фенолами, причем при синтезе используется не менее двух фенолов. НС позволяет получить фоторельеф, удобный как для применения в полиграфических формах в качестве печатающих элементов, так и для защиты при глубинном травлении подложки. Светочувствительными компонентами, помимо обычно применяемых диазидов, служат азиды на основе гетероциклов, например 2-(4-азидофенил)-6-метил - бензотиазол, 2-(4-азидофенил)нафто[1,2-с?]оксазол-4,5. Содержание светочувствительного компонента и композиции определяется назначением фоторезиста, чаще всего оно составляет от 10 до 30 % к массе полимера, т. е. значительно выше, чем в слоях на основе циклокаучуков. Эти композиции отличаются высокой светочувствительностью и стабильностью свойств: после 6 мес хранения не изменилась ни светочувствительность, ни длительность проявления слоев. Для фоторезистов же, содержащих нафтохинондиазиды, это предельный срок хранения.
Составы, содержащие эпоксидированные НС, поли-я-винилфе - нол и 3,3'-диазидодифенил, применяют в качестве верхнего несущего изображения слоя, в трехслойных фоторезистных системах (см. гл. VIII) [39].
Диазобензилиденовые производные кетонов и циклокетонов используются в композициях на основе НС, полиамидов в ряде других полимеров. Так, состав, содержащий диазид I и НС в смеси метилэтилкетон — толуол (1:1) [пат. США 4287297], разработан для нанесения на пленку из ПЭТФ. Материал используется для приготовления печатных схем и печатных плат. В качестве резистов для коротковолнового УФ-света с поглощением в области 250— 300 нм предложено использовать композиции крезоло-формальде - гидных смол (ММ 500—6000) с 1,2-ди(я-азидофенил) этаном или ди(я-азидофенил) метаном [пат. ФРГ 3125572]. Достигнуты размеры элементов порядка 0,85—0,9 мкм (см. также раздел VI. 1).
Сдвиг поглощения светочувствительной композиции в область максимальной эмиссии металло-галогенидных ламп достигается использованием в них арилазидов, имеющих цепи сопряжения различной длины (халконовых, азометиновых, стирильных производных арилазидов). Так, предложенная в пат. ФРГ 1597614, композиция содержит азидохалконы общей формулы:
N3RC6H3CX==CH—(СН=СН)„—COC6H5_mRm
R = Н, Hal, Alkoxyl, R' *= ОН, N02, S02NH2, S02N3; X = H, Hal, m= 1,2; n = 0,1.
Азидная группа находится в 3- или 4-положении бензольного цикла. В зависимости от используемых заместителей максимум поглощения этих соединений лежит в области 314—394 нм. В качестве пленкообразующей основы используют сополимеры стирола с малеиновым ангидридом или винилацетата с кротоновой кислотой, НС или продукты конденсации фенола и формальдегида с производными целлюлозы, например этилцеллюлозой. Все эти композиции растворимы в эфирах гликолей, в ДМФА при 20 °С и в 3 %-ном водном растворе NaOH. Необходимо отметить очень вы
сокое массовое содержание светочувствительного соединения в составе; предпочтительно от 1 : 1 до 1 :5. Возможно, такое соотношение обусловлено рекомендацией преимущественно использовать в слоях моноазиды.
Из диазидопроизводных предложены соединения, типа
|
|
|
И N; |
|
|
|
V V-so2N3 |
Аналогичные пленкообразователи, красители и растворители и их соотношения предлагаются [пат. ФРГ 1572067] для светочувствительного материала, содержащего азидоазометины следующих общих формул:
N3RCH=NR' и N3RCH=NR"— n=chrn3
где R, R''-фенилен, нафтилен, пиридинилен; R' — фенил; нафтил или пиридил.
Используются также [пат. ФРГ 1572070] и азидостирильные производные общей формулы: .
N3—R—СН=СН—R'R"
где R = фенилен; R' = фенилен, нафтилен или замещенный фенилен; R" = Н или СН = CHRN3.
Максимум полос поглощения в спектрах этих соединений лежит в области 290—400 нм. Соотношение азид: полимер предпочтительно от 1 : 1 до 1 :5. Композиции применяются при изготовлении офсетных форм. Слои настолько прочны, что их проявление осуществляют тампоном, смоченным органическим или лучше водным раствором щелочи. Для водного проявления рекомендованы растворы солей щелочеземельных металлов или четвертичных аммониевых оснований.







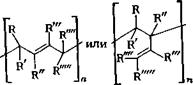

 Опубликовано в
Опубликовано в