МНОГОСЛОЙНЫЕ РЕЗИСТНЫЕ СИСТЕМЫ
 9 февраля, 2014
9 февраля, 2014  admin
admin Фактором, оказывающим влияние на разрешение, является также топология подложки, которая может иметь рельеф, созданный предыдущими операциями. При оптическом экспонировании происходит интерференция света, отраженного от подложки и краев топологического рельефа. Этот эффект особенно характерен для субмикронной области. При экспонировании пучком электронов наблюдается рассеяние электронов в обратном направлении, что
|
|
делает невозможным достижение высоких значений AR. Использование системы мно-
Рис. VIII. 1. Литография с МСР при различных обработках планаризацион- иого слоя:
А — ПХТ; Б — жидкостное проявление после сплошного экспонирования с сохранением верхнего слоя; В — то же с удалением верхнего чувствительного слоя; Г — ИХТ; 1 — чувствительный слой; 2 — промежуточный слой (для трехслойиой системы); 3 — плаиарнза - циоиный слой; 4 — элемент рельефа подложки.
гослойных резистов (МСР) дает возможность решить эти проблемы, а также улучшить результаты переноса изображения в подложку при использовании обычных резистов [1; пат. США 4394437].
В основе МСР лежит образование относительно толстого слоя планаризационного резиста на поверхности подложки (рис. VIII. 1), который затем покрывается слоем чувствительного резиста. После экспонирования и проявления слой чувствительного резиста служит маской при сплошном экспонировании планаризационного слоя. Эта маска называется Portable Conformable Mask — прилегающей маской (ПМ), так как точно воспроизводит поверхность планаризационного слоя. В ряде случаев между слоями планаризационного и чувствительного резиста вводят промежуточный слой, который служит маской при травлении. Можно использовать и большее число слоев, придав им соответствующие функции. Толщина планаризационного слоя зависит, помимо прочих факторов, от топологии подложки и обычно лежит в интервале 1—4 мкм. Толщина чувствительного слоя резиста обычно 0,3—0,5 мкм, толщина промежуточного слоя 0,05—0,2 мкм. Система МСР может быть использована как в оптической и электронной литографии, так и в рентгеновской и ионной. Во всех случаях достигают большего разрешения, чем при обычной однослойной технологии.
Использование МСР в оптической литографии имеет особое значение прежде всего для проекционного экспонирования, так как дает возможность свести к минимуму ограничения глубины
резкости однослойных систем и изменения ширины линий, обусловленные разной толщиной пленки резиста на рельефных подложках, а также различиями в интенсивности отраженного от подложки света и связанным с этим интерференционным эффектом. При контактной печати с зазором улучшается качество переноса изображения в результате выравнивания подложки планаризационным слоем и, следовательно, уменьшения непостоянства зазора и толщины слоя чувствительного резиста.
В проекционных системах используется излучение ртутных ламп, имеющее широкие полосы в ближней УФ и коротковолновой видимой области спектра. Если слой резиста толщиной d 2 мкм с показателем преломления п = 1,6 экспонировать светом с длиной волны 436 нм с помощью объектива, имеющего апертуру А 0,28, то глубина резкости Аz такой системы составит Дг « %/2А2 « « 2,7 мкм, при этом, используя достижимые в реальных условиях оптимальные режимы обработок, удается получать линии шириной %/А « 1,5 мкм. Имея в виду, что эффективная оптическая толщина слоя равна d/ti— 1,25 мкм, то область допустимых ошибок резкости (устойчивость системы к различному виду отклонений) составляет величину —'1,5 мкм. Если же при общей толщине МРС 2 мкм чувствительный слой будет иметь толщину 0,5 мкм, то, очевидно, резко возрастает устойчивость совокупного резистного слоя к различному виду отклонений при общем высоком AR МРС. Такой эффект разделения функций между чувствительным и устойчивым к травлению планаризационным слоем позволяет применять объективы с большей апертурой и тем самым одновременно экспонировать большие площади |2].
Так как при экспонировании однослойного резиста происходит многократное отражение света от подложки и от границы резист — атмосфера, то нижние слои резиста экспонируются в меньшей степени, а после изотропного проявления профиль слоя позитивных резистов в верхних слоях расширен (overcut), а у негативных сужен. Разница в ширине проявленных линий на рельефной подложке зависит, следовательно, от толщины слоя резиста, определяемой высотой рельефа подложки. При экспонировании слоев на подложке, которая содержит несколько отражающих слоев (Si02 на поли и монокристаллическом Si), интенсивность отраженного света в результате многократной интерференции зависит от толщины слоев [3]. При помощи системы МСР, особенно при использовании активно поглощающих свет планаризационных слоев, отражение света от подложки исключается, что улучшает качество передачи изображения. Для повышения поглощения в этот слой вводят краситель. Вместо окрашивания между планаризационным и чувствительным слоями рекомендуется использовать слой, поглощающий отраженный свет [4; яп. заявка 59—14639].
Если показатели преломления слоев МСР одинаковы, то будет также образовываться стоячая волна. Эти волны весьма однородны в поперечном направлении и вызывают появление «гребенки» в профиле резиста, Правильно выбранной постэкспозиционной термообработкой можно сгладить их отрицательное действие. При использовании тонких слоев резиста обычно снижается продолжительность экспонирования, однако у МРС время экспонирования возрастает, так как снимается действие света, отраженного от подложки. Необходимо поэтому, чтобы резист имел повышенную чувствительность.
Несмотря на то что в электронной литографии для достижения субмикронного разрешения используются апертуры меньшие, чем в оптической литографии, и достигается большая глубина резкости, в результате рассеяния электронов наблюдается расширение линий. Обычно используемая фокусировка пучка электронов до сечения радиусом 50 нм может привести к экспонированию участков с линейными размерами порядка нескольких микрометров (эффект близости). Кроме того, имеет место и отрицательное влияние накопления заряда диэлектриком (например, БЮг). Поскольку рассеяние и отражение электронов возрастает с ростом заряда ядра атомов элементов, входящих в состав подложки, влияние на эти величины Si и Se более ярко выражено, чем влияние органических материалов, состоящих только из углерода, водорода и кислорода, что и достигается в планаризационном слое.
Планаризационый резист ограничивает рассеяние в чувствительном слое резиста электронов, отраженных от подложки. Теоретические расчеты показывают, что этим способом можно получить в слое резиста вертикальное изображение краев с меньшими отклонениями при проявлении [5]. Для исключения влияния заряда, накапливающегося при экспонировании резиста на подложке Si02/Si, как и в случае однослойной системы, можно нанести на подложку тончайшие проводящие слои А1 или Аи, либо сильно легированные полупроводниковые слои Si или Ge. Это, однако, является дополнительной технологической операцией. Для большинства электронорезистов, имеющих чувствительность около 10~б Кл/см2, для использования в обычном однослойном варианте требуется высокое значение AR (СОР, FBM, PBS, Sel N). Система МСР дает возможность уменьшить длительность экспонирования при использовании тонкого слоя электронорезиста и толстого слоя планаризационного резиста. При этом можно перенести изображение на подложку с очень высоким значением AR, используя резист с низким значением AR.
При использовании в качестве источника рентгеновского излучения синхротрона применение МСР не имеет преимущества, так как этот источник дает коллимированное излучение, причем можно получить качественный профиль резиста во всем экспонированном поле. Использование МСР, однако, целесообразно при работе с квазиточечными источниками рентгеновского излучения. Определяющим фактором в этом случае является чувствительность резиста, а также возможность коррекции косого профиля рельефа резиста, который образуется, когда линейные размеры экспонируемого участка сравнимы с расстоянием источника до подложки [[6]. Квазиточечные источники рентгеновского излучения работают
в области длин волн 0,1—1 нм при 3—20 кВт. В этих условиях можно использовать приемлемые по длительности экспозиции — 60 с при дозе 5-10-3 Дж/см2. Такие резисты, как ПММА и FBM, вследствие малой чувствительности, требуют экспозиционной дозы 1 Дж/см2 и 50 Дж/см2 и создают изображение при малом AR [7]. ПДХПА в смеси с сополимером глицидилметакрилата с этилакрилатом, а также с N-винилкарбазолом и политетрафторпропилмет - акрилатом при толщине слоя 0,2 мкм требует для экспонирования дозу около 10 Дж/см2 [6], что при использовании МСР обеспечивает достаточное AR. При косом пучке излучения из точечного источника края резиста на границах экспозиционного поля также косые (см. рис. 1.23). Это ухудшает передачу ширины диагональных линий в предельных по разрешению структурах.
|
|
|
б
|
Использование трехслойного МСР этот недостаток сводит к минимуму. Промежуточный слой можно травить изотропно, а нижний слой планаризационного резиста — анизотропно.
Рис. VI 11.2. Образование ПМ для ИХТ при введении Ga3+B толстый слой чувствительного резиста: а — система после введения галлия; б — рельеф после ИХТ; / — полимерный чувствительный резнст; 2 — рельефная подложка; 3 — слой с галлием.
При экспонировании резиста ионами не наблюдается эффекта близости, так как ионы значительно тяжелее и путь их пробега в резисте и подложке зависит от типа ионов и их энергии. Легкие ионы, такие, как Н+ и Не+, могут иметь пробег около 1 мкм, однако у более тяжелых ионов, таких, как Аг+ и Gas+, пробег составляет сотни нанометров. Так как при действии ионов могут нарушиться полупроводниковые свойства подложки, использование МСР может обеспечить высокое качество экспонирования тонкого слоя чувствительного резиста, причем слой планаризационного резиста служит буфером для предотвращения действия ионов на подложку. Кроме того, можно образовать нужный изоляционный барьер, используя толстый слой чувствительного резиста и прямо вводя в него ионы при экспонировании [8]. Если соединения, образованные этими ионами (например, Ga3+), устойчивы при ИХТ, непосредственно образуется собственно ПМ и можно достичь эффективности МСР при использовании однослойного резиста (рис. VIII.2).
Как только стало ясно, что полупроводниковая память может превзойти систему памяти на магнитных доменах как с точки зрения технологии, так и стоимости, возникла необходимость в разработке методов изготовления субмикронных элементов и контроля ширины линий на рельефных поверхностях кремниевых подложек. Первоначально системы МСР были использованы для контролируемого изготовления узких линий при помощи образования ин
версного профиля резиста («взрывная» литография, lift-off). Принцип взрывной литографии состоит в анизотропном напылении слоя А1 на экспонированный и проявленный слой резиста, причем на открытых местах подложки образуются линии, ширина которых определяется шириной окон у наружной поверхности резиста. При этом резко уменьшается расширение профиля элементов (линий) у поверхности подложки. Металл, напыленный на поверхность резиста, затем удаляется вместе с резистом при последующем снятии слоя резиста растворителем. С помощью этой техники недавно удалось получить рельефное изображение с шириной линий 10— 20 нм [9].
Для взрывной лнтографни использовали сначала трехслойную систему [пат. США 3873361; яп. заявка 58—151023, 58—151021]. Ннжний планаризаци - онный слой был образован сшитым негативным резистом KTFR илн предварительно сильно отвержденным позитивным резнстом AZ-111. В качестве промежуточного слоя использовался неорганический материал (преимущественно А1, Si, SiO, Si3N4 и MgO [2, 10]), напыленный в вакууме. Верхним слоем служили обычные резнсты [11]. После образования рельефа в верхнем слое проводили мокрое травление промежуточного неорганического слоя, а затем травление планаризационного слоя кислородной плазмой нли ИХТ. Значительное упрощение было достигнуто прн использовании ПДМС в качестве промежуточного слоя, преимущество которого состоит в возможности нанесения из раствора в бутилацетате [12; пат. США 4004044]; кроме того, ПДМС устойчив прн ИХТ и благодаря прозрачности при толщине слоя до 0,15 мкм дает возможность, в отличие от неорганического слоя, легкого совмещения при экспонировании. Этот метод называется Spin-on-Resin-Glass.
В двухслойной системе для электронной литографии в качестве чувствительного нли планаризационного слоя используются сополимеры метилмета - крнлата с метакриловой кислотой и двойное проявление. Сначала обрабатывают проявителем верхний слой резиста, причем проявитель составляют так, чтобы планарнзационный слой растворялся значительно медленнее и нарушалась только поверхность раздела фаз за счет набухания. Для достижения чувствительности по крайней мере 3-10~5 Кл/см2 необходимо использовать этот сополимер в качестве верхнего слоя. Затем проводят изотропное ПХТ планаризационного слоя, поэтому эта двухслойная система называется wet-etch ПМ [13; пат. США 4024293] (см. рнс. VIII. 1).
Использование двухслойной системы для коротковолновой УФ-литографии основано на том, что позитивные резисты типа AZ-1350 сильно поглощают в коротковолновой области УФ-спектра и эта область может быть использована как рабочая для резист - иой маски на планаризационном слое ПММА [14]. Систему можно использовать и для электронной литографии [15]. Слой позитивного резиста сначала экспонируют пучком электронов, например, дозой З-КН Кл/см2 при 25 кВ или «обычным» УФ-светом, а после проявления экспонируют целиком коротковолновым УФ-излуче - нием. После сплошного экспонирования проявляют планаризацион - ный слой, на котором слой резиста AZ-1350 может быть сохранен или удален путем подбора проявителя (см. рис. VIII. 1,5,В). Это достигается при использовании в качестве проявителя соответственно толуола или метилизобутилкетона. Рекомендуется удалять возникший на границе фаз слой кислородной плазмой, особенно при экспонировании пучком электронов. Для снятия интерферен
ционных эффектов после экспонирования УФ-светом рекомендуется нагрев.
Халькогенидное стекло GeSe, чувствительность которого повышена серебром, нанесенное на планаризационный органический слой, способно образовывать высококачественную маску для ИХТ [16]. Эта система позволяет достичь высокого разрешения, получить очень четкие края профиля резиста, а следовательно, и высокую точность передачи линий. Принцип системы состоит в вакуумном нанесении на планаризационный слой ПММА толщиной 2,5 мкм слоя Ge—Se толщиной 0,2 мкм. Повышение чувствительности этого слоя достигается введением серебра, что осуществляют сухим способом — напылением Ag или Ag2Se, либо, что предпочтительно, «мокрым» способом — действием раствора KAg(CN) 2 согласно уравнению [17]:
GeSe2 + 4KAg(CN)2 + 8KOH —► 2Ag2Se + K4Ge04 + 8KCN + 4Н20
В процессе экспонирования серебро проникает в слой Ge—Se. С неэкспонированных участков Ag2Se удаляют раствором KI/Kb" образующим растворимый комплекс KAgI2. Стекло Ge—Se с этих участков удаляется раствором NaOH, содержащим ионы S2-. В органическом слое можно затем создавать окна с помощью ИХТ в кислородной плазме, при этом Ge—Se служит маской. При введении Ag в слой Ge—Se в процессе экспонирования повышается оптическая плотность пленки Ag2Se. При этом, как и в случае обычных органических резистов, постепенно увеличивается экспозиция экспонируемых областей. В результате образования градиента концентрации Ag на краях изображения Ag может при засветке из неэкспонированного слоя диффундировать в экспонированные области. Хотя это и может привести к снижению пропускания в результате повышения концентрации Ag, однако в результате улучшается четкость краев, что наблюдается у линий шириной не более 0,5 мкм. Непрозрачность слоя Ag2Se/(Ge—Se) для УФ-света исключает влияние отраженного от рельефной подложки света и, наоборот, пропускание света длиной волны более 500 нм дает возможность легкого оптического контроля совмещения.
Двухслойная полиснлоксановая система, предназначенная для ИХТ, основана на одновременном нспользованнн нескольких положительных свойств по - ливнннлметилсилоксана [2,18]: а) высокой чувствительности D*=2-10~6 Кл/см2 при экспонировании пучком электронов; б) высокой чувствительности при экспонировании светом с длиной волны 220 нм; в) стойкости при ИХТ; г) возможности нанесения этого полимера из раствора на планаризационный резист (обычно AZ-1350 нли AZ-1350J). Ниже указана последовательность операций при использовании двухслойной полнсилоксановой системы: 1) нанесение центрифугированием иа подложку из раствора слоя планарнзацнонного резиста толщиной 2,5—3 мкм; 2) предэкспозицнонная термообработка (200 °С); 3) нанесение центрифугированием из раствора слоя полисилоксана толщиной 0,25—0,3 мкм на слой планаризационного резиста; 4) экспонирование пучком электронов или УФ-светом с длиной волны 220 нм; 5) проявление полисилоксанового слоя растворителем; 6) ИХТ планаризационного слоя. Система позволяет достичь AR = 6. Для этой же цели рекомендован и хлорметилнрованный полидифенил - силоксан [19].
Современные трехслойные системы для ИХТ подобны системам, используемым для взрывной литографии, и пригодны для всех известных способов экспонирования [20]. В качестве маски, стойкой к ИХТ, можно использовать промежуточный слой Si02, нанесенный на планаризационный резист [21]. Маска удовлетворительна для получения рельефов на Si3N4, полисилоксане, фосфорно-кремниевых стеклах и алюминии. В ПМ, пропускающей коротковолновое УФ-излучение, можно вместо Si02 использовать алюминий [22], что, однако, исключает ИХТ. Предложена система фоторезист/АэгЗз/ПММА [23].
В последние годы системы МСР развивались в двух направлениях: создание ПМ для ИХТ (I) и для экспонирования коротковолновым УФ-излучением (II):
|
Число слоев |
2 |
2 |
2 |
3 |
|
Материал маски * |
Ge— Se |
НС |
Сополимер ** |
Si |
|
Назначение ПМ |
II |
II |
II |
I |
|
Литература |
[16] |
[29] |
[28] |
[24, 25] |
|
Число слоев |
3 |
3 |
3 |
3 |
|
Материал маски* |
Ge |
Si3N4 |
Ge—Se |
Si02 |
|
Назначение ПМ |
I |
I |
I, II |
I |
|
Литература |
[25] |
[26] |
[28] |
[27] |
|
* Среднего слоя в 3-слойной системе. ** Полистирол, модифицированный тетратиофульвалеиом. |
Отметим некоторые особенности МСР. Использование кремния в качестве промежуточного слоя имеет ряд преимуществ: работа с ним безопасна и не возникают проблемы с загрязнением подложки; он образует маску, стойкую к ИХТ в кислороде, и непрозрачен при экспонировании в коротковолновой УФ-области, в то время как при 500 нм полностью прозрачен; однако слой кремния может быть легирован для повышения электрической проводимости и ограничения влияния заряда при экспонировании пучком электронов [30].
Если использовать в качестве промежуточного слоя пленку полимера + Si02, то в него можно ввести краситель и тем самым улучшить все показатели процесса [31]. Нанесение полисилоксана центрифугированием [27] позволяет исключить плазменное нанесение слоя Si02, что упрощает технологию.
С целью совершенствования систем МСР для экспонирования коротковолновым УФ-светом стали применять новые лампы низкого давления на основе кадмия, которые дают требуемую область излучения и работают с эффективностью, в 10 раз превышающей эффективность ксеноно-ртутных ламп [28]. Кадмиевая лампа мощностью 100 Вт способна дать 10 % мощности в коротковолновой (200—300 нм) области, причем в отличие от ртутной лампы, не излучает в области 254 нм. Такие кадмиевые лампы позволяют использовать НС для получения ПМ, работающих в этой области спектра.
Другим подходящим источником для сплошного экспонирования в коротковолновой УФ-области являются мощные импульсные
микроволновые ртутные лампы. Эти лампы в коротковолновой УФ-области дают 8-кратную мощность по сравнению с обычными ртутными лампами [28]. В результате специфических геометрических ограничений части лампы, в которой возникает УФ-излучение, можно, однако, использовать только 15 % этой мощности. Микроволновые ртутные лампы дают стабильный световой поток в течение длительного времени (за 500 ч службы мощность снижается лишь на 10 %) и выходят на рабочий режим за 3 с.
Система с использованием полистирола, модифицированного замещенным тетратиофульваленом, в качестве негативного электроиорезиста и ПММА в качестве планаризационного слоя для коротковолновой УФ-области основана на разнице в чувствительности этого полимера (1-10—5 Кл/см2) и ПММА (8-10-5 Кл/см2) [29]. Экспонирование такого полимера, который не образует с. ПММА межфазного подслоя, не оказывает влияния на свойства ПММА. Полученную при проявлении маску можно использовать для экспонирования коротковолновым УФ-светом. Слой этого полимера толщиной 0,3 мкм позволяет работать с AR«2,7.
|
|
Специальной модификацией однослойного резиста можно приблизиться к технологическим решениям, достигаемым с помощью двухслойных систем. Модификация состоит в снижении скорости растворения поверхностного слоя резиста или в использовании резиста с подходящей оптической плотностью и чувствительностью, который способен образовывать рельеф, имеющий профиль, показанный на
Рис. VIII. 3. Схематическое изображение профиля позитивного резиста AZ, экстрагированного хлорбензолом, с уширенным поверхностным слоем [уширеиие =(г—У )/2].
рис. VIII. 3. В первой системе используется обычный хинон - диазидный позитивный резист, который перед или после экспонирования смачивают хлорбензолом так, чтобы глубина проникновения (Ь—а) составляла 0,3 мкм при общей толщине слоя (b) 1 мкм [32, пат. США 4212935; яп. заявка 58—145133]. Экстракция низкомолекулярных компонентов НС хлорбензолом снижает скорость растворения поверхностного слоя резиста при проявлении и образованный профиль (см. рис. VIII. 3) можно затем использовать во взрывной литографии. Если слой резиста толщиной около 0,3 мкм достаточен в качестве маски для сухого травления, можно провести анизотропное сухое травление подложки или взрывную литографию [33]. В другой системе используется негативный резист MRS, содержащий одновременно компоненты, чувствительные в коротковолновой и средневолновой областях УФ - спектра [34], причем его чувствительность и поглощение выше в области коротковолнового УФ-излучения. У этого резиста из-за малой глубины проникновения коротковолнового УФ-света дости
гается высокое разрешение в поверхностной части слоя; излучение же с большей длиной волны проникает в нижние слои и обеспечивает достаточно высокое значение AR. В результате создается профиль рельефа, как и в предыдущей системе с хлорбензолом.
Тщательное изучение планаризационного слоя с использованием механического глубиномера показало, что наибольший собственно планаризационный эффект наблюдается при использовании ПММА с ММ около 33000 [2]. Поскольку контрастность ПММА как позитивного резиста повышается с ростом его ММ, это необходимо учитывать при выборе ММ планаризационного резиста.
В результате использования тонких слоев чувствительного резиста с целью получения более точного переноса изображения система МСР оказывается более уязвимой по критерию пористости. Для определения числа пор проводят следующие операции. В производстве МДП-транзисторов наносят на проводник пленку SiC>2 толщиной 35 нм и создают МСР в соответствии с полной технологической схемой, за исключением экспонирования. Диоксид кремния затем травят в местах дефектов мокрым или сухим (плазма CF4) способом. После этого резист удаляют, а на поверхность Si02 наносят кружки алюминия диаметром 0,8 мм, подавая на них последовательно напряжение 1,5—3,0 В на 1 см. В качестве меры пористости используют отношение общего числа замыканий к общей площади алюминиевых кружков. Этот метод может быть использован для оценки вклада каждой технологической операции в создание пористости. Оказалось, что пористость обусловлена дефектами в слое чувствительного резиста AZ, но не дефектами в планаризационном слое ПММА [2]. При использовании органоси - локсанов в качестве промежуточного слоя пористость составила 3 см-2, которая столь мала, что не оказывает влияния на последующие технологические процессы.
Важной проблемой системы МСР является возникновение меж - фазного подслоя (вуали) между планаризационным и чувствительным слоями в двухслойной системе и между промежуточным поли - силоксановым слоем и планаризационным слоем, а также чувствительным слоем в трехслойной системе.
В системе AZ/ПММА возникновение межфазного подслоя является диффузионным процессом, который усиливается с повышением температуры предэкспозиционной термообработки и концентрации резиста при постоянной частоте вращения центрифуги в операции формирования слоев. С ростом скорости центрифугирования толщина межфазного слоя уменьшается. Опытным путем сначала выбирают оптимальную температуру предэкспозиционной термообработки, а потом концентрацию резиста и частоту вращения центрифуги. Оптимизация проявителя состоит в использовании растворителя, который при проявлении планаризационного слоя одновременно немного растворяет и рельефный слой. При этом может быть обеспечено удаление межфазного подслоя. Планаризационный слой должен быть перед нанесением полисилоксана предварительно отвержден при 200°С так же, как и полисилоксановый слой перед нанесением слоя чувствительного резиста с тем, чтобы избежать межфазного смешения и растрескивания силоксанового слоя.
При сухом травлении на поверхности подложки могут оседать остатки электродов. Чтобы избежать этого, кроме поддержания абсолютной чистоты камеры для травления резиста или проведения травления подложки и резиста в разных камерах, можно покрывать все экспонированные проводящие поверхности на подложке диэлектриком, например фоторезистом. Удаление осадков проводят ополаскиванием подложек в растворителе и слабым мокрым травлением с последующим ополаскиванием.
Вместо жидкостного проявления рекомендуется применять сухой процесс — создавать на полисилоксане после его экспонирования пучком электронов резистный рельеф в результате полимеризации мономера из газовой фазы на активированных участках [35].
Причиной ряда дефектов может быть возникновение напряжений в разных слоях, что проявляется прежде всего у трехслойных систем, содержащих промежуточный слой; с этой точки зрения особенно невыгоден слой Ti.
Удовлетворительные результаты при использовании МСР достигаются лишь в случае хорошего совмещения. При сплошном коротковолновом УФ-экспонировании чувствительный резист должен проявлять высокую поглощающую способность, что необходимо для достижения высокого контраста, и одновременно быть прозрачным для света, предназначенного для контроля совмещения. С этой точки зрения вполне удовлетворительными являются резисты, содержащие в качестве полимерной основы кремнийорга - нические полимеры или НС, непрозрачные для коротковолнового УФ-света, но прозрачные для света с большей длиной волны. Удовлетворительной является также и система Ge—Se [1].
Контроль полученного изображения в слое чувствительного резиста при экспонировании с помощью видимого света затруднен из-за малой толщины слоя и его прозрачности. Для измерения ширины линий при помощи электронно-оптических приборов необходима высокая контрастность и толщина линий. Поэтому применять эти приборы для контроля изображений не удается. Вообще оптимальная методика контроля до сих пор не разработана. Для определения параметров проявления планаризационного резиста можно, однако, использовать типовые приемы, способные регистрировать окончание процесса проявления. Так, для системы МСР применяют методику определения конца проявления слоя резиста в крайней точке, экспонированного дозой, двойной по сравнению с оптимальной (Double Exposure End Point Detection, DEEPDET) [36].
Удаление органических слоев всех типов после травления подложки можно проводить в кислородной плазме при условии, что поверхность слоя резиста не была сильно модифицирована введением ионов при травлении. В противном случае лучше применять кислотную смесь (H2S04—HNO3).
Создание рельефов субмикронных размеров приведет к услож
нению всего литографического процесса, к увеличению числа технологических операций и к повышению требований к резистам и приборам. Преимуществом однослойных систем является прежде всего простота процесса, состоящего из 4 операций, включая проявление. Даже при использовании хлорбензола в качестве ингибитора растворения поверхностного слоя резиста добавляется всего две операции. Для двухслойных систем с мокрым проявлением или ИХТ необходимо уже 7 технологических операций, система Ge—Se требует 8 операций. Достоинством модифицированных однослойных систем является возможность достижения хорошего разрешения и высокого AR при использовании обычного экспозиционного устройства.
Поскольку выбор материалов для однослойной системы существенно ограничен взаимоисключающими требованиями, дальнейшее улучшение чувствительности этих систем будет зависеть от создания новых материалов. Ограничение влияния стоячей волны при фотолитографии, эффекта близости в электронной литографии, косого профиля в рентгеновской литографии или малого пробега ионов в ионной литографии возможно только при использовании МСР [29]. Наиболее перспективными представляются двухслойные системы, хотя трехслойные системы и более универсальны, до сих пор неизвестно, будут ли высокие затраты на их создание окупаться стоимостью конечных изделий.
Недавно созданный при помощи так называемой методики CEL (Contrast Enhanced Litography) МСР дает возможность распространить фотолитографию на создание элементов субмикронных размеров. При этом методе для повышения контрастности промышленных позитивных резистов используется снижение пороговой светочувствительности Snop, что достигается нанесением на позитивный резист тонкой пленки (около 0,2 мкм), содержащей вещество, поглощающее в области экспонирующего света (~436 мкм).
При экспонировании происходит постепенное повышение прозрачности пленки и за обычное время слой резиста экспонируется главным образом в середине прозрачного участка шаблона, а на краях этого участка слой резиста не получает дозы, отвечающей Snop (см. рис. 1.8). Результатом является резкое сужение линий образованного рельефа до предела, определяемого длиной волны света. Использование третьего противоореольного слоя между подложкой и резистом дает возможность применять эту систему и на отражающих подложках. Увеличение числа технологических операций и в некоторой мере длительности экспонирования компенсируется возможностью изготовления рельефа с разрешением 0,45 мкм на промышленных фоторезистах с применением обычных проекционных устройств без существенных дополнительных капиталовложений. Этот метод в ближайшее время предполагают внедрить в технологическую практику, его разработка является доказательством того, что еще не в полной мере использованы возможности фотолитографии [37].
В настоящее время наиболее широко изготовляются и применяются составы (табл. 1—5), которые в основном обеспечивают запросы полупроводникового приборостроения и полиграфии [I—5]. Область их применения не исчерпывает потенциальных возможностей состава. Приведенные ниже параметры отвечают усредненным показателям прн их традиционном использовании.
Негативные фоторезисты, выпускаемые в СССР (см. табл. 2), относятся к азидсодержащим (например, ФН-11, ФН-ИК» ПЦГД), циииаматиым (например, ФН-5ТК», фотопо- лимериым (ФПС). Кроме того разработаны и другие материалы, например, фстополимер - иые составы «Фотосет» или отличающийся великолепными фототехническими параметрами ФСН [6],. Найденные коистаиты фотолиза и термолиза ФН-Ii и ФН-5ТК позволяют оптимизировать их применение [7]. Резисты ФН-II, ФН-ПК имеют большую разрешающую способность по сравнению с фоторезистом ФН-5ТК и устойчивы в кислотах и щелочах.
Негативные фоторезисты чехословацкого производства приведены в табл. 3. Композиция SCR-3.I подходит для слоев толщиной 3—5 мкм и репродукции элементов размером более 20 мкм, может использоваться для образования рельефных элементов иа металлической фольге. Композиция SCR-3,2 подходит для получения слоев толщиной 1,5—3 мкм, разрешающая способность 10—30 мкм, может наноситься окунанием. Резист SCR-3,3 разработай для образования субмикроииых элементов с четырьмя краями в слоях толщиной 0,3—1,5 мкм, специально очищен от механических примесей. Резист SCR-3,4 пригоден для травления Si02, оптимальная толщина слоя 0,8—1 мкм. Резист SCR-7,1 тщательно очищен, имеет минимальную зольность, рекомендуется для создания полупроводников, особенно иа кремнии. Композиция SCR-7,Ip создана специально для травления кремния в производстве мощных транзисторов, подходит для травления до глубины 50 мкм, устойчива в агрессивных травильных растворах; оптимальная толщина слоя 6—8 мкм. Резист SCR-7,2 тщательно очищен, имеет минимальную зольность, пригоден для быстрого травления алюминия горячей концеитрироваииой фосфорной кислотой и далее для травления Si02. Резист SCR-7f3 имеет повышенную адгезию в толстых слоях, стабилизирован для долговременной обработки в кислородной атмосфере, допускает иаиесение окунанием; можно проявлять в парах трихлорэтилеиа, подходит для травления подложки иа большую глубину. Фоторезисты следует хранить в темной стеклянной посуде при Ю—20 °С. После нанесения слой резиста 5—10 мни сушат прн комнатной температуре, а затем 10—30 мин при 60—80 °С. До - отверждеиие проводят при 80—150 °С в зависимости от агрессивности используемого тра - вителя.
Из позитивных резистов композиция SCR-5 отличается высокой разрешающей способностью; используется в микроэлектронике; разводится в отношении 1 : . Композиция SCR-9 рекомендуется для серийного производства многослойных печатных плат с металлизированными отверстиями; оптимальная толщина 5—10 мкм; наносится поливом, большая вязкость резиста предотвращает затекание в отверстия. Резист SCR-П отличается хорошей адгезией к металлическим поверхностям, рекомендуется для образований элементов с размерами в полупроводниковой технологии при травлении А1, Сг и Si02 порядка 1 мкм; оптимальная толщина слоя 1—2 мкм; проявляется в проявителе для SCR-9, разведенном деионизованной водой в отношении I ; 4.
Один из выпускаемых в США негативных фоторезистов (табл. 4) KPR (Kodak Photoresist) производится нескольких типов для получения пленок различной толщины, первоначально предназначался для полиграфии, может использоваться в производстве печатных плат. KPR и KPR-2 подходят для создания тонких слоев, KPR-3 —для травления относительно толстых слоев. Резист KPL (Kodak Photosensitive Lacquer) применяется аналогично KPR, но имеет в 4 раза большее содержание сухого вещества и растворим в значительно более летучих растворителях; дает более толстые пленки, применим для травления толстых слоев. Резист KOR (Kodak Ortho Resist) предназначен для ускоренного экспонирования, отличается повышенной светочувствительностью к зеленой части спектра. Композиция KMER (Kodak Metal-etch Resist) рекомендуется для тонких слоев; характеризуется высокой разрешающей способностью; различные марки имеют несколько отличающиеся состав и чистоту; Предназначается для глубокого травления оксидов и металлов, таких как Мо, Та, Ni, Сг, А1, Си и нержавеющая сталь; отличается стойкостью к действию большинства травителей. Резист KTFR (Kodak Thin Film Resist) обладает очень хорошей адгезией к металлическим н оксидным слоям; устойчив к кислотам с сильным окисляющим действием и щелочным растворам. Microneg — исключительно чистый фоторезист (фильтрован через поры 0,5 мкм), производимый в нескольких вариантах, различающихся по вязкости; равномерная толщина слоя достигается иаиесеииём центрифугированием при 4000—7000 об/мии; сушат при 70—90 °С в течение 10—20 мин. Резист Waycoat 1C подобен резисту KTFR, перед иаиесеиием фильтруется через поры 0,5 мкм. Micro-Image Isopoly дает очень хорошее разрешение, разбавлением можно изменять вязкость в пределах от 10 до 500 мПа с; максимальный размер твердых частиц 0,2 мкм; влияние кислорода до некоторой степени подавлено.
Одни из выпускаемых в США позитивных фоторезистов (табл. 5) AZ-I350 подходит для создания рельефов с тонкими линиями в тонких слоях. AZ-I350H подобен AZ-I350, но имеет более высокое содержание сухого вещества и дает более толстые слои; пригоден для создания рельефа с элементами 2,5 мкм, рельеф отличается минимальным подтравли - ваиием. Резист Micro-Image Isofine и растворы для его обработки фильтрованы через поры 0,2 мкм, при проекционной технике — до 2 мкм; имеет хорошую адгезию к SICfe, Ai, Сг, Си и другим металлам; устойчив к травителям. Резист Microline, PR-102 перед иаиесеиием фильтруется через поры 0,25 мкм; пригоден для создания рельефов с размерами элементов 2,5 мкм.
Фоторезисты серий AZ-1300, AZ-I400, AZ-100, AZ-300 предназначены главным образом для стандартной фотолитографии в УФ-области 360—450 нм, причем типы AZ-1300 особенно подходят для производства полупроводниковых интегральных схем и солнечных батарей. Тип AZ-111 кроме производства полупроводников используется для изготовления печатных форм. Типы AZ-1400 особенно подходят для производства шаблонов и видеодисков
[1] Этим вопросам посвящена недавно вышедшая книга В. К. Грищенко, А. Ф. Маслюка, С. С. Гудзера «Жидкие фотополимеризующиеся композиции» (Киев: Наукова думка, 1985).
[2] AR (aspects ratio) — отношение толщины линий к ширине в наиболее разрешенных участках рельефа — количественная характеристика резиста.
[3] Фитовая кислота—гексафосфат инозитола С6Н6 [ОРО (ОН)2] е.
[4]|Ph2CO + (СНзЬСНОН—*-Ph2COH + (СНзЬСОН
Ph2COH + Ph2I+ —► Ph2C_OH + Ph2I •
(CH3)2COH + Ph2I+ —(СНзЬСОН + Ph2b
Ph2I Phi + Ph •
Ph - + (CN3)2CHOH —»- (СНзЬСОН + PhH
Ph2COH —v Ph2CO + H+
(CH3)2COH —*■ (CH3)2CO + H+

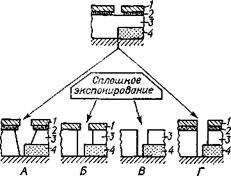
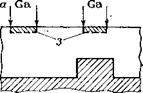


 Опубликовано в
Опубликовано в