Механизмы люминесценции в слаболегированном материале
 16 марта, 2014
16 марта, 2014  admin
admin В разд. 3.3.3 и 3.3.4 мы рассмотрели механизмы электролюминесценции в светодиодах из GaAs и выяснили, что эти механизмы могут быть тесно связаны с процессами электрической инжекции в сильнолегированных р — /г-переходах. Интересно также рассмотреть механизмы излучательной рекомбинации в слаболегированных прямозонных полупроводниках, подобных арсениду галлия. В этом случае инжекцию неосновных носителей удобно осуществить фотовозбуждением.
Довольно трудно идентифицировать однозначно механизмы фотолюминесценции в GaAs, при которых испускается излучение с энергией фотонов, близкой к ширине запрещенной зоны, потому что большая часть ранних работ была выполнена на материале, легированном до концентраций ~ 101S см-3 или даже больше (предельная чистота, которую тогда можно было получить). При этих концентрациях острые спектральные линии, соответствующие слабосвязанным экситонам, не могут появиться в спектре из-за плазменного экранирования [202]. Для возникновения люминесценции связанных экситонов необходимо выполнение следующего неравенства для концентрации свободных носителей п:
|
(3.28) |
п < 3/4 ла3г3,
где а — радиус связанного состояния, rs — критический параметр, принимающий значение ~5 для полного экранирования свободного экситона в CdS [208]. При этих условиях длина экранирования (разд. 3.2.9) сравнима с радиусом а.
Переход Мотта для газа из носителей одного типа наступает при rs fa 2,5, а для изотропной электронно-дырочной плазмы — при m*e = m*h rs«?10 [209]. Для неводородоподобных состояний, требующих больших поправок положительной центральной ячейки, rs меньше, по-видимому, потому, что по сравнению с водородоподобным центром в этом случае большая доля общего заряда заключена внутри сферы с заданным радиусом [209а].
Из неравенства (3.28) следует, что свободные экситоны и нейтральные доноры становятся в GaAs нестабильными при п Ю16 см-3. Некоторые из линий, обусловленных связанными экситонами с малыми энергиями локализации ~ 1 мэВ, являются еще более чувствительными к увеличению концентрации. Многие экситонные линии не могут быть удовлетворительно раз - ' решены до тех пор, пока концентрация электрически активных примесей не снижена до значений <;1016 см-3 (рис. 3.39). При такой концентрации в спектрах фотовозбуждения доноров в дальней инфракрасной области становится хорошо разрешимым первое возбужденное состояние мелких доноров (£д= 1,45 мэВ) [214, 215].
Первые попытки определения химической природы донорных уровней с помощью спектроскопии в дальней инфракрасной области оказались не слишком успешными из-за того, что материал, используемый в ранних исследованиях, был недостаточно легирован [210а]. Позже была успешно идентифицирована структура уровней, связанных с донорными примесями: Si, Sn и Se. Было установлено, что изменения энергии ионизации, связанные с химической природой донора, лежат в пределах 1 см-1 (~0,1 мэВ) [214, 215]. Линия Х, связанная с донорами и преобладающая в спектрах слоев, выращенных в таких условиях, при которых предотвращается введение Si [215], обусловлена, вероятно, центром SAs с Ed fa 5,79 мэВ. Сильный узкий дублет, обозначенный (4Л)2п (рис. 3.39) часто является доминирующим в примесной области спектров краевого поглощения и спектров фотолюминесценции GaAs (и очень сходного с ним полупроводника типа АП|ВУ — ІпР). Он связан с рекомбинацией экситона на нейтральных акцепторах. Расщепление обычно объясняют обменным взаимодействием, происхождение которого связано с двумя способами соединения дырок в связанном экситонном комплексе, хотя прямого экспериментального доказательства' этого и не получено [216, 218].
На основании выполненных магнитооптических измерений сделано предположение, что в ІпР и GaAs этот дублет связан
|
|
|
Знергия фотона,. зВ |
|
Рис. 3.39. Низкотемпературная фотолюминесценция слаболегированного GaAs [210]. Видна рекомбинация экситонов на нейтральных акцепторах (4А), нейтральных - (AD) и ионизированных донорах (3D), которая преобладает в краевой люминесценции материалов р - и я*типа соответственно. В работе [211] приводятся спектры с лучшим разрешением на более слаболегироваииом GaAs. В GaAs и InP, полученных методом газовой эпитаксии, доминирующим остаточным акцептором всегда оказывается Zn [212, 219а], тогда как в не - легированиом GaAs, полученном методом жидкостной эпитаксии, доминирующее положение занимают С н Si, a Zn, не заметен [219а] (рис. 3.30). |
|
Длина Волны, А |
с электронно-дырочным обменным взаимодействием, ведущим к расщеплению [219]. Дырочно-дырочное обменное расщепление должно бы быть значительно больше, и соответствующая линия, относящаяся к связанному экситону, как утверждалось, представляет собой слабую особенность в области больших энергий (эта линия помечена прямой скобкой на рис. 3.39)’. Энергии бесфононных линий, относящихся к связанному экситону и мелким акцепторам в GaAs (табл. 3.2) и InP [212], в отличие от GaP [56] и Si [51] не очень чувствительны к изменениям энергии ионизации акцепторов. Таким образом, эти линии лишь частично можно использовать для химического анализа примесей. Однако спутники этих экситонных линий ясно видны при концентрациях ^<;1015 см-3. Они обусловлены рекомбина-( цией экситонов, в результате которой акцептор переходит в мелкое возбужденное s-состояние. Эти переходы с участием двух дырок полностью аналогичны переходам с участием двух элек-
|
1 1 Г" |
і і |
Г III 1 □ а |
Till Mg |
T Г I 1—1 II |
|
II |
D I |
Zn |
II |
|
|
0 II |
Cd |
n |
||
|
ai |
С |
в |
||
|
□ I |
St |
Й |
||
|
0 1 |
Ge |
1 |
||
|
□ 5 |
□ і |
Ql |
LPE |
- II |
|
і і і |
і і |
0 и 1 і і I I |
УРЕ I l I I |
II 1 1 1 1 1 |
|
і ї ї № |
1 1 |
і і і і i 1,49 |
і і і і 1,50 |
1 1 1 1 1 1,51 эВ |
I Спектр с участием связанных экситонов (1,5Кj □ Пик для перехода из сВоіїодноео 6 сВязанное состояние ($к)
Рис. 3.40. Схематическое изображение особенностей краевой люминесценции очищенного GaAs, нелегированного (нижние два ряда) или соответствующим образом леги^Ьванного малыми концентрациями акцепторов [219, 220а, 256а].
Справа расположены дублеты линий, соответствующих бесфононной рекомбинации экситонов, связанных с этими акцепторами; эти линии имеют слева повторения, возникающие в результате процесса, при котором нейтральный акцептор остается в возбужденном состоянии, соответствующем мелкому уровню (2Sa/2). Энергии смещения дублета зависят от энергий возбужденных состояний акцепторов — 2Sj/2). Они изменяются почти на
весь интервал сдвига, который связан с химической природой различных акцепторов и который проявляется в изменении энергии основного ISiy - состояния. Поэтому прямоугольники сдвигаются влево по энергиям. Прямоугольники обозначают полосы люминесценции, возникающей при рекомбинации свободных электронов на мелких акцепторах, Точная форма спектров для иелегироваииого очищенного GaAs зависит от конкретных условий роста (поэтому она различна для разных лабораторий-изготовителей). Тем не менее четкое различие между основными загрязняющими материал акцепторами при жидкостной (LPE) и газовой (VPE) эпитаксии оказывается довольно общим свойством, н его можно интерпретировать в рамках соответствующих термохимических представлений.
тронов, которые описаны в разд. 3.2.3 для GaP и которые также видны как спутники линий (4D), относящихся к связанному эк - ситону в GaAs и ІпР [220]. Энергии, на которые смещаются эти спутники (рис. 3.40) — «двухдырочные» сдвиги, — очень чувствительны к изменениям энергии ионизации акцепторов, хотя сдвиги, связанные с химической природой, для возбужденных 2S»/, - состояний по отношению к соответствующим сдвигам основных lSs/j-состояний больше, чем предсказывает теория.
Линии спектра вблизи 1,5152 эВ на рис. 3.39, безусловно, относятся к излучательной рекомбинации свободных экситонов [213]. В работах [221, 222] обсуждается влияние пространственной дисперсии, поляритонных и интерференционных эффектов на поверхностных барьерах Шоттки на точный вид спектров фотолюминесценции и спектров отражения в области энергий,
близких к энергии основного экситона в GaAs и InP. Неясным остается вопрос, связана ли слабая структура спектров фотолюминесценции с влиянием переходов с верхней и нижней поля - ритонных ветвей, или это проявление внутреннего перепоглоще - ния люминесценции сильной узкой линией, обусловленной основным состоянием свободного экситона [221а]. Спектральную линию, связанную со свободным экситоном, лучше всего получить из измерения оптического поглощения слоев толщиной ~ 1 мкм.
Техника этого довольно трудного эксперимента была существенно развита в последнее время. Были найдены селективные травители для GaAs-подложки, которая поддерживает структуру GaAlAs — GaAs — GaAlAs, выращенную методом жидкостной эпитаксии. Травлением получались круглые окна [222в]. Спектры поглощения измерялись вплоть до 2,2 эВ при 2 и 298 К. Вновь полученная ширина запрещенной зоны при 298 К равна 1,424 + 0,001 эВ. Линия свободного экситона слегка расщеплена и сдвинута вследствие изотропного растягивающего механического напряжения, связанного с различием коэффициентов теплового сжатия GaAs и GaAlAs [371]. Дополнительных малых сдвигов, связанных с переносом — 1 % * А1 внутрь слоя GaAs, полученного методом жидкостной эпитаксии, можно избежать, если ту же структуру вырастить методом молекулярной эпитаксии [2226]. Верхнее покрытие из слоев GaAlAs дает возможность легко установить соотношение между процессами фотолюминесценции и оптического поглощения по формулам детального равновесия (разд. 3.1.1) и вычислить верхний предел скорости рекомбинации на границе слоев GaAs — Alo. sGao. sAs, равный 5-Ю4 см/с при 298 К - Соответствующее значение скорости поверхностной рекомбинации на свободной поверхности GaAs составляет ~ 107 см/с. Диффузионная длина в GaAs при 298 К при Nd — Nk = 1016 см-3 равна по крайней мере 2,5 мкм (максимальное значение определяется излучательной рекомбинацией). Равновесная скорость рекомбинации = 4,5 -103 см/с [выражение (3.8)], а излучательная постоянная В= 1,4 х X 10~9 см3/с. Свободный экситон может быть обнаружен по зависимости высокочастотной диэлектрической проницаемости GaAs [222г] и AlxGaj_xAs [222д] от энергии, а также по спектрам возбуждения люминесценции [222е].
Ключ к пониманию происхождения сильной линии, обозначенной (4D) (рис. 3.39), дают наблюдения ее спутников, которые имеют подобную форму, а также слабых линий, соответствующих большим энергиям, которые обозначены на рис. 3.39 вопросительным знаком. Спутники смещены к меньшим энергиям на ~4,4 мэВ [220]. По поведению этих линий-спутников в магнитном поле можно установить, что онц связаны с переходами с донорных возбужденных уровней 2S или 2Р, характерных для GaAs. Таким образом, эти спутники появляются в результате «двухэлектронных» переходов; это означает, что основные линии, с которыми они связаны, появляются вследствие рекомбинации экситонов, локализованных на нейтральных донорах. Однако при этом остается неясным, почему промежутки между основными линиями значительно больше тех, которые следует ожидать на основании известных разностей энергий ионизации, связанных с химической природой основных доноров в GaAs [214, 215]. Некоторые авторы предполагают, исходя из результатов магнитооптических измерений, что даже сильная линия (4D) связана с дефектом симметрии, более низкой, чем Та- Другие утверждают [219], что линии (4D) ведут себя так, как будто они связаны с точечным дефектом (по крайней мере в ІпР), хотя полученные при этом значения g этому не соответствуют. Уайт, Дин и Дэй [219] предполагают, что линии, помеченные вопросительным знаком на рис. 3.39, связаны скорее с возбужденными состояниями системы экситон —■ нейтральный донор, чем с химически различными донорными центрами. Точно природа более широкой линии, обозначенной (3D), остается пока неясной. На основании формы линии и ее поведения можно предположить, что она обусловлена главным образом рекомбинацией свободных дырок на нейтральных донорах [222а], хотя, возможно, в наиболее чистых кристаллах и в сильных магнитных полях в нее может давать вклад рекомбинация экситонов, связанных с ионизированными донорами.
В теоретической работе [223] указывается, что электростатические поля заряженных доноров и акцепторов играют важную роль в уширении линий люминесценций, связанных с «диффузными» экситонными состояниями, а также с диффузными одночастичными состояниями, которые проявляются в спектрах фотовозбуждения доноров, снятых в дальней инфракрасной области [224а]. Этот механизм приводит к сужению линий спектров фотовозбуждения при одновременном освещении образца светом с энергиями квантов, большими ширины запрещенной зоны [2246]. Уширение линий, связанных со свободными экси - тонами, вызывается главным образом примесным рассеянием, а не флуктуациями дальнодействующего электрического поля [223а]. Смещение линий происходит вследствие экранирования кулоновского взаимодействия, и оно одинаково как для свободных, так и для связанных экситонов. По-видимому, этот эффект слабее, чем был предсказан в одной из ранних работ.
Сдвиг на 2 мэВ в спектрах CdS происходит при концентрациях свободных носителей 3-Ю17 см-3 [223а]. Полагают, что эти хаотические штарковские поля дают существенный (возможно, основной) вклад в процесс перехода к проводимости металлического типа, которая наблюдается при более высоких концентрациях примеси [выражение (3.28) [223]]. В этом случае донорные состояния принимают вид хвоста нелокализованных состояний зоны проводимости (разд. 3.3.1) и в оптическом спектре уже нет дискретной структуры, связанной с примесями. Было, однако, показано, что простирающийся в область меньших энергий хвост люминесценции (обусловленной связанным эксито- ном), который появляется в результате случайных штарковских полей [223], соответствующим образом отражается в линии поглощения. Отсюда следует, что основной вклад в эту асимметрию дает рамановское рассеяние, в котором участвуют делока - лизованные электроны (описываемое так же, как оже-процесс [223а]).
Вблизи 1,49 эВ в спектрах низкотемпературной люминесценции видна полоса, в которой заметны слабые повторения продольным оптическим фононом. Тонкая структура в этой полосе была видна в спектрах образцов с концентрацией примесей '<С1015 см-3, и считалось, что резкая компонента в этой структуре обусловлена рекомбинацией экситонов, связанных с ионизированным акцептором [216, 217]. Однако приходится сомневаться, что такие комплексы в GaAs стабильны, поскольку из аналогии связей в экситоне с атомными связями следует, что отношение Отд/m* должно быть ^<0,7 [28], тогда как в действительности это отношение для GaAs составляет ~7! Предположения о том, что имеются два не связанных между собой отношения эффективных масс, которым могут соответствовать разные условия связи [226], также подвергались сомнению в работе [227].
Вероятно, появление этой группы дополнительных линий обусловлено присутствием посторонних линий [возможно, «двухдырочных» спутников, которые были рассмотрены выше (рис. 3.40)]. Важными, характерными для этого спектрального диапазона являются широкие полосы, объединенные в пары, с расстоянием между максимумами, равным ~3 мэВ. Соотношения интенсивностей этих полос сильно зависят, как и в случае хорошо известной краевой люминесценции полупроводниковых соединений типа A"BVI, от температуры [225, 32а]; аналогична и интерпретация зависимости. Полоса, соответствующая большим энергиям кванта, в каждой паре связана с излучательной рекомбинацией свободных экситонов на мелких нейтральных акцепторах (разд. 3.2.2) [229] (в GaAs обычно EAIED « 5, так что акцепторы остаются в основном неионизованными в той температурной области, где доноры начинают терять свои электроны и выбрасывать их в зону проводимости). Излучательная рекомбинация электронов, находящихся на донорах, и рекомбинация дырок, находящихся на далеких акцепторах, дают полосу люминесценции в каждой паре, соответствующую меньшим энергиям. Форма полосы, связанной с рекомбинацией на донорно- акцепторных парах (разд. 3.2.1), зависит от ряда факторов: уровня легирования, степени компенсации, скорости оптической накачки и температуры [32а]. Поэтому трудно сопоставить широкую спектральную полосу, связанную с неразрешенными переходами на далеких парах, с простым соотношением (3.12) для того, чтобы получить точное значение Ед + ED. Из этой суммы можно было бы получить ЕА, поскольку Ев в GaAs практически не зависит от вида донора. Для того чтобы получить непосредственно значение Ел, лучше анализировать полосу люминесценции, появляющуюся в результате переходов из свободного состояния в связанное, с помощью уравнения (3.16).
Таким путем были обнаружены наиболее важные мелкие акцепторы в GaAs (рис. 3.40) [219а] и в ІпР, полученном методом газовой эпитаксии [212]. Существенным результатом этих работ является выявление четких различий между материалом, полученным методом газовой эпитаксии, и материалом, полученным методом жидкостной эпитаксии. Единственным важным мелким акцептором в GaAs и ІпР, полученных газовой эпитаксией при обычных условиях роста, является Zn, замещающий узлы решетки атомов III группы. В GaAs, полученном методом жидкостной эпитаксии, преобладают акцепторы IV группы, причем обычно концентрации их находятся в следующем соотношении: [С] > [Si] > [Ge]; акцепторная примесь Ge часто, a Zn обычно всегда отсутствует. Несмотря на эти четко выявленные закономерности, имеются доказательства того, что акцептором, который определяет компенсацию GaAs гс-типа, полученного методом газовой эпитаксии в реакторе из плавленого кварца, не является ZnGa [220а].
Информация, полученная из полос люминесценции, обусловленных переходами из свободного состояния в связанное, была подтверждена и уточнена с помощью спектральных полос, обусловленных переходами с участием двух дырок (табл. 3.2). В результате стала более ясной природа наиболее важных акцепторов, неизбежно присутствующих в материалах, изготовленных различными методами. Методику фотолюминесценции теперь можно с большой пользой применить для анализа GaAs, легированного до уровня, необходимого для микроволновых устройств (<<;1016 см-3), а также для анализа гетероструктур светодиодов с нелегированными активными областями [549в]. Однако в GaAs, легированном до уровня, типичного для светодиодов, концентрация составляет обычно ~1018 см-3 (больше, чем в непрямозонных полупроводниках типа GaP) и даже акцепторы неотличимы друг от друга. Форма линии люминесценции, связанной с переходами из свободных состояний в связанные,
|
—і— ----------------------------- 1------------------------------ j_____________________ ' },Ш2 x f,4937 1,4892 1,4847 , Энергия сротона, эВ Рис. 3.41. Спектры излучения слаболегированного (л « 1015 см-3)' GaAs при 1,6 К, полученные с разрешением во времени [230]. С увеличением времени задержки вндны сдвиг в область меньших энергий и небольшое сужение-полосы, лежащей вблизи 1,49 эВ. Это связано с участием в рекомбинации до- иорно-акцепторных пар. |
подробно проанализирована для случая GaAs p-типа с концентрацией дырок 1015 см-3; при Т ^ 20 К линия люминесценции видна отчетливо, поскольку отсутствовала линия, составляющая с ней дублет [229]. Форма указанной полосы соответствует той, которую следует ожидать для случая переходов из свободного состояния в связанное, на акцепторы в невырожденном материале
R (hv) « (hv - Eg + Еа)'!exp [~(hv-Eg + EA)/kBT. (3.29)
To, что полоса в спектрах краебой фотолюминесценции GaAs, расположенная в каждом дублете со стороны меньших энергий, связана с рекомбинацией на донорно-акцепторных парах, было четко установлено при изучении релаксации спектров во времени. На рис. 3.41 показано, что эти полосы слегка сужаются и
|
Рис. 3.42. Спектры фотолюминесценции GaAs при 300 К [11]. Уровни легирования типичны для светодиодов из GaAs. Кривая а соответствует [р] — “ 10*9 см—3, кривая б — М •* б'Ю" см — |
сдвигаются в сторону меньших энергий с увеличением интервала времени между импульсным возбуждением и временем регистрации спектра [230]. Было показано, что эти полосы монотонно смещаются в область больших энергий при увеличении температуры [231] и интенсивности возбуждения [232]. Релаксация этих полос во времени — процесс медленный и неэкспоненциальный; он ускоряется при увеличении концентрации примесей [230] в противоположность поведению краевой люминесценции при ~ 1,51 эВ.
Дингл [230] показал, что рассматриваемые явления можно количественно описать с помощью выражений для электроннодырочной рекомбинации на удаленных донорно-акцепторных парах [29], причем Е0 ~ 6,5 мэВ, а ЕА « 28,5 мэВ. Аналогично ведут себя расположенные рядом спектральные полосы, из которых одна соответствует энергии ~1,48 эВ и связана скорее с акцептором Ge, нежели с Si или Zn [219а, 230]. В спектрах GaAs не было найдено никаких следов дискретных линий, связанных с переходами на близких дискретных донорно-акцепторных парах, что отличает их от спектров GaP и прямозонных полупроводников типа A"BVI: ZnSe [233] и CdS [234]. Это, вероятно, связано с тем, что в очень слабо легированных кристаллах мало близких пар, для которых наблюдаются хорошо выраженные релаксационные характеристики, типичные для рекомбинации на донорно-акцепторных парах; в то же время переходы на далеких парах насыщаются с трудом, потому что полупроводник прямозонный и волновая функция донора в GaAs (по сравнению с CdS) очень слабо локализована.
• Из исследований релаксации люминесценции следует, что спад полосы 1,49 эВ аналогичен спаду полосы свободных эк си - тонов (1,51 эВ); обе полосы расширяются при концентрации выше 5-Ю16 см-3. В светодиодах из GaAs при обычных концентрациях доноров Nd — Na 1018 см-3 и при повышенных температурах переходы на парах и переходы _из свободного в связанное состояние неразличимы вследствие делокализации электронов [выражение (3.28)]. Остается выяснить вопрос, является ли концентрация носителей достаточно высокой, а плотность состояний на хвосте достаточно низкой, чтобы квазиуровень Ферми (и энергия фотонов в максимуме спектра) поднялся выше той области, где заметно влияние хвоста зоны [199]. Это может произойти с квазиуровнем электронов, но не дырок (рис. 3.37), при тех концентрациях носителей, которые обычно характерны для эффективной люминесценции (рис. 3.35). Полоса люминесценции, близкая к Eg, становится очень широкой, расширяясь от 10 мэВ при концентрации 1016 см-3 до ~0,14 эВ при 1019 см~3 в материале «-типа при 77 К (рис. 3.42, кривая а). Быстрое расширение полосы не наблюдается для материала о-типа до концентрации р ^ 1019 см-3 (рис. 3.42, кривая б),


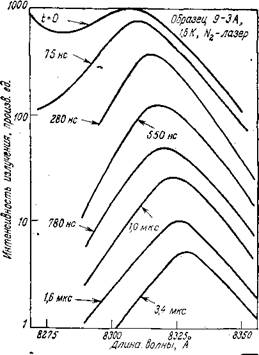

 Опубликовано в
Опубликовано в