Эмпирическое изучение деградации в GaP и GaAs
 30 марта, 2014
30 марта, 2014  admin
admin В этом разделе мы представим краткий обзор известных в настоящее время данных о процессах деградации в светодиодах. Мы увидим, что большая часть этих сведений получена скорее косвенными методами (такими, как исследование деградации вольт-амперных характеристик диодов), чем из прямых измерений свойств соответствующих центров безызлучательной рекомбинации. Однако в результате проведенных работ пробелы в наших знаниях начинают постепенно заполняться. Природа состояний, которые гасят краевую люминесценцию, остается пока неизвестной, хотя по этому поводу существует множество предположений. Мы ограничимся обсуждением светодиодов из GaP и GaAs, сообщим несколько результатов, полученных на диодах из GaAsi_*Px, а также подробно рассмотрим лазеры на основе гетероструктур GaAlAs — GaAs (для этих диодов проблема старения стоит наиболее остро).
Известно много факторов, которые уменьшают квантовый выход светодиодов. К ним относятся дефекты, возникающие
Vi _____
-чР х т - Оксидированные диоды 2 оксидирован-
_ * I г',2—£•——_________________________________ т т ных диода
'Ч
I
'і Контрольные диоды Vpa диода неоксидиробанные, у уоален-
|
ным слоем окисла |
Stfe3 про&ребания)
ч
Контрольные диоды (чеоксидироданныег прогретые до 250°С)
o,otLi—і—і—і—1—і—і l_j і і і і і і і * і і
0 200 400 600 800
Время, ч
Рис. 3.78. Изменение во времени внешнего квантового выхода красных светодиодов из GaP, полученных методом жидкостной эпитаксии, при 200 °С и плотности прямого рабочего тока 8 А/см2 [529].
Предварительный прогрев при 250 °С в течение 2 ч резко ускоряет деградацию контрольных (неоксидированных) днодов. Очень важно, что скорость деградации сильно уменьшается у диодов, которые были сначала оксидированы (пассивация поверхности) прн 20 °С, а затем прогреты до 250 °С. Удаление слоя окисла во время испытаний вызывает резкое возрастание скорости деградации.
в диодах в процессе изготовления: недопустимые отклонения концентрации вводимых примесей; избыточная концентрация неконтролируемых примесей; отклонения от стехиометрии; слишком большая концентрация дислокаций, микротрещин и дефектов поверхности, возникающих при механической обработке; химические загрязнения. Квантовый выход светодиодов может уменьшаться после изготовления при хранении или в процессе работы из-за перемещения ионов (диффузия), дополнительного загрязнения из окружающей среды, радиационных повреждений, нарушений, вызванных деформацией, или тепловых эффектов при работе. Обычно предполагают, что эти факторы определяют тот значительный разброс, который часто наблюдается в характеристиках старения светодиодов. Однако квантовый выход светодиодов из GaP, пассивированных по методике, предложенной в работах [529, 530], по-видимому, не слишком сильно зависит от всех этих эффектов (рис. 3.78). В работе [530а] обсуждена степень идентичности полученных при этом защитных окисных пленок, которые были получены с помощью гальванических и анодных процессов в водных растворах перекиси водорода Н2О2, а также путем термического окисления. Факторы, влияющие на исходный квантовый выход светодиодов, та
кие, например, как оже-процессы (разд. 3.6.1), описаны в разд. 3.2 и 3.3. Здесь мы рассматриваем только то, что изменяется во время работы светодиодов, и то, что ограничивает их рабочий ресурс. Следует подчеркнуть, что, как и в случае многих твердотельных устройств, выход из строя светодиода — процесс постепенный (не принимаются во внимание такие причины выхода из строя диодов, которые легко избежать, например обрыв контактной проволочки из-за плохой пайки и др.). Таким образом, светодиоды будем характеризовать таким временем жизни, за которое их яркость упадет в 2 раза (рис. 3.78), в отличие от четко определенного времени жизни ламп накаливания,
0 котором говорит наш опыт обращения с ними.
Исследования диодов на основе GaAs и GaP показали, что поверхностные эффекты, возникающие при работе в нормальной среде (такой, как. влажный 02), не являются существенными в процессе деградации. Покрытие GaAs-лазеров слоем Si02 не влияет на быстрые процессы деградации [531]. Такие светодиоды можно хранить неограниченно долго в нормальных условиях (Т < 50 °С). Заметная деградация наблюдается только в процессе работы при прямом смещении. При длительном пребывании на воздухе при повышенной температуре (~ 100 °С) возможно кратковременное улучшение квантового выхода (отжиг); при этом может происходить деградация поверхности. Начальное увеличение квантового выхода г], часто наблюдаемое в светодиодах из GaP [532], связано, вероятно, с образованием дополнительных пар Zn — О (разд. 3.2.8). Последующая быстрая деградация, часто наблюдаемая в самом начале работы светодиодов из GaP, которые не подвергались специальной дополнительной обработке (рис. 3.78), происходит по-разному. В предельных случаях т] уменьшается почти на 50% в течение
1 ч с последующим довольно резким переходом к намного меньшим скоростям деградации [533]. В настоящее время механизм этих явлений не выяснен, однако известно, что пассивация сильно уменьшает долговременную деградацию [529].
Время, за которое Ці уменьшается в некоторое число раз, для красных светодиодов из GaP подчиняется закону Аррениуса (рис. 3.79), причем энергии активации лежат в диапазоне 0,5— 0,8 эВ [532]. Интенсивность электролюминесценции L в этих светодиодах зависит от напряжения смещения V как L0exp(eV/nkT) (n = 1). При больших значениях V имеет место отклонение от этого закона из-за влияния последовательного сопротивления (рис. 2.4); в уже деградировавших диодах такие отклонения начинаются при меньших смещениях. Последнее обусловлено существенным ростом составляющей тока, связанной с безызлучательной рекомбинацией в области пространственного заряда во всем диапазоне смещений. Если в только
|
Рис. 3.79. Деградация по закону Аррениуса красных светодиодов из GaP, полученных методом жидкостной эпитаксии [532]. Энергия активации EQ процесса деградации зависит от количества подвижных нонов (Си) внесенных в процессе изготовления. Старение осуществлялось при рабочем токе / — 10 мА (плотность тока приблизительно равна 10 А/см2). /—специальное загрязнение медью, £ =0,53 эВ; 2 —светодиоды изготовлены в лабораторных условиях» £д=0,53 эВ; 3—светодиоды изготовлены в отсутствие медн, 0,76 эВ. |
что изготовленных диодах присутствуют и рекомбинационная (п = 2), и диффузионная (п = 1) составляющие тока, то в деградировавших диодах ток I определяется только составляющей, связанной с рекомбинацией в области пространственного заряда. На рис. 3.80 приведены вольт-амперные характеристики красных светодиодов из GaP (n-слой на р-подложке) до и после старения. Наклон вольт-амперной характеристики до старения при увеличении VF изменяется. При малых токах более резко выражена рекомбинационная составляющая тока (п « 2), но в области рабочих значений тока присутствует значительная доля диффузионной составляющей (п « 1), поэтому наклон вольт-амперной характеристики соответствует п= 1,3—1,6 (1,45 для диода на рис. 3.80). После деградации ток определяется рекомбинацией в области пространственного заряда во всем рабочем диапазоне смещений вплоть до значений, при которых начинает сказываться последовательное сопротивление (разд. 2.2.3). В этом и заключается основная причина деградации при работе диода в области прямых смещений; то же происходит и в GaAs-диодах [534, 535]. И в этом случае интенсивность электролюминесценции L светодиодов до деградации за-
|
|
напряжение VF> в
Рис. 3.80. Вольт-амперные характеристики светодиодов из GaP до и после
старения [532].
|
|
|
Рис. 3.80а. Деградация, которая проявляется в уменьшении относительного уровня интенсивности электролюминесценции, измеряемой при фиксированном напряжении прямого смещения, равном 1,7 В [535а]. |
|
Время, ч |
|
Эти данные получены на современных красных светодиодах нз GaP : Zn, О. изготовленных на предприятиях фирм «Вестерн Электрик» и «Белл» в Ридинге в Пенсильваиин. Каждая точка получена геометрическим усреднением данных для группы нз 5 диодов. Температуры, которые имели диоды, и пропускавшиеся через диоды постоянные токи при данных испытаниях указаны на рисунке. Решающее влияние, которое оказывают иа эффекты деградации прикладываемое напряжение нлн токи в прямом направлении, очевидно. Основные явления деградации, которые наблюдаются на современных днодах, сильно Отличаются от тех яэленнй, что наблюдались иа материале, полученном до 1971 г« |
Ток в только что изготовленном диоде в области малых значений определяется рекомбинационной составляющей (п — 2), но в рабочей области токов значительную роль играет также диффузионная составляющая тока (п =* 1). Поэтому экстраполяция для определения величины п (штриховая прямая) проводится при больших уровнях тока; при малых уровнях эта прямая отклоняется от экспериментальной кривой.
висит от смещения V по закону L0exp(eV/nkT) с п = 1 [534]. Подобно тому как это происходит в GaP, деградация вызвана появлением безызлучательного тока, связанного с рекомбинацией в области пространственного заряда (п « 2). Поэтому понимание природы этой безызлучательной составляющей тока является ключом к пониманию и контролю механизмов деградации в светодиодах как из GaP, так и из GaAs.
В красных светодиодах из GaP изменение степени ассоциации акцепторов Zn и доноров О можно определить из соотношения красного излучения (ближайшие пары) и инфракрасного излучения (далекие пары) [532], которое исходит из р-области, куда проникает диффузионная составляющая тока (рис. 2.16). В деградировавших диодах не наблюдается новых полос люминесценции, по крайней мере с энергией больше ~ 1 эВ. Из этого можно сделать вывод, что дополнительный «избыточный» ток возникает за счет полностью безызлучательной рекомбинации в области пространственного заряда, идущей, возможно, через глубокие уровни. Это же верно и для случая деградировавших гетеролазеров, речь о которых идет ниже в этом же разделе.
Описанная только что картина деградации красных светодиодов из GaP : Zn,0 была установлена на диодах, изготовленных в лабораториях фирмы «Белл» до 1971 г. Светодиоды, полученные с помощью управляемого технологического процесса на фирме «Вестерн электрик», ведут себя по-другому: при деградации диодов, у которых p-область находится со стороны, откуда выходит свет, не наблюдается увеличения недиффузионной составляющей тока. Более того, коэффициент инжекции в р-область может даже возрастать при деградации! В этих диодах при деградации происходит уменьшение объемного квантового выхода люминесценции самого материала p-области. Как мы только что видели, в более ранних работах такое явление не наблюдалось. Причины изменения поведения диодов не ясны, но уже то, что такое изменение возможно, говорит о том, что эффекты деградации в действительности очень сложны. Новые данные относительно старения диодов были получены в условиях, сравнимых с прежними. Герметически запаянные диоды, через которые проходил ток, равный 30 мА, находились в тепловом контакте с теплоотводом, имевшим температуру 200 °С. Температура перехода равнялась 220°С. Ральстон и Лоримор [535а] показали, что деградация нового материала может быть связана с тем, как изменяется диффузионная составляющая тока электронов через р — n-переход, и с изменением самого гв, если интенсивность выходящего излучения измерять при заданном смещении на р — n-переходе; это смещение должно быть меньше тех напряжений, при которых становится существенным влияние последовательного сопротивления (рис. 3.80а).
Действительно, при этих условиях, когда свет генерируется только в p-области, поток света L ~ цв'12. Из рис. 3.80а также следует, что постоянная высокая температура сама по себе еще не достаточна для быстрой деградации, при которой интенсивность излучения падает на 1 /4 значения всего после 1 ч работы и падает до 10% исходного значения после 103 ч. Изменение смещения на диоде меняет пространственное распределение электрических полей в р — n-переходе. Кроме того, в диоде имеются большие градиенты температур в области, прилегающей к р — n-переходу. Какой из указанных факторов (или, может быть, другой фактор) определяет деградацию, необходимо еще выяснить. Исследования красных светодиодов из GaP с помощью растрового электронного микроскопа указывают на то, что Tie существенно уменьшается при удалении от р — «-перехода на расстояние, равное нескольким диффузионным длинам внутри p-области. Измерения диффузионных длин из зависимости наведенного тока через р — n-переход от положения зонда растрового электронного микроскопа относительно самого р — n-перехода показали, что у диодов, деградация которых происходила так, как у диодов с характеристиками, изображенными на рис. 3.80, наблюдается уменьшение цв по крайней мере в 2 раза по обе стороны от перехода. Величина уменьшения r]s может быть даже больше внутри критического слоя толщиной около двух диффузионных длин в диоде, смещенном в прямом направлении. Какой-либо информации о безызлучательных механизмах, гасящих люминесценцию, или о природе центров, обусловливающих эту в значительной мере не локализованную деградацию материала, до сих пор не получено.
Была предпринята еще одна попытка получить более точную информацию о центрах, ответственных за избыточные безызлу - чательные рекомбинационные токи. Есть разные методы, с помощью которых можно обнаружить присутствие центров безызлучательной рекомбинации даже в тех случаях, когда они сосредоточены в узкой области, например вблизи р — п-перехода. Энергии активации центров, образованных в процессе старения, можно определить из измерений термостимулированных токов, протекающих через р — n-переход, или из соответствующих фо - тоемкостных ЦП] или фотовольтаических измерений [536]. Эти методы позволяют исследовать область полупроводника непосредственно около р — n-перехода (именно эти области определяют электрические свойства светодиода). При использовании широко известного метода термостимулированной люминесценции (термолюминесценции [537]) мы сталкиваемся с тем об* стоятельством, что влияние уровней, локализованных в области перехода, оказывается смазанным из-за проявления объемных свойств областей, удаленных от р — n-перехода, где обычно эффекты деградации не наблюдаются. Мы уже видели в разд. 3.2.8, как можно использовать метод фотоемкостных измерений для нахождения термических и оптических энергий активации ловушек, сечений захвата для носителей заряда определенного типа и значений концентрации центров захвата. Что касается глубоких уровней, связанных с О в GaP, то это, пожалуй, наиболее подходящий пример того, для чего может быть применен метод фотоемкостных измерений. Концентрации и энергия активации О в GaP имеют как раз подходящие для этого метода значения: центр захвата хорошо идентифицирован, многие результаты измерений, связанных с ним, подтверждены с помощью независимых методов исследования. Однако нет полной уверенности в том, что этот и родственные ему методы, использованные для изучения старения светодиодов [533, 538], позволят получить достаточное количество хороших результатов. Поскольку энергия кванта падающего монохроматического излучения меньше Eg/2, можно считать, что влияние стационарной населенности уровней в полупроводнике пренебрежимо мало. Это упрощает измерение концентраций глубоких уровней в верхней половине запрещенной зоны. Другие методы измерений (те, которые основаны на освобождении захваченных носителей заряда, например метод термостимулированных токов) имеют ограниченные возможности, поскольку в них используются переходы, наблюдаемые в той половине запрещенной зоны, которая непосредственно примыкает к краю разрешенной зоны, содержащей основные носители заряда.
В работе [539а] исследована безызлучательная (шунтирующая) рекомбинация в GaP, полученном по Чохральскому под флюсом и жидкостной эпитаксией. При этом были использованы метод фотоемкостных измерений и метод термостимулированных токов. Фотоемкостные измерения были выполнены на диодах Шоттки, поскольку в этих диодах активная область (обедненный слой) выражена лучше, чем в р — п-переходах. В случае диодов Шоттки отсутствует неясность относительно поведения определенных уровней [эта неопределенность существует для случая обычных р — n-переходов, если любым независимым способом нельзя узнать, к какой части (п или р) обедненного слоя эти уровни относятся]. Однако изменения зарядового состояния глубоких ловушек при инжекции неосновных носителей лучше всего наблюдается в р — n-переходе. В материале, полученном методом Чохральского, имеется энергетический уровень (концентрация равна ~ 1016 см-3), лежащий на >~0,4 эВ выше потолка валентной зоны; этот уровень характеризуется малой величиной скорости термической ионизации. Данный материал имеет, кроме того, близкую по величине концентрацию ловушек, энергетический уровень которых лежит в верхней половине запрещенной зоны. В материале, полученном жидкостной эпитаксией, концентрации ловушек с уровнем 0,4 эВ были обычно только в несколько раз меньше, чем в GaP, полученном по Чохральскому. Но что касается концентраций ловушек, энергетические уровни которых лежат в интервале на ] эВ ниже дна зоны проводимости, то таких ловушек в материале, полученном жидкостной эпитаксией, было по крайней мере на порядок меньше.
Кроме уровня 0,93 эВ для доноров О в GaP п-типа, методом термостимулированных токов был зарегистрирован целый набор уровней: 0,27, 0,43, 0,57, 0,64, 0,72 эВ. Уровни 0,57 и 0,93 эВ были основными в материале, полученном по Чохральскому. Ловушки с энергиями активации 0,43 и 0,71 эВ преобладали в легированном серой GaP, полученном жидкостной эпитаксией. Интересно отметить, что, хотя Фабр и др. [357а] сообщали об уровнях 0,27, 0,43, 0,56, 0,64, 0,72, 0,90 эВ, они еще нашли не часто проявляющиеся уровни с энергией ~0,50 и 0,80 эВ и постоянно встречающиеся уровни ~0,36 эВ. Именно этот последний уровень связан с донорами —халькогенидами, найденными исследователями из североамериканского отделения фирмы «Филипс» [357а] (разд. 3.4.4), Группой «Ферранти» были зарегистрированы уровни 0,4 и 0,7 эВ выше потолка валентной зоны в GaP : Zn p-типа, полученном по Чохральскому. Это было сделано с помощью метода термостимулированных токов. В работе же [357а] в GaP, полученном жидкостной эпитаксией, найдены акцепторные уровни. Энергии ионизации этих уровней равны 0,22, 0,29, 0,39 и 0,55 эВ (рис. 3.62). В первом случае найденные уровни отнесены к центру Sip, во втором случае — к CuGa (табл. 3.1) [3576]. Обе полосы спектра, связанные с уровнями 0,29 и 0,55 эВ, увеличиваются при старении диодов. Этот факт обнаружен при измерениях сроков службы светодиодов, смещенных в прямом направлении при рабочей температуре 300 К - Ниже в этом разделе мы увидим, что имеются независимые указания на то, что при наличии Си в материале происходит ускоренная деградация светодиодов из GaP (рис. 3.79). Идентификация большинства обнаруженных уровней пока не осуществлена, а для некоторых из обнаруженных уровней может быть произведена только в результате исследования данными методами GaP-кристэллов, выращенных и легированных самыми различными способами. Необходимо провести дополнительные исследования для того, чтобы выяснить, существует ли родственная связь между обнаруженными уровнями и теми уровнями, которые появляются при деградации светодиодов из GaP. Проведенные ускоренные испытания, целью которых было определение сроков службы светодиодов, показали, что концентрация ловушек с энергиями уровней 0,23 и 0,67 эВ выше потолка валентной зоны, обнаруженных с помощью фотоемкостных измерений на только что изготовленном методом жидкостной эпитаксии диоде из GaP p-типа, существенно увеличивается в ходе испытаний [121г]. Еще более важно то, что близко к середине запрещенной зоны появлялся новый уровень, имеющий необычно малое оптическое сечение захвата. Это мог бы быть уровень с энергией ~ 1 эВ выше потолка валентной зоны, относительно которого недавно выяснено, что он определяет объемный квантовый выход люминесценции GaP n-типа, полученного жидкостной эпитаксией [1216]. Потребуется проделать значительный объем работы в этом направлении, чтобы проверить данную идею. Модель указанного глубокого центра в настоящее время пока не предложена.
Исследования термостимулированных токов позволили выявить дефекты, появившиеся в процессе деградации в светодиодах, изготовленных путем диффузии Zn в GaAsi-xP*. Энергии активации этих дефектов лежат в диапазоне 0,2—0,4 эВ, отсчитанном от края одной из разрешенных зон [540] (рис. 3.81, а). Была замечена качественная корреляция между концентрациями этих дефектов и обратной величиной квантового выхода электролюминесценции. Хотя энергии активации (рис. 3.81, а) лежат в том же диапазоне, что и энергии активации дефектов, введенных при облучении вещества электронами с энергией 1 МэВ, эти дефекты отличаются друг от друга. Дефекты, полученные облучением электронами, могут быть почти полностью ликвидированы с помощью двухминутного отжига при 480 '"С (рис. 3.81,6). Концентрация основного дефекта, появляющегося при старении, с энергией активации ~0,4 эВ мало изменяется при такой обработке. Вероятно, два типа воздействия на светодиоды (старение и облучение электронами) образуют различные виды дефектов, с которыми связаны центры захвата. При этом в обоих случаях центры, к которым мигрируют подвижные компоненты, могут быть одними и теми же: примесные центры или неподвижные дефекты решетки.
В работе [541] проведены исследования деградации светодиодов из GaAs, вызываемой у-излучением [541]. Показано, что радиационное воздействие может уменьшить концентрацию центров излучательной рекомбинации, а также ввести новые центры безызлучательной рекомбинации. Подобные эффекты, очевидно, очень сложны, и их трудно распознать во всех деталях. При облучении электронами, скорее всего, собственные атомы решетки переходят в междоузлия, при этом тут же образуются решеточные вакансии. В случае же эффектов старения мы имеем дефекты, связанные с примесными атомами (см. ниже). Этот вывод сделан на основании измерений атомной плотности. Следует, однако, сделать оговорку. Существуют ме-
|
|
|
После W00 ч работы после облучения |
|
4й? уработы I Вез облучения |
Знергий актибациц лоВуїики, эВ
0,2 аз ол
100 /во 200 Температура, К
а
Энергия актибации ловушки, зВ 0,2 0,3 0,4-
tOO 150 200
Температура, К
6
Рис. 3.81.
а — пики термостимулированного тока в р—rt-переходах в GaAs^^P^, полученных диффузией Zn. Старение диодов осуществлялось длительной {несколько тысяч часов) ра* ботой при 300 К и плотностях тока 5—10 А/см2. Пики указывают иа наличие уровией, отделенных от края одной из разрешенных зон энергетическим зазором, равным 0,2—0,4 эВ.
б — пики термостимулированных токов, полученные на светодиодах из GaAs0 6Р0 ^ Эти диоды сначала работали 4000 ч при 10 А/см2 и 300 К, затем они были облучены электронами с энергией 1 МэВ (доза облучения равнялась 10'7 см-2). После этого они были одновременно отожжены при температурах, указанных на рисунке. Видно, что в отличие от того, что наблюдалось на графике а при температурах ниже 200 К, в данном случае отжиг полностью «гасит» пики. Остается только пик. соответствующий энергии актявации ~-0,4 эВ; он является основным в процессе старения [540].
ханизмы, для которых облучение электронами может приводить к смещению примесных центров, как было доказано для GaAs [542а]. Этот эффект возможен даже в слаболегированных полупроводниках [542]. Тот факт, что дефекты, вызванные старением, нельзя ликвидировать отжигом, можно понять с помощью моделей Лонжини или Голда — Вайсберга, описанных ниже в этом разделе. Зная измеренные энергии активации дефектов, еще нельзя хорошо понять их природу. Хотя имеются независимые указания на то, что при старении возникают вакансии VGa, следует отметить, что центры меди в GaAs имеют энергии активации, лежащие между 0,26 и 0,43 эВ [543].
В светодиодах из GaAs степень деградации примерно пропорциональна полному заряду, прошедшему через р — «-переход при прямом смещении [535, 544]. Вид деградации зависит от технологии изготовления диодов [534, 535] и от распределения легирующей примеси в р — я-переходе [544]. Байард, Пит-
12 Зак. 1242
мэн и Лизер [534] предположили, что образование неизлучающих областей в светодиодах из GaAs, работающих при прямом смещении, может вызываться механическими напряжениями, возникающими в процессе изготовления. Неизлучающие области проявляются в виде темных линий на полученных в инфракрасном диапазоне спектра фотографиях светодиодов (рис. 3.82). Эти темные линии образуются только при пропускании тока через диод в прямом направлении: они возникают по периметру р — n-перехода в кристалле, ориентированном в плоскости (1 1 1), а затем распространяются в глубь диода. Хотя влияние прямого смещения на этот механизм деградации еще не выяснено, образование этих дефектов было связано Жауэром [545] с различием в постоянных решетки подложки и рекристаллизо - ванной области.
В диодах, изготовленных вплавлением в подложку из GaAs я-типа слоя p-типа толщиной 10 мкм, легированного Zn и Sn, концентрация легирующей примеси вблизи р — n-перехода достигает 5-Ю20 см-3. Обе легирующие примеси Zn и Sn замещают атомы Ga и изменяют постоянные решетки GaAs, в результате чего вблизи р — n-перехода постоянная решетки изменяется и появляется рассогласование. На снятых в инфракрасных лучах фотографиях излучающей области светодиода с р — n-переходом в плоскости (10 0), смещенного в прямом направлении, наблюдается прямоугольная сетка из темных линий. Эти линии расположены вдоль направлений (1 1 0) [545] и внешне очень похожи на линии, образующие треугольную сетку (рис. 3.82) в диодах, ориентированных в плоскости (111) [534]. Эти линии не видны в проходящем свете; их связывают с отсутствием излучательной рекомбинации на линейных дефектах [545].
Подобные картины нельзя наблюдать на светодиодах из GaP вследствие распространения света по всему кристаллу; это происходит потому, что коэффициент поглощения света в GaP мал. Аналогичные линии, появление которьГх связано с деградацией, были найдены на фотографиях излучающих светодиодов из GaAs, легированного кремнием — амфотерной примесью; линии опять имели ориентацию (110) [546]. И в этом случае была найдена связь между эффектами деградации и изменениями в вольт-амперной характеристике; в показателе опять появляется п = 2, что свидетельствует о том, что составляющая тока, связанная с рекомбинацией в области пространственного заряда р — n-перехода, становится большой (рис. 3.80). Полагают, что эти линии связаны с дислокациями, начинающимися в плоскостях спайности (1 1 1). Путем подсчета чисел ямок травления найдено, что плотность дислокаций на поверхности, соответствующей подложке, увеличилась; критическая плот-
|
Рис. 3.82. Фотографии люминесценции в инфракрасных лучах [534]. Видиы темные линии, связываемые с деградацией светодиодов из GaAs. |
ность дислокаций составляла ~5-104 см-2. Считают, что безыз - лучательные переходы могут идти на дислокациях, на которых «осели» быстро диффундирующие примеси (такие, как Си), или на примесных центрах, которые образовались путем смещения атомов из узлов рещетки полями напряжений, связанных с дис*
локациями [142, 167, 547]. Описанные эффекты наблюдались в довольно сильнолегированных кристаллах GaAs, в которых концентрации примесей Zn, Sn, Si были равны или больше 1018 см-3. Напряжения, порождающие множество дислокаций, могут появляться по разным причинам во время изготовления светодиодов [534]. Вполне возможно, что изготовление омических контактов большого диаметра всегда порождает такие напряжения. Напряжения могут возникнуть во время работы светодиода вследствие градиентов температур и разности тепловых коэффициентов расширения разных областей светодиодов. Обычно самые низкие скорости деградации имеют светодиоды из GaAs, изготовленные диффузией Zn в материал я-типа, содержащий оптимальные концентрации доноров [548]. У таких диодов скорость деградации настолько мала, что уменьшение интенсивности излучения на 10% происходит после 22 000 ч работы при плотностях рабочего тока ~ 500 А/см2. К сожалению, эти диоды, имеющие стандартный вид прямоугольного параллелепипеда, характеризуются внешним квантовым выходом всего лишь ~1%; поэтому для многих целей они не пригодны (разд. 4.2).
Брэнтли и Харрисон [547] обнаружили, что диоды, полученные диффузией Zn в относительно слабо легированные подложки из GaAs с Nd « 2-Ю17 см-3, будучи подвергнуты непосредственному одноосному механическому давлению в направлении, перпендикулярном р — «-переходу, с помощью пресса (рис. 3.83), имеют значительно большие скорости деградации. Старение под воздействием механического давления осуществлялось при плотностях тока 170 А,/см2 (типичные значениях для исследования процессов деградации в GaAs) и температуре окружающей среды 100 °С. Если электрическое смещение на диод не поддавалось, то одно механическое давление не ускоряло процесса деградации. Остаточные напряжения в GaAs в 10 и более раз превышают максимальное значение, указанное на рис. 3.84, но в работе предполагалось, что приложенное механическое напряжение увеличивалось за счет влияния эффектов, связанных с градиентами температур, которые появляются при больших прямых смещениях на диоде. Все светодиоды, прошедшие такие испытания, обнаруживают при нулевом смещении значительное увеличение доли безызлучательной рекомбинации, идущей в области пространственного заряда.
'Травление диодов показало, что частично деградация связана с поверхностными явлениями на периферии диода, но, у сильно деградировавших диодов (таких, как представленные на рис. 3.84) этот вклад в деградацию очень незначителен. В общем случае эффекты поверхностных утечек не обязательно играют такую важную роль в деградации типичных светодио-
|
Фиксирующии штидзт |
|
Тефлоновый разъем,, для держателя Алюминиевая ^ стойка |
|
|
|
АлюминиеВый поршень Нейлоновая втулка |
|
Диод на держателе ТО-18 |
|
Алюминиевое основание |
|
Кислотоупорный клей |
|
Рис. 3.83. Устройству, с помощью которого создавалось механическое напряжение в кубике из GaAs (с ребром 0,4 мм), внутри которого имеется р — «-переход, полученный диффузией Zn [547]. |
|
|
|
Пластина аз 6аAs |
Структура проходила испытание иа старение. При испытаниях к р—гс-переходу приклады* валось смещение в прямом направлении. Контакт к тонкой р-областн был сделан омическим по всей плоскости соприкосновения с держателем ТО-18; верхняя rt-область имела контакт в виде вплавленной сбоку проволочки. Давление верхнего поршня прикладывалось через приклеенную пластину из GaAs площадью, в 16 раз большей, чем у днода.
дов из GaAs, как это предполагалось в работе [534], особенно, когда производится пассивация поверхности азотом или как-нибудь иначе. В деградировавших диодах в отличие от того, что изображено на рис. 3.82, не было обнаружено пространственных изменений интенсивности электролюминесценции. Однако в диодах, у которых под воздействием механического напряжения проявилась быстрая составляющая процессов старения, наблюдались дефекты в виде линий и протяженные дефекты вблизи подложек, удаленных от р — «-переходов. Деградация может быть связана либо с диффузией атомов примесей, перемещающихся под воздействием механического напряжения по направлению к р—n-переходу, либо с образованием центров безызлучательной рекомбинации благодаря сильным механическим напряжениям в области р—«-перехода аналогично тому, как это происходит по описанной ниже модели термического усиления Голда — Вайсберга. При условиях, указанных на рис. 3.83, может происходить образование дислокаций. Однако точно механизм деградации в этой работе не определен. Он, по-видимому, достаточно сложен из-за комплексного взаимодействия эффек-
|
диод под нагрузкой /401 |
|
}цоды под нагрузкой 540 г і |
|
|
|
300 |
|
100 |
|
200 Время, ч |
Рис. 3.84. Сравнение процесса деградации восьми контрольных диодов с деградацией диодов, находящихся под механической нагрузкой, создаваемой с помощью поршня, изображенного на рис. 3.83 [547].
Старение проводилось при пропускании прямого тока, равного 200 мА, при температуре 100°С в атмосфере сухого азота. Точки иа нижней кривой (относящейся к диодам под нагрузкой) соответствуют разным диодам. Наблюдаемое вначале быстрое старение диодов, не находящихся под нагрузкой, типично для светодиодов из GaAs и Gap (рнс. 3.78).
тов, связанных с наличием электрического смещения и механического напряжения, превышающего пороговое значение, равное ~2-108Н/см2. По тому как диоды, с которыми работали Брантли и Харрисон, ломались на части при больших однородных давлениях, был сделан вывод о том, что в диодах существуют рассмотренные выше напряжения. Эти напряжения возникают в диодах при их изготовлении; в частности, они появляются со стороны вплавленного контакта. Трудно избежать возникновения таких напряжений в приборах, изготавливаемых по обычной технологии, особенно в тех случаях, когда поверхность диода, близкая к активной области прибора, должна быть припаяна к металлическому теплоотводу или когда применяют сложный теплоотвод, изготовленный из материалов с очень разными упругими свойствами и коэффициентами теплового расширения. Особые опасения вызывают контакты, сделанные с помощью термокомпрессии.
Хасегава и Ито [549] полагают, что дислокации, появляющиеся в ^диодах Ганна при термокомпрессии, являются главной причиной, по которой происходит часто наблюдаемое при серийном изготовлении диодов увеличение (с определенным разбросом по величине) их сопротивления, соответствующего малым
полям, и связывают это явление с возникновением в материале дефектов акцепторного типа. В общем случае следует отдавать предпочтение теплоотводам с гальваническим покрытием.
Исследования, недавно выполненные в ряде лабораторий, В частности в лабораториях фирмы «Белл» в США [549а], «Нии - пон электрик» [5496] и «Хитачи» [549в] в Японии, доказали наличие связи между качественно сходными с изображенными на рис. 3.82 картинами, вызванными механическими напряжениями, и пока очень быстрой деградацией лазеров с двойным гетеропереходом, работающих в постоянном режиме при 300 К. При наблюдении спонтанной электролюминесценции [549а], как и при исследовании катодолюминесценции с помощью растрового электронного микроскопа [5496], а также при изучении фотолюминесценции полосковых лазеров [549в] (при этом возбуждающий свет от Кг+-лазера проходил через прозрачный слой из GaAlAs) были видны темные линии, расположенные вдоль направлений (10 0). Эти эффекты происходят только в тонком активном слое GaAs, который находится под действием механического напряжения, по величине близкого к номинальному пороговому значению (108 Н/см2), необходимому для возникновения деградации, усиленной давлением (рис. 3.84). Данные результаты находятся в согласии с оценкой Рейнхерта и Логана [371] (разд. 3.4.5). Механическое напряжение возникает в результате разности коэффициентов термического сжатия относительно прилегающих слоев GaAlAs при охлаждении структуры ниже температуры роста, при которой имеет место точное согласование постоянных решетки [5496]. Таким образом, еще до включения эти приборы находятся в состоянии, близком к порогу, при котором наступает деградация, связанная с механическим напряжением; обычно пороговое состояние не достигается. Активный слой в типичном приборе с гетеропереходами, содержащими в обоих металлургических переходах слои Ga0l5Al0,5As, очевидно, подвержен внутреннему напряжению, малое увеличение которого вызывает ту или иную форму макроскопического ухудшения свойств материала, приводящего к сильной безызлучательной рекомбинации в активном слое. Это предположение подтверждается следующим наблюдением: механическое повреждение светом выходного окна, находящегося на верхней поверхности полоскового лазера, приводит к появлению соответствующей темной полосы в люминесценции, которая исходит из активной области, находящейся на глубине нескольких микрометров [549в]. Таким путем часто наблюдают темные линии, вырастающие из-под краев электродных структур, в особенности тогда, когда применяют круглые электроды [549в].
Исследования быстрой деградации гетероструктур с двойными переходами [549л] подтверждают, что большое значение имеет механическое напряжение, возникающее на границе раздела между двух - и трехкомпонентными соединениями; они же показывают, что этот вид деградации может быть не связан с механическим напряжением, возникающим при монтаже, с наличием р — п-перехода или с уровнем легирования. Результаты, однако, согласуются с моделью образования декорированных дислокаций [549а]. Прежде всего влияние света накачки на деградацию может быть связано с увеличением подвижности неидентифицированных примесных центров, обусловливающих декорирование. Этим можно объяснить, почему указанные темные линии возникают в области прямой оптической накачки. Ямки травления, обнаруженные в непосредственной близости от гетерограниц, подтверждают тот факт, что темные линии начинаются из гетерограниц, а не на поверхностных нарушениях или у подложки [549м]. Хотя чаще всего наблюдаются темные линии, иногда бывают видны темные точки, связанные, очевидно, с локальными напряжениями, возникающими из-за локализованных дефектов или преципитатов [549в]. Темные точки, которые наблюдаются при фотолюминесценции недеградировавших _ приборов, коррелируют с канавками на травленой поверхности, соответствующими групповым нарушениям. Указанные дефекты можно устранить путем улучшения условий образования зародышей при жидкостной эпитаксии. Этого можно добиться, добавляя А1 в активный слой [549в]. В отличие от тех темных линий и точек, которые появляются при старении, местонахождение исходных темных точек не ограничено активным слоем. Поскольку при работе приборов плотность и размер этих образований увеличиваются, наблюдается рост порога генерации лазеров и уменьшение driE/dJ, где J — плотность тока.
В опытах, при которых внутреннее механическое напряжение в напаянных лазерах уменьшалось, наблюдалось существенное увеличение их срока службы [549г]. Уменьшение механического напряжения регистрировалось с помощью инфракрасного излучения, проходящего через лазер, который был помещен между скрещенными поляризаторами. Аналогичным образом было получено существенное удлинение срока службы серийных приборов на основе двойных гетероструктур, после того как использовали технологию, дающую малые механические напряжения: тщательное изготовление In-соединения между пластиной полупроводника и предварительно залуженным теплоотводом [549г], большая чистота приготовления материалов и, что особенно важно, уменьшение скачка концентрации А1 между активным и прилегающим к нему слоями (рис. 3.64). Последнее достигалось, например, путем добавления ~10% А1 в активный слой [5496] при наличии 20—30% АІ в прилегающих слоях. Другой путь уменьшения напряжений при рабочих температурах приборов заключается в применении четверных соединений (вместо тройных) в качестве материала для прилегающих слоев (например, к GaAlAs добавляют Р) [370а]. Очевидно, дефекты согласования решеток образуются главным образом при температурах, отличных от температуры роста слоев. В настоящее время непонятно, почему у лазеров из четверных соединений наблюдаются более низкие пороги.
В течение первого года после улучшения технологии изготовления светодиодов срок службы приборов увеличился от нескольких часов (некоторая доля выпускаемых приборов работала в течение нескольких сотен часов [549д]) до более 1000 ч (вплоть до ~ 5000 ч) [5496]. Полагают, что без дальнейшего фундаментального углубления нашего понимания процессов старения можно достичь срока службы светодиодов в непрерывном режиме при 300 К, превышающего 104 ч [549е]. Тщательным изготовлением диодов из материала, в котором механические напряжения на гетерогранице были уменьшены с помощью подходящих добавок А1 или Р в активный слой, уже достигнут режим работы на постоянном токе в течение более 6000 ч при 300 К. Помимо уменьшения общих напряжений при 300 К суще-' ственно ниже была плотность дефектов роста во время жидкостной эпитаксии. Отсюда следует, что инжекционный GaAs-лазер с двойным гетеропереходом становится жизнеспособным прибором, который найдет применение в быстро развивающихся областях оптической связи и интегральной оптики [549н]. Как показали исследования [5496], толстые (~200 мкм) некогерентные светодиоды из GaAs—(Ga, Al)As, выращенные методом жидкостной эпитаксии, могут иметь срок службы, в течение которого интенсивность их излучения падает в 2 раза, больше 104 ч, даже если они работают при плотностях тока, больших 103 А/см2. Эти светодиоды также могут быть использованы как источники излучения в волоконнооптических системах связи [549в]. В настоящее время можно изготовить полосковые GaAlAs-лазеры с двойным гетеропереходом и с активным слоем толщиной 0,1—0,2 мкм, у которых пороговые токи jt « 100 мА в постоянном режиме при 300 К. Дальнейшее снижение jt можно получить, улучшая морфологию роста за счет введения заданного распределения концентрации А1 внутри активного слоя [549в, 549е], а также развития метода жидкостной эпитаксии применительно к определенным четверным соединениям [549з]. Такие приборы можно изготавливать обычным способом, используя хорошо сконструированную печь для жидкостной эпитаксии [5496].
Нахождение корреляции между деградацией спонтанной люминесценции и деградацией лазеров осложнено тем, что генерация лазера происходит в нитевидном канале, а в спонтанных диодах большой площади происходит неоднородная деградация в объеме [547о]. Имеются данные, которые говорят о том, что добавление А1 удлиняет сроки службы как гомогенных, так и гетерогенных светодиодов. По-видимому, это происходит благодаря механизму соударения фононов, который рассмотрен ниже.
До сих пор не установлена природа дефектов, обусловливающих появление темных областей. Темные линии, ориентированные в направлении (110) (рис. 3.82), считаются связанными с декорированными дислокациями [549ж]. Исследования показали, что линии, ориентированные вдоль направления (10 0), образуются в лазерах на двойных гетеропереходах в результате - статистического объединения дислокаций, наклоненных к границе перехода и лежащих в плоскости {100} [549м]. Эти дислокации могут являться каналами, по которым идет быстрая диффузия примесей из объема полупроводников или с приконтакт - ных поверхностей внутрь тонкого активного слоя. Определяющим влиянием этого процесса можно объяснить, почему неэффективна пассивация кислородом для получения защитного слоя на внешней поверхности лазерной структуры при проведении диффузии [531]. Однако быстрая деградация, связанная с появлением темных линий, стремится к насыщению; это говорит о том, что основную роль играет уменьшение механического напряжения, а не процесс, в основе которого лежит электромиграция. В результате исследований состаренных лазеров с двойным гетеропереходом, выполненных с помощью просвечивающего электронного микроскопа [549з], были обнаружены системы дислокаций, ориентированные в направлении (10 0), которые совпадали с темными линиями, видимыми при наблюдении электролюминесценции. Эти системы дислокаций находятся в области полоскового перехода и характеризуются большими плотностями дислокаций, лежащими в диапазоне 10s—109 см~2. Они смещаются в прилегающую тонкую область GaAlAs. Этот результат расходится с тем, что получено в работе [5496]. Петров и Хартман [549з] считают, что эти дислокации — дислокации особого, винтового типа в отличие от дислокаций, ориентированных по направлению (110) и связанных с рассогласованием решеток при гетероэпитаксии. Они начинаются иа одиночных дислокациях, которые проходят сквозь все эпитаксиальные слои, начиная со слоя, лежащего у внешней базы GaAs-диода. На основании морфологии дислокаций можно предположить, что процесс винтового продвижения дислокаций идет во время работы лазера. Образование при этом точечных дефектов и процессы продвижения дислокаций пока еще неясны. Неясно также, является ли существенным декорирование этих дислокаций атомами примеси.
Механические напряжения гетероперехода, которые усилены термическими напряжениями, связанными с типичными уровнями потока энергии (10s Вт/см2), необходимыми для возбуждения генерации в активном слое, являются основной причиной деградации, при которой наблюдается появление темных линий. Из наблюдений областей, невосприимчивых к деградации, можно предположить, что важны и другие факторы (вероятно, обусловленные примесными атомами), которые декорируют дислокации и вызывают деградацию или явления, связанные с наличием электронно-дырочной плазмы. Например, даже было высказано предположение, что существенным может быть и уменьшение силы связи в решетке в области сильной инжекции дырок [549е]. При слабых микроскопических повреждениях поверхности в структуре ALGai-xAs, предназначенной для лазеров с двойным гетеропереходом, легко появляются темные точечные дефекты, не являющиеся выделенными в сети темных линейных дефектов. Оказывается, они связаны с полем упругих напряжений, окружающих повреждение [549у]. При качественном описании следует сказать, что эти явления можно ожидать при отталкивании носителей от области сжатия, которая находится в плоскости гетероперехода, где происходит уменьшение энергетического зазора X—Г; количественно описать эти эффекты трудно. Так создаются большие области (где невозможна накачка) с коэффициентом поглощения до 104 см-1. Радиус этих областей составляет 50—100 мкм. Таким образом, материалы для двойных гетероструктур при изготовлении приборов следует обрабатывать очень осторожно. При этом часто рекомендуется в процессе изготовления проводить контроль с помощью метода флюоресцентной микроскопии.
На деградацию существенное влияние оказывает прямое смещение. Подтверждением этого вывода служат наблюдения того, как у системы InxGai_xAs с увеличением х ослабляется медленная деградация [549т]. Срок службы ряда светодиодов из InxGai_*As увеличивается с ростом х экспоненциально; при изменении х от 0 до 0,2 срок службы возрастает в 104 раз. У светодиода с х — 0,2 деградация не наблюдается в течение 103 ч при плотности тока 103 А/см2 (и это несмотря на большое увеличение плотности дислокаций, вызванное рассогласованием решеток). Светодиоды с резкими переходами были получены методами жидкостной и газовой эпитаксии (разд. 3.4.5). Такая тенденция, очевидно, имеет место в Ini-*GaxP и GaAsi_*Pjf. Скорость деградации в объеме при высоких смещениях монотонно растет с увеличением ширины запрещенной зоны соединения, т. е. с увеличением энергии кванта люминесценции. Оказывается, эти результаты подтверждают описанную на стр. 369 модель фононного удара или термического выброса, согласно которой в материале образуются центры безызлучательной рекомбинации. Из этих результатов следует, что изготавливать эффективные с большим сроком службы лазеры на двойных гетеропереходах на основе системы GaAs — InGaAs может быть значительно проще, чем на основе GaAs — AlGaAs.
Темные линии появляются из-за того, что в областях, где находятся декорированные дислокации, имеется локальное оптическое поглощение, характеризуемое большой дисперсией; в указанных областях отсутствует инверсное распределение носителей тока [549о]. Деградация приводит к суперлинейной зависимости усиления от тока; это происходит из-за того, что эти области поглощения, где а ~ 100 см-1, насыщаются [549п]. Области деградации, имеющие вид темных линий и темных точек, приводят к появлению острых пиков в частотном спектре флуктуаций интенсивности лазеров, работающих в постоянном режиме. Эти флуктуации вызываются тем, что при подключении указанных областей, играющих роль насыщающихся поглотителей энергии, происходит изменение добротности [549ф]. - Более медленная составляющая деградации лазеров с двойным гетеропереходом может быть по природе своей очень похожей на деградацию, обычно наблюдаемую в некогерентных светодиодах на гомогенных переходах. Имеются доказательства того, что при этом важную роль играет электромиграция. Такая деградация описана ниже в этом разделе. Следует отметить, что обычная естественная пассивация кислородом не предотвращает проникновения Na внутрь светодиода путем диффузии; Na — загрязняющая примесь, которая потенциально может быть даже более опасна, чем Си.
Несмотря на то что с помощью спектров спонтанной люминесценции можно наблюдать глубокие уровни (так, например, с глубоким уровнем связан широкий максимум на длине волны 970 нм, который может даже поддерживать генерацию лазера на длине волны 971,5 нм [5496]), сами глубокие уровни прямо не связаны с темными линиями и, следовательно, с быстрыми и средними по длительности процессами деградации. Область, подверженная деградации, характеризуется широким хвостом поглощения (на уровне ~200 см-1), простирающимся в область энергий, меньших ширины запрещенной зоны. Дальнейшие поиски глубоких уровней методами термостимулированных токов и фотоемкостных измерений, а также путем изучения спектров фотолюминесценции, снятых с помощью фотоприемника из PbS, могут оказаться успешными.
Связь, обнаруженная между прямым смещением на диоде и деградацией, очевидно, аналогична эффекту, зарегистрированному в обычных диффузионных диодах в работе Брантли и Харрисона [547]. Эта связь является следствием двух причин. Первая причина — диффузия примесей вдоль дислокаций, поддерживаемая электрическим полем (механизм Лонжини [564], вероятно, включающий процесс термического выброса [568], который рассмотрен ниже). Вторая возможная причина — дополнительное. критическое влияние механического напряжения, вызванного большим градиентом температур вблизи активного слоя, соответствующим изменению температуры на 20—30 °С на расстоянии, равном нескольким микрометрам. Появление такого градиента температур неизбежно при работе прибора с хорошим теплоотводом. Для того чтобы определить, какой из этих двух возможных эффектов играет определяющую роль в типовом приборе, требуется провести дальнейшие исследования. Ясно, что действительные различия в поведении светодиодов, изготовленных в разных лабораториях, могут изменяться в широких пределах.
Описанные выше результаты подтверждают предположение о том, что медленные процессы деградации обусловлены введением быстро диффундирующими ионами глубоких уровнен внутрь обедненного слоя (или рядом с ним), которые изменяют распределение потенциала в р — я-переходе. Быстрые процессы деградации связаны с образованием безызлучательных областей в кристалле: сюда входят и различные кристаллические несовершенства, которые могут быть образованы при приложении механических напряжений, превышающих предел упругой деформации материала. Возможно, что пока нет достоверно установленного примера процесса деградации, внутренне присущего светодиодам, т. е. такого процесса, который бы являлся неизбежным следствием полезной нам излучательной рекомбинации. Мы исключаем особые случаи повреждения зеркальных поверхностей в мощных инжекционных лазерах. Эффекты повреждения зеркальных поверхностей определенным образом связаны с большими уровнями потока мощности света, который вызывает линейчатое повреждение (эрозию) зеркальных поверхностей полупроводника [549и, 572а]. Повреждение зеркальных поверхностей может способствовать появлению темных линий во внутренней активной области [568а].
Быстро диффундирующие примесные атомы металлов могут стимулировать образование различных внутрикристаллических нарушений; их вхождению внутрь кристалла могут способствовать стеклообразные [529] и, возможно, химически активные [550] поверхностные защитные слои. В определенных случаях и в GaAs [551], и в GaP [532] увеличение безызлучательных составляющих тока связано с подвижными примесными ионами, такими, как Си. Указанные эффекты могут давать значительный вклад в медленную составляющую процессов старения гетеролазеров. Мы уже видели (в частности, в случае инжекционных лазеров с двойным гетеропереходом), что надо быть готовым к тому, чтобы уметь различать целый набор механизмов деградации, проявляющихся совместно, хотя, возможно, их скорости и различны.
Бахрамэн и Оулдхэм [552] показали, что старение светодиодов из GaAs, легированных Zn, существенно ускоряется, если их преднамеренно загрязнить медью, в особенности при малых плотностях тока и повышенных температурах. Начальная деградация люминесценции с энергией кванта, близкой к ширине запрещенной зоны, характеризуется энергией активации (равной — 0,45—0,1 эВ), полученной из закона Аррениуса; деградация идет быстрее при больших токах. Используя простую модель, согласно которой излучательный и безызлучательный пути рекомбинации конкурируют между собой, можно показать, что для случая существенной деградации Тбезызл < тИЗл и относительное уменьшение внешнего квантового выхода пропорционально относительному увеличению концентрации безызлучательных центров. Если последнее ограничено скоростью диффузии примесей, то показатель в соотношении Аррениуса будет определять коэффициент диффузии (так для Си в GaAs он равен 0,53 эВ) [553а, 5536]. Широкая полоса люминесценции вблизи 1,28 эВ, которую Морган и др. [554] связывали при 77 К с наличием Си в GaAs, была наиболее сильной в спектрах светодиодов, загрязненных медью. Эта люминесценция деградировала гораздо слабее, чем люминесценция с энергией кванта, близкой к ширине запрещенной зоны. Данные наблюдения могут оказаться не очень существенными, поскольку при большой концентрации глубоких уровней процессы туннелирования возбужденных носителей с передачей энергии фононам решетки гасят люминесценцию с энергией, близкой к ширине запрещенной зоны [72]. Полоса излучения при 1,28 эВ вполне отличима от полосы при 1,35 эВ, связанной с изолированными акцепторными центрами Си в GaAs [555].
В разд. 3.4.4 говорилось о том, что Си индуцирует люминесценцию с участием связанного экситона на аксиальио симметричных центрах в GaAs [347, 556]. Акцепторный уровень с энергией ионизации 156 мэВ, вероятно, ответствен за появление полосы люминесценции с энергией 1,35 эВ. Этот акцептор имеет тригональную симметрию, связанную, возможно, со статическим сдвигом Яна — Теллера для центра CuGa [557]. Некоторые авторы утверждают, что центры Си порождают также нежелательные ямки на границах слаболегированных эпитаксиальных слоев я-типа, применяемых в микроволновых ганновских генераторах. Подтверждение этому было получено при изучении поведения спектральных полос фотолюминесценции, лежащих вблизи 1,26 эВ и связываемых с донорными комплексами, содержащими Си [558].
Другие авторы подчеркивали роль легирования кремнием [559]. Ивасаки и Сугибучи [560] наблюдали фотолюминесценцию ступенчато протравленных GaAs-слоев, полученных эпитаксией из газовой фазы и легированных разными примесями, в частности Si и Sn, а также влияние термообработки в Нг - Они полагают, что ямки на границах возникают вследствие пространственного изменения концентрации акцептора с энергией ионизации ~0,11 эВ, который, по их мнению, является более глубоким из двух уровней, принадлежащих центру SiAs в GaAs. Нет сомнения, однако, что центр SiAs дает в GaAs мелкий акцепторный центр с Еа = 0,035 эВ (табл. 3.2). Простой изолированный центр SiAs не может давать и глубокий, и мелкий акцепторные уровни; ясно, что акцепторный уровень 0,1 эВ на рис. 3.48 соответствует значительно более сложному центру (разд. 3.3.8). Причина появления важной с технологической точки зрения полосы люминесценции с энергией — 1,4 эВ у GaAs : Si в настоящее время неясна (разд. 3.3.2 и 4.2). Дополнительная сложность состоит в том, что электрические характеристики GaAs : Si претерпевают большие изменения при отжиге при не очень высоких температурах (например, 400 °С)
[562] . Это явление предстоит еще тщательно изучить. Что касается ямок на границах, то ясно, что с помощью фотолюминесценции можно распознать это явление, в особенности если будут проведены тщательные измерения при более низких температурах на более слабо легированных [256а] (чем до сих пор [558, 560]) кристаллах.
Из ускоренного старения диодов из GijP, изготовленных путем наращивания п слоя на материале p-типа в условиях загрязнения технологической аппаратуры, и особенно диодов, преднамеренно загрязненных медью (рис. 3.79), следует, что медь, безусловно, усиливает процесс деградации в GaP. Менее очевиден тот факт, что деградация диодов из GaP, не загрязненных специально, связана с неконтролируемыми загрязнениями медью. Из рис. 3.85 видно, что механизм переноса этих примесей по диоду к чувствительной области р — я-перехода существенно зависит от температуры [529]. Известно, что поверхностный слой корпусов транзисторов типа ТО-18, которые обычно используются для монтажа светодиодов из GaP, загрязнен такими потенциально быстро диффундирующими примесями, как Na, К и В. Механизм воздействия этих примесей на область объемного заряда непонятен. Ниже описан механизм, предложенный для объяснения деградации, вызванной медью [532].
В работах [532, 553] высказано предположение, что медь Присутствует в материале главным образом в виде ионов внед-
|
Рис. 3.85. Деградация внешнего квантового выхода непассивированных красных светодиодов из GaP, изготовленных методом жидкостной эпигаксии [529, 550]. Диоды подвергались термообработке в отсутствие смещения перед началом излучения процессов старения. Хотя начальные свойства диодов (вольт-амперные характеристики, емкость р—n-перехода, квантовый выход и т. д.) прн такой предварительной термообработке не изменяются, скорость деградации резко возрастает. Этот эффект не сильно зависит от свойств подложки, изготовленной вытягиванием из расплава, а — подложка ZN 70209, старение прн 100 °С, постоянный ток 10 мА; б — подложка ZN 704В, старение прн 200 °С, постоянный ток 10 мА; в — подложка ZN 70501, старение прн 200 °С, постоянный ток 10 мА. |
рения Си+ в p-области и в виде ионов замещения Си2- в п-области и что концентрация Си минимальна внутри или вблизи р— /г-перехода из-за диффузионного потенциала в обедненном слое несмещенного диода. Существование этого минимума было установлено методом распределения радиоактивных изотопов
[563] . При большом прямом смещении электрическое поле в р — n-переходе почти исчезает и подвижные ионы Си+ могут диффундировать или дрейфовать в слабом электрическом поле p-области к р — л-переходу, где вследствие компенсации может произойти пересыщение медью. В результате возможно образование комплексов и (или) выделение меди, что может привести к возникновению глубоких ловушек и, как следствие, к необратимой деградации. Энергия активации для процесса миграции CuL составляет обычно ~0,5 эВ [553]. На начальный квантовый выход и, возможно, на скорость деградации могут оказы - еать сильное влияние и другие факторы. При использовании кислорода в качестве легирующей примеси в диодах из GaP : Zn,0 эффективность люминесценции сильно уменьшается из-за игольчатых выделений Ga203, которые наблюдались оптически в слоях p-типа, полученных методом жидкостной эпитаксии,-'и в пластинках, выращенных из раствора [103]. Дефекты кристалла, действующие как центры безызлучательной рекомбинации, могут быть и результатом механических напряжений, возникающих в процессе изготовления [534], и результатом изменений постоянной решетки из-за высокой концентрации примесей в сильнолегированных кристаллах [545]. Эти явления всегда присущи приборам на гетероструктурах, даже на структурах на основе системы GaAlAs (разд. 3.4.5).
Аналогичные эффекты можно ожидать прн диффузии других активных примесей, таких, как Zn. Это предположение высказал Лонжини [564] для объяснения деградации в GaAs и затем рассмотрел Шибата [565] для случая деградации туннельных диодов. Поскольку Zn является необходимой составной частью центра красного излучения в GaP (разд. 3.2.8), то механизм диффузии Zn мог бы наложить принципиальное ограничение на срок службы светодиодов из GaP, Однако легко диффундирует лишь Zn, находящийся в междоузлиях, а поскольку равновесное отношение концентраций внедренного и замещающего Zn мало [566], то это ограничение вряд ли играет заметную роль. Более того, для GaAs коэффициент диффузии подвижного внедренного цинка по крайней мере на три порядка меньше, чем коэффициент диффузии внедренной меди, а энергия активации для Zn составляет ~1 эВ, тогда как для Си она равна ~0,5эВ [553, 567]. Аналогичное поведение диффундирующих ионов Си и Zn, находящихся в междоузлиях, следует ожидать и в GaP. Однако в этом случае, возможно, следует принять во внимание и другие факторы, например отношение сечений захвата для глубоких ловушек, связанных с Zn и Си [533].
Принципиальное ограничение на срок службы светодиодов может накладывать и процесс деградации, связанный с образованием в обедненном слое дефектов по Френкелю. Голд и Вайсберг [568] предположили, что смещение атомов вызывает локальный разогрев вследствие многофононной безызлучательной рекомбинации в р — я-переходе. Из наблюдаемой зависимости характеристического времени деградации в туннельных диодах от тока инжекции [544] можно предположить, что число таких возникающих центров пропорционально полному заряду, прошедшему через р — я-переход.
Эту же модель использовали Сушков и Щепетилова [569] для объяснения деградации светодиодов из GaAs при больших плотностях токов (^,50 А/см2) и нашли, что ток, связанный с рекомбинацией в области пространственного заряда, прен§;
брежимо мал как до старения, так и после старения, что расходится с данными других авторов по крайней мере для плотностей тока, меньших нескольких сот ампер на 1 см2. Было обнаружено соответствие между деградацией и скоростью излучательной рекомбинации электронов, инжектированных в - р-область диода, через примесные центры Zn. Итак, процесс деградации связан с активным слоем прибора. Это означает, что деградация наиболее существенна в светодиодах с наибольшим1 начальным квантовым выходом. Данная корреляция, безусловно, имеет место в светодиодах на р — п-переходах [529], хотя долгое время [511] это считалось верным для электролюминесцентных ячеек из ZnS [486]. Авторы работы [552] отмечают, что деградация светодиодов из GaAs, изготовленных путем диффузии Zn, может быть значительно сильнее при более низких плотностях тока; они пришли к выводу, что безызлучательная рекомбинация должна быть при больших токах индуцирована в p-области. Подтверждение этому было найдено при измерениях степени деградации GaAs-лазеров, работавших при плотностях тока 17 000 А/см2. Было обнаружено, что время жизни неосновных инжектированных носителей при старении существенно уменьшается [570]. Это расценивается как веский аргумент в пользу образования центров безызлучательной рекомбинации. в соответствии с механизмом Голда — Вайсберга [568].
Вайсберг [583] провел сравнение механизма’ Голда — Вайсберга с диффузионной моделью Лонжини, расширенной на случай загрязнений медью. Он отметил, что изменения напряжения или тока, предсказываемые обеими моделями при постоянной температуре, одинаковы. В отличие от модели Лонжини в модели Голда — Вайсберга предполагается, что внутренний квантовый выход люминесценции изменяется вследствие безызлучательной рекомбинации на вакансиях парных дефектов по Френкелю, возникающих в результате безызлучательной рекомбинации на центрах, находящихся вне обедненного слоя. Однако большая часть таких парных дефектов по Френкелю может исчезнуть в результате естественного отжига, если только они не возникли вблизи края обедненного слоя, где междоузельный атом имеет большую вероятность уйти от вакансии, дрейфуя в поле р — я-перехода. Кроме того, в отличие от модели Голда— Вайсберга модель Лонжини при низких температурах неприменима даже при больших прямых смещениях. Экспериментально наблюдается уменьшение квантового выхода излучения только при больших плотностях тока; это указывает на то, что модель Голда — Вайсберга, справедливая в данной области, непригодна для области малых смещений, в которой справедлива только модель Лонжини.
Итак, этот процесс деградации может быть присущ светодиодам (большие напряжения смещения, плотности тока 1^1000 А/см2), если на специально вводимых, первоначально излучательных рекомбинационных центрах происходит локальный разогрев. Арсенид галлия, облученный электронами с энергией 1 МэВ, был тщательно исследован с помощью спектроскопии переходных процессов с участием глубоких уровней [121aj. Исследования показали, что в этом случае происходит отжиг электронной ловушки с уровнем, лежащим на 0,45 эВ ниже зоны проводимости [583а]. Отжиг, очевидно, прямо связан со скоростью электронно-дырочной рекомбинации на этом дефекте в обедненном слое р — я-перехода, на котором и производятся емкостные измерения. Термический отжиг этого центра характеризуется энергией активации •—• 1,4 эВ. Чтобы процесс электронно-дырочной рекомбинации способствовал отжигу, на этом дефекте должно иметь место сильное электронно-фононное взаимодействие. В результате должен наблюдаться достаточно размытый оптический спектр, и поэтому обнаружение этого центра данным методом затруднительно.
На этот механизм обратили особое внимание Крессел и Байер [531], когда исследовали деградацию лазеров из GaAs, работающих при больших плотностях токов. Они обнаружили, что образование дефектов по Френкелю также сильно зависит от плотности тока. Крессел и Байер отметили, что деградация усиливает неоднородность распределения лазерного излучения по р — я-переходу; это согласуется с результатами выполненных и описанных выше работ, в которых изучались приборы на гетероструктурах. Крессел и Байер предположили, что образование дефектов по Френкелю происходит главным образом около больших дефектов [таких, как дислокации или выделения примесей (преципитаты)], которые, как обычно считают, являются причиной появления начальной неоднородности [571]. Еще один механизм деградации, существенный при мощных световых потоках в инжекционных лазерах, состоит в образовании ямок на полированных или полученных методом скола гранях резонатора. Образование ямок связывается с термохимическими эффектами, вызванными частичками пыли на поверхности полупроводника, или просто с тепловым эффектом брил - люэновского рассеяния на поверхности [572а, 5726]. Постепенная деградация поверхности может происходить также из-за неоднородного окисления зеркальных поверхностей парами воды. Шварц и др. [550] описали эффективный метод пассивации поверхности полосковых лазеров перекисью водорода. Они обнаружили новое достоинство Gai_*Al*As: присутствие А1 существенно усиливает химическую стабильность поверхности (рис. 3.86).
|
Рис. 3.86. Уменьшение скорости травления твердого раствора Gai_*Al*As с увеличением х [550]. Травитель представляет собой 30%-ный водный раствор перекиси водорода, нейтрализованный NH(OH. |
Исследования, проведенные на выращенных пластинах из GaAs, показали, что излучение лазеров (при возбуждении электронным пучком) регулярно возникает в каналах, хотя на рентгенограммах, снятых до и после возбуждения, нет никаких указаний на наличие дислокаций [573]. Было бы интересно сравнить деградацию этого материала с результатами Крессела и Байера. Байер [574] отметил, что деградация светодиодов из GaAs не очень чувствительна к плотности светового потока в р — n-переходе, если только не происходит повреждения зеркал. Крессел и Байер [531] подчеркивают, что, несмотря на различия, о которых говорилось для случая GaAsP (рис. 3.81), деградация, наступающая в результате старения, и деградация, связанная с действием ионизирующего излучения высоких энергий, имеют определенные сходные черты. Однако, помимо уменьшения г], что происходит без образования новых полос люминесценции в видимой или ближней инфракрасной области {hv > 1,0 эВ), радиационные повреждения GaP в противоположность деградации при старении уменьшают излучательное время жизни, не оказывая влияния на емкость р — «-перехода и на его вольт-амперную характеристику [575]. Если судить по уменьшению внешнего квантового выхода, соединение Gai_*AlxAs значительно меньше подвержено радиационным повреждениям нейтронами или у-излучением [575а]. Эта тенденция при малых х значительнее для уизлучения, и частично она объясняется теми же механизмами, по которым устройства из аморфных полупроводников относительно устойчивы к излучению {5756].
Барнс [576] показал, что деградация эффективности светодиодов из GaP, вызванная электронным облучением, пренебрежимо мала в тех областях вольт-амперных характеристик, где преобладает рекомбинация в области пространственного заряда (при низких смещениях область 2 на рис. 2.11). Это происходит потому, что скорость рекомбинации в'обедненном слое определяется расстоянием между квазиуровнями Ферми, определяемыми концентрациями основных носителей (рис. 2.1), тогда как рекомбинация в диффузионной области определяется временем жизни инжектируемых неосновных носителей—параметром, значительно более чувствительным к присутствию дефектов.
Фосфид галлия, облученный протонами, имеет непрерывное распределение уровней, простирающееся глубоко внутрь запрещенной зоны. Это распределение имеет место как до, так и после отжига при температурах в диапазоне 200—500 °С, после которого наблюдается существенное восстановление оптического пропускания и в значительно меньшей степени электрической проводимости [577]. Метод бомбардировки протонами можно использовать для создания изолирующих областей в приборах как из GaP, так и из GaAs [578]. Шейде и др. [579] исследовали влияние бомбардировки электронами с энергией 1 МэВ на светодиоды из GaAsi-xP* с помощью методов термостимулированных токов и измерения емкости р — я-переходов, о которых говорилось выше. При облучении дозой 1017 электронов на 1 см2 внешний квантовый выход снижался до значений, несколько меньших 10-7 при 300 К, и полностью исчезала зависимость от состава, характерная для точки, где происходит смена энергетической структуры полупроводника с прямозонной на непрямозонную (рис. 3.50, а). В этом случае опять не были зафиксированы полосы люминесценции, связанной с радиационными повреждениями (ни до, ни после отжига), в противоположность тому, что имеет место для Si [580] и алмаза [581]. Полосы же люминесценции, связанные с переходами на глубокие центры, были подвержены меньшему воздействию, чем краевая люминесценция; вероятно, это связано с процессом возбуждения и туннелирования, о котором говорилось выше [72]. После отжига в течение 2 мин при 500 °С в Нг значение кван
тового выхода достигало уровня, близкого к тому, который был до облучения и зависел от состава твердого раствора [совсем по-другому ведут себя безызлучательные процессы при старении (рис. 3.81)]. Низкотемпературный порог для процесса отжига снижался с 270 до 185 °С по мере увеличения х до значения, равного 0,4. Емкостные измерения выявили акцепторные центры с концентрацией (1 — 5) -1017 см-3, не зависящей от х. Полагают, что они-то и вызывают деградацию. Этот акцепторный уровень должен лежать близко к уровню Ферми внутри «-области, чтобы он мог определять большие изменения емкости. Таким уровнем может быть уровень, найденный в монокристаллах GaAs я-типа, лежащий на глубине ~0,14 эВ ниже Ес [582].
Другие разновидности центров с энергиями, отличающимися на 0,2—0,35 эВ от энергии края зоны, обнаруживаются при измерениях термостимулированных токов (рис. 3.81,6). Их концентрация сильно увеличивается с изменением параметра х в диапазоне 1015 — 4-Ю16 см~3. Возможно, это есть следствие меньшей энергии для замещения атомов Р. Данные центры не сильно влияют на квантовый выход светодиодов в отличие от центров, обнаруженных указанными методами в деградировавших диодах (рис. 3.81, а).
Из результатов работы, в которой существенная в ранних диодах быстрая и средняя по длительности деградация в инжекционных гетеролазерах связывается с образованием микроскопических дефектов под воздействием механического напряжения, можно предположить, что микроскопические процессы могут быть причиной явлений только медленной деградации. Их еще предстоит изучить более тщательно. На основании данных, приведенных на рис. 3.79, можно также заключить, что примесь Си значительно более вредна, чем последствия диффузии Zn или образования дефектов по Френкелю в светодиодах из GaP p-типа. Время службы даже непассивированных светодиодов из GaP, изготовленных в свободной от Си среде (определенное по падению г) до значения, равного 0,5ці при 25°С), может превышать 105 ч (рис. 3.79). Вероятно, в этом случае оно определяется другими механизмами. Расплавленный Ga является хорошим геттером для Си при температурах, превышающих 600 °С [553]. Как следует из кривой 3 на рис. 3.79, отжиг при этой температуре в той же печи для жидкостной эпитаксии из Ga, в которой выращиваются и р — я-переходы, значительно увеличивает срок службы красных светодиодов из GaP. Мы видели, что пассивация кислородом может дать еще более существенное и воспроизводимое улучшение срока службы светодиодов из GaP. Этот факт указывает на первостепенное значение прямой диффузии примесей в материалах для деградации.
Мы отметили, что с экономической точки зрения интересен метод изготовления светодиодов путем прямой диффузии нужных примесей в исходный материал. Помимо более низкого квантового выхода, общим недостатком диффузионных диодов (например, GaAs-светодиодов) [535] по сравнению с диодами, выращенными из расплава (разд. 3.2.10), можно считать малый срок службы. В работе [548] рассматриваются возможности повышения срока службы этих светодиодов с помощью двухтем - пературной диффузии Zn в сильнолегированный GaAs п-типа.
Краткое изложение результатов всех- рассмотренных выше работ по деградации — довольно трудная задача. Из сказанного выше можно проследить связь между особо вредными явлениями и механическими повреждениями материала. Само собой разумеется, что быстро диффундирующие элементы, такие, как Na и Си, должны быть исключены из среды, окружающей приборы во время их изготовления. Даже тогда, когда нельзя доказать, что они участвуют в создании конкретных безызлучательных рекомбинационных центров, они могут изменить профиль потенциала электрического поля р — я-перехода. Если имеется адекватное, удовлетворяющее требованиям гигиены оборудование, то необходимо, по-видимому, создавать такую технологию, при которой внутренние механические напряжения были бы сведены к минимуму. Если удается избавиться от быстрой начальной деградации, связанной с механическими напряжениями, то проявляются средние по длительности процессы деградации двойных гетеролазеров; они в основном определяются электромиграционными процессами. Оказывается, что очень малые градиенты параметра решетки, имеющиеся около гетеропереходов, или даже неверно выбранный профиль распределения примесей могут привести к значительным механическим напряжениям. Поэтому при изготовлении приборов методом диффузии примесей необходимо, соблюдая меры предосторожности, особенно тщательно делать гетеропереходы, которые являются составной частью активной области прибора. Необходимо также защищать активную область приборов с гомогенными переходами от влияния случайных полей механических напряжений, возникающих из-за неизбежных больших скачков постоянных решетки в местах электрических контактов, и от соединений с теплоотводом. И процесс получения большого начального квантового выхода, и деградация характеристик светодиодов — особо чувствительные явления по сравнению с некоторыми эффектами в чисто электрических твердотельных устройствах, поскольку светодиоды являются приборами, в которых основную роль играют неосновные носители. Как уже указывалось в начале этого раздела, до сих пор нам мало известно о микроскопических рекомбинационных явлениях, ответственных за Основную долю деградации, даже для хорошо изученных р — я-пе - реходов светодиодов.
В некоторых наименее хорошо разработанных типах электролюминесцентных устройств, описанных в разд. 3.5, в особенности в хорошо преломляющих бинарных соединениях SiC (разд. 3.5.1) и GaN (разд. 3.5.2), деградация очень мала. Некоторые приборы, такие, как устройства на основе тройных соединений со структурой халькопирита (разд. 3.5.2) и устройства, изготовленные методом ионной имплантации в соединениях AUBVI (разд. 3.5.3), находятся еще на том уровне развития, когда получено мало конкретной информации о сроках службы приборов. Вероятно, стабильность структуры этих систем низка по сравнению со светодиодами, изготовленными обычными методами на основе бинарных полупроводниковых соединений. Тем не менее, согласно неофициальным сообщениям, можно предположить, что ионной имплантацией могут быть получены некоторые устройства на основе соединений типа AUBVI со сроком службы — 1000 ч [585]. Знания о механизмах деградации электролюминесценции в более сложных приборах с гетероструктурами, которые описаны в разд. 3.5.4 и 3.5.5, еще более скудны, чем в случае р — «-переходов. Исследования порошковых электролюминесцентных ячеек из ZnS [584], изготовленных по методике, предложенной в работе [504], показали, что во время формовки, которой должны быть подвергнуты ячейки, происходит миграция Си. Весьма вероятно, что деградация происходит в результате длительного воздействия эффектов, связанных с процессом формовки. Эмпирические исследования позволили найти условия изготовления и условия работы устройств, при которых сроки службы превышали 1000 ч; при этом яркость свечения их была удовлетворительной для типичных цифровых дисплеев (рис. 3.76). Основную роль в существенном улучшении параметра, представляющего собой произведение яркости на срок службы, сыграло за последние несколько лет контролирование состава газовой среды, в которой находится светодиод после изготовления [511]. Оказалось, что как раз тот режим работы, который необходим для многозначных адресных X— Y дисплеев, не содержащих встроенной в панель памяти, обеспечивает их медленное старение. Режим работы таких дисплеев заключается в обновляемом сканируемом управлении, при котором элементы дисплея переключаются с помощью униполярных импульсов, поступающих с большой скважностью (степень заполнения — 0,5%) (разд. 3.5.5). Возможно, что при деградации происходит диффузия под воздействием поля, которая сдерживается в тех случаях, когда поле прикладывается на очень короткие промежутки времени — несколько микросекунд для типичной панели дисплея. Предварительные исследования старения светодиодов из ZnSe на барьерах Шоттки (МДП-структуры) [586] показали, что во время работы диодов происходит увеличение их последовательного сопротивления. Увеличение вызвано ростом изолирующего слоя диэлектрика (слой окисла), находящегося под золотыми контактами, под действием поля. Старение сводится к минимуму с помощью соответствующей непроницаемой оболочки из эпоксидной смолы, а также выбором условий изготовления, благоприятствующих появлению тонких, медленно растущих слоев диэлектрика. Сопротивление слоев определяется, как оказалось, процессами проводимости, ограниченной пространственным зарядом. Работа лучшего диода в течение 2000 ч при плотности тока ~2 А/см2 характеризовалась увеличением сопротивления на 9% при соответствующем уменьшении ND в ZnSe я-типа (диод был залит эпоксидной смолой). Измеренное уменьшение светового выхода при работе на постоянном токе составило — 20%, большая часть которого произошла в первые два часа. Таким образом, практически нет оснований сомневаться в том, что отсутствует какой-либо механизм, ограничивающий срок службы устройств, работающих на контактном барьере металл — полупроводник AnBVI. По крайней мере он не проявляется в процессе испытаний по определению их срока службы под током, т. е. в пределах нескольких десятков тысяч часов.

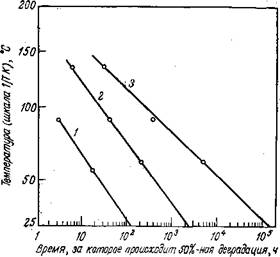
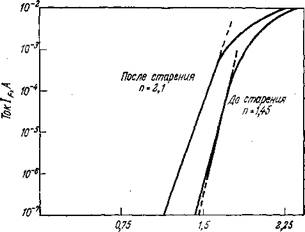

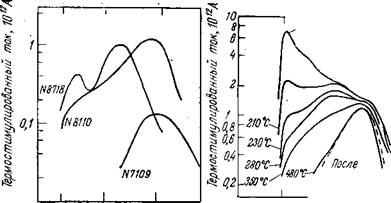



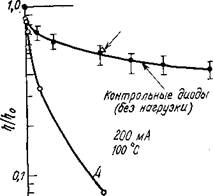

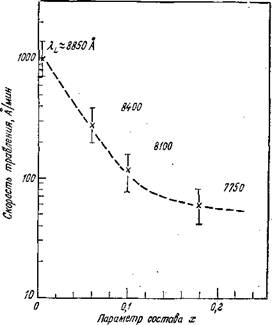
 Опубликовано в
Опубликовано в