ЭКСПОНИРОВАНИЕ
 4 ноября, 2013
4 ноября, 2013  admin
admin Экспонирование является самым существенным этапом при получении рельефов из пленок резиста — в них в результате этой операции создаются скрытые изображения. В фотолитографии
1
|
|
Рис. I. 3. Схема контактного и бесконтактного экспонирования:
1 — свет; 2 — маска; 3 — пространство между маской и слоем резиста (при контактном экспонировании минимальное, при бесконтактном имеет ширину » 10 мкм); 4 — фоторезист; 5 — диоксид кремния; 6 — кремний.
существует ряд методов экспонирования слоев фоторезистов УФ-светом в области 200—400 нм, генерируемого главным образом ртутными лампами; вводятся эксимерные лазеры [21].
В контактном методе шаблон максимально приближен к поверхности слоя резиста (рис. 1.3). В бесконтактном методе («контактная печать с зазором») между слоем резиста и маской остается зазор. В проекционном методе плоскости шаблона и слоя резиста оптически сопряжены с помощью проекционной системы (объектива). Первые два метода находят применение вследствие относительно низкой цены аппаратуры и простоты работы, возможности экспонирования больших площадей, что обеспечивает высокоэффективные групповые методы обработки изделий. Эти методы используют и в производстве сверхбольших интегральных схем для запоминающих устройств [22]. Проекционный метод более производителен и надежен, дает меньшую плотность дефектов и поэтому также широко используется в микроэлектронике. Существует ряд способов проекции, важнейшими из которых являются проекция в масштабе 1:1, сканирующий перенос щелью в масштабе 1:1, мультипликация (фотоповторение) в масштабах 1:1, 1 : 10 и др. [23, 24].
Во многих проекционных устройствах используют обычную оптическую систему как линзовую, так и зеркальную. Линзовая система экспонирования состоит из трех главных частей. Оптическая часть образована источником света (ксеноновая или ртутная лампа), конденсором и светофильтром; механическая часть — несущей рамой с маской; проекционная часть — объективом, подложкой с нанесенным фоторезистом, которые расположены на подвижном столе. Схема проекционной системы изображена на рис. 1.4. Светофильтр дает пучок шириной 10—15 нм, трансформирующийся оптической системой; он обеспечивает достаточную плотность энергии света на слое резиста. Несущая г-н—1 рамка с маской размещаются в плоскости, перпенди - S-r кулярной световому пучку, с допустимым отклонением менее 1 мкм [23].
|
о- |
Механическое движение и фиксация положения стола осуществляются специальным приводом,
j часто с оптическим контролем положения
меток совмещения, заранее нанесенных на
|
|
подложку. Вообще оптическое определение по-
4 ложения подложки осуществляется интерферомет-
5 рически (интерферометр Майкельсона), методом счета муаровых полос или по специальным меткам
6 совмещения.
|
|
Рис. 1.4. Схема проекционной экспозиционной системы:
“7_ / — источник излучения с зеркалом; 2 —конденсор; 3 — фильтр; 4 — мас - т? ка; б —несущая рамка маски; б —объектив; 7 — подложка со слоем фо« У торезиста.
Так как дорого и сложно производить объективы, способные дать высококачественное 1 : 1 изображение сразу на всей площади кремниевой пластины диаметром 7,5—10 см, то для этой цели используют мультипликацию и сканирующий перенос. Мультипликация дает возможность получать изображение с высоким разрешением и на большом поле. Она может быть использована для
изготовления элементов с размерами 1—1,5 мкм. Необходимость применения мультипликации обусловлена тем, что при прочих равных условиях объективы с повышенной разрешающей способностью имеют меньшее поле изображения и наоборот, тем самым для экспонирования с высоким разрешением больших площадей требуется пошаговое экспонирование всего поля. Эта система требует прецизионного механического движения подложки, дающего возможность шаг за шагом абсолютно точно совмещать изображение различных слоев на всей площади кремниевой подложки. Более низкая производительность мультипликации компенсируется лучшим качеством изображения; метод находит все более широкое применение [24].
|
|
При сканирующем переносе щели в масштабе 1 : 1 по всей площади кремниевой подложки (рис. 1.5, а) используется зеркальный объектив со сферическим зеркалом — система Micralin Perkin-
Elmer [23, 25]. Свет ртутной лампы проходит через конденсор и дугообразную щель шириной в несколько миллиметров, световая дуга проектируется объективом так, чтобы перекрыть подложку по всей ее ширине; маска и кремниевая подложка непрерывно движутся под этой дугой при помощи сканирующего механизма, который обеспечивает экспонирование подложки по всей ее длине. Так как разработанная оптическая система позволяет работать с минимальными искажениями, то это дает возможность производить схемы с элементами размером 1—1,5 мкм, отклонением
|
|
|
а 5 |
|
|
Рнс. I. 5. Принцип 1 : 1 сканирующего (а) н растрового {б) методов:
/ — маска; 2 —оптическая система; 3 —подложка; 4 — направление одновременного движения маскн и подложки.
±0,4 мкм при экспонировании светом с длиной волны 350— 430 нм. Высокая производительность (около 40 пластин в час) обусловила широкое использование этого проекционного метода в практике большинства ведущих зарубежных фирм.
В растровом методе используется узкий световой пучок, а сканирование проводится в двух взаимно перпендикулярных направлениях. Принцип растрового сканирования изображен на рис. I. 5,6.



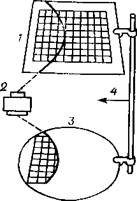
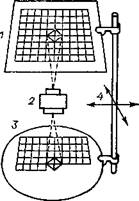
 Опубликовано в
Опубликовано в