ЖИДКОСТНАЯ ЭПИТАКСИЯ
 13 апреля, 2014
13 апреля, 2014  admin
admin Впервые возможности красных светодиодов из GaP были продемонстрированы с помощью 1%-ных светодиодов, изготовленных методом эпитаксии из жидкой фазы [137]. Хотя с тех пор приборы с такими характеристиками получены и другими методами (табл. 5.1), методом жидкостной эпитаксии обычно изготавливают светодиоды с наивысшим квантовым выходом. Этим методом получали также различные полупроводниковые соединения [138, 139]; затем он нашел широкое применение в промышленном производстве.
Эпитаксия из жидкой фазы — особый случай роста кристаллов из растворов. Основные стадии эпитаксии из жидкой фазы можно описать следующим образом. Сначала жидкий металл (например, Ga) насыщается при повышенной температуре полупроводниковым соединением (таким, как GaAs). Монокристал - лическая подложка из того же полупроводникового материала нагревается до той же температуры, что и расплав, пока растворенное вещество не будет равномерно распределено в расплаве (рис. 5.23, а). Затем подложка и расплав приводятся в соприкосновение (рис. 5.23,6). Если температуры подложки и расплава неодинаковы, часть подложки растворяется в расплаве или часть расплава выделяется в виде твердой фазы на подложке. Эпитаксиальное нанесение инициируется одновременным охлаждением расплава и подложки. По мере охлаждения расплав перенасыщается атомами As и, следовательно, мышьяк выделяется в твердой фазе в виде GaAs. В идеальном случае данный процесс идет только на подложке; при этом образуется слой, полученный эпитаксией из жидкой фазы. Рост кристалла можно остановить путем механического отделения подложки от расплава (рис. 5.23, б).
Сравнивая этот процесс с описанным выше процессом химического осаждения из газовой фазы, можно выделить следующие его особенности.
Рост кристалла происходит на границе раздела твердой и жидкой фаз, что обычно дает кристаллы с меньшей плотностью
|
|
|
Рис. 5.23. Стадии эпитаксии из жидкой фазы. а — насыщенный расплав и подложка нагреваются до начальной температуры 7*j; б — подложка перемещается до соприкосновения с расплавом и температура расплава понижается, прн этом происходит рост кристалла из пересыщенного расплава на подложке; в — подложка механически отделяется от расплава и процесс жидкостной эпитаксии заканчивается. |
|
6 в |
дислокаций, чем в подложке, на которой выращивается кри - сталл [140]. Это одно из наиболее важных преимуществ эпитаксии из жидкой фазы. Кроме более низкой плотности дислокаций, при росте из жидкой фазы обеспечиваются оптимальные условия для снижения плотности вакансий галлия в выращенном кристалле.
В кристаллах, выращенных из почти стехиометрического расплава, по методу Чохральского под флюсом, время жизни неосновных носителей обычно в 500 раз меньше, чем в кристаллах, выращенных из расплавов, обогащенных галлием [141]. Уменьшение времени жизни обычно сопровождается уменьшением внутреннего квантового выхода фотолюминесценции более чем на два порядка величины. Отклонение от стехиометрии в сторону обогащенных галлием расплавов снижает число вакансий галлия, что в свою очередь ведет к большим временам жизни и более высокому квантовому выходу [142].
При жидкостной эпитаксии перенос материала происходит в стационарной жидкости, а при химическом осаждении из газовой фазы перенос идет в потоке газа. Поскольку перенос ма - териала к подложке является основным фактором как для про - ( цесса, так и для оценки метода с точки зрения экономичности, рассмотрим его немного подробнее. Механизмами переноса материала в перемешиваемом расплаве являются конвекция и диффузия. Если плотность жидкой фазы выше в верхних слоях расплава, сила тяжести заставляет более тяжелую жидкость опускаться вниз. Конвекция наступает тогда, когда число Релея
R превышает критическое значение Rc. Для жидкости, контак - тирующей с двумя поверхностями твердой фазы, Rc ~ 1700 [143]. Число Релея можно выразить следующим образом:
R = g$ACw3/£,va, (5.31)
где g — ускорение силы тяжести, р — изменение плотности на единицу градиента концентрации, w — толщина слоя расплава, ДС — изменение, содержания растворенного вещества в пределах w, £—плотность расплава, v — кинематическая вязкость, а — коэффициент температуропроводности.
Снижение температуры расплава и уменьшение истощения расплава (в отношении атомов Р в случае жидкостной эпитаксии GaP) приводят к увеличению его плотности. Конвекция при этом возможна только в том случае, если подложка помещена над расплавом. Например, для расплава, состоящего из GaP в Ga, и подложки, плавающей поверх расплава, падение температуры на 25 °С от начальной температуры 1050 °С соответствует уменьшению концентрации атомов Р приблизительно на 1,2 ат.%- Для толщины слоя расплава, равной 5 мм, число Ре - лея равно
R = 980 • 0,4 • 1,2 • 0,53/б • 3 • 10“3 • 0,1 =3267.
Данное значение превышает критическое значение Rc почти в 2 раза, и, следовательно, конвекция в расплаве будет увеличивать перенос материала к подложке. Это частично объясняет, почему толщина слоя на плавающих подложках обычно больше, чем на погруженных подложках при одинаковых условиях эпитаксии из жидкой фазы [144].
В реальных установках подложка погружена в расплав либо горизонтально (рис. 5.23), либо вертикально (рис. 5.24). В обоих случаях преобладающим механизмом переноса массы вещества является диффузия атомов элементов V группы из расплава к подложке. Этот процесс, однако, не обязательно является процессом, ограничивающим скорость роста кристаллов. И зависимость процесса введения примесей [145], и зависимость процесса роста кристаллов [146] от ориентации подложки говорят о том, что в определенных условиях жидкостной эпитаксии скорость процесса ограничивается связанной с ним кинетикой, а не переносом массы.
Если расплав чист (свободен от нерастворившегося полупроводника и инородных частиц), то можно достичь значительного переохлаждения расплава, в котором кристаллизация будет идти только на подложке [147]. Если это условие выполнено и перенос массы является элементом процесса, ограничивающим его скорость, то скорость роста кристалла может быть описана диффузией атомов элементов V группы к поверхности раздела
|
Рис. 5.24. Схема установки для жидкостной эпитаксии с вертикальным погружением подложки. |
твердой и жидкой фаз. Теоретические расчеты существенно упрощаются, так как коэффициент теплопроводности расплава a fv 0,5 см2/с значительно выше, чем коэффициент диффузии атомов As или Р в расплаве (D « 5-Ю-5 см2/с). Поэтому можно предположить, что на расстояниях, сравнимых с диффузионной длиной растворенных атомов, расплав имеет одинаковую температуру. Для наиболее часто встречающихся условий жидкостной эпитаксии GaAs и GaP это предположение можно в действительности распространить на весь расплав. Одномерный расплав толщиной ад, охлаждаемый с постоянной скоростью г, имеет перепад температуры
Д T = w2r/n2K. (6.32)
Для типичной скорости охлаждения г <3°С/мин и толщины расплава w = 1 см АТ < 0,01 °С,
При рассмотренных выше предположениях избыточная концентрация растворенного вещества может быть рассчитана в любой точке расплава. В простом случае, когда ЬС/Ы является б-функцией времени, например когда подложки погружаются в пересыщенный расплав, можно непосредственно применить [149] соотношение, полученное для переноса тепла [148]. Градиент концентрации в расплаве толщиной w в момент времени / может быть записан в виде 00
2пХ+ j - ехр[— D (2 п + 1 fn2tjw2] • sin [(2 п + 1) nx/w],
, *-о (5.33)
где С — концентрация растворенных атомов, избыточная по сравнению с равновесной, на расстоянии х от подложки в расплаве, а С0 — начальная концентрация растворенных атомов в изотермическом переохлажденном расплаве. Значение Со можно перевести в температуру переохлаждения с помощью кривой ликвидуса. Концентрация растворенного вещества для слабых растворов полупроводников AHIBV при температурах, далеких от границ интервала [151], можно представить в виде
С = С0 ехр (— Т'/Т), 1(5.34)
где Т' — температура активации процесса растворения [151]. Значение Т' равна 1260 К для GaAs и 1510 К для GaP.
С помощью выражений (5.32) и (5.34) в любой точке расплава можно рассчитать степень пересыщения как функцию времени для любого произвольного цикла охлаждения [152]. Если переохлаждение велико и расплав (или контейнер) является местом, где образуются зародыши, часть полупроводника осаждается на подложке. В чистой системе возможно существенное переохлаждение, и в этом случае эффективность осаждения ограничена только процессом диффузии растворенных веществ. Определяя эффективность диффузии как долю избыточного растворенного вещества, осажденного на подложку (рост ограничен подложкой), можно получить следующие соотношения:
для ступенчатого охлаждения
/ = 2 (D//n)V. от», (5.35)
для равномерного охлаждения
f = 4 {Di/ф • ЗаГ1. (5.36)
Для обоих случаев на рис. 5.25 для растворенного в расплаве вещес;гва представлена функция безразмерного параметра Dt/w2. Из кривых видно, что эффективность осаждения прямо
|
|
|
OflZ |
|
III I |
|
0,01 |
|
1.0 |
|
10,0 |
|
з |
|
0,1 время Dt/w |
Рис. 5.25. Эффективность осаждения при ступенчатом (а) и равномерном (б) охлаждении расплавов толщиной w.
Кривая для равномерного охлаждения справедлива только при малых приращениях температуры. Формулы (5.35) (кривая а) и (5.36) (кривая б) применимы для малых значений эффективности [152].
"пропорциональна коэффициенту диффузии растворенного вещества и времени роста и обратно пропорциональна квадрату толщины, расплава. Следовательно, наиболее верный путь получения высокой эффективности осаждения состоит в уменьшении толщины расплава.
В заключение сравним два эпитаксиальных процесса с эко
|
J |
номической точки зрения. Легко видеть, что химическое осаждение из газовой фазы имеет преимущество перед обычным процессом жидкостной эпитаксии [138]. Для проведения процесса жидкостной эпитаксии требуются большие количества исходных материалов; насыщенные расплавы должны быть приготовлены для каждого цикла роста, а при химическом осаждении из газовой фазы из данного источника можно вырастить много слоев: производственная мощность системы для жидкостной эпитаксии обычно значительно ниже, чем системы для химического осаждения из газовой фазы. Многие из перечисленных выше недостатков метода жидкостной эпитаксии можно устранить, если использовать очень тонкие слои расплава
|
|

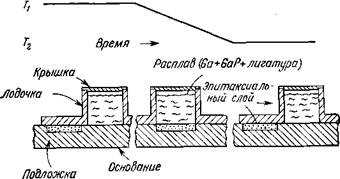


 Опубликовано в
Опубликовано в