Зависимость эффективности люминесценции и функции видности от состава твердого раствора
 21 марта, 2014
21 марта, 2014  admin
admin Как следует из модели виртуального кристалла, при изменении состава тройных твердых растворов внешний квантовый выход светодиодов часто не изменяется существенным образом, цока Г-минимум остается на (4—§) квТ ниже ближайшего не-
|
|
|
|
X
Рис. 3.50.
а — внешний квантовый выход светодиодов из GaAs^^P^. при 300 К в зависимости от параметра состава к, ие легированных азотом (сплошная линия) и специально легированных изоэлектроииыми ловушками N с концентрацией~ Ю18 см-3 (штриховая линия). Следует обратить внимание на изменение шкалы х для штриховой кривой, б —яркость светодиодов из GaAsj^^P^ в зависимости от X. Экспериментальные точки соответствуют плотности тока через диод, равной 4,4 А/см2 (рис. 3.54 и 3.58) [273].
прямого минимума (это видно из рис. 3.50, а в случае GaAsi-xP* [273]). При возрастании х энергетический зазор АЕ между Хс - и Гіс-минимумами уменьшается (рис. 3.49), и тройной, твердый раствор становится непрямозонным при хс ~ 0,45 или, согласно измерениям, проведенным в работах [143, 273а], при хс=0,49± ± 0,02 (Egc = 2,02 ± 0,03 эВ).
Эффективная масса электрона при увеличении х возрастает от значения tnQaAs для GaAs по закону
|
(3.36) |
™ ** «сыаД1 + Y*),
где y ж 0,5 [279]. Подвижность электронов резко падает при возрастании эффективной массы в области перехода к непрямозонному полупроводнику между х — 0,4 и X ~ 0,5 [143]. Это отражает различие в поведении электронов в Г - и Х-минимумах зоны проводимости в данных полупроводниках. Следствием этого является значительно меньшая электропроводность непрямозонного полупроводника я-типа при заданном уровне легирования, что необходимо учитывать при создании эффективных. светодиодов. Из исследований In. vGai__xAs, полученного эпитаксиальным выращиванием нз газовой фазы, — соединения, в котором не происходит изменения структуры зоны проводимости и который при всех л: остается прямозонным полупроводником,— вытекает, что статистический характер расположения атомов в подрешетке практически не влияет на подвижность электронов при 300 К [2796]. Это противоречит более ранним результатам, полученным для этой системы, которые в свою очередь отличаются от поведения близкой системы InAsi-^P*. Рассеяние на статистически распределенных в подрешетке атомах превосходит рассеяние на фононах ниже 120 К при х > 0,1, что согласуется с результатами, полученными из простой модели, в которой локальный рассеивающий потенциал определяется разностью значений ширины запрещенной зоны бинарных соединений.
Квантовый выход светодиодов на основе тройных твердых растворов в области составов, отвечающих непрямозонным полупроводникам, очень мал в основном из-за малой вероятности непрямых переходов по сравнению с прямыми [выражение (3.8)] и плохих электрических свойств полупроводника. В этом и следующих разделах мы покажем, что малый квантовый выход свойствен полупроводниковым твердым растворам, причем особенно важным является различие постоянных решетки бинарных соединений (разд. 3.4.5). Из рис. 3.50, а видно, что г]£ начинает падать уже при л: ^ 0,25 (300 К), т. е. значительно раньше момента перехода к непрямозонному полупроводнику (хс = 0,45). Такое поведение и в общем случае вид кривой на рис. 3.50, а могут быть объяснены простой теорией с подгоночным параметром [305], в которой предполагаются постоянными времена жизни носителей т как в прямом, так и непрямом минимумах зоны проводимости (большая часть света генерируется в p-области этих диодов, где неосновными носителями являются электроны; разд. 2.4). Значения времен жизни обычно определяются безызлучательными каналами рекомбинации. В теории рассматривается статистическое распределение электронов между двумя типами минимумов. В случае применимости больц - мановской статистики (невырожденный случай) и параболических зон отношение концентраций электронов, например в X-
и Г-долинах, определяется выражением
fx/fr = Мх KK)1'' ехР (- ЬЕ/квТ), (3.37)
где Мх — число эквивалентных долин (3 для минимумов Xic)- Величина Мчх (tnK/tnv) для GaAsi-ArP* довольно велика — около 13, а величина kBT при 300 К определяет плавную форму колена на рис. 3,50, а. Хакки [305] определил оптимальное значение состава следующим образом:
*opt = - Ьх (Рис- 3-50- б)> (3 38)
6x = AE'/(Sr-Sx),
где производные Sr = dEr/dx, Sx — dEx/dx (Sx < Sr) вычисляются при x — xc, если величины Ет и Ех нелинейно зависят от состава [272]. Величина ДЕ' — зазор между Г - и Х-миниму - мами, необходимый для сохранения заданного значения г|е/(г|е)г. Из-за быстрого возрастания функции видности краевой люминесценции в области энергий, перекрываемой GaAsi-^P^ (или Gai_*AUAs) при увеличении х (рис. 3.50,6), значение оптимального состава х оказывается больше, чем то максимальное значение, при котором це/("Пе) г еще остается близким к 1. Для GaAsi_xP^ Xopt « 0,40 [273] (рис. 3.50, б).
В лучших диодах при этом значении состава квантовый выход равен г|н « 0,2%; за последние несколько лет достигнуто лишь совсем небольшое его повышение. Указанная величина много меньше максимальных значений, полученных для этого же соединения в области прямых переходов, например равна 2,5% в приборах с полусферической геометрией и ограниченной площадью перехода [272а]. Вычисления функции видности для излучения в зависимости от энергии фотона и других факторов, касающихся оптимизации свойств светодиодов, предназначенных для визуального восприятия, рассмотрены в разд. 1.2 и 6.4. Ширина полосы люминесценции, быстро возрастающая с увеличением неоднородности состава твердого раствора [259] и с образованием «хвостов» в p-области перехода [273], влияет на величину функции видности для излучаемого света. Заметим, что пороговая плотность тока в инжекционных лазерах также обратно пропорциональна ширине спектров спонтанной люминесценции.
Хакки ввел также величину Sr/(Sr — 5X), связывающую уменьшение энергии кванта люминесценции для межзонных переходов с энергетическим зазором ДЕ'. Эта величина оказывается приблизительно равной 1,6 для GaAs^P* и чуть больше, 1 для In*Gai-*P—тройного соединения, которому в последнее время уделяется большое внимание [303а — ЗОЗд]. Таким. образом, если величина ДЕ' одна и та же для Ini_*Ga*P и
GaAs[_*P*, то энергетическая величина SrA£7(Sr—Sx) значительно меньше для первого соединения.
Эффективность светодиодов в области прямых переходов (рис. 3.50) определяется, как и в обычных светодиодах из GaAs, большой разностью между це и г]/ [уравнение (3.34)], обусловленной внутренним поглощением излучения. В работах [284, 304] описаны структуры из Gai_*AlxAs с переменным по толщине структуры составом, в которых самопоглощение существенно меньше благодаря тому, что р — я-переход расположен в области структуры с наименьшей шириной запрещенной зоны. Диршке [284] получил значение цЕ « 13% при 300 К и энергии фотона в максимуме спектра до 1,7 эВ в р — гг-нереходах, изготовленных диффузией Zn. При дальнейшем увеличении энергии фотона в максимуме спектра, согласно предыдущим рассуждениям [305], наблюдалось уменьшение квантового выхода по закону
Л/ = V[1 + Мх КК)3/! ехр (- ЩквТ)1 (3.39)
где т]в — внутренний квантовый выход в светодиодах из прямозонного полупроводника. Для красной люминесценции в области 1,8 эВ внешний крантовый выход составлял ~4%.
Арчер [285] ввел критерий световой эффективности — световую отдачу, определяемую величиной яркости на единицу плотности тока:
B/J ~27hvxVx, (3.40)
где B/J — световая отдача, кд/Л; V*. — функция видности (разд. 1.1.2) для света с энергией кванта hv, которая полагалась равной (Eg — 0,025) эВ; г] — квантовый выход. Далее он рассчитал зависимость возможного внешнего квантового выхода от энергии фотона для нескольких важных тройных твердых растворов соединений AInBv, использовав уравнение (3.37), чтобы получить величину
Ле-f [1 + + ШҐ - <3-41>.
где / — коэффициент пропорциональности между внешним и внутренним квантовыми выходами [уравнение (3.34)], который предполагался равным 1%; Mx(ml:/тгУ! з в УРапнении (3.37) предполагалось равным 50, а тНзл/тбезызл ~ 1 для электронов в Г-минимуме. В уравнении (3.41) эффективность излучательной рекомбинации для электронов в Х-минимуме предполагалась равной нулю при том же самом Тбезызл - Используя приведенные в табл. 3.4 значения ширины запрещенной зоны и состава, соответствующие моменту перехода к непрямозонному полупроводнику, Арчер построил зависимость световой отдачи от энергии
|
Таблица 3.4 Значения ширины запрещенной зоны (в электронвольтах) и состава, соответствующих переходу к непрямозонному полупроводнику, для некоторых тройных твердых растворов соединений типа AmBv при 300 К1)
J) Результаты взяты нз работы [285]. Индекс 0 означает прямозониый, а I — непрямо* зонный полупроводник, за исключением AI^Ga^XN, в котором обе зоны прямые, a (eg)GaN<(Eg)AIN- 2) Даииые, используемые Арчером [285], предпочтительнее данных, цитируемых Кра - фордом и др. [275], так как в последних предполагается, что наименьшие значении ширины запрещенной зоны для прямых н непрямых переходов в GaP равны соответственно 2,91 н 2,15 эВ, что, безусловно, неверно 117, 265]. |
3) Значения параметров полупроводника в точке перехода н величина в 1пР
обсуждаются в тексте. Здесь приведено меньшее нз двух значений состава в точке перехода, хотя ширина запрещенной зоны в этой точке приблизительно на 0,06 эВ меньше, чем считают другие авторы.
кванта (рис. 3.51). Очевидно, что твердые растворы на основе ІпР весьма перспективны для создания светодиодов в области от красного до оранжево-желтого цвета. Однако эти преимущества трудно реализовать из-за крайней сложности роста кристаллов. Излучательное время жизни в типичных диодах из прямозонных полупроводников в зависимости от уровня легирования Zn составляет 1—10 не и сравнимо с твезызл в диодах из твердых растворов, в то время как в хороших диодах из GaP и в высокоэффективных диодах из GaAs, легированных амфотер - ными примесями [307], безызлучательное время жизни приблизительно в 20 раз больше. Предсказываемые значения эффективности сильно зависят от отношения твезызл/тизл, в особенности когда переход к непрямозонному полупроводнику происходит в области быстрого изменения функции видности, как, например, в GaAsP и GaAlAs.
Зависимость квантового выхода фотолюминесценции от состава этих двух твердых растворов была исследована Алферовым и др. [285а] и более подробно проанализирована с учетом различия времен жизни тиепрям и тпрям в прямозонном и непрямозонном полупроводниках. Данные, полученные для образцов п - и p-типа, подтверждают результаты исследований действия
|
Рис. 3.51. Теоретические кривые для световой отдачи некоторых твердых растворов соединений типа AIHBV, рассчитанные для 300 К согласно уравнению (3.40); внешний квантовый выход для прямых переходов определялся по уравнению (3.41) [285]. В каждом случае быстрый спад кривых с уменьшением длины волны обусловлен не уменьшением чувствительности глаза (рис. 1.2), а переходом от прямозонного полупроводника к относительно низкоэффективному непрямозонному. Квантовый выход излучения для непрямых переходов полагался равным иулю. Это слишком грубое предположение, но оно хорошо аппроксимирует результаты для твердых растворов, не легированных кзо - электроннымн ловушками (рис. 3,54). К сожалению, очень трудно изготовить хорошие светодиоды с высоким квантовым выходом из GalnP и особенно нз АЦпР. |
одноосного сжатия на интенсивность фотолюминесценции: уменьшение энергетического зазора между Г - и Х-мииимумами зоны проводимости несущественно изменяет время жизни основных носителей (дырок), но сильно влияет на времена жизни неосновных носителей. В твердых растворах р-типа при 300 К тнепрям/тпрям » 10 для GaAsi-^Рл:, полученного методом газовой эпитаксии, и ~ 100 для Al*Gai-*As, полученного методом жидкостной эпитаксии. Как МЫ уже видели, Тнепрям определяется безызлучательными процессами. Такое резкое увеличение времени жизни для непрямых переходов в Al*Gai-*As приводит к расширению спектральной области, в которой получается высокий квантовый выход значительно дальше границы для видимого света (~1,8 эВ). Из-за большого значения тНзл для непрямых переходов уменьшение квантового выхода при возрастании энергии фотона в этом соединении начинается более резко, чем в GaAsi-vP* p-типа и в обоих твердых растворах я-типа. Зависимость для полупроводников n-типа аналогична зависимости, приведенной на рис. 3.50, а, и описывается уравнением (3.41) с постоянным тбезызл. Сравнительно небольшое значение отношения Тиеп'рям/тпрям в GaAs!_j:Px приписывается влиянию глубоких уровней, связанных с Х-минимумом зоны проводимости. Из приведенных дйнных следует, что p-область перехода играет важную роль при разработке светодиодов, особенно если учесть, что в кристаллах GaAs p-типа, полученных методом газовой эпитаксии, эффективность объемной люминесценции превышает эффективность излучения GaAs «-типа приблизительно в 30 раз. При использовании односторонней инжекции в гетероструктурах GaAs — GaAlAs, полученных методом жидкостной эпитаксии (разд. 3.4.6) [2856], был получен внешний квантовый выход ~ 1 % при 300 К вплоть до hv та 1,9 эВ ').
Крафорд и др. [283] получили сравнительно большие времена релаксации излучения (^5 не) для прямозонного GaAsP. Оказывается, что времена релаксации излучения часто возрастают с уровнем инжекции [284а]. Это обусловлено заполнением ловушек, связанных с дислокациями несоответствия, которые появляются даже в слоях с очень плавным изменением состава, выращенных на подложках из GaAs (разд. 3.4.5). Если путем улучшения качества материала можно будет увеличить время жизни, то даже в самом неблагоприятном случае твез ызл/Тизл ^ 0 в области непрямых переходов станет возможным соответственна увеличить квантовый выход. Улучшение качества материала оказывается чрезвычайно сложной задачей; как будет показано ниже, статистический характер распределения атомов в подрешетке твердых растворов накладывает определенные ограничения на свойства кристаллов. Мы увидим, что наибольший прогресс был достигнут благодаря некоторому увеличению отношения Тбезызл/тизл ~ 0 в области непрямых переходов при введении того же активатора N, который был столь успешно использован для получения эффективной краевой люминесценции в GaP (разд. 3.2.7).
О некоторых достижениях в. создании совершенных твердых растворов соединений AIHBV, не легированных азотом, можно судить по значениям световой отдачи, приведенным в табл.3.5.
‘) Алферов Ж. И. и др. в гетероструктурах GaAs — Gai-^AbAs получили внешний квантовый выход до 40% при 300 К (Письма в ЖГФ, 1977, т. 3, - вып. 14, с. 657). — Прим, ред.
~ Таблица 3,5
Наибольшие значения световой отдачи светодяодов из различных материалов при 300 К
|
Световая |
||||
|
Материал |
Цвет |
отдача, кд/А |
Литература |
|
|
GaAsP |
Красный |
0,055 |
[273] ') |
|
|
GaAsP : N |
Оранжево желтый |
0,014—0,021 |
[283] |
|
|
A! GaAs |
Красный |
0,034 |
[284] 1)2) |
|
|
GalnP |
» |
0,017 |
[285] ь2) |
|
|
Оранжевый |
0,069 |
[286] |
||
|
» |
0,106 |
[150] |
||
|
Желтый |
3,4. Ю-4 |
[146]2) |
||
|
» |
0,24 |
[312] *'2) |
||
|
GaP : Zn, 0 |
Красный |
0,31 |
[164] г) |
|
|
0,051 |
' [144] ’'2) |
|||
|
GaP : N |
Зеленый |
1,03 |
[117] 2) |
|
|
» |
0,17 |
[84] !'2) |
||
|
Желтый |
0,086 |
[134]') |
||
|
GaN : Zn |
» |
0,01 |
[288] |
|
|
Синий |
0,001 |
[288] |
||
|
SiC : 4H |
» |
7-10-1 |
[289] |
|
|
SiC:6H |
Желтый |
0,0034 |
[5, 290] |
|
|
Уо,74^Ь0,25ЕГ(),оіОС1 NaY0>57Ybo,39Ero, o4F 4 |
Красный |
0,001 |
[291 ] 3) |
|
|
Зеленый |
0,0041 |
[291а] 3) |
||
|
Yo,65Ybo,35Tmo, ooiF3 ZnS (МДП) |
Синий |
8-Ю-' |
291 ] 3) |
|
|
» |
3,4- 10 |
293] 4) |
||
|
ZnSe (МДП) |
Желтый |
0,068 |
294] ’) |
|
|
ZnS : Mn |
Желто оранжевый |
0,21 |
295]4) |
|
|
ZnTe : О (МДП) |
Красный |
0,0041 |
296]4) |
|
|
ZnTe (МДП) |
Зеленый |
0,0068 |
296]4) |
|
|
ZnSe: Mn |
Оранжевый |
0,068 |
297]4) |
|
|
ZnTe |
Зеленый - |
0,068 |
298] 4) |
|
|
Антрацеи (плотность ~ 1 мА/см2) |
Синий |
0,0017 |
[299] |
|
|
ZnS : Tb |
Зеленый |
0,0021 |
[300] |
|
') Дноды получены диффузией Zn. 2) Диоды изготовлены методом жидкостной эпитаксии (свободная кристаллизация в [312]). 8) Оценка для диода нз GaAs с г «#2% прн плотности тока 10 А/см2. Комбинация ИК-светодиода нз GaAs и люминофора (разд. 4.3). 4) Уменьшено относительно приводимых авторами значений в qVfhv раз. |
Примечание. В случае, когда результат вычислялся по измеренным значениям квантового выхода, значения, соответствующие светодиодам из монокристаллов с малым внутренним поглощением, обычно уменьшались в 3 раза из-за учета условий вывода света.
Значения световой отдачи для красного светодиода из GaP : Zn,0 с квантовым выходом 5% и зеленого светодиода из GaP ; N с квантовым выходом 0,25%, приведенные в табл. 3,5,
|
Мо/іьная до/ія А1Р х Рис. 3.52. Зависимость ширины запрещенной зоны для наинизших прямых (Г8->-Гі) и непрямых (Г8->-^і) переходов в AUIni-rP от состава х по данным катодолюминесценции [ЗОЗг]. |
Так как ширина зоны для прямых переходов резко увеличивается с возрастанием X н приближается к ширине зоны для непрямых переходов в области, где относительная функция вндностн также сильно возрастает при увеличении х (рнс. 1.2), то теоретическая кривая зависимости световой отдачи от состава (виизу) оказывается очень узкой; в расчете предполагалось, что квантовый выход для непрямых переходов равен нулю [285].
были уменьшены в 5 и 3 раза соответственно из-за растекания излучения в непрямозонных полупроводниках по большой площади (разд. 6.1.5, 6.2.3). Если нас интересует прежде всего полный световой поток, а не поверхностная яркость (это важно для индикаторных светодиодов в отличие от монолитных цифровых индикаторов), эти множители использовать нельзя, и тогда светодиоды из GaP более предпочтительны.
В тех соединениях, у которых зависимость ширины запрещенной зоны для прямых переходов от состава очень сильная (как в GalnP и особенно в АПпР), оптимальный состав ограничен очень узкими пределами (рис. 3.52). Это приводит к необходимости такой степени контроля состава, которую трудно осуществить при выращивании этих твердых растворов: в них. СИЛЬНО отличаются атомы III группы, образуются нерегулярны^
растворы, а рост кристаллов, очевидно, происходит в таких термодинамических условиях, при которых появляются области несмешиваемости. Вопрос о том, будут ли разработаны промышленные светодиоды из этих интересных твердых растворов, пока остается спорным.
Ряд последних работ посвящен контролю эпитаксиального выращивания GalnP из газовой фазы [146, 279а], жидкой фазы [287, 308, 309] и из расплава [149]. Основной трудностью контроля состава при выращивании из расплава любых тройных твердых растворов, бинарные компоненты которых сильно различаются по теплоте образования (например, GalnP и GaAlP), является то, что из-за большого коэффициента распределения более легкого атома III группы между твердой и жидкой фазами используется лишь малая часть диаграммы состояний [310].
Нуезе и др. [150] получили оранжевую люминесценцию р — «-переходов в Ini^GaArP, выращенном методом газовой эпитаксии на подложках из GaP путем плавного изменения состава твердого раствора. Внешний квантовый выход достигал 0,1%, а световая отдача 0,106 кд/А. Немного больший квантовый выход при несколько худшей воспроизводимости был получен прямым осаждением твердого раствора с х « 0,5 на подложку из GaAs, соответствующую ему по параметру постоянной решетки (разд. 3.4.5); световая отдача в красной области спектра (энергия кванта — 2,0 эВ) достигала,0,11 кд/А [311]. В слоях' с медленно изменяющимся составом, выращенных эпитаксией из газовой фазы на подложках из GaP [310а], получено когерентное оранжевое излучение с длиной волны в диапазоне 610,5— 615 мм при значениях плотности порогового тока до 4000 А/см2 (77 К) и с наиболее короткой длиной волны 598 нм. Высокая пороговая плотность тока (~7-104 А/см2) при к = 0,6 препятствует непрерывному режиму генерации даже при 77 К. Нуезе и др. [311] указывают, что р — «-переход в этом соединении необходимо изготавливать не диффузией Zn в эпитаксиальные слои «-типа (разд. 3.2.10), а в процессе выращивания из газовой фазы; кроме того, они отмечают, что средние и высокие уровни легирования р - и «-областей, требуемые для изготовления инжекционных лазеров, неблагоприятно влияют на квантовый выход светодиодов. Преципитация наблюдается уже при концентрациях [Zn]^> 3-Ю18 см"3 и [Se]3> Ы0П см-3 (в первом случае она обусловлена образованием Zn3P2). Таким образом, оптимальные концентрации легирующих примесей составляют ~ 1018 см”3 для Zn и ~1017 см"3 для Se, т. е. гораздо меньше, чем в GaAs (рис. 3.35). Интенсивность нежелательной широкой полосы, люминесценции, находящейся на 0,4—0,5 эВ ниже ширины запрещенной зоны, быстро возрастает как с увеличением
концентрации [Se], так и с увеличением х. Окуно, Суто и Ниши - зава [312] получили при таком же квантовом выходе световую отдачу выше 0,24 кд/А в желтой области спектра для диода с х — 0,68 в твердом растворе, выращенном из обогащенного индием расплава (несмотря на то что р — я-переход был получен диффузией Zn). Значение квантового выхода гораздо больше того, которое может быть получено с помощью GaAsP или GaAlAs (табл. 3.5).
Анализ, проведенный Хакки, полезен при обсуждении поведения тройных твердых растворов в области составов, соответствующих прямым межзонным переходам. Однако он не дает удовлетворительного описания их поведения во всей области составов, которые соответствуют непрямым переходам, так как предположение постоянства тх и г]* часто неверно для составов, близких к непрямозонному бинарному соединению. Например, данные работы [273] (рис. 3.50, а) не совпадают с данными разд. 3.2, где для квантового выхода г)аар приведено значение ~0,002%, в то время как в светодиодах из GaP : N могут быть легко получены значения больше 0,1% [133]. В действительности расхождение даже еще больше, чем показано на рис. 3.50, а, так как излучение, зарегистрированное в работе [273], включает, кроме краевой люминесценции, также полосу люминесценции, лежащую на 0,37 эВ ниже Eg. Однако возможно, что в работе [273] данные для х 0,9 определялись состоянием технологии изготовления светодиодов из непрямозонных твердых растворов, в которой не используется легирование азотом.
Небольшие добавки As (~1%) вызывают резкое уменьшение квантового выхода красных светодиодов из GaP: Zn,0 [313, 314] и зеленых светодиодов из GaP : N [314] (штриховая линия на рис. 3.50, а). По-видимому, это уменьшение не связано с образованием явных макроскопических дефектов в процессе роста кристаллов (дефектов упаковки, дислокаций) при добавлении As [314]. Действительно, в работе [315], посвященной исследованиям GaP, показано, что слои с большим квантовым выходом, выращенные методом жидкостной эпитаксии, могут быть получены на подложках с большой плотностью дислокаций, причем г| уменьшается только приблизительно в 3 раза при возрастании плотности дислокаций, которые могут прорастать в эпитаксиальный слой, от 102 до 105 — 106 см-2. Стрингфеллоу и Грин [142] показали, что лишь декорированные дислокации приводят к существенному уменьшению квантового выхода фотолюминесценции. Напротив, Эттенберг [315а], исследуя светодиоды из GaAs, обнаружил, что дислокации уменьшают диффузионную длину неосновных носителей L, если они не декорированы, независимо от того, были ли они вызваны рассогласованием при гетероэпитаксиальном выращивании из жидкой фазы (разд. 3.4.5). Это явление заметно только тогда, когда среднее расстояние между дислокациями становится меньше L, что соответствует плотности дислокации больше 5-Ю6 см-2 для типичного материала при 300 К. Эти результаты согласуются с исследованиями топографии фотолюминесценции с высоким разрешением, из которых следует, что образованные механическими деформациями свежие дислокации гораздо сильнее гасят фотолюминесценцию GaAs во всей области спектра, чем «зрелые», дислокации, образовавшиеся при выращивании [3156]. Последние вызывают искажение формы спектров люминесценции, обусловленное главным образом сильным уменьшением концентрации акцепторов вблизи дислокаций. Общий квантовый выход уменьшается в 2—3 раза, возможно, из-за влияния электрических полей на распределение электронно-дырочных пар, возбужденных светом [3156]. Дислокации скольжения могут усиливать безызлучательную рекомбинацию благодаря характерным для них болтающимся связям. Резкое увеличение широкой полосы люминесценции в области 1,3 эВ (она связана с комплексами донор — вакансия; разд. 3.4.4) после отжига при 600 °С позволяет предположить, что дислокации могут двигаться и образовывать стабильные конфигурации, создавая при этом значительное число вакансий. Образующиеся комплексы дислокаций могут быть аналогичны комплексам, предложенным Хорн - стра [315в]. Кроме того, возможно, что болтающиеся связи насыщаются примесями, что приводит к сильному уменьшению безызлучательной рекомбинации через дислокации. В ранних исследованиях плотности дислокаций в слоях, полученных методом жидкостной эпитаксии, Ладани и др. [165] отметили, что их плотность может быть уменьшена по крайней мере до 10% уровня ~5-105 см-2, типичного для выращенного под флюсом GaP. Лютер [313] получил квантовый выход г) « 1,5% для красной электролюминесценции в эпитаксиальных слоях, выращенных из жидкой фазы на затравки, предварительно полученные из газовой фазы на подложках из GaAs, в которых первый слой материала (толщиной 0,5 мм), загрязненный As, удалялся перед эпитаксиальным выращиванием.
Сильное гашение люминесценции (штриховая линия на рис. 3.50, а) не зависит от того, содержится ли As в одной или обеих областях перехода; таким образом, оно не связано с небольшим макроскопическим несоответствием постоянных решетки между GaP и GaAs*Pi_* при х <i 0,01 [314]. Для таких малых значений х при 300 К можно пренебречь изменением коэффициента инжекции, обусловленным скачком Eg в переходе, асимметрично легированном As. Точный механизм, приводящий к уменьшению квантового выхода, остается пока неизвестным. Однако в этих исследованиях было, показано, что в присутствии малых количеств As коэффициент инжекции в красных и зеленых диодах из GaP уменьшается вследствие резкого увеличения компоненты тока рекомбинации через глубокие состояния в области пространственного заряда; этот ток преобладает в области малых смещений на р— п-переходе (рис. 2.11). Время релаксации электролюминесценции не зависит от содержания As; это подтверждает предположение о том, что уменьшение квантового выхода люминесценции при добавлении As ие связано с уменьшением времени жизни неосновных носителей в активной области прибора (обычно p-области перехода). Так как эти явления практически не наблюдаются в прямозонных твердых растворах с небольшим содержанием Р (рис. 3.50) или А1 [338], можно заключить, что соответствующие безызлучатель - ные уровни в области пространственного заряда связаны скорее с непрямыми минимумами зоны проводимости, чем с минимумом в точке Г, в котором эффективная масса мала. Интересно, что в работе [285], в которой обсуждаются потенциальные возможности светодиодов из прямозонных твердых растворов, рекомбинация в области пространственного заряда и безызлучатель - ные туннельные токи не рассматриваются совсем. Эти компоненты тока привлекаются для объяснения резкого уменьшения г| в зависимости от ї в светодиодах из прямозонного GaPi_xAsx, выращенного методом жидкостной эпитаксии [339]. Влияние малых добавок As или In на ц в GaP качественно аналогично явлениям, наблюдаемым при деградации светодиодов из GaP и GaAs (разд. 3.6).
Крафорд [143] высказал предположение, что почти не зависящий от состава квантовый выход в GaAsi_*Px при х < 0,3 получается в некоторой степени случайно, несмотря на значительное ухудшение качества кристаллов и уменьшение внутреннего квантового выхода при возрастании х в этой области составов. Это, вероятно, получается потому, что результаты, подобные кривым на рис. 3.50, обычно получаются при создании р — п-переходов методом диффузии Zn в режиме, подобранном для GaAso. ePcM; в этом случае подвижности носителей и, следовательно, диффузионные длины неосновных носителей оказываются много меньше, чем в GaAs или в твердых растворах с малыми значениями х. Таким образом, квантовый выход светодиодов при малых х может (в некоторой степени) ограничиваться режимом диффузии и усилением безызлучательной рекомбинации в поверхностном слое р+-типа. Из измерений при 77 К, в которых эти явления не проявляются из-за существенно меньшего диапазона изменений L„, обычно следует, что г) уменьшается с возрастанием х в области х < 0,3 и резко падает вблизи перехода к непрямозонному полупроводнику. Итак, мы вынуждены признать, что получение результатов типа кривых
на рис. 3.50, не искаженных какими-либо эффектами, уменьшающими максимальный квантовый выход светодиодов из твердых растворов, является чрезвычайно сложной задачей; в большинстве экспериментальных работ, опубликованных к настоящему времени, она решена лишь частично.
Качественно подобные механизмы рекомбинации в слое пространственного заряда привлекались также для объяснения малого квантового выхода в светодиодах из GaP, полученных методом газовой эпитаксии [340]. Показано, что неизбежная при эпитаксиальном выращивании GaP на подложках из GaAs высокая плотность дислокаций [341] частично определяет эти безызлучательные переходы [313, 340], хотя для красных эпитаксиальных слоев GaP, выращенных из газовой фазы на по. п ложках из GaP [342], также получаются низкие значения квантового выхода, что связывается с трудностью получения необходимой концентрации О в слоях при газовой эпитаксии [3426]. Тем не менее чрезвычайно малый квантовый выход низкотемпературной краевой фотолюминесценции для нелегированиого GaP, полученного методом газовой эпитаксии, по сравнению с образцами, полученными методом жидкостной эпитаксии, свидетельствует о том, что слоям, выращенным из газовой фазы, присущи дополнительные ограничения (фотолюминесценция исследовалась в эпитаксиальных образцах обоих типов и в кристаллах, полученных свободной кристаллизацией в установке для газотранспортного выращивания, с использованием как галоидных соединений, так и влажного водорода). Обычно малые значения квантового выхода в материале, полученном методом газовой эпитаксии, связывают с безызлучательными центрами — дефектами стехиометрии (вероятно, вакансиями Ga), хотя до сих пор существование этой связи экспериментально не доказано.
Фотолюминесценция прямозонных х умеренно легированных твердых растворов соединений AmBv при 300 К связывается с межзонными переходами [316, 317] (табл. 3.3), как в GaAs (разд. 3.3.5). Кроме того, в полупроводниках с большими значениями эффективных масс и ширины запрещенной зоны (как в непрямозонных, так и в прямозонных) экситонные эффекты в краевой люминесценции проявляются даже при 300 К (разд. 3.2.7). В работе [317а] сообщалось об экситонной электролюминесценции в прямозонном соединении AnBVI ZnSe n-типа при 300 К - Межзонный механизм переходов сохраняется и в значительно сильнее легированных твердых растворах /г-типа, в которых появляются хвосты зон и вырождение электронов (рис. 3.45). Лоренц и Блейксли [282] проанализировали результаты для GaAsi_[6]P*: они обсудили соотношение между фото - и электролюминесценцией в отнбсительно сильно легиро-
ванном материале, который используется для создания эффективных светодиодов. Пики электролюминесценции обычно несколько сдвинуты в область меньших энергий, что указывает на участие примесей в рекомбинации (это, например, обнаружено в GalnP [149]). Действительно, при средних уровнях легирования, используемых для изготовления некогерентных источников света, часто наблюдаются два пика электролюминесценции. Пик с наибольшей энергией соответствует краевым переходам, в которых некоторую роль играют хвосты, обусловленные заполнением доноров при вырождении [273] '). Вторая линия расположена на ~15 мэВ ниже в GaAs и на ~33 мэВ ниже в GaAso,6Po,4- Полагают, что эта линия определяется рекомбинацией на акцепторах Zn, энергия ионизации которых в случае GaAs уменьшается из-за более сильного легирования цинком; в GaAs диффузионная длина электронов велика, так что в светодиодах, изготовленных диффузией цинка, большая часть рекомбинации идет в поверхностном слое p-типа. Из-за искажения спектра, обусловленного самопоглощением излучения [282] (рис. 3.46), пик электролюминесценции обычно лежит на 20— 30 мэВ ниже пика фотолюминесценции материала р-типа, полученного диффузией Zn. Крессель и др. [342а] показали, что при низкой температуре в спектрах, кроме линии межзонной люминесценции, которая преобладает в спектре относительно слабо легированного Ino. sGao. sP, содержатся три полосы. Эти линии - соответствуют рекомбинации на донорно-акцепторных парах и переходам свободных носителей на связанные состояния (зона— примесь). При очень малом уровне легирования энергии ионизации примесей, полученные из положения этих линий, близки к соответствующим значениям энергий в InP [212].
Неопределенность связи спектров краевой люминесценции с краем поглощения положила начало обсуждению точного вида зонной структуры Ga. tIni_^P вблизи перехода к непрямозонному полупроводнику. Одна группа авторов склоняется к значениям х — 0,74, Eg = 2,26 эВ в точке перехода [149, 285, 318, 319], а другая группа указывает х = 0,63 и Eg « 2,17 эВ [136] или Eg « 2,14 эВ [320] при 300 К - В некоторых работах приводятся промежуточные значения: так, например, Нуезе и др. [146] получили хс — 0,70 и Eg = 2,20 эВ. Это противоречие можно объяснить тем, что параметр нелинейности зависимости ширины прямой запрещенной зоны от состава этого твердого раствора определяется по-разному и отсутствуют данные о точном положении Х-минимума зоны проводимости в InP; обе величины
влияют на форму кривой на рис. 3.51, вычисленной для GalnP. Для твердых растворов, которые выращиваются легко (например, GaAsP) [ЗОЗг], таких расхождений не существует, хотя непонятно, обусловлены ли все расхождения различиями и недостаточной точностью контроля состава в разных лабораториях. Бахрах и Хакки [136] отмечают, что преобладание термически заселенных Г-минимумов в оптических явлениях вблизи перехода к пепрямозонному полупроводнику приводит к некоторой трудности в интерпретации и требует обращения к зависимости свойств полупроводника от давления. Другой проблемой при сравнении значений состава, соответствующих переходу к непрямозонному полупроводнику, и ширины запрещенной зоны в этой точке, полученных разными авторами, является существование сильной зависимости энергетических зазоров между различными минимумами зоны проводимости от температуры. В GaAs — ЕС «г 0,38 эВ при 300 К [321] и -—- 0,47 эВ при 2 К [322]; в ІпР эти значения равны ■— 0,8 эВ при 300 К [323] и 0,96 эВ при 8 К [324], в то время как в GaP они равны —0,53 эВ при 300 К и —0,545 эВ при 4 К [265]. Таким образом, во всех случаях прямой минимум сдвигается при изменении температуры сильнее, чем непрямой минимум. Если это верно, то приведенное выше значение ширины запрещенной зоны в точке перехода для GalnP при комнатной температуре согласуется со значением, полученным при исследовании фотолюминесценции при 80 К [325].
Непрямой энергетический зазор Гу — Хс в InGaP часто представляют слабонелинейной или линейной функцией состава. Однако в GaAsP (рис. 3.49) обнаружена существенная нелинейность этой зависимости. Так как приближение виртуального кристалла к InGaP применимо хуже, чем к GaAsP, проведенные рассуждения указывают на возможность существования заметной нелинейности как в прямом, так и непрямом зазорах твердых растворов InGaP. На основании полученного Онтоном и др. [324] значения Е% — можно предположить, что в 1пР ширина запрещенной зоны для непрямых переходов Е% — Е£ равна ~2,38 эВ, т. е. на 0,04 эВ больше, чем в GaP!
В самых последних исследованиях зависимости коэффициента Холла и электрического сопротивления In^Ga^P п-типа от давления [325а] предлагается интересный возможный путь «примирения» различных взглядов на структуру зоны проводимости этого соединения. На наборе образцов прямозонных твердых растворов с различным составом обнаружены особенности, обусловленные междолинным переносом электронов при сближении Г-, X - и L-минимумов по мере увеличения гидростатического сжатия, которые можно объяснить следующим образом.
|
Рис. 3.53. Зависимость ширины запрещенной зоны для наинизших прямых (Гв-»-Гі) и непрямых (Гв->^і, Гв-*-/,) переходов B'lni-^Ga^P от состава х при 300 К. Эти данные получены нз измерений явлений переноса в IИ j Qa^P п-типа под действием гидростатического сжатия [325а]. из измерений эффекта Холла при высоких давлениях [1481; из измерений, проведенных в работе [І491; —оценка линин А по данным работы [149а]. |
Во-первых, при х = 0,63 (Eg да 2,17 эВ) твердый раствор становится непрямозонным с наинизшим L-минимумом (а не Х-ми - нимумом). Затем при х да 0,75 (Ее да 2,26 эВ) следует второй переход между L - и Х-минимумами. Эта модель была подтверждена исследованиями зависимости края оптического поглощения от давления, количественные результаты которых отличаются от результатов ранних исследований [ЗОЗд]. С помощью приведенной на рис. 3.53 зонной структуры можно «примирить» большую часть наиболее надежных оптических данных. Например, поведение запрещенной зоны в точке Г согласуется со спектрами электроотражения [320], а увеличением зазора между L - и Х-минимумами при х = 0,7 можно объяснить резкий изгиб зависимости энергии изоэлектронной ловушки N от состава [3256]; это явление, не наблюдающееся в GaAsi_*Px [326], иначе остается необъясненным. Различные температурные зависимости этих трех энергетических зазоров усложняют определение моментов перехода между Г-, L-, Х-минимумами зоны проводимости при 77 К [3266]. В частности, энергетический зазор между ними становится во много раз меньше, чем при 300 К, а значение состава, соответствующего переходу между Г - и L-минимумами, существенно возрастает; таким образом объ-' ясияется возможность оптического наблюдения прямых переходов при 77 К вплоть до х = 0,7 [3256, 331]. Однако следует отметить, что данные на рис. 3.53 все еще остаются под сомнением, главным образом положение L-минимума [325в].



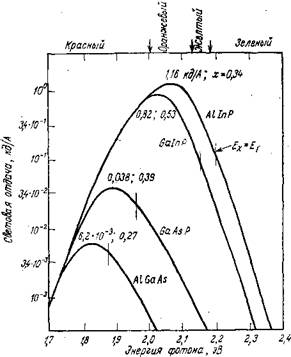
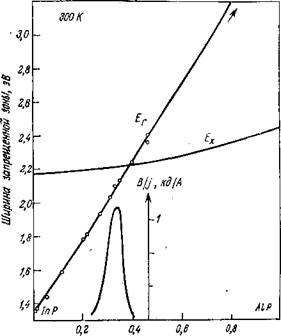

 Опубликовано в
Опубликовано в