Светочувствительные полимерные материалы
 1 ноября, 2013
1 ноября, 2013  admin
admin Б. Беднарж, А. В. Ельцов, Я. Заховал, Я. Краличек, Т. А. Юрре
Среди большого разнообразия материалов, используемых современной радиоэлектроникой и полиграфией, фото-, электроно - и рентгенорезисты занимают особое положение. Они предназначены для проведения литографии — создания под действием излучения на поверхности подложки в виде рельефного изображения топологии будущей радиоэлектронной схемы или полиграфической печатной формы. С этих технологических операций и начинается длинная цепь этапов производства радиоэлектронных, в том числе и микроминиатюрных, приборов. Если учесть, что размеры элементов современных радиоэлектронных схем составляют менее 1 мкм, то очевиден высокий уровень требований к совокупности свойств таких материалов. Без резистов была бы невозможна современная микроэлектроника.
Фото-, электроно-, рентгенорезисты — это чаще всего композиции из органических полимеров и веществ, чувствительных к излучению. Создание таких композиций представляет собой сложную задачу, решаемую на стыке органической, коллоидной и физической химии, химии и физики высоких энергий и полупроводников, а также других наук.
Коллективы ученых и исследователей крупнейших радиоэлектронных и полиграфических фирм мира создали многие тысячи композиций, защищенных патентами, и выполнили большой объем исследований по всестороннему изучению химических свойств и превращений резистов в модельных и приближенных к практике условиях. Анализу этих научных и прикладных работ в области фоторезистов были посвящены широко известные книги: Дина - бург М. С. «Светочувствительные диазосоединения и их применение» (М.—Л.: Химия, 1964), «Введение в фотолитографию» под ред. В. П. Лаврищева (М.: Энергия, 1977); Kosar J. «Light-Sen - seitive Systems. Chemistry and Application Nonsilver Halide Photographic Processes» (New York; Wiley, 1965); De Forest W. S. «Photoresists: Materials and Processes» (New York: McGraw-Hill, 1975).
Из-за высоких требований к материалам только немногие из выполненных разработок нашли применение в производстве, однако необходимость совершенствования микроэлектронных приборов и полиграфических систем требует резкого улучшения параметров фоторезистов, качественного изменения их свойств. Например, стремление к повышению разрешающей способности полимерных рельефов обусловило переход от систем, чувствительных к коротковолновому УФ-свету, к композициям, изменяющим свои свойства под действием пучка электронов, т. е. к электронорези- стам. Такое состояние разработок материалов и их развитие требует систематического рассмотрения работ, динамики изменения областей приложения усилий ученых, переосмысливания известных фактов и наблюдений.
В настоящее время для создания рельефных слоев — печатных форм в полиграфии — нашли применение так называемые фотополимеры— продукты индуцированной светом полимеризации ненасыщенных (в основном с этиленовыми связями) мономеров и олигомеров. Техническая литература по этим материалам весьма обширна. Она может явиться предметом отдельной монографии. Научные же основы процессов и классификация материалов удачно даны в обзоре, опубликованном в книге Jacobson К., Jacobson R. Imaging Systems. (London, New York; Focal Press, 1976)[1].
По этой причине авторы сочли нецелесообразным помещать специальный раздел о фотополимерах в данной монографии, осветив только в гл. III новые разработки по фотоотверждению эпоксисоединений светочувствительными ониевыми солями. В монографии не отражены и работы в области одной из самых старых групп фоторезистов — хромированных коллоидов, например систем на основе желатины и бихромата калия. Они до сих пор имеют большое практическое значение; вопросы по химии, технологии и применения рассмотрены недавно в гл. 6 книги Крюкова А. И., Шерстюка В. П., Дилунга И. И. «Фотоперенос электрона и его прикладные аспекты» (Киев: Наукова думка, 1982).
Цель настоящей книги — рассмотрение химических и некоторых физических аспектов литографии, а также обзор современного состояния и тенденций развития резистов для отдельных литографических приложений, особенно для микроэлектроники. Книга написана в содружестве ученых Ленинградского технологического института имени Ленсовета и Пражского технологического института, работающих в области материалов для литографии. Введение, гл. I и VIII и Приложение написаны докт. Я. Заховалом и проф. Я. Краличеком (Прага); гл. II и III и разделы VI. 1—VI. 3 — проф. А. Ельцовым (Ленинград); гл. IV и V и разделы VI. 4— VI. 6 — канд. хим. наук Т. Юрре (Ленинград); гл. VII — докт. Б. Беднаржем и проф. Я. Краличеком (Прага); перевод чешской части выполнил канд. техн. наук А. Н. Егорьков.
Авторы выражают благодарность инженеру Я. Девятому (Прага) за проработку части патентов по электронным резистам, канд. техн. наук Е. А. Никанчиковой, Б. Н. Котлецову, Ю. Г. Тур - кевичу, а также канд. хим. наук Б. Г. Герасимову и В. М. Чудно - вой за ценные замечания, сделанные по прочтении рукописи, инж. В. Н. Багал — за участие в подборе патентов и публикаций по фоторезистам, инж. Н. В. Кузнецовой и 3. П. Кожевниковой — за большую техническую работу с рукописью и с патентами в области фотолитографии.
Термин литография (от греческого lithos — камень, grapho — пишу) первоначально служил для обозначения способа печати, в ротором в качестве печатной формы использовался шлифованный известняк. На его гидрофильную (смачиваемую водой) поверхность при помощи жирового карандаша вручную наносили рисунок. Олеофильные места изображения смачивались гидрофобной печатной краской, в то время как свободная поверхность известняка, увлажненная водой, печатную краску не воспринимала. Печатная краска с литографического камня (первой формы плоской печати) с помощью прижима переносилась на бумагу. Перед каждым нанесением краски поверхность известняка снова смачивали водой.
Принцип избирательной лиофилизации поверхности был распространен на многослойные металлические подложки, у которых слои различных металлов отличались по гидрофильности. При стравливании верхнего слоя по определенному рисунку образовывалось рельефное изображение, одни элементы которого (один металл) воспринимали олеофильную краску, а вторые (другой металл) ею не покрывались.
Если при травлении образуется выпуклый рельеф (высота около 5 мм), как это получается при травлении цинковых или магниевых пластин, то можно получить печатную форму для высокой печати. Печатная краска переносится с рельефа на бумагу тисканием. В противоположном случае печатная краска переносится на бумагу с вытравленных углублений, и речь тогда идет о глубокой печати.
Для того чтобы провести стравливание по определенному рисунку, необходимо защищать места, которые не следует подвергать травлению, слоем материала, устойчивого при этой химической операции. Такие материалы называют резистами (англ. resist— устойчивый). Если резист является светочувствительным и это свойство удается использовать для создания слоя резиста с нужным рисунком, то такой резист называют фоторезистом.
Принцип создания негативных и позитивных изображений под действием света отражен на рис. 1. Основой фотолитографии является такой результат взаимодействия света (обычно в области 340—430 нм) со светочувствительным компонентом фоторезиста, который обусловливает изменение физико-химических свойств участков экспонированного слоя, не защищенных маской (шаблоном), в первую очередь — растворимости и летучести. Это дает возможность при последующем проявлении удалить или неэкспонированные места (негативный процесс А), или экспонированные (позитивный процесс Б), и тем самым получить рельефное изо
бражение в слое резиста. Полученный таким образом рельеф («контактная маска») служит затем защитным слоем при селективном травлении или металлизации поверхности подложки в открытых местах, что дает возможность перенести рельефное изображение на подложку. Степень соответствия элементов изображения имеющимся на шаблоне, использованном при экспонировании, служит мерой качества литографического процесса в целом. Тем не менее, последующие операции с первичным изображением также влияют на конечный результат, что заставляет весь литографический процесс рассматривать комплексно [1].
|
|
Использование фоторезистов в полиграфии дало возможность фотомеханического изготовления не только рельефных, но и плоских печатных форм. При печати с плоских форм печатная краска с гидрофильных печатающих элементов может переноситься на бумагу при помощи промежуточного валика. Такой способ печати называется офсетной печатью. В офсетных печатных формах в качестве гидрофобных печатающих элементов могут быть использованы непосредственно слои фоторезиста, или фоторезист может быть
Рис. 1. Принцип негативных и позитивных светочувствительных слоев:
А — негативный процесс; Б — позитивный процесс; / — резист; 2 — слой диоксида кремния; 3 — кремнии.
|
подложек, в которых |
маской для травления полиметаллических после смачивания один металл, например хром, служит гидрофильной частью, а другой — медь — гидрофобной. При использовании монометаллических пластин, в частности алюминиевых, контакт поверхности алюминия с некоторыми светочувствительными слоями вызывает их каталитическое разложение. Для предотвращения этого поверхность алюминия окисляют (часто с помощью анодирования), а также обрабатывают специальными составами; механическое зернение способствует лучшей адгезии резистного слоя. Светокопировальные составы применяют для изготовления не только собственно печатных форм, но и шаблонов, в том числе и в цветной печати. Разработка резистов для изготовления полиграфических форм развилась в самостоятельное направление, привлекающее активное внимание исследователей [2].
Травление по рельефу, созданному резистом, было использовано впервые вскоре после второй мировой войны для серийного производства проводниковых схем в электротехнической промышленности. Они получили название «печатные схемы» пли «печатные платы», поскольку тиражировались способами, применяемыми в полиграфии. Большинство печатных плат производилось сначала сеткографией, заключающейся в образовании изображения посредством продавливания на подложку полимерного материала (печатной краски) через тонкую сетку. На поверхности подложки
тонкие капельки раствора полимерного материала сливаются, образуя рельеф требуемой конфигурации, служащий резистом для травления меди. Историю развития этой области техники подробно описал в своей книге Де Форест [3]. Использование фоторезистов дало возможность повысить разрешение рельефа и автоматизировать производство печатных плат.
Повышение требований к технологии литографии и фоторезистам произошло примерно 30 лет назад благодаря резким изменениям в технологии производства электротехнических устройств и гриборов.
|
|
Роль фотолитографии в полупроводниковой технике становится ясной, если обратиться к рассмотрению транзистора с р—«-переходом. Искусственное резкое изменение типа доминирующей примеси в части объема кристаллического полупроводника ведет к
|
|
|
Рис. 2. Схема отдельного биполярного р—п—р - транзистора' |
I — диоксид кремния; 2 — кремний; 3— эмнттер; 4 — база; 5 — коллектор.
Рис. 3. Принципиальный способ исполнения униполярного МДП-траизистора:
/ — исток; 2 — затвор; 3— диоксид кремния; 4 — сток; 5 — кремний; 6 — область объемного заряда полупроводника.
появлению р—«-переходов. Биполярный транзистор составлен из двух взаимосвязанных р—«-переходов, взаимодействие между которыми обеспечивает база (рис. 2). Эмиттер образован областью полупроводника с очень высокой концентрацией акцепторных примесей р++, база имеет значительную концентрацию доноров «+, а коллектор образован полупроводником с низкой концентрацией примесей в p-области. Присоединение проводников осуществляется при помощи омических контактов, р—«-Переход может быть использован для образования четырехполюсного электронного элемента, способного регулировать ток на выходе без потери мощности. Регулировка осуществляется приложением напряжения на входе, образованном р—«-переходом, включенном в непроводящем направлении. На рис. 3 изображена основная структура униполярного транзистора, управляемого объемным зарядом (6‘) и затвором на изолирующем слое Si02 (5) подложки (МДП-транзи - сторы), реализованная в плоскости.
Соединение активных и пассивных элементов посредством проводников образует интегральную схему. Увеличение плотности размещения элементов схемы за счет уменьшения их размеров примерно ДО 104 на 1 мм2 (микроминиатюризация) дало толчок СъчШлиу развитию электроники (микроэлектроника). В микробе для производства интегральных схем используется в
основном кремний, в частности, потому, что его диоксид образует изолирующий слой для последующего введения примесей в требуемые области кремния. Кроме диоксида кремния Si02 применяются и другие диэлектрики, например нитрид кремния Si3N4. Резкое увеличение плотности элементов оказалось возможным только в результате развития фотолитографии на базе использования фоторезистов. На кремниевую подложку со слоем диэлектрика наносят резист и проводят экспонирование. Так как схемы имеют малые размеры, то на каждой отдельной подложке одновременно изготовляют ряд схем, поэтому экспозиционная маска (шаблон) часто содержит соответствующее число изображений одного типа. На кремниевую подложку нанесены метки, предназначенные для точного совмещения маски перед экспонированием.
Полученное в результате фотолитографии рельефное изображение шаблона в слое резиста (негативное или позитивное), нанесенного на слой диоксида или нитрида кремния, находящийся на кремнии, служит защитной маской при вытравливании этих диэлектриков до кремния; в эти окна при последующих операциях идет диффузия примесей в кремний. При этом получают требуемые характеристики отдельных транзисторов и схемы в целом. Большая интегральная схема содержит десятки тысяч транзисторных элементов, соединенных проводниками: алюминием или поли- кристаллическим кремнием с высоким содержанием примесей. Для образования сложной интегральной схемы литографический процесс надо проводить несколько раз, при этом каждый элемент схемы должен быть воспроизведен с требуемой точностью [4].
Первая интегральная схема была изготовлена в I960 г. фирмами Fairchild Semiconductor и Texas Instruments (США). Результатом этого революционного открытия служит современное использование микроэлектронных устройств в вычислительной технике, приборах связи, медицинской аппаратуре, бытовой электронике и, к сожалению, в военной технике. Средний размер электронного элемента, составлявший в 1976 г. 8 мкм, снизился в 1982 г. до 2 мкм, а в 1985 г. предполагается производство субмикронных элементов [5].
Одно из новых направлений в электронике определяется развитием приборов с зарядовой связью (ПЗС). ПЗС состоит из систем электродов, размещенных на поверхности диоксида кремния, который нанесен на кремниевую подложку или получен на ней окислением. Изменение потенциала этих электродов образует в соответствующих областях кремния уровни потенциала. Каждый свободный заряд вблизи поверхности кремния находится на самом нижнем из доступных потенциальном уровне. Если потенциалы под соседними электродами разные, то заряд постепенно переносится к электроду, который имеет самый низкий уровень потенциала. Система тактовых импульсов, подаваемых поочередно на электроды, сдвигает этот уровень с низким потенциалом вдоль поверхности. Считываемый с последнего электрода сигнал поочередно приносит информацию о заряде под каждым электродом,
тем самым обеспечивая трансляцию записанной в виде заряда информации. Эта система часто требует субмикронных размеров (около 0,5 мкм) всех элементов. Создание электродов и их соединение может быть проведено только при помощи микролитографии. В ряде случаев отпадает необходимость диффузии, требуется лишь напыление металла на область электродов и соединений. С уменьшением размеров элементов интегральной схемы одновременно повышается их число на единице поверхности, возрастает функциональная емкость, причем цена микросхемы остается в среднем постоянной. В целом, следовательно, снижается цена отдельной функции. Такая тенденция выдвигает постоянно растущие
|
ТАБЛИЦА 1. Ограничение интегральных схем, обусловленные физическими и литографическими факторами
|
требования к достижениям физики, созданию масок и схем, а следовательно, и к литографии [6].
Плотность размещения элементов схемы и размер интегральных схем на основе кремния ограничены физическими и литографическими факторами, из которых одни определяют нижнюю, а другие верхнюю, границу (табл. 1). Так как указанные физические пределы до сих пор еще не достигнуты в реальных устройствах, «кремниевая технология» может развиваться и далее в сторону микроминиатюризации. В оптоэлектронике размер объемных элементов структур может быть значительно меньше указанных и приближается к молекулярным; их можно создавать также с помощью литографии.
В современных промышленных устройствах для экспонирования используется свет с длиной волны 360—430 нм; из-за его дифракции предел разрешения составляет около 1 мкм. Так как уменьшение размеров элементов приводит к росту информационной емкости схемы, то усилия исследователей направлены на повышение разрешающей способности литографии. Дифракция довольно существенно снижается с уменьшением длины волны света, поэтому в последние годы разрабатывается экспонирование УФ-светом с длиной волны до 210 нм [коротковолновая УФ-лито - графия (гл. VI)]. Далее используют двух - и трехслойные резист - ные системы, в которых нижний слой Планаризует, а верхний тонкий слой служит для экспонирования (гл. VIII). Эти методы имеют то достоинство, что с помощью существующей аппаратуры и приемов работы удается достичь разрешения менее 1 мкм.
Дальнейшим шагом по пути уменьшения длины волны экспозиционного пучка (и предела разрешения) явился переход к электронной, рентгеновской и ионной литографии. Все виды литографии объединяют термином актинолитография. При экспонировании пучком электронов экспериментально достигнуто разрешение 0,1 мкм, а рентгеновским излучением — 0,02 мкм. Новые виды актинолитографии требуют создания, освоения и использования дорогостоящего оборудования, что приводит к большим капиталовложениям [7].
Литографические свойства резиста определяются рядом факторов (гл. I). Полимеры для негативных фоторезистов обычно линейны, их ММ 103—106. Из их растворов в летучих растворителях формируют на подложке пленки микронной и субмикронной толщины. Необходимо, чтобы светочувствительный компонент поглощал в области эмиссии используемого источника света, а изменение физико-химических свойств пленки, требуемое для создания различий в свойствах экспонируемых и иеэкспонируемых участков в расчете на 1 квант света, было как можно большим, так как оба фактора определяют время экспонирования. Полимерный рельеф должен иметь хорошую адгезию к подложке, чтобы исключить подтравливание краев при последующих операциях травления подложки (растворами сильных кислот или щелочей), а также уменьшить пористость слоя.
Несколько типов фоторезистов образуют базу традиционной фотолитографии. Еще в 1852 г. запатентовано [пат. Великобритании 565] использование смеси бихроматов с желатиной; экспонирование такого слоя светом делает освещенные места нерастворимыми в воде, они служат печатающими элементами в малотиражной факсимильной печати. Материалы этого типа («хромированные коллоиды») применяются и сегодня, непрерывно совершенствуясь в связи с новыми областями применения. Затем были использованы и другие негативные резисты, разработанные А. Мури в 1931 г. Вначале светочувствительная система основывалась на фотодимеризации коричной кислоты и ее производных в матрице природных пленкообразующих смол (копала, кумароновых и других подобного типа), использовавшихся для предотвращения кристаллизации коричной кислоты. Эфиры коричной кислоты и поливинилового спирта [пат. США 2725372, 2690966] явились первым типом нового поколения фоторезистов, появившихся на международном рынке в 1953 г., — KPR (Kodak Photo Resist) (гл. IV). В 1950 г. были описаны позитивные резисты на основе о-хинон - диазидов и новолачных смол [пат. Великобритании 708384] (гл. II), а в 1955 г. — негативные резисты, образование рельефа которыми основано на сшивании природного и синтетического
каучука диазидами [пат. Великобритании 767985] (гл. V). Известны и другие резисты.
Резисты можно разделить на 2 группы. У резистов первой группы фотолиз низкомолекулярного компонента вызывает химические изменения в полимерной составляющей (инициирует полимеризацию, сшивает или деструктирует полимеры и т. д.). У резистов второй группы низкомолекулярный светочувствительный компонент действует как ингибитор растворения и его фотолитическое превращение ведет к повышению скорости растворения полимерного компонента. В обоих случаях между двумя компонентами фоторезиста осуществляется тесное взаимодействие.
Создание и исследование резистов продолжается до сих пор с целью разработки материалов с оптимальными свойствами. Получены резисты для электроно - и рентгенолитографии, разрабатываются материалы для ионной литографии (гл. VII). Решающую роль в росте производительности литографии может сыграть повышение чувствительности резистов, поэтому с целью достижения большей светочувствительности в новых разрабатываемых позитивных резистах используется термическое усиление первичных процессов в результате каталитического действия продуктов фотолиза светочувствительного компонента на гидролиз пленкообразующего полимера. Разрабатываются новые типы резистов: стойкие к ИХТ, для создания чувствительных к коротковолновому УФ-свету планаризационных слоев, для создания слоев и проявления без участия растворителей (сухие резисты) (гл. VI). Очевидно, для развития микроэлектроники необходимо создавать новые резисты, выдвигая и используя перспективные идеи. Особенно важно находить эффективные фотореакции и на этой основе получать резистные композиции. Так, относительно недавно была обнаружена и изучена высокая светочувствительность ониевых солей органических соединений элементов пятой и шестой групп; использование полученных результатов в литографии позволило ввести в обиход в качестве полимерного компонента эпоксидные смолы (гл. III). Важным материалом для литографии оказались также полиолефинсульфоны.
Резистные слои полифункциональны; как мы уже видели, они не только защищают поверхности при травлении, но служат также печатающими элементами в печатных формах, избирательное поглощение излучения резистными слоями используется в масках и фильтрах. В настоящее время установлено, что пленку резиста можно применять в качестве электроизоляционного слоя, что требует повышения ее термостойкости. Недавно были разработаны фоторезисты-диффузанты (гл. VI), которые совмещают в одном материале стойкость к травлению и способность к диффузии примесей в подложку. Несомненно, в дальнейшем будут выявляться и широко использоваться другие свойства высокоразрешенных рельефных полимерных слоев.

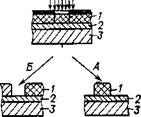

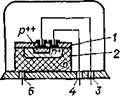
 Опубликовано в
Опубликовано в