Расчет скорости рекомбинации
 2 марта, 2014
2 марта, 2014  admin
admin В полупроводниках, специально легированных с целью увеличения вероятности излучательной рекомбинации с энергией, близкой К Eg, край полосы поглощения может иметь сложную форму. Это показано на рис. 3.4 на примере GaP, легированного азотом. Для прямозонных полупроводников, например GaAs, отсутствует точное аналитическое выражение для плотности состояний в «хвостах» примесных зон, которые возникают при высоких уровнях легирования, необходимых для получения эффективных светодиодов (рис. 2.6). Поэтому скорость-рекомбинации удобно выражать через коэффициент межзонного поглощения, который можно определить экспериментально.
При термодинамическом равновесии и в предположении отсутствия вырождения и единичного квантового выхода Ван Рус-
|
Рис. 3.4. Край полосы поглощения нелегированного GaP н GaP: N (N = = 7-1018 см-3) при 2 К.. Мощная узкая линия А связана с образованием связанных экснтонов, а структура при энергиях, равных или больших А%, возникает из-за наложения поглощения на атомах N с образованием связанных экснтонов, свободных экснтонов и электронно-дырочных пар. Слабые лиини NN связаны с ближними парами атомов азота. Стрелками указаны фонои - ные повторения с участием Х*фоионов (с сохранением импульса) и Г-фоиоиов (центр зоны) [22]. Концентрация азота N указана по шкале работы [86]. |
брек и Шокли [19] на основе принципа детального равновесия получили для скорости рекомбинации R выражение
|
Я = |
|
(3.8) |
|
c2h3 |
|
ап2и2 du е“- 1 |
где и = hv/kBT. Выражение (3.8) можно использовать для вычисления формы спектра люминесценции при данной температуре, если известна зависимость а от hv.
В условиях стационарного возмущения (оптическое возбуждение, инжекция неосновных носителей через р — я-переход и т. д.), вызывающего отклонение от теплового равновесия, скорость рекомбинации растет как
-^возбужд
= (np/nf)R. (3.9)
Время жизни при небольшом увеличении концентрации носителей относительно равновесной равно
ПоРо
|
В полупроводнике с |
1 ~ R (По + ра) • (ЗЛ°)
собственной проводимостью Т = th/2R.
|
Рис. 3.5. Спектры рекомбинационного излучения для прямых и непрямых меж* зонных переходов в Ge. Спектр при 70 К для непрямых переходов с участием продольных акустических фоноиов получен экспериментально. Кружками обозначены значения, рассчитанные для переходов обоих типов' из данных по поглощению. Величины По. п и р обозначают концентраций свободных носителей соответственно в прямом и непрямом минимумах зоны проводимости и в максимуме валентной зоны. |
Таким образом, вероятность излучательной рекомбинации В = Rim пропорциональна коэффициенту поглощения. Кроме того, константа А в выражении (3.3) обычно более чем в 103 раз превышает В в выражении (3.6). Поэтому для собственного излучения Янепр Должно быть намного меньше Япрям, как это показано на примере экспериментальных данных для Ge (рис. 3.5) [20]. Обнаружено, хорошее согласие эксперимента и теории, использующей экспериментальные данные по поглощению [21], которые в свою очередь хорошо описываются выражет ниями (3.1), (3.3), (3.6) и (3.7). Теоретическая и экспериментальная формы полосы собственного излучения в InSb приведены на рис 3.6. Расчет проводился для-прямой рекомбинации без учета образования экситона в предположении, что газ электронов вырожден, а газ дырок невырожден. В этом случае
/ (Av) ~ v2 (hv — Eg)'k exp [— (hv — Es)fkBT X
X {exp[(/*v -Eg - Ep)JkBT] + 1>,, (3.11)
4,2 К [23].
|
|
|
a S |
|
Рис. 3.6. Спектры фотолюминесценции чистого InSb (а — 5-1013 см-3) при |
|
Энергия сротона, мэВ |
а — межзонные нзлучательные переходы, преобладающие при малых концентрациях примеси; б—экспериментальная форма спектра излучения ( ) и------------------------------------------------------------------------------- теоретически рассчитан
ная (—С)—) для прямых межзонных переходов без учета образования экснтонов.
При Ер S [(m*h + m^)/m*] kgT такая форма спектра хорошо описывает линию примес*
ного излучения с энергией 228 мэВ на рис. 3.6, а которую можно представить как прямую рекомбинацию свободных электронов из зоны проводимости с вырожденным распределением носителей с дырками на акцепторах Zn.
где I (hv) — интенсивность излучения, a EF — уровень Ферми для электронов. Вероятно, такая ситуация имеет место в прямозон - кых полупроводниках типа АП1ВУ, в которых эффективная масса электронов мала и/я*<С/Яд, так что энергия ионизации доноров очень мала и вырождение электронного газа наступает при низком уровне легирования (;>,1015 см~3 для InSb и ^,1017 см-3 для GaAs) или при низком уровне инжекции.
Вероятность излучательной рекомбинации имеет большое значение с точки зрения квантового выхода светодиодов, поскольку излучательные переходы конкурируют с безызлучательными. Некоторые из безызлучательных механизмов можно считать «собственными», подразумевая под этим то, что'они возникают вследствие высокой концентрации свободных носителей в той области полупроводника, где происходит излучательная рекомбинация. Примером безызлучательного механизма такого типа служит оже-рекомбинация (разд. 3.2.4 и 3.2.5), которая в случае непрямозонного полупроводника может определять верхний предел квантового выхода светодиодов в соответствии с концентрацией носителей, допустимой с точки зрения хороших электрических характеристик диода. Другие типы безызлучательных переходов, обусловленные в основном рекомбинацией на глубоких примесных уровнях или других дефектах решетки, также играют существенную роль в полупроводниковых соединениях
с практически достижимой степенью чистоты и совершенства; эти механизмы часто ограничивают время жизни неосновных носителей. Даже в германии (вероятно, наиболее совершенном полупроводнике, который можно получать сейчас) время жизни неосновных носителей, обусловленное непрямыми межзонными переходами, составляет ~2 с [24], тогда как экспериментальные значения для материала самой высокой чистоты не превышают ~100 мс [24а]. Точная природа остаточных дефектов, которые оказывают такое сильное влияние на скорость безызлу- чательной рекомбинации, а также соответствующие механизмы рекомбинации часто недостаточно изучены даже в хорошо исследованных полупроводниках. Неясным остается механизм, ответственный за большие (иногда ~ 1(Н5 см2) сечения безызлуча - гельного захвата, которыми обладают нейтральные центры с глубокими уровнями типа Аи и Zn в Si, на что было указано в обзорной статье по примесным механизмам рекомбинации [25], хотя и в этой области в последнее время наметился некоторый прогресс [48а] (разд. 3.6).
Сложные центры с уровнями вблизи середины запрещенной зоны являются особенно эффективными центрами рекомбинации вследствие их устойчивости по отношению к термической ионизации.

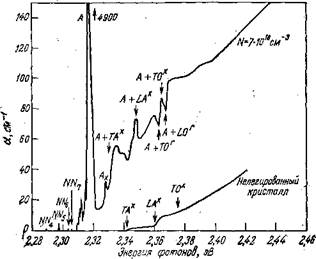

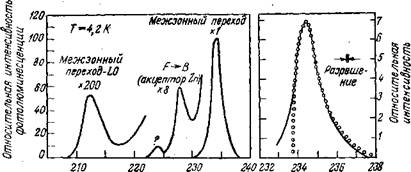
 Опубликовано в
Опубликовано в