Применение светодиодов с гетерострунтурой в качестве инжекционных лазеров
 24 марта, 2014
24 марта, 2014  admin
admin На гетерогранице между подложкой из GaAs и слоем Gai-.rAljcAs происходит резкое изменение ширины запрещенной зоны Eg: это отличает приборы с так называемой гетероструктурой. Хотя светодиоды с гетероструктурой и инжекционные лазеры в настоящей книге специально не рассматриваются, мы. кратко упомянем об успехах, достигнутых в последнее время в области увеличения эффективности лазеров, в которых используются уникальные свойства этой системы твердых растворов. Хорошее согласование постоянных решетки GaAs и AlAs дает возможность создавать приборы с чрезвычайно низкой концентрацией неидентифицированных безызлучательных рекомбинационных центров, которые обычно появляются на резкой границе между областями кристалла с сильно отличающимся составом (разд. 3.4.5).
Известно, что, когда ао резко изменяется, около границы между фазами появляется большая концентрация дислокаций несоответствия и что из-за разности коэффициентов термического сжатия при охлаждении кристалла после выращивания может образоваться дополнительное число дислокаций. Декорированные дислокации уменьшают хе в GaAsi-xP* [142] и GaAs [376], а недекорированные дислокации начинают играть важную роль при больших плотностях (>5-106 см-2) [315а].
В плавном гетеропереходе плотность этих дефектов может уменьшаться обратно пропорционально ширине переходного слоя [341, 364]. Если полная величина рассогласования, которое надо компенсировать, не очень велика, можно избежать сильного ухудшения качества материала [310а]. Напряжения изгиба могут быть уменьшены выбором профиля состава [341]. Лютер [313] показал, что величина квантового выхода красных светодиодов из GaP, изготовленных методом жидкостной эпитаксии путем однократного погружения подложек п-тнпа, выращенных из газовой фазы, не сильно зависит от плотности дефектов упаковки (их плотность уменьшалась по экспоненциальному закону при увеличении расстояния от стороны подложки, находившейся в контакте с затравкой из GaAs в процессе выращивания из газовой фазы). Однако он обнаружил заметное уменьшение т} с увеличением концентрации остаточного алюминия на первой стадии наращивания из газовой фазы.
Для импульсных лазеров с односторонней гетероструктурой на основе Gai-^AUAs можно получить пороговую плотность тока jt меньше 9000 А/см2 при 300 К [377а, 3776, 378]. Это достигается благодаря усилению инверсного распределения электронов, которое возникает вследствие ограничения инжектированных неосновных носителей в области между р — «-переходом в GaAs и гетерограницей GaAs — Gai_*Al*As, на которой резко изменяется положение края зоны проводимости; гетерограница расположена в /7-области на расстоянии нескольких микрометров от р — n-перехода. Для первых конструкций значение х составляло ~0,5 и приводило к увеличению Eg на •—■ 0,5 эВ при переходе через гетерограницу. Оптическое ограничение в той же области может быть также существенным, в особенности если расстояние между р — «-переходом и гетерогранйцей превышает диффузионную длину инжектированных неосновных носителей [379] (рис. 3.64).
В последующих конструкциях были использованы преимущества двойной гетероструктуры [380] (рис. 3.64) и величина jt была уменьшена до <2300 А/см2 при 300 К. К преимуществам^ относятся улучшение волноводных свойств структуры и подавление инжекции дырок, обусловленное существенным увеличением ширины запрещенной зоны и скачкообразным изменением положения края валентной зоны при добавлении /г-слоя из AUGaj-xAs. В этом случае р — /г-переход формируется между данным слоем и GaAs р-типа. Толщину активной области можно уменьшить до значений, меньших 1 мкм; при этом плотность тока jt непрерывно понижается с уменьшением толщины. Достаточно однородные плоские металлургические переходы получались методом жидкостной эпитаксии даже в ранней работе [382а] (рис. 3.65),
Односторонняя Двойная
гетероструктура гетероструктура
, P~Alx fl-Alx і p~Alx j п-GaAs p-GaAsGa,.xAs Ga,.xAs GaAsGaf. xAs
n-Ga Asp-SaAs і і. і і
4-е------------------------------------------ ! I J! ------- ‘—
|
ршм?) i_ |
|
^ hv P |
|
0,1 MKИ |
|
|
|
r і T 0,1- t і l ft! ! v-a /o І 1 1 S77 |
|
мч ІШМ 0,1 MW |
|
Рис. 3.64. Зонная диаграмма лазерных структур при прямом смещении [382а]. |
|
|
J I
|
|
Показано распределение электронов и дырок в вырожденных гг - и p-областях (рис. 2,8), изменение показателя преломления и распределение генерируемого излучения для р—^-перехода, односторонней гетероструктуры и двойной гетероструктуры. Толщниа активной области из GaAs, равная 1—2 мкм, характерна для ранних разработок приборов.
Влияние плавного изменения состава в гетеропереходах AljtGai-jtAs — GaAs с толщиной переходной области, равной нескольким сотням ангстрем, исследовали Вомак и Редикер [381]; они обнаружили, что это необходимо для омического характера п — /г-гетероперехода. В работах [382, 382а] величина jt в двойных гетероструктурах была „уменьшена до ~ 1000 А/см2, что позволило получить генерацию в непрерывном режиме при температуре теплоотвода выше комнатной (до 311 К). При 297 К была получена мощность 20 мВт при hv = 1,446 эВ. Для сравнения максимальная температура теплоотвода для непрерывного режима генерации простых диодов из GaAs с наиболее эффективной в смысле теплоотвода полосковой геометрией равна 206 К [383]. Необходимо отметить, что вследствие дифракции в плоскости, перпендикулярной плоскости перехода, использование очень тонких активных областей (с<1 мкм) приводят к сильной расходимости в картине дальнего поля (ширина лепестка ~40°). Зависимость расходимости пучка лазера с двойной гетероструктурой от толщины активной области и состава твердого раствора исследована в работе [383а]. Расходимость пучка в плоскости р — /г-перехода обычно составляет ~
|
|
|
6.U /,*Ш is |
|
Подложка из SaM |
|
Рис. 3.65. Изображение сколотой поверхности четырехслойной гетероструктуры в растровом электронном микроскопе [382а]. Резкие изменения интенсивности вторичных электронов (горизонтальные лииин) указывают на металлургические переходы. |
Угловая расходимость, равная всего лишь —0,35°, получается при выводе света перпендикулярно плоскости перехода из лазера GaAs — GaAlAs с односторонней гетероструктурой и гетерограницей, гофрированной в виде дифракционной решетки для создания так называемой структуры с распределенной обратной связью [388а].
Из оптических спектров, полученных на специальной пятислойной гетероструктуре с активной областью /7-типа из GaAs : Si и разрывом края зоны проводимости с соседней /7+-областью из AUGai-xAs : Ge, равным 0,06 эВ, следует, что потери за счет носителей, преодолевающих этот барьер, имеют термоактивационный характер с энергией 0,06 эВ [3826]. Поперечный профиль лазерного пучка также указывает на существование скачкообразного изменения показателя преломления, который определяет оптическое ограничение света с длиной волны 900 нм; эти результаты согласуются с результатами прямых измерений зависимости показателя преломления от х в ALGa^As [222д].
Дингл и др. [382в] обнаружили квантовые эффекты в спектрах края оптического поглощения GaAs, которые следует ожидать при ограничении носителей в очень тонких слоях (контролируемую толщину ~ 100 А можно легко получить методом молекулярно-лучевой эпитаксии). В этом эксперименте для получения особенностей в спектре поглощения была использована структура типа «сэндвича», содержащая приблизительно 50 невзаимодействующих слаболегированных слоев одинаковой толщины, которую можно было создать лишь методом молекулярно-лучевой эпитаксии. Различные эффекты слабого дырочного и сильного электронного ограничений, проявляющиеся в оптических спектрах, позволили определить, как изменение ширины запрещенной зоны от GaAs к Alo^Gao. eAs распределяется между зоной проводимости и валентной зоной. Методом молекулярнолучевой эпитаксии можно было получать скачки по энергии на гетерогранице менее чем через 5 А, и с этой точностью структура оставалась стабильной во время хранения при 300 К после выращивания при 900 К - Из сравнения с результатами для объемного GaAs следует, что в этих узких потенциальных ямах существуют двумерные экситоны, энергия связи которых в 4 раза превышает энергию связи для трехмерного экситона; это вытекает из уравнения (2.4), в котором масса т* заменена приведенной массой электрона и дырки. Очевидно, эти экситоны могут существовать вплоть до гетерограницы GaAs — GaAlAs в отличие от границы GaAs — воздух [221, 222], что еще раз подтверждает вывод об очень низкой плотности состояний на гетерогранице в этой системе [222в] (разд. 3.4.5).
В работе [384] описывается структура с широким оптическим резонатором, в которой функции оптического волновода и ограничение носителей пространственно разнесены путем создания соответствующего профиля изменения ширины запрещенной зоны и показателя преломления; это осуществляется изменением концентрации А1 в выращенных на GaAs четырехслойных лазерах с двойной гетероструктурой. Такие структуры позволяют сильно уменьшить плотность светового потока без существенного уменьшения дифференциального квантового выхода, так что выход из строя, обусловленный катастрофическим разрушением оптических зеркал, становится гораздо менее вероятным. Расходимость лазерного пучка в дальнем поле, обусловленная дифракцией, также сильно уменьшается. Этот тип лазеров имеет самое низкое значение jt = (690 + 40) А/см2 в непрерывном режиме генерации при 300 К [384а]. Самым главным здесь является то преимущество, которое можно получить при уменьшении jt с толщиной d активной (ограничивающей носители) области до d 0,1 мкм, не уменьшая, коэффициент усиления (дифференциальный квантовый выход), из-за неполного ограничения излучаемого света в столь узком волноводе. Очень широкое пространственное распределение излучаемого света появляется при d < Я в отсутствие окружающих, гораздо более широких областей с повышенным значением диэлектрической постоянной, которые уменьшают хвосты негауссова профиля излучения.
|
Рис. 3.66. Плотность состояний р и распределение плотности п электронов в зоне проводимости компенсированного (о) и некомпенсированного (a) GaAs (активная область двойной гегероструктуры) [389]. Уровень Ферми Ер j н концентрация п, относятся к малому уровню инжекции, а Ер2 н п2—к большому. Заштрихованная область указывает на электронные состояния вблизи уровня Ферми, которые принимают участие в лазерной генерации; эта область мала при низком уровне возбуждения слаболегироваиного некомпенсированного материала (а). Хвосты плотности состояний изменяют р, так что Ер перемещается ближе к максимуму распределения носителей даже прн малых уровнях инжекцин (б). |
Крессель и Локвуд [385] утверждают, что зависимость коэффициента усиления от плотности тока в лазерных гетеропереходах AlGaAs—GaAs при 300 К не согласуется с моделью лазерных переходов между зонами с параболическим распределением плотности состояний. Пинкас и др. [386] также обнаружили, что для сильно компенсированного кремнием материала усиление возрастает с током значительно менее резко; в этих образцах усиление при малых токах оказывается больше, чем в образцах с низким уровнем компенсации и п да 1018 см-3. Они показали, что такое поведение качественно согласуется с теоретическими работами Штерна [387] и Хуанга [388].
Зависимость коэффициента усиления от тока можно понять также из графического рассмотрения Хайаши [389], основанного на анализе распределения плотности состояний (рис. 3.66). В слаболегированном некомпенсированном материале (хвосты плотности состояний отсутствуют) (рис. 3.66, а) при низкой концентрации инжектированных носителей п большая их часть находится выше уровня Ферми. Следовательно, лишь немногие
из них могут участвовать в вынужденном излучении, а рост их числа с уровнем возбуждения (а-^-Пг) оказывается быстрым. Для сильнолегированного компенсированного материала, в котором существенно влияние хвостов плотности состояний (рис. 3.66,6) (разд. 3.3.1), справедливо обратное. Число электронов, участвующих в вынужденном излучении, и, следовательно, коэффициент усиления при более высоких уровнях возбуждения становятся сравнимыми. Пинкас и др. [386] показали, как из зависимости дифференциального квантового выхода от длины резонатора для набора диодов можно вычислить значение внутреннего квантового выхода и получили г)/ « 65% для двойной гетероструктуры.
Соммерс [390] из исследований односторонних и двусторонних гетероструктур из GaAs также получил высокие значения внутреннего квантового выхода лазерного излучения (до 100%), хотя безызлучательные эффекты не могли быть совсем исключены. Он перечисляет ряд важных выводов линейной теории лазерной генерации [387, 388], которые сильно расходятся с экс-, периментальными данными: переключение мод, непрерывное (т. е. во всей области длин волн) увеличение интенсивности спонтанного излучения при лазерной генерации, плавное изме нение концентрации накопленных электронно-дырочных пар (без выделения пороговой концентрации), распределение мощности когерентного излучения между модами резонатора и появление максимума дифференциального квантового выхода излучения при уровнях накачки значительно выше порога. Очевидно, что выше порога лазерного излучения наблюдается заполнение хвостов (разд. 3.3.3) [196]; это явление не описывается линейной теорией. Пинкас и др. [386] обнаружили, что потери на поглощение в активной области хорошо согласуются с ожидаемым эффектом от поглощения на свободных носителях.
Такой анализ стал возможным для инжекционных лазеров с гетероструктурой, в которых гетерограница GaAlAs — GaAs практически свободна от дефектов и действительно не вносит существенной рекомбинации, а плотность возбуждения сравнительно однородна. Хайаши и Паниш [3776] показали, что эти характеристики сильно влияют на ряд физических свойств GaAs (например, уменьшают степень температурного гашения в интервале 100—300 К, когда возбуждаемый светом GaAs защищен слоем GaAlAs толщиной, сравнимой с диффузионной длиной неосновных носителей). Миллер и др. [391] описали технологию изготовления лазеров с двойной гетероструктурой с контролируемой толщиной активной области всего — 0,14 мкм и дополнительными слоями толщиной только —0,5 мкм. Эти лазеры имеют пороговую плотность тока 1100 А/см2 при 300 К и дают 200 мВт мощности в непрерывном режиме и 6 Вт в импульсном режиме (последняя величина ограничена катастрофическим разрушением оптических зеркал) (разд. 3.6.3).
Исследования фотолюминесценции активных областей из GaAs в лазерах с двойной гетероструктурой [549в] при возбуждении Kr-лазером показали, что точные детали механизма рекомбинации могут быть установлены при использовании активных областей с уровнями легирования ^1016 см-3. В спектрах имеются уширенные линии, но структура спектра аналогична структуре, показанной на рис. 3.39. Ясно видно, что лазерный эффект в таком материале возникает на межзонных переходах с hv = 1,54 эВ при 77 К, что согласуется с результатами, приведенными на рис. 3.44. Имеются данные, свидетельствующие о том, что лазеры с двойной гетероструктурой и нелегированной активной областью имеют меньшее значение параметра jt/d по сравнению с обычными легированными структурами (d—толщина активной области). По предварительным данным jt достигает 3000 А/(см2-мкм) для нелегированных слоев при 3500— 5000 А/(см2-мкм) для легированных активных областей приборов, изготовленных таким же способом [549в].
В работах [392, 370а] проведены предварительные исследования лазеров на основе четверных твердых растворов, например в системе твердых растворов AlGaAsP. С помощью этих соединений можно создать лазеры из GaAsP, практически свободные от сильной рекомбинации ка гетерогранице и поверхностной рекомбинации и, следовательно, с малой плотностью порогового тока при 300 К для генерации видимого света. Из четверных фазовых диаграмм можно выбрать другие системы, имеющие более широкую область прямых переходов [393]. Излучающие красный свет лазеры с гетеропереходом были получены вплоть до длин волн 657 нм (для непрерывного режима генерации) и до 628 нм (в импульсном режиме) при 77 К. В этих приборах в качестве активной области используется Alo,3Gao,7As, а барьеры в гетеропереходах поддерживаются равными ~0,1 эВ [392а]. Двойные гетероструктуры также использовались для облегчения режима лазерной генерации в GaAs : Si при больших уровнях легирования кремнием и, следовательно, в области более длинных волн [393а]. В этом случае трудности, обусловленные чрезвычайно большими диффузионными длинами в легированном кремнием GaAs, могут быть легко преодолимы.
К сожалению, опыт работы с системой GaAs — GaAlAs, описанный здесь и в разд. 3.6.3, приводит к выводу, что приборы с гетеропереходами, в которых неизбежно большое резкое рассогласование постоянных решетки (например, больше 1%), не следует изготавливать на основе простой экстраполяции этого опыта. Согласно имеющимся данным, эти приборы, по-видимому, должны иметь малую величину начального квантового
10 За к, 1242
выхода и особенно быстро деградировать. К этой большой категории относятся многие интересные лазерные структуры: InGaP для переходов с большой энергией кванта и InGaAs для работы в области длин волн — 1,06 мкм, которые предпочтительны для систем оптической связи. Однако и лазеры с р — п - переходоім в InGaAs, выращенные из газовой фазы с небольшим числом промежуточных слоев между подложкой из GaAs и активной областью с концентрацией In около 20%, имеют свойства, сравнимые с GaAs [3366]. Об изготовлении инжекционных лазеров с двойной гетероструктурой методом молекулярно-лучевой эпитаксии сообщалось в работе [393в]. Плотность порогового тока в этих лазерах превышает плотность порогового тока в изготовленных жидкостной эпитаксией структурах не более чем в 2 раза. Преимущества этого способа выращивания заключаются в лучшей воспроизводимости очень тонких слоев и большей гибкости при создании некоторых новых структур. К недостаткам следует отнести высокую стоимость и некоторые ограничения на легирующие примеси и на общую толщину, которая не превышает нескольких микрометров (скорость роста — 1 мкм/ч). Кроме того, изготовленные из BN ячейки выдерживают только —30 опытов. Было обнаружено, что для того, чтобы уменьшить порог генерации в 10 раз (до —4-Ю3 А/см2), после выращивания при 600 °С необходимо провести отжиг при ^>,700 °С в течение 2 ч.






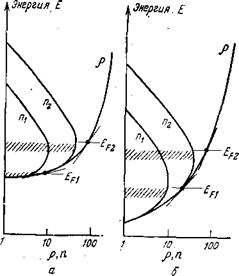
 Опубликовано в
Опубликовано в