Нитрид галлия и другие менее распространенные полупроводники
 26 марта, 2014
26 марта, 2014  admin
admin Нитрид галлия является одним из немногих полупроводников группы AInBv, энергия запрещенной зоны которого лежит выше всего диапазона энергий видимого участка спектра. Поэтому приборы из GaN могут излучать свет любого цвета. Нитрид галлия обычно получают эпитаксиальным ростом из газовой фазы; в качестве источника азота служит NH3, а галлий переносится в виде хлоридных соединений [416]. Свободно выращенные гексагональные иглы в подобной системе были получены в небольшом количестве, но при очень высокой температуре — порядка 1100 °С [417] —по сравнению с 825 °С в работе [416]. Эпитаксиальные слои GaN из газовой фазы выращивались на подложках SiC при очень низких температурах (— 600 °С) путем разложения при нагревании комплекса аммиак — трибромид галлия в атмосфере аммиака [418]. Получаемые пленки имели высокое удельное сопротивление; это говорит, возможно, о низкой концентрации Vn, что соответствует обсуждению, проводимому ниже в этом разделе. Первые исследователи использовали реакцию разложения Ga203 в NH3 в интервале температур 600—1100 °С [419]. Поликристаллические слои нитрида галлия с высоким удельным сопротивлением и толщиной до ~5 мкм были выращены на сапфировых и кремниевых подложках методом высокочастотного распыления в интервале температур 25— -750 °С [420]. Обычно при аммиачио-хлоридном процессе слои GaN растят иа монокристаллических сапфировых подложках. Совершенство слоя полностью зависит от ориентации подложки. Наиболее часто использовалась ориентация (0001), которая не является оптимальной [421].
Так же как A1N, нитрид галлия растет в гексагональной структуре с осью с, параллельной направлению роста слоя, в отличие от более узкозонных полупроводников АШВУ. Нелегированный GaN представляет собой водянисто-белый тонкий слой (10—20 мкм) /г-типа с концентрацией носителей обычно выше 1018 см-3, хотя и был выращен нелегированный материал с Nd — Na < 1017 см-3 [422]. Процесс получения слаболегированного материала, по-видимому, очень чувствителен к геометрии области между вводной трубой для аммиака и сапфировой подложкой, которые должны быть в непосредственной близости друг к другу [423]. В исследованиях спектров отражения GaN при 2 К обнаружена резкая экситонная структура, подобная наблюдавшейся в прямозонных гексагональных полупроводниках группы AnBVI (таких, как ZnO) структуре с расщеплениями, обусловленными кристаллическим полем и спин-орбитальным взаимодействием, равными 22 ± 2 и 11 ±5 мэВ соответственно. Из спектров следует, что Eg = 3,50 ± 0,01 зВ с энергией связи свободных экситонов ~30 мэВ [423]. Эффективная масса электрона составляет (0,20 ± 0,02) т0 [424].
Из ранних исследований оптического поглощения можно предположить, что при 300 К Eg составляет ~3,4 эВ [416] и 3,5 зВ [425] и что запрещенная зона является прямой. На это также указывает большой положительный сдвиг запрещенной зоны под действием гидростатического сжатия [426]. Низкотемпературная краевая люминесценция очень слабо легированного нитрида галлия была подробно исследована в работе [427]. Анализ спектров донорно-акцепторных пар, проведенный в этой работе, дал возможность предположить, что ED ~ 42 мзВ, Ед яі 200 мэВ с большой постоянной скорости рекомбинации, которая согласуется с моделью прямых межзонных переходов. Кроме того, спектры содержат линии экситонов, связанных на нейтральных донорах и акцепторах, которые ожидаются в этом материале (рис. 3.69). Эти группы линий и полос люминесценции в наиболее типичном материале с ND — Na > 1018 см-3 уширяются в две главные полосы вблизи 3,5 и 3,3 эВ. Гораздо более широкие полосы часто встречаются в видимой области спектра (рис. 3.69). Вынужденное излучение наблюдалось вблизи 3,45 эВ на иглах GaN с Nd — NA % 1019 см-3 при сильном оптическом возбуждении. Оказалось, что внутренний оптический коэффициент усиления очень велик и сравним с коэффициентом усиления в GaAs [428]. Из более поздних исследований. краевой фотолюминесценции GaN : Cd [428а] получено значение Ed = 29 ± 6 мэВ, что находится в близком согласии с водородоподобной теорией в приближении эффективной массы [424]. В работе [424] найдена несколько большая величина для Еа (225 ± 10 мэВ), которая, по-видимому, не зависит от вида
|
Энергия, зЗ Рис. 3.69. Типичные спектры фотолюминесценции (Т = 4,2 К) образцов GaN, легированных цинком [427]. Видно, что линия экситона /, связанного на доноре, заменяется линией 1, приписанной рекомбинации экситонов, связанных на нейтральных акцепторах Zn, при увеличении кон* центрацин цинка (верхние спектры). Относительно узкая полоса вблизи 3,3 эВ с сильными ХО-фононнымн повтореннями содержит ожидаемые характерные черты рекомбинации электронов и дырок на далеких донорно-акцепторных парах (рис. 3.40» Очень широкая полоса с максимумом 2,85 эВ преобладает при наибольших концентрациях Zn. |
примесей замещения — элементов II группы, как обсуждается ниже.
Благодаря этим свойствам нитрид галлия потенциально является очень полезным материалом для изготовления светодиодов. Хотелось бы также надеяться на получение видимой электролюминесценции при добавлении активаторов с подходящими энергиями активации. К сожалению, это еще пока пожелания, которые нужно выполнять. Прежде всего, нитрид галлия довольно трудно вырастить. Отсутствие подходящих подложек для эпитаксии приводит к сильной деформации выращенных слоев, которые могут часто растрескиваться или раскалывать подложку во время охлаждения до комнатной температуры. Оказалось, что слои, выращенные методом газовой эпитаксии, и слои, выращенные из раствора Ga + Bi при 950 °С, в которых Nd — Na яа х 1018 см~3 [429], чрезвычайно трудно легировать. Первоначальные сообщения об удачном уменьшении Nd — NA при введении некоторых примесей [416] оказались трудно воспроизводимыми. В частности, не представляется возможным получить материал р-типа добавлением Ge. Выяснилась одна систематическая особенность: можно, хотя и сложно, получить почти скомпенсированный полуизолирующий GaN добавкой Zn. В результате получается материал с общей концентрацией легирующей примеси, значительно большей чем 1018 см-3, который дает при низкой температуре довольно размытые спектры люминесценции с очень широкой эффективной голубой полосой с максимумом — 2,85 эВ [421, 430, 431] (рис. 3.69). Времена релаксации голубой люминесценции довольно большие; они составляют ~5 мкс при 300 К - Люминесценция была приписана туннельным переходам из хвоста состояний зоны проводимости в области, сильно легированной донорами, на соседние глубокие акцепторы, лежащие выше валентной зоны на ~0,7 эВ [432а].
Это дает объяснение сдвига полосы люминесценции с интенсивностью возбуждения, отличное от модели донорно-акцепторных пар, предложенной в работе [432в]. Компенсация глубокими акцепторами очень чувствительна к температуре источника Zn, что может быть результатом прямого уничтожения доноров (вакансий 1/N) цинком, замещающим азот и являющимся тройным акцептором. Эта необычная возможность легирования может быть проверена спектроскопией локальных колебаний, так как Zn должен бы давать щелевую моду. Уменьшение выхода люминесценции при больших концентрациях цинка может быть обусловлено ионным внедрением цинка с концентра - 'цией выше 1018 см-3 [4326]. Однако отсутствие контрольного внедрения нейтральных ионов не дает возможности однозначно интерпретировать результаты этой работы.
Авторы работы [427] наблюдали характерные линии эксито - нов, связанных на неидентифицированных донорах и на акцепторах Mg, Zn и Cd. Все эти акцепторы дают линии, близкие к 3,45 эВ. Наиболее невероятным является то, что энергии иони? зации этой группы акцепторов с Еа~ 200 мэВ неразличимы, хотя полосы донорно-акцепторных пар и кажутся нечувствительными к акцептору [428а, 433]. Указанная модель не согласуется также со структурой, обнаруженной в соответствующей полосе в GaN : Cd в области высоких энергий [428а], что может
свидетельствовать о люминесценции связанных экситонов. Более вероятно, что энергия локализации этого связанного экситона не чувствительна к изменениям величины Еа, как это имеет место для более узкозонных прямозонных полупроводников GaAs [219а] и InP [212]. Широкие полосы с низкими энергиями наблюдались также в кристаллах, сильно легированных кадмием или цинком. Было обнаружено влияние некоторых других примесей на фотолюминесценцию. После многочисленных экспериментов, в которых нередко исходные концентрации электронов были очень низкими, группа сотрудников лабораторий фирмы «Белл» получила полуизолирующий нитрид галлия путем добавления цинка, но еще в поликристаллическом виде [433] в противоположность разработкам некоторых других лабораторий. Это подчеркивает современные трудности управления примесями в GaN. Оказалось, что невозможно получить полуизолирующий нитрид галлия с Cd [428а], хотя, как показано ниже, благодаря более высоким растворимостям Be и Mg это можно сделать.
Многие из указанных трудностей, несомненно, связаны с высокими равновесными давлениями N2 над жидким Ga и GaN вблизи температуры роста ~ 1000 °С, рассчитанными из гораздо более низких давлений аммиака, необходимых для управления химическим потенциалом азота [429]. Большинство исследователей полагают, что высокие концентрации носителей, наблюдаемые в нелегированном GaN, приготовленном различными методами, являются результатом избытка доноров VN. Предварительные активационные анализы ионами Не [434] показали, что концентрация кислорода, который, возможно, является наиболее вероятным простым примесным донором в GaN, по крайней мере в 10 раз ниже, чем требовалось бы для объяснения концентрации свободных электронов в типичных слоях. Эмиссионный и масс-спектрометрический анализы исключили иного других возможностей [434а]. Кроме того, анализ электропроводности более высокоомного материала указывает на присутствие двух активных доноров [434а]. Глубина мелкого донора совпадает с оптическими данными [427], тогда как другой лежит гораздо глубже. На электрические характеристики оказывают сильное влияние скорость роста и совершенство кристаллических слоев.
В кристаллах с гг 8-1018 см~3 была обнаружена ожидаемая проводимость металлического типа [434а]. Таким образом, оказалось, что с точки зрения создания светодиодов нитрид галлия имеет много нежелательных свойств, присущих широкозонным соединениям группы AnBVI [3]. Хотя в GaN можно получить приемлемые величины ЕА и Ed и несмотря на то, что это очень хороший люминофор, работающий при комнатной темпе-
|
Аи
Рис. 3.70. Типичная схема светодиода из GaN с і—п-структурой [430]. Слой і получен легированием Zn или Mg. Излучение генерируется в і—«-переходе и выходит наружу через «'Слой, который может быть довольно толстым. Это может привести к заметному спектральному искажению вследствие самопоглощения. |
ратуре, очень большие трудности управления свойствами материала препятствуют производству приборов с р — я-переходами.
В работе [430] сообщается о создании структуры МДП с верхним контактом из In (рис. 3.70). В этой структуре можно получить сине-зеленую или желтую электролюминесценцию в зависимости от толщины слоев и от уровня легирования изолятора цинком. Сильное легирование цинком дает уровень, лежащий выше валентной зоны на ~0,7 эВ. В сине-зеленой области спектра были получены к. п. д. до 0,1% [436а, 4366]. Обычно при высоком уровне инжекции, необходимом для наблюдения при нормальном окружающем освещении, к. п. д. имеют значения в желтой области 10~3— 10~2% [288]. Желтая электролюминесценция в режиме постоянного тока была получена на приборах, геометрия которых аналогична показанной на рис. 3.70. В такой структуре очень толстые слои и - и /-типа (0,2 — 0,7 и — 0,05 мм соответственно) предназначены уменьшить влияние деформаций на промежуточной поверхности подложки [288]. В спектре электролюминесценции имеется пик ~2,2 эВ (рис. 3.71), гораздо более слабый, чем голубая полоса фотолюминесценции, обусловленная цинком. Это, возможно, вызвано внутренним поглощением в коричнево-оранжевом слое изолятора. Из емкостных измерений найдено, что толщина активной области данного прибора составляет только — 0,2 мкм; это говорит о том, что і-слой содержит проводящие включения.
Можно сделать так, что свет будет появляться на промежуточных поверхностях металл (точка In) — полупроводник или изолятор — слой n-типа (в зависимости от полярности постоянного напряжения смещения). Лучшие характеристики получаются в последнем случае при положительном смещении на точке In. В настоящее время максимальный к. п. д. в желтом диапазоне составляет всего лишь ~4-10-4 [288]. Это значение меньше к. п. д. промышленных желтых светодиодов из GaP : N, полученных эпитаксией из газовой фазы [134]. В отличие от светодиодов на основе GaP : N и аналогично светодио-
|
Рис. 3.71. Спектры излучения различных светодиодов из GaN при 300 К [436а]. Спектры А, В, С и D получены на і—^-структурах, подобных изображенной на рнс. 3.70, при легировании цинком. Спектры Е и D соответствуют диодам из нелегированного GaN с поверхностными барьерами при положительном смещении. Спектр Е получен на дноде с электродом из коллоидного графита, а спектр F — на МДП-структуре с изолирующим слоем из SigN^ при возбуждении прямоугольными биполярными импульсами напряжения. |
дам из карбида кремния (разд. 3.5.1) такой к. п. д. получается только при низких уровнях инжекции и заметно уменьшается при более высоких уровнях инжекции, необходимых для наблюдения при нормальном окружающем освещении. Группа фирмы RCA [436а, 4366] обнаружила, что люминесценция возникает на границах внутренних зерен в слоях. Предполагается, что в этих областях происходит лавинный пробой через п — і — п - структуры. Поэтому для получения хороших результатов часто выгоднее подавать на эти электролюминесцентные приборы биполярное напряжение с резкой сменой полярностей, а не гладкое синусоидальное напряжение. Предполагается также, что дырки, генерируемые в лавинном процессе, рекомбинируют с электронами, захваченными на глубоких уровнях Zn на краю и-области. Видимая люминесценция тогда обусловлена переходами электронов из хвоста состояний зоны проводимости на уровни цинка. Люминесценции, обусловленной захватом дырок, обнаружено не было. Нитрид галлия — наилучший из имеющихся в настоящее время прямозонных материалов для голубых светодиодов с яркостями, сравнимыми с некоторыми МДП - структурами на ZnS [293], до ~68 кд/м2. В работах [436а, 4366] сообщалось о. дальнейшем улучшении светодиодов из GaN, работающих на постоянном токе. К. п. д. составлял 0,1% в сине-зеленой полосе,
При производстве голубых светодиодов технологические преимущества, по-видимому, имеет нитрид галлия, легированный магнием. В этом случае комплексы, связанные с магнием, образуют уровень на —0,2 эВ ближе к валентной зоне, чем в GaN : Zn при высоком уровне легирования [435]. Соответствующий комплекс с Cd дает еще более сильную связь [428а]. Соответствующая люминесценция будет скорее сине-фиолетовой, чем сине-зеленой. К. п. д. первоначальных приборов из GaN : Mg были довольно низкие: —10~3% при 15—20 В прямого смещения в і — n-структуре, подобной изображенной на рис. 3.70. Тем не менее фиолетовая люминесценция легко видна в хорошо освещенной комнате при токах в прямом направлении — 1 мА, распределенных нерегулярно по точкам в квадрате площадью 1 мм2, как было оценено по изменению интенсивности испускаемого света [435]. Полуизолирующий нитрид галлия можно также получить путем добавки Be или Li и, возможно, Dy [436]. Наибо-. лее эффективная фотолюминесценция обеспечивается при введении Dy.
Несмотря на трудности, связанные с легированием и ростом кристаллов, нитрид галлия является, очевидно, наиболее многообещающим полупроводником для новых разработок электро - люминесцентных приборов. В настоящее время трудно оценить возможности многих других материалов, которые относятся к этой категории. Прежде всего технология создания этих материалов не способствует получению монокристаллов. Еще более трудным является производство кристаллов приемлемых размеров, заданной чистоты и Определенной стехиометрии, которые необходимы для оценки величины и типа запрещенной зоны. Выращивание кристаллов, обладающих хорошей проводимостью л - и p-типа, необходимой для производства эффективных светодиодов, также остается до сих пор сложной проблемой.
Значительный интерес вызвали некоторые тройные аналоги хорошо известных бинарных полупроводников, обладающие восемью валентными электронами на ячейку кристаллической структуры, в частности соединения A"BIVCj и Д'Є^’С^1. Эти материалы имеют большие кристаллографические единичные ячейки, чем их бинарные аналоги, и кристаллизуются по типу халькопирита в тетрагонально искаженной структуре, вытянутой вдоль оси г (или с). Удвоение единичной ячейки в направлении оси 2 приводит в результате к пропорциональному сжатию зоны Бриллюэна (уменьшение объема до 25% объема ячейки типа цинковой обманки). Кроме того, появляется новый тип псевдопрямого перехода — результат переноса некоторых особенностей структуры зоны проводимости от границ приведенной зоны в решетке типа цинковой обманки (например, минимумов X и W) в центр зоны для растянутой тетрагональной решетки
|
волновой Вектор к Рис. 3.72. Преобразование зоны Бриллюэна для тетрагонально искаженной решетки полупроводников со структурой халькопирита из хорошо известной зонной схемы для пространственной решетки цинковой обманки [437]. Удвоение единичной ячейки решетки халькопирита в реальном пространстве приводит к соответствующему сжатию единичной ячейки в обратной решетке. Схема показывает, каким образом «складываются» части зонной схемы структуры цинковой обманки, отсутствующие у халькопирита. Перенос точки X в точку Г дает ряд псевдопрямых перехо-’ ,дов, например между Г]5у и Х[С- |
[437] (рис. 3.72). Вероятность этих псевдопрямых переходов зависит от степени различия в псевдопотенциалах двух типов катионов. Считают, что псевдопрямые переходы, например, ответственны за появление многих дополнительных структур в спектре электроотражения ZnSiAs2 — типичного полупроводника со структурой халькопирита [438], хотя запрещенная зона является, очевидно, прямой, как и в некоторых других соединениях типа AnBIVCj [439]. В дополнение к эффекту удвоения единичной ячейки некубический кристаллический потенциал содержит вклады от малых смещений анионов из соответствующих положений в решетке цинковой обманки и от малого сжатия решетки халькопирита вдоль оси 2 (тетрагональное искажение).
В работе [440] показано, каким образом квазикубическую модель, предложенную Хопфилдом для объяснения строения валентной зоны в полупроводниках со структурой вюрцита (которая рассматривалась в данном случае как возмущенная структура цинковой обманки), можно использовать для расчета свойств тройных кристаллов со структурой халькопирита (при учете только эффекта одноосного сжатия и рассмотрении трех, дискретных зон и дихроичного края поглощения). Трудности при расчетах для кристаллов А^111^1 возникают из-за р — af-гибри - дизации от af-оболочек благородного металла. Это приводит к полному подавлению вклада спин-орбитального расщепления для некоторых кристаллов сульфидов [441]. Дополнительным следствием этого является уменьшение ширины запрещенных зон соединений A'b"1^1 на ~0,6—1,6 эВ по сравнению с их бинарными аналогами, тогда как различие этих энергий для системы AnBlvCj находится в интервале примерно ±0,3 эВ. Такой сдвиг очень нежелателен, особенно если учесть стремление получить легко выращиваемые и легируемые полупроводники с большой шириной запрещенной зоны; мы видели, что уже бинарные соединения имеют слишком узкие запрещенные зоны, чтобы идеально удовлетворять требованиям, предъявляемым к материалам для создания светодиодов в видимой области. Кроме того, при получении кристаллов тройных соединений и контроле над примесями с ростом числа компонент трудности увеличиваются.
Бар и Смит [442] обобщили собственные результаты и опубликованные результаты других авторов относительно ширины запрещенной зоны при комнатной температуре в рассмотренных выше двух системах. Эти данные, дополненные более поздними результатами по соединениям А^111^1 из работы [443], по соединениям А'^^Сг" и тетрагональному ZnP2 [444], приведены в табл. 3.7. Все эти материалы можно приготовить p-типа, но только AgInTe2 с Eg да 0,96 эВ можно получить и и-типа [4576]. Наибольшими выращенными из расплава кристаллами без трещин были кристаллы AgGaTe2. Материалы, рассмотренные в табл. 3.7, являются главным образом прямозонными полупроводниками, хотя некоторые из них, в частности ZnP2 [444] и ZnSiP2 [445], относятся к непрямозонным полупроводникам. Исследования электропоглощения ZnSiP2 и ZnGeP2 [445а] подтвердили, что для них край собственного поглощения вблизи 2 эВ не аналогичен сильным прямым переходам Г^-э-Гь наблюдаемым в GaP (рис. 3.2). Он обусловлен псевдопрямыми переходами из валентной зоны Г15, расщепленной кристаллическим полем (на рис. 3.72 малое расщепление не показано), в минимум зоны проводимости Г2, полученный из непрямого минимума Xi в GaP (на рис. 3.72 он показан при большей энергии, чем Гь что справедливо для некоторых других тройных соединений). Псевдопрямая структура гораздо слабее, чем можно было ожидать, исходя из заметной разности псевдопотенциалов атомов второй и четвертой группы, образующих ячейку.
Ясно, что многие из выводов относительно характера запрещенной зоны в этих сложных кристаллах должны рассматриваться как предварительные. Оказалось, что обнаружение
|
Таблица 3.7 Ширина запрещенной зоны некоторых соединений АПВ^, AMBIVCJ н A! BIHC2VI со структурой халькопирита
|
|
1) Относятся скорее к тетрагональному, чем к моноклинному, типу решеткн. Существует также альтернативная группа соединений A^B^f, например с прямой запре |
щенной зоной ~ 0,59 эВ при 77 К [452].
2) Н, П—непрямозонный и прямозонный полупроводники соответственно.
Примечание, Такие соединения, как AgXTe2, где X—Al, Ga, In, не включены. Оказалось, что вырастить (или затем обработать) эти полупроводники с хорошими оптическими или электрическими свойствами трудно даже по сравнению с приведенными в таблице селенидами.
действительного хвоста поглощения, обусловленного непрямым переходом и лежащего чуть ниже запрещенной зоны для прямых переходов, довольно трудная задача, пока не будут доступны монокристаллы достаточных размеров высокого оптического качества и чистоты. Например, считалось, что отдельные полупроводники типа AnBVI с цинком и кадмием действительно являются непрямозонными. В литературе по тройным полупроводникам имеется много противоречивых данных. Часто приводятся значения энергий запрещенной зоны, гораздо меньшие, чем те, которые приведены в табл. 3.7; очевидно, что это следствие преобладания в спектрах образцов плохого качества особенностей, обусловленных примесями. Завышенные результаты, приводимые для ZnGeP2, кажутся маловероятными, а оптические данные, из которых они получены, не особенно надежными [454]. Результаты работы [445а] дают возможность предположить, что непрямой или псевдопрямой край собственного поглощения ZnGeP2 при 300 К расположен заметно ниже 2,05 эВ.
Опубликованные результаты по определению типа проводимости в этих материалах обычно слишком отрывочны для того, чтобы их можно было представить в виде таблицы (за исключением некоторых исследований отжига на десяти соединениях A^CJ1 [443]). В основном прослеживается следующая тенденция, характерная и для бинарных полупроводников: легко получить относительно узкозонные тройные соединения с хорошими электрическими свойствами, такие, как CuInS2 [453], но которые не представляют интереса для видимой люминесценции. Соединения меди р-типа можно легко получить путем отжига при избытке S или Se (возможно, как результат образования вакансий Си), а материал я-типа — путем отжига в вакууме [453а]. Аналогичные результаты возможно получить при росте из расплавов, содержащих избыток Se или In. р— гс-Переходы могут быть приготовлены путем кратковременного отжига этого материала р-типа. Соединение CuInSe2 вызывает в настоящее время интерес как источник длинноволнового излучения (1,3 мкм) для волоконнооптических световодов с низкими потерями [4536]. Однако его внутренний квантовый выход составляет только 0,1%. Соединение CuGaS2 находит применение в светодиодах с гетероструктурой (разд. 3.5.4). Монокристаллы CuGa^xIrixSa могут быть выращены из раствора In или методом иодидного транспорта [453в] в полном диапазоне х, обеспечивающем широкое изменение ширины запрещенной зоны (табл. 3.7). Попытки легирования AgGaS2 и AgGaSe2 в процессе роста или последующей диффузией с использованием широкого диапазона примесей для получения синей и красной люминесценции не привели к надежным результатам [455],
В работе [447] сообщалось о ярко выраженном и-типе и о высокоомном p-типе ZnSiP2, тогда как в работе [454] утверждается, что ZnGeP2 обычно p-типа. В работе [450] сообщается о получении соединения CdGeP2 и и - и p-типа с ограниченной проводимостью. Для получения более надежных результатов для каждого из этих материалов необходимы гораздо более целенаправленные исследования. В настоящее время, по-видимому, это не имеет смысла для разработки светодиодов.
Интерес к соединениям А'^^Сг" был связан главным образом с их лазерными свойствами при оптической накачке или при накачке электронным пучком, так же как и с возможностью их применения в приборах нелинейной оптики. Эти приложения перспективны, хотя обычно требуются более хорошие монокристаллы больших размеров, без трещин и пустот [456]. В низкотемпературных исследованиях при высоком разрешении на ZnP2 [444] и ZnSiP2 [448, 457] обнаружена люминесценция связанных экситонов со структурой, аналогичной структуре, показан» ной на рис. 3.20, а для Cd — О в GaP с экспоненциальными временами затухания —8,5 и —30 мкс соответственно. Несомненно, что если будут получены тройные материалы халькопиритов достаточно хорошего качества, то можно будет тщательно исследовать механизмы рекомбинации, аналогичные механизмам в GaP. Однако эти материалы не имеют преимуществ перед GaP как основы для светодиодов. Соединение AgGaS2 имеет довольно большую ширину запрещенной зоны для прямых переходов (табл. 3.7). К сожалению, это соединение было выращено ^только p-типа с низкой подвижностью и слабой проводимостью, определяемой глубокими акцепторами, которые, возможно, связаны с внутренними дефектами. Высокоомный материал п-типа был получен при соответствующем отжиге [455а]. В работе [455а] сообщается о получении кристаллов, качество которых достаточно для того, чтобы выявить люминесценцию связанных экситонов на хвосте широкой сине-зеленой полосы люминесценции в области высоких энергий, аналогичную, очевидно, той, которая показана на рис. 3.20, а.
Эта ситуация аналогична ситуации для некоторых других классов материалов. Одно из соединений A'"BV (AIAs) было получено довольно высокого качества, и ширина его запрещенной зоны для непрямых переходов была определена достаточно точно ( — 2,16 эВ) [458]. Авторы работы [459] установили, что слои AIAs n-типа, эпитаксиально выращенные на GaAs, не так гигроскопичны, как обычно предполагалось. Они приготовили р — n-переходы путем диффузии цинка и получили желто-зеленое излучение с эффективностью —10_3%. К сожалению, ширина запрещенной зоны для непрямых переходов AIAs значительно меньше, чем у GaP, тогда как энергетический зазор Гс — Хс гораздо больше (чуть больше 0,8 эВ) [460]. Поэтому структура зоны проводимости AIAs менее пригодна для непрямых переходов, обусловленных изоэлектронными ловушками, как это было показано для SiC, и, следовательно, имеется меньше перспектив для светодиодов на основе AIAs. Ширина запрещенной зоны AIP при 300 К составляет 2,45 эВ [458], что больше, чем у GaP. Однако этот материал относительно трудно приготовить — он очень гигроскопичен, и, кроме того, энергетический зазор Гс — Хс очень велик [уравнения (3.6) и (3.7)].
Некоторые из несовершенно тетраэдрических слоистых соединений AmBVI имеют большую ширину запрещенной зоны и хорошие оптические свойства [461]. Соединения Ga обычно p-типа и при легировании цинком или кадмием дают материал p-типа, а при введении Ge -+- Si или I с меньшей надежностью дают материал n-типа. Особенностью низкотемпературной фотолюминесценции является отсутствие компонент, которые можно было бы уверенно приписать связанным экситонам, ассоцииро-
ванным с химическими примесями, несмотря на тщательное изучение кристаллов, специально легированных большинством из вероятных кандидатов. Люминесценция свободных экситонов четко обнаруживается в кристаллах высокого качества, в то время как в легированных образцах видна при несколько меньших энергиях дополнительная люминесценция, приписываемая структурным дефектам, обусловленным высокими концентрациями примеси [461а]. Противоречивые мнения [461] высказывались о том, имеет ли GaSe при низкой температуре непрямой край приблизительно на 50 мэВ ниже прямого края, который при 300 К составляет ~2,1 эВ. Сульфид галлия определенно можно отнести к непрямозонным полупроводникам с Eg « да 2,5 эВ. Спектр связанных экситонов с малой энергией локализации (1,2 мэВ) наблюдался в поглощении и люминесценции GaS [4616]. До сих пор неясно, связан ли этот спектр с примесью или со структурным Дефектом [461а]. О видимой инжех - ционной электролюминесценции GaS при 77 К сообщалось в работе [462], но важность этого эффекта для создания приборов оценить трудно.
Было показано, что соединения бериллия с элементами VI группы (полупроводникп типа AnBlv) имеют большую ширину запрещенной зоны. Теллурид бериллия с Eg ж 2,7 эВ (по-видимому, прямозонный, согласно экспериментальным оптическим" данным) может быть выращен в виде монокристаллов в автоклаве [463]. Выводы из вычислений зонной структуры ВеТе различны и ненадежны. В работе [463] отмечается, что, согласно одним теоретическим расчетам, он является непрямозонным полупроводником с Eg ж 2,9 эВ (1-н>-Х), тогда как, согласно другим, ВеТе—полуметалл с перекрытием зон Гу — X порядка 0,18 эВ. Нелегированный материал имеет умеренную проводимость p-типа. Однако маловероятно, что в этой системе будет легко управлять введением примесей. Теллурид бериллия гораздо более нестабилен в присутствии воды, чем обычные соединения AnBVI. Теллурид бериллия аналогичен, возможно, такому материалу, как pGa203, который обладает некоторой проводимостью, по крайней мере для одного типа носителей [464].. Этот материал более правильно рассматривать как основу для широкозонного ионного люминофора, который, подобно А120з, может давать видимую фото - и катодолюминесценцию после соответствующего легирования. Маловероятно, что такие материалы будут служить основой для светодиодов с хорошим к. п. д.
Теллурид кадмия-магния является очень мало изученным твердым раствором соединений AHBVI в отличие от хорошо известного узкозонного материала для инфракрасных лазеров и приемников CdHgTe. Необычно то, что достаточная проводимость CdMgTe р - и и-типа может быть получена в диапазоне
составов, в котором ширина запрещенной зоны быстро увеличивается с увеличением [Mg], в отличие от гораздо более широко изученных твердых растворов соединений AnBVI, например ZnSexTei-* (разд. 3.5.3). Но более широкозонный богатый магнием твердый раствор очень трудно вырастить в виде качественного монокристалла, несмотря на близкое соответствие постоянных решетки двух бинарных компонент. Диоды на основе Cd0,57Mg0,43Te имеют две широкие полосы люминесценции с максимумами — 640 и 700 нм. Последняя полоса преобладает при использовании высоких уровней легирования алюминием [464а]. Максимальный квантовый выход при 300 К, о котором сообщалось до сих пор для оранжево-желтой электролюминесценции, составляет — 2-10-2% при смещении 2,9 эВ и плотности тока 1 А/см2 [464а]. Полоса 640 нм приписана акцептору Р, в то время как полоса 700 нм может быть связана с дефектами решетки, число которых растет при сильном легировании алюминием. Алюминий в этом растворе является обычно мелким донором, как и в CdTe. Светодиоды получаются при диффузии акцепторов Р в подложку, легированную алюминием. Считается, нто в ближайшее время очень трудно будет получить качественные кристаллы CdMgTe с составами, пригодными для зеленой электролюминесценции, чтобы они могли конкурировать с GaP: N (разд. 3.2.7). Еще более трудным будет изготовление •голубых светодиодов из CdMgTe, поэтому приборы с гетероструктурами, созданные на основе бинарных соединений, в настоящее время считаются более перспективными (табл. 3.5).
Наконец, следует отметить, что свойства твердых растворов соединений AnBVI — AIUBV также не очень перспективны для их использования в светодиодах. Обычно эти соединения обладают неприемлемо высокими сопротивлениями, за исключением того случая, когда они содержат меньше 5 мол.% соединения AHBVI -[401]. К сожалению, хотя полная растворимость имеет место - для нескольких систем, например ZnS и ZnSe с GaP, ширина запрещенной зоны изменяется с составом очень нелинейно с небольшим увеличением при доле соединения AnBVI —70 мол. %. .Любой новый полупроводник вызывает слабый практический интерес, если его более трудно приготовить, чем GaP, и если, кроме того, он имеет ту же самую ширину запрещенной зоны. В твердых растворах, содержащих меньше 10 мол. % соединения AnBVI, например GaP — ZnSe, подвижность носителей сильно ограничена рассеянием на примесях и по сравнению с GaP краевая электролюминесценция гораздо слабее более длинноволновой [465]. Эти явления очень нежелательны. Приборы, полученные методом жидкостной эпитаксии и содержащие соединения AmBv в малой концентрации в /7-области р — п-перехода и соединения AnBvl или их твердый раствор в и-области, также обладают низкой эффективностью люминесценции [466]. Улучшения, предложенные для структуры Робинсона («-тип: ZnSe или ZnSeo,2So, s; р-тип: твердый раствор AnBVI — AmBv, эпитаксиально выращенный на кристаллах AnBVI), оказались трудно воспроизводимыми в других лабораториях [467].

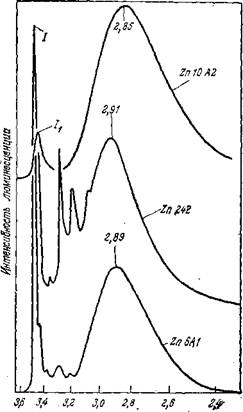



 Опубликовано в
Опубликовано в