Некоторые физические пределы оптического экспонирования
 6 ноября, 2013
6 ноября, 2013  admin
admin Ограничения разрешающей способности оптического метода формирования микроизображения определяются длиной X света, характеристиками светового излучения, такими, как когерентность, спектральный состав, а также качеством совокупной оптической системы, природой регистрирующей среды, условиями, при которых создается микроизображение (наличие турбулентной и рассеивающей среды, вибрации, температурная деформация и т. д.).
Предельные возможности контактного и проекционного оптических способов формирования изображения определяются простыми
Соотношениями. Для контактного метода в реальных условиях
применения: __
6К яа VsX (!■ 5)
где бк — минимальный разрешаемый элемент изображения; s — зазор между контактирующими поверхностями.
Иногда используется следующее теоретическое соотношение:
где 2b — период решетки, состоящей из прозрачных и непрозрачных для света линий одинаковой ширины [26].
Для бесконтактного метода минимальный период решетки для s d определяется соотношением [27]:
2&мин « 3 л/sX + 0,5Д «ЗлДГ (1.7)
На практике зазор sMHh ~ Ю мкм, что отвечает разрешению около 3 мкм. В работе [28] приводятся методы точного нахождения этого зазора.
Для проекционных методов
бПр « Х/(2А)- А = nD/(2f) (Г. 8)
где А — апертура объектива; п — показатель преломления среды для данной длины волны; D — диаметр линзы; f — фокусное расстояние.
Из приведенных соотношений видно, что разрешающая способность пропорциональна X для проекционного способа и Х°>5 для контактного способа. Очевидно, для оптического диапазона (X « 0,2 - г - 0,8 мкм) разрешение не может превышать 0,2 мкм. Это ограничение оптического метода экспонирования может быть преодолено лишь при переходе в более коротковолновый, например рентгеновский, диапазон электромагнитного излучения, где X « « 0,5—5 нм. Однако реальные оптические системы, реальные условия формирования микроизображения не позволяет достичь и этих предельных значений и в настоящее время предельная разрешающая способность оптических методов не превышает 0,5—0,8 мкм, а хорошо освоенные и широко используемые процессы и системы обеспечивают разрешающую способность 1—1,5 мкм. Кроме длины волны излучения и другие параметры ограничивают реальную разрешающую способность оптических методов и часто определяют возможность использования того или иного метода на практике.
Для проекционного метода значение имеет качество всей оптической системы, причем в настоящее время лимитирующими являются не аберрация объектива, строящего изображение, а дифракционные ограничения, определяемые волновой природой света, и явления, связанные с рассеянием света (в том числе и в толще светочувствительного материала), интерференционными эффектами и когерентностью (частичной) света [29]. При этом необходимо учитывать, что объективы, используемые в высококачественных фотолитографических системах, являются дифракционно ограниченными.
Реальную разрешающую способность контактного метода ограничивает величина зазора (от 1 до нескольких мкм) между поверхностями шаблона и резиста, которая непостоянна по всему полю экспонирования, так как указанные поверхности практически никогда не бывают плоскими.
К принципиальным недостаткам контактного метода относятся образование дефектов изображения из-за контактных нагрузок на фоторезистную пленку и несовмещаемость изображений различных слоев, также связанная с контактными деформациями искривленных поверхностей. Оптимизация условий контактного экспонирования и приводит к тому, что предельные возможности метода не реализуются на практике. Попытки снизить контактное усилие с целью устранения дефектообразований в резисте приводит к падению разрешающей способности метода и неконтролируемому уходу размеров элементов из-за образования зазоров, а также расходимости экспонирующего пучка лучей и дифракции. Расходимость (апертура) пучка лучей даже при наличии конденсорных коллимирующих систем в современных установках экспонирования составляет 3—7°, что и при небольших зазорах приводит к образованию полутени в изображении, отклонениям линейных размеров элементов и ухудшению качества края элементов. Дифракция света на краях элементов при наличии микрозазоров переменной величины по площади объекта приводит к образованию интерференционной структуры в изображении и ряду других нежелательных эффектов, например так называемому двойному краю — оконтуриванию изображения элементов вследствие осцилляции освещенности у края элементов, что связано с контрастностью и пороговыми свойствами светочувствительного материала. Могут искажаться углы элементов и даже их форма, особенно существенными эти искажения могут быть при использовании когерентного света.
Распределение интенсивности в дифракционной картине при падении плоской световой волны на полуплоскость имет вид, представленный на рис. 1.6; соответствующие аналитические выражения можно найти для непрозрачного экрана в большинстве курсов физической оптики, а для полупрозрачных экранов, какими являются некоторые покрытия, используемые в качестве маски в микроэлектронике,— в работе [30].
Осцилляции амплитуды и интенсивности света, возникающие в слое в результате сложения прямо прошедшего через маску и ди - фрагмированного на краях элементов волновых фронтов, могут проявляться на фоторезисте при условии, если максимумы интенсивности в тени или минимумы интенсивности в прозрачных областях маски обеспечивают за время экспонирования накопление энергии в слое резиста, соответствующей пороговой экспозиции, и достаточной для удаления части слоя резиста в данных условиях обработки.
На рис. I. 7 приведена картина типичного распределения интенсивности света (изолюксы) в изображении угла топологического элемента. Видно, что при различных условиях экспонирования и обработки в изображении могут быть получены различные отклонения формы и размеров элементов (линии, угла, прямоугольника и т. д.). На рис. 1.8 показана качественная картина распределения интенсивности света в слое резиста при контактной печати. В зависимости от режимов обработок и свойств резиста при наличии подобного скрытого изображения может быть образован в конечном итоге рельеф с линиями различной геометрии. Интересно, что
a ft
|
Рнс. 1.6. Распределение интенсивности света (б) дли частично пространственно когерентного луча света после дифракции от края маски (я): / — точечный источник; 2 — край маски. |
Рнс. 1.7. Распределение интенсивности света (изолюксы) в изображении угла толологнчеч ского элемента:
/ — маска; 2 — область освещенности за границами маскн.
могут быть получены и элементы с размерами, значительно меньшими размеров окон маски.
Когерентность источника излучения оказывает существенное влияние на качество оптического изображения как в контактном, так и в проекционном методе формирования микроизображения. При когерентном освещении меняются условия формирования изображения; в изображении складываются амплитуды светового поля, а не интенсивности, как при некогерентном освещении; возникает характерный «когерентный шум», зернистость изображения. В связи с этим возможности формирования тех или иных структур в изображении оказываются зависимыми не только от качества оптической системы, но и от фазовых соотношений в объекте, взаиморасположения, размеров и формы элементов.
Для описания указанных зависимостей наиболее целесообразно применять аппарат современной теории формирования изобра
жения [31], где оптическая система, включающая и приемник излучения (например, фоторезист), рассматривается как фильтр пространственных частот. При этом объект и изображение описываются их спектрами пространственных частот, показывающими распределение комплексных амплитуд, на которые могут быть разложены функции, описывающие объект и изображение, с помощью преобразования Фурье.
|
|
Передача совокупной оптической системой, состоящей из объекта, источника излучения, объектива, фотоприемника и других
|
|
Рнс. I. 8. Распределение интенсивности света / , обусловленное дифракцией света от маски с прозрачными и непрозрачными областями (решетки):
1 — свет; 2 — маска; 3 — резист; 4 —подложка; б— период решетки; s - пространство между подложкой н маской; штриховой линией обозначено идеальное распределение интенсивности света / по ширине окон в маске в отсутствие дифракции, сплошной линией показано реальное распределение интенсивности в результате дифракции.
Рнс. I. 9. Оптическая передаточная функция (ОПФ) системы для разных факторов когерентности:
/ — а ** 0; 2 — О — 0,7; 3 — О -» <*>; v — пространственная частота.
элементов, тонкой структуры объекта рассматривается при этом как последовательная фильтрация спектра пространственных частот и характеризуется оптической передаточной функцией (ОПФ), которая в общем случае является комплексной величиной. Модуль ОПФ называется частотно-контрастной характеристикой (ЧКХ); иногда его называют функцией передачи модуляции (ФПМ). Типичный вид ОПФ (ЧКХ) приведен на рис. 1.9. ЧКХ называют также коэффициентом передачи контраста, так как для каждой данной пространственной части объекта v ЧКХ равна отношению контраста изображения k' к контрасту объекта k:
A (v) = k'/k (I_ д)
Контраст же объекта определяется отношением:
макс /мнн)/(^макс Т" Iмин) (I, Ю)
где / — интенсивность света.
Пространственная частота, при которой А — 0, и определяет разрешающую способность, Для фотолитографической системы,
характеризующейся некоторым порогом восприятия контраста 5k, разрешающая способность R может быть определена как:
R = I000/(2vnop) (1.11)
где Vnop соответствует величина A(vnop)= 5k.
Аппарат ОПФ (ЧКХ) удобен для описания сложных фотолитографических систем, так как передаточная функция (результирующая ЧКХ) определяется произведением ЧКХ отдельных составляющих элементов оптической системы.
Случай полностью когерентного и некогерентного излучения встречается редко, на практике всегда наблюдается частично когерентное освещение. Оно имеет место даже при полном согласовании апертур осветительной системы и объектива, т. е. при полном заполнении входного зрачка объектива. При уменьшении степени заполнения зрачка степень когерентности б увеличивается, а при заполнении зрачка в виде точки освещение приближается к когерентному случаю. Этим приемом начинают пользоваться на практике при конструировании современной фотолитографической аппаратуры, причем стремятся выбрать оптимальное заполнение зрачка, оптимальную степень когерентности [32].
В ряде систем проекционной литографии принято а0Пт = 0,7, что, с одной стороны, повышает крутизну пограничной кривой, дает при некоторых заданных пространственных частотах большие значения ОПФ (ЧКХ), а с другой стороны, еще не приводит к значительным осцилляциям интенсивности (что может, например, дать оконтуривание изображения — «двойной край»), резонансным эффектам, характерным для когерентного освещения. Учет подобных эффектов, ограничивающих возможности фотолитографии, становится особенно важным при использовании лазеров в качестве источников излучения для формирования микроизображений [33]. При использовании лазеров в качестве мощных источников монохроматического излучения основной проблемой является именно уменьшение когерентности, существенно ухудшающей («когерентный шум») качество изображения и приводящей к резонансным эффектам в изображении, что особенно опасно при передаче сложной конфигурации. Снижение пространственной когерентности излучения может быть осуществлено различными способами— от временного усреднения путем вращения рассеивающих компонентов или сканирования по зрачку [33] объектива до создания специальных, например эксимерных, лазеров, дающих некогерентное излучение [21, 34].
Уменьшения пространственной когерентности необходимо добиваться и при использовании простой контактной печати с обычными ламповыми источниками излучения. Действительно, широко используемые в фотолитографии ртутные лампы сверхвысокого давления типа ДРШ имеют малое по сравнению с расстоянием до плоскости экспонирования L тело освещения (2—5 мм при L = = 200—500 мм), т. е. по размерам приближающееся к точечному источнику. Точечный же источник создает когерентное освещение,
что в большинстве случаев является нежелательным. Для снижения пространственной когерентности необходимо применять протяженный источник излучения, каждая точка которого некогерентна друг другу, за счет чего в плоскости изображения происходит наложение нескольких волновых фронтов, каждый из которых дает соответствующие распределения интенсивности. В результате интенсивности отдельных дифракционных минимумов и максимумов, результирующая амплитуда осцилляции уменьшается, качество изображения улучшается.
Чрезмерное увеличение размера (апертуры) источника, как отмечалось выше, приводит к увеличению области полутени, уменьшению крутизны пограничной кривой (изображение полуплоскости), что такое нежелательно. Именно поэтому с учетом этих двух
V V Y Y У,
|
|
|
Рис. I. 10. Факторы, влияющие Гу на передачу изображений при контактной печати: / — экспонирующий свет; 2 — маска; 3 — зазор; 4 — слой резиста; 5 — отражающая часть подложки; 6 — подложка; а — апертура источника. |
факторов существует оптимальное значение апертуры источника экспонирующего излучения, которое составляет аОПт = 5°.
Еще одним явлением, ограничивающим возможности фотолитографии, является образование стоячей волны в толще слоя фоторезиста — приемника излучения, который стоит последним в совокупной цепи формирования микроизображений; свойства резиста должны отвечать особенностям результирующей структуры скрытого изображения. На рис. I. 10 представлен ряд эффектов, которые ограничивают возможности фотолитографии: а —апертура светового пучка; б — многократное отражение, в — дифракция, г — рассеяние в толще светочувствительного материала, д — стоячие волны. Стоячие волны возникают в толще фоторезиста в результате взаимодействия падающей и отраженной от подложки световых волн. Можно показать, что интенсивность стоячей волны /с определяется выражением:
/с (х) = 4/1 sin2 k (d —■ х) (1.12)
где Л — интенсивность волны, распространяющейся по направлению х в толще фоторезиста.
Величину k находят из выражения (I. 13)
k = 25Ш/А, (1.13)
В результате образования стоячей волны в толще фоторезиста имеют место чередующиеся максимумы (пучности колебаний) и минимумы (узлы колебаний), что приводит к неравномерному засвечиванию фоторезиста по толщине. Положение максимумов и
минимумов освещенности относительно отражающей поверхности подложки определяется выражениями:
/МН11 = d - X = 0; А/(2я), 2Я/(2п) ЫХ/(2п) (1.14)
/макс = Я/(4я); ЗЛ/(4п).............. (2N. + 1) А/(4я) (I. 15)
где JV = 0; 1; 2; ... — порядковый номер экстремума.
Эффект стоячих волн может привести к неравномерному экспонированию резиста у поверхности и у подложки, к непроявлению элементов, к переэкспонированию (или недоэкспонированию) у поверхности, к существенному разбросу времени проявления для участков с различной толщиной слоя фоторезиста и, наконец,
|
|
к неровности края, характерной многослойной, ребристой структуре краев элементов (рис. 1.11 и I 12) [35, 36]. Все это существенно ограничивает возможности фотолитографии и нередко является препятствием к внедрению новых технологических средств и методов (например, проек-
—in I 1 - I t « « Рис. I. 11. Распределение интенсивности света с X
0,1 0,2 0,3 0,4 0,5 0,6 0,7 404,7 им в слое резиста AZ — 1350 J толщиной 0,63 мкм
иа отражающей силиконовой подложке в начале ос, мкм экспонирования.
ционной фотолитографии с использованием монохроматического излучения).
Зависимость экспозиции и, следовательно, размеров элементов в изображении от толщины слоя фоторезиста (точнее разно - толщинности) приводит к искажению формы элементов, искривлению прямых линий, возникновению на них характерных утолщений.
Влияние стоячей волны может быть частично устранено выбором оптимальной толщины слоя резиста и с помощью изменения отражательной способности подложки [27], а также постэкспози - ционной тепловой обработкой, которая дает возможность при нагреве полимерного материала выше Тс улучшить границы рельефа фоторезиста вследствие текучести материала [37]. Подобное влияние оказывает и использование концентрированных проявителей или продолжительного проявления; эти приемы, однако, не позволяют избежать изменения размеров линий на рельефных поверхностях. Эффективным методом является планаризация рельефной поверхности подложки слоем полимера, на который затем наносится слой резиста. Такая структура дает возможность достичь нормального изображения в тонком слое резиста с последующим переносом изображения в планаризационный полимерный слой
[16] (см. гл. VIII).
Для уменьшения влияния дифракционных эффектов на качество края в изображении элементов при экспонировании могут быть
использованы несколько полос линейчатого спектра или некоторый диапазон длин волн сплошного спектра источника, при этом наложение различных максимумов и минимумов приводит к сглаживанию результирующей картины. Использование этого приема также уменьшает эффект стоячей волны, так как узлы и пучности при различных длинах волн располагаются в разных местах в толще фоторезиста, что уменьшает неоднородность экспонирования по толщине и неровность края Однако этим приемом можно пользоваться сравнительно легко в контактной фотолитографии,
|
Рис. I. 12. Рассчитанные границы экспозиционного профиля для линий шириной 2 мкм в слое позитивного хннондиазидного резиста толщиной 0,6 мкм (/ — расстояние от центра линии). |
где допустимо использование света с широким диапазоном длин волн, но трудно, а часто невозможно, — при проекционной фотолитографии, где для создания высококачественных безаберрацион - ных систем необходимо использовать свет с узким диапазоном длин волн.
Таким образом, предельное разрешение, которое может быть достигнуто в фотолитографии при оптимизации совокупной оптической системы, лежит в пределах 0,4—0 6 мкм [38]; достижение этих значений возможно при использовании коротковолновой области УФ излуиетия v учета важнейших факторов, влияющих на качество результирующего изображения.




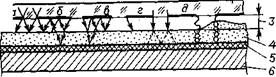

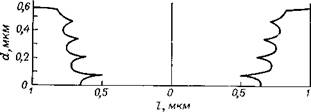
 Опубликовано в
Опубликовано в