ЕМКОСТЬ ПЕРЕХОДА
 28 февраля, 2014
28 февраля, 2014  admin
admin Из измерений емкости перехода можно получить важные сведения о величине и распределении концентрации примесей в диоде. При обратном смещении почти вся емкость диода создается его обедненным слоем, тогда как при прямом смещении значительный вклад в емкость диода дает накопление избыточных неосновных носителей, инжектируемых в нейтральные области диода. Ограничимся рассмотрением емкости обедненного слоя. Для резкого перехода со ступенчатым распределением примеси
Г eeNnN, Г/2
C1*(VD±V)(KD + NA) • (2-26)
|
|
|
-2 0 2 і 5 В Ю )2 1Ь V, в |
|
Рис. 2.12. Зависимость 1/С2 от напряжения для красного светодиода из GaP с высоким внешним квантовым выходом (— 2%), изготовленного методом жидкостной эпитаксии я-слоя на р-подложке [40]. |
|
-в -4 |
Эта зависимость линейна, за исключением области малых обратных смещений (V поло жнтельно). Для прямых смещений 5* 1,5 В диффузионная емкость пренебрежимо мала. Сдвиг линейной области, благодаря которому экстраполированное значение прямого напряжения, соответствующее I/С = 0, оказывается существенно больше Eg, может быть
вызван наличием /-слоя. Указанный сдвиг и отклонение экспериментальных точек от прямой можно также объяснить, исходя из представлений о зависимости от коорди
наты вблизи перехода.
где знак плюс выбран для обратного смещения. Очевидно, что график зависимости 1/С2 от V представляет собой прямую линию, наклон которой пропорционален NdNa/(Nd + Mi) » ND (при Na No) и которая пересекает ось напряжений в точке V = — Vo « —Eg/e (рис. 2.12).
Для перехода с постоянным градиентом концентрации примеси
|
|
(2.27)
где а — градиент концентрации.
Основными методами изготовления р — я-переходов являются методы диффузии, эпитаксиального выращивания из газовой или жидкой фазы и вплавления. Эффективные светодиоды из фосфида галлия (разд. 3.2.7—3.2.9) обычно получают методом жидкостной эпитаксии, а эффективные светодиоды из арсенида галлия — либо методом эпитаксии из газовой фазы (этот метод имеет преимущества с точки зрения технологии), либо диффузией. Однако наиболее высокоэффективные светодиоды из GaAs с гетеропереходом, предназначенные для работы в лазерном Режиме на постоянном токе при высоких температурах
(разд. 3.4.6), изготовлены методом эпитаксии из жидкой фазы. Все эти методы позволяют варьировать в широких пределах уровень легирования и степень компенсации материала в окрестности перехода, но величина градиента концентрации примеси зависит от применяемого метода. Резкие переходы (рис. 2.2) легче получаются методом вплавления или эпитаксии; диффузия дает плавные переходы. Величина контактной разности потенциалов, определенная по пересечению с осью напряжений продолженной экспериментальной прямой (рис. 2.12), оказалась значительно выше, чем Eg у фосфида галлия (~2,26 эВ при 300 К), которая в свою очередь больше Уд (рис. 2.1). Вначале это объясняли наличием ї-слоя [37], благодаря которому ширина обедненного слоя, как указывалось в разд. 2.2, не зависит от напряжения [в отличие от простого резкого перехода, для которого W ~ ~(Уо± У)1/2] • В работе [38] показано, что в предположении о независимости ширины обедненного слоя от смещения волът-ам - перные характеристики светодиодов из GaP, изготовленных методом жидкостной эпитаксии (n-слой на р-подложке), описываются выражением (2.23) в диапазоне изменений тока на пять порядков при 300 К - Уход экспериментальных точек вниз от экстраполирующей прямой на рис. 2.12 объясняется наличием7 глубоких уровней, которые дают вклад в емкость диода, обусловленный захватом носителей, находящихся в обедненном слое.: В работе [39] обращается внимание на роль глубоких донорных и акцепторных уровней в сплавных диодах из фосфида галлия, легированного медью, в возникновении отклонений зависимости С-2(У) от линейной в области небольших обратных смещений. Диффузионная емкость 1) этих диодов, по-видимому, пренебрежимо мала, по крайней мере до прямых смещений 1,5 В.
Хзкетт и Шарфеттер [40] подобрали такое распределение примеси (рис. 2.13), для которого машинный расчет зависимости С~2 от У совпадал с экспериментальной зависимостью (рис. 2.12) для светодиодов из GaP с оптимальным внешним квантовым выходом (2%), изготовленных методом эпитаксии из жидкой фазы п-слоя на р-подложке. Появление я-области обусловлено донорной примесью (теллуром), концентрация которой вблизи металлургического перехода постоянна, и цинком, который диффундирует из подложки во время эпитаксиального процесса. Подтверждение вида распределения примеси, вычисленного на основании С-2— У-зависимостей, было получено из измерений поверхностно-барьерной емкости на косом шлифе.
') Диффузионной емкостью принято называть приращение емкости за счет накопления неосновных носителей в нейтральных областях вблизи краев обедненного слоя. Эта составляющая приобретает существенное значение при прямых смещениях, когда инжекция неосновные носителей становится зна - чительноі;.
|
Рис. 2.13. Расчетное распределение примеси в окрестности р— «-перехода эффективного красного светодиода из фосфида галлия, изготовленного методом жидкостной эпитаксии «-слоя на р-подложке [40]. Слой п предполагается некомпенсированным и однородно легированным с концентрацией 1,5• 1017 см~3. Вычисленный профиль распределения примеси в я-области экстраполирован до предполагаемой границы компенсации теллуром; затем строилось симметричное (дополнительное) распределение цинка, переходящее в постоянную концентрацию 1 • Ю18 см-3. |
В этом эксперименте на поверхность пластины, сошлифованную под углом 3° к плоскости перехода, наносился ряд золотых контактов диаметром 0,05 мм, расстояние между которыми в плоскости шлифа составляло 0,1 мм, что позволяло получить разрешение в направлении, перпендикулярном переходу, равное 5 мкм. Концентрация примеси iV; определялась по наклону вольт-фарадной характеристики контакта металл — полупроводник с барьером Шоттки в соответствии с равенством
В разд. 2.4 продолжено рассмотрение р — л — n-структуры, пред* ставленной на рис. 2.13. Общим условием возникновения я-области в таких диодах является пространственное разделение металлургической границы и электрического перехода при выращивании последнего слоя. В работе [41] показано, что в светодиодах из фосфида галлия, легированного теллуром и цинком, это выполняется при 4Na > Nd > Na/2,

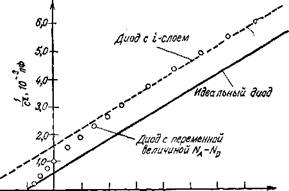

 Опубликовано в
Опубликовано в