Электронное излучение и электронная литография
 7 ноября, 2013
7 ноября, 2013  admin
admin С точки зрения литографии электронное излучение интересно главным образом тем, что его длина волны на несколько порядков меньше, чем УФ-излучения, поэтому с помощью пучка электронов можно в принципе сформировать изображение на несколько порядков меньшее, чем с помощью света. Электронным пучком легко управлять, его можно сфокусировать в пятно диаметром менее 10 нм. Такая фокусировка необходима для формирования топологического рисунка с субмикронными размерами элементов.
|
33 |
Системы, использующие электронное излучение, можно разделить на две большие группы: системы фокусированного сканирующего по подложке электронного пучка и проекционные системы, экспонирующие подложку целиком. Последние изучались интенсивнее, так как потенциально могут обеспечить более высокую производительность, благодаря одновременному экспонированию боль-
2 Зак. 554
шего числа микросхем на подложке, по сравнению с последовательным экспонированием отдельных микросхем, даже и с относительно более коротким временем экспонирования каждой [39].
Сканирующие системы делятся на: 1) работающие с точечным пучком круглого сечения и Гауссовым распределением интенсивности излучения в пучке и 2) работающие с электронным пучком определенной формы в сечении (рис. 1.13). Все сканирующие си-
|
а б
Рнс. I. 13. Схематическое изображение систем, работающих с пучком электронов круглого сечення (а) н сечения определенной формы (б): / — точечный круглый пучок; 2 —диафрагма; 3 — линза; 4 — отклоняющая система; 5 — подложка; 6 — пучок электронов; 7 — формирующая сеченне маска. |
стемы, вне зависимости от характера экспонирования, имеют общие черты. На рис. I. 14 приведена упрощенная схема ЭЛУ с использованием электронного пучка, которая состоит из источника электронов (электронной пушки), оптической части (формирующей электронный пучок), механической части и ЭВМ для управления механической частью и электронным пучком. Электронная оптическая колонна — важнейшая часть ЭЛУ — состоит из источника, одной или более линз (используемых для фокусировки и формирования пучка), приспособления, модулирующего пучок, диафрагмирующего и отклоняющего устройства, последнее может с высокой точностью изменять положение пучка на экспонируемой поверхности. Предельные возможности каждого из этих устройств вместе с ограничениями, обусловленными рассеянием электронов в резисте и подложке, определяют возможности системы в целом.
Предполагаем, что экспонируется поверхность площадью а. Электронная оптическая система образует на этой площади макси-
мальный ток i, который зависит от параметров электронной оптической колонны. ЭВМ, управляющая электронным пучком, задает частоту, с которой управляется электронный пучок. Все в целом определяет максимальное время экспонирования t. Из этих данных находят максимальную дозу Dмакс, которая может быть получена резистом: £)ма кс =
|
|
Рнс. I. 14. Схема ЭЛУ:
/ — программирующее устройство; 2— управляющая ЭВМ; 3 — устройство для управления перемещением стола; 4 — источник электронов; 5 — устройство для формирования пучка; 6 — отклоняющая система; 7 — вакуумная камера; 8 — слой электронорезиста; 9—металлическая фольга; 10 — кремниевая подложка; 11 — стол;
12 — устройство для перемещения стола.
|
|
= it/a. Очевидно, что оптимальными параметрами по критериям экономичности обладают такие резисты, которые дозой £)макс будут наилучшим образом экспонироваться, сшиваясь (негативное изображение) или приобретая растворимость (позитивное изображение).
ЭЛУ могут функционировать только с системой движения стола. В отличие от экспозиционных систем с пучком определенной формы, которые используют дискретное движение (шаг - и -экспонирование), в ЭЛУ с пучком круглого сечения возможно как непрерывное, так и дискретное движение подложки. Сечение негауссова пучка имеет, как правило, квадратную или прямоугольную форму. Изменением размеров и формы сечения пучка можно свести к минимуму число экспонирований, необходимых для образования данного изображения (рис. 1.15). При многократном экспонировании одинаковых геометрических структур [например, при создании системы
Рнс. I. 15. Схема системы, работающей с пучком электронов переменного сечення н размеров:
/ — формирующая сечение маска; 2, 5 — лнизы; 3 — устройство, отклоняющее пучок для вторичного формирования; 4 — экспозиционная маска; 6 — устройство, отклоняющее пучок при экспонировании; 7 — экспонируемая поверхность (слой резиста).
памяти на магнитных доменах или МДП (металл-диэлектрик-
проводник)-транзистор] удобно сразу придать пучку сложную
форму, соответствующую этим структурам. На рис. I. 16 схематически изображены примеры экспонирования геометрически сложного рисунка.
|
2* |
|
35 |
Проекционные ЭЛУ сконструированы для проекции отдельных схем или сразу всей пластины. ЭЛУ для экспонирования пластины
целиком созданы в нескольких лабораториях в начале 70-х годов [40]. Эти установки основаны на фотоэлектронной эмиссии с облучаемого УФ-светом катода (служащего одновременно маской) и
Ш////////Л
I
|
СЕ |
. LJJ ,
'1 Л J LflTt®
1 25 150 450
Рис. I. 16. Сравнение приемов экспонирования разнообразных структур (а) и результирующих профилей (б):
/—Гауссов круглый пучок; 2 —пучок постоянного (не круглого) сечения; 3— пучок сечения переменной формы; 4 — экспонирование пучком сложной геометрической формы; внизу указано относительное число точек изображения, создаваемых одновременно.
ориентацией образующегося потока электронов магнитной линзой. Описана и ЭЛУ с уменьшением [41] (рис. I. 17).
|
|
|
|
В конце 50-х годов методам с использованием электронного пучка начали уделять главное внимание вследствие их способности давать высокое разрешение. Затем последовало успешное развитие сканирующей электронной микроскопии, и опыт показал, что модификация этой системы дает возможность непосредственно образовывать с большой скоростью и точностью высокоразре - шениые рельефы. Первые экспериментальные ЭЛУ, работающие с электронным
Рис. I. 17. Схема проекционной ЭЛУ:
а — изображение образовано электронами, испускаемыми фотокатодом; б — изображение с уменьшением, полученное на подложке при помощи поглощающей маскн; / — УФ-свет; 2 — прозрачный носитель фотокатода; 3 — непрозрачные участки фотокатода; 4 — эмнтнрующая поверхность катода; 5 — соленоид; 6 — поток электронов; 7 — подложка с резнстом; 8 — маска; 9 — электронная пушка; 10 — система линз.
пучком, использовали его высокую разрешающую способность [42]: в первых промышленных ЭЛУ экспонирование электронным пучком применялось для создания масок и малосерийных интегральных схем, так как оно позволяет непосредственно получать структуры по программе, заложенной в ЭВМ. Электронная литография сейчас становится промышленным методом для изготовления высокопрецизионных масок для фотолитографии, важным преимуществом которых является точное размещение структур [43] с соблюдением постоянства их размеров [44].
Рис. I. 18 иллюстрирует главные элементы технологии электронной литографии и последовательность отдельных операций. Хотя большинство операций формально соответствует операциям при УФ-литографии, их необходимо осуществлять на качественно и количественно более высоком уровне. При использовании электронной литографии в технологическом процесссе необходимо при
зе
нимать во внимание ее ограничения, определяемые возможностями отдельных подсистем.
Источники электронов, используемые в ЭЛУ, такие же, как и в классическом электронном микроскопе. Эти источники в зависимости от способа эмиссии электронов делятся на 2 типа: с непосредственно накаляемым катодом и с катодом с полевой эмиссией [45]. В первом случае эмиссия электронов осуществляется нагреванием выше критической температуры такого материала, как вольфрам, вольфрам с примесью тория, гексаборид лантана.
|
|
Преимуществом вольфрамовых катодов является легкость их производства, стабильность по току и нечувствительность к изменению вакуума, они имеют максимальную интенсивность 1 -105 — 3-105 А/(см2-ср), а обогащение их поверхности торием повышает их срок службы. Гексаборид лантана менее стабилен, но интенсивнее излучает [106 А/(см2-ср)], требуя, однако, более высокий вакуум в рабочем пространстве.
В источниках с катодом с полевой эмиссией используется узкий вольфрамовый катод, помещенный в электростатическое поле с высоким напряжением. На конце катода возникает электронный луч диаметром несколько нанометров. Такие источники способны работать с высокой интенсивностью [108—109 А/(см2-ср)], но сложны в изготовлении и требуют для работы вакуум 10~s— 10-8 Па.
Все части электронной оптической системы в зависимости от их использования могут быть скомпанованы по-разному [46]. Технически невозможно в сканирующих системах отклонять электронный пучок по всей поверхности кремниевой подложки, поэтому необходимо использовать механическое устройство, движущее подложку. Движение может осуществляться двумя способами: 1) шагами между отдельными экспонированиями соседних площадей
|
Рис. I. 19. Способы работы систем, использующих электронный пучок: а —строчное сканирование с непрерывным движением стола; б — векторное сканирование с пошаговым движением стола; 1 — отклоняющая система; 2 — пучок электронов; 3 — линейный размер одного сканирования; 4 — кристалл (чип); 5 — подложка с резистом; 6 — направления движения стола. |
[47] (точность фиксации в новом положении обеспечивается ин - терферометрически лазерным лучом или при помощи меток совмещения; 2) непрерывным движением подложки с одновременным экспонированием по заданному рисунку [48] (рис. I. 19). Мгновенное положение подложки должно быть обеспечено с точностью долей микрометра, чтобы погрешность в установке подложки могла быть устранена изменением в отклонении пучка. Эти сложные системы управляются ЭВМ, которая в реальном времени осуществляет мониторинг рабочих параметров электронной оптической и механической систем и на его основе переносит данные, необходимые для дискретного образования изображения, в отклоняющую систему. Скорость, с которой управляющая система способна передавать эти данные, лимитирует время экспонирования. Вышеизложенное справедливо как для растровой системы, так и для систем, работающих с пучком определенной формы (векторная система). Растровая и векторная системы представляют собой два основных сканирующих метода, используемых в электронной литографии [49, 50] (рис. 1.20). При векторной системе электронный пучок отклоняется в соответствии с заданным рисунком микро
электронной схемы, а не вдоль кремниевой подложки, как в случае растровой системы. Это, однако, делает отклоняющую систему в первом случае гораздо более сложной, так как необходимо компенсировать гистерезисные эффекты и большие углы отклонения. Векторная система использована в нескольких успешно работающих ЭЛУ фирм Philips, IBM VSI, Texas Instruments EBSP и Cambrige EBM. F-2. Имеются данные о более совершенной ЭЛУ, EBMF-6, предназначенной для ускоренного изготовления шаблонов [51]. Все эти ЭЛУ работают с гауссовым круглым пучком. Однако, как уже было сказано, векторный сканирующий метод
|
|
5
|
|
Рнс. 1.20. Схематическое сравнение образования структур при векторном (а) и растровом ((f) сканировании:
I — размер пучка электронов; 2 — путь пучка электронов.
более перспективен в отношении использования пучка определенной формы и он реализован в чехословацкой ЭЛУ.
Растровая система с использованием непрерывно движущейся кремниевой подложки была впервые описана в 1971 г. [48]. Эта система известна как EBES, она создана для проведения быстрого, практичного и экономичного экспонирования в производстве высокоточных масок и схем специального назначения. Движение подложки контролируется с точностью 0,125 мкм на площади 100 см2.
При изучении взаимной зависимости характеристик электронного луча и свойств резиста оказалось, что воспроизводимость профиля зависит от ошибок положения луча, его расфокусировки, наклона луча, уровня шумов [52]. С целью увеличения производительности сканирующей ЭЛУ исследованы возможности многолучевого сканирования в варианте с параллельной фокусировкой, но с индивидуальным бланкированием лучей [39]. Некоторые практические аспекты электронной литографии отражены в [53].


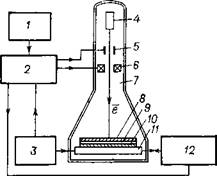


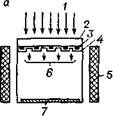
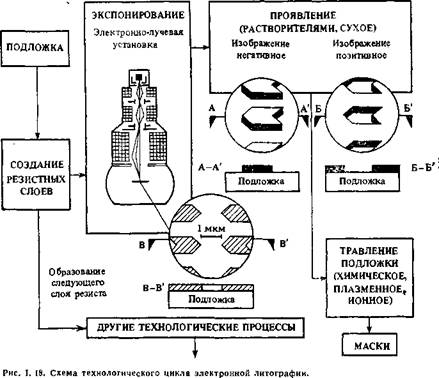
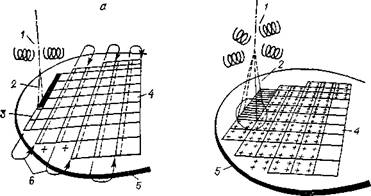


 Опубликовано в
Опубликовано в